هيونغ كون تشو ∗
قسم هندسة المعادن ، جامعة Dong-A ، بوسان 604-714
جيونج يونج لي
قسم علوم وهندسة المواد ،
المعهد الكوري المتقدم للعلوم والتكنولوجيا ، دايجون 305-701
لقد بحثنا في تكوين حفر على شكل حرف V في أغشية النيتريد مثل InGaN / GaN و AlGaN / GaN المزروعة على ركيزة من الياقوت باستخدام المجهر الإلكتروني للإرسال. تعتمد آلية تكوين الحفرة بشدة على تركيبات الإنديوم (In) والألمنيوم (Al) في Inxجا1 × سن و آلxجا1 × سطبقات N ، على التوالي. مع زيادة تكوين الإنديوم ، نشأت الحفر على شكل حرف V من قمة خلع الخيوط إلى حدود عدم تطابق التراص الناتجة عن أخطاء التراص ونمو الجزيرة ثلاثي الأبعاد في المرحلة الأولية بسبب عدم تطابق الشبكة الكبيرة. مع زيادة تركيبة الألمنيوم ، اختلف أصل الحفر أيضًا عن تموج السطح بسبب الإجهاد غير الملائم المرن إلى قمة خلع الخيوط.
أرقام PACS: 61.72.Ff ، 68.55.Ln ، 68.55.-a
الكلمات المفتاحية: Pit، Nitride، TEM، AlGaN، InGaN
I. مقدمة
تخضع أشباه الموصلات المستندة إلى Wurtzite GaN (GaN و InGaN و AlGaN) حاليًا لتحقيق واسع النطاق كمواد واعدة للأجهزة الإلكترونية الضوئية وعالية الحرارة وعالية الطاقة بسبب بعض الخصائص مثل فجوة النطاق المباشرة الكبيرة ، والاستقرار الحراري العالي ، و interatomic قوي. السندات [1 ، 2]. فيxجا1 × سن و آلxجا1 × سطبقات N المزروعة على GaN ، قد تؤدي الزيادة في تركيبات الإنديوم (In) والألمنيوم (Al) حتماً إلى سلالات غير متطابقة في الأفلام. بالإضافة إلى السماكة الحرجة ، تنشأ العديد من العيوب الهيكلية مثل الاضطرابات غير الملائمة ، وأعطال التراص ، والحفر على شكل حرف V ، وما إلى ذلك ، عن طريق استرخاء البلاستيك [3 ، 4]. ومع ذلك ، أيضًا عند السماكات الأصغر ، قد يتم تحفيز الاسترخاء المرن عن طريق تكوين الجزر ، وتموج السطح ، وما إلى ذلك ، كما لوحظ في InGaP / InAsP ، In0.77Ga0.23As / InGaAs ، SiGe / Si ، وما إلى ذلك [5-7 ].بالإضافة إلى ذلك ، قد تؤدي الزيادة في التركيب إلى عدم التجانس الكيميائي للـ Inxجا1 × سطبقات البئر N بسبب ضعف الامتزاج بين InN و GaN [8 ، 9].تم حساب قابلية الذوبان المنخفضة لـ In in GaN لتكون أقل من 6٪ عند 800 درجة مئوية باستخدام نموذج Stringfellow [10].قد تؤثر هذه الخصائص بشكل كبير على الخصائص البصرية والهيكلية للأجهزة [11 ، 12].
لقد أبلغنا مؤخرًا عن نموذجين لتشكيل حفر على شكل حرف V في آبار كمومية متعددة InGaN / GaN (MQWs) ذات تكوين عالٍ [13]. أيضًا ، تم إثبات عدم الرغبة والتأثير على خصائص الانبعاث لهذه الحفر سابقًا بواسطة المجهر الإلكتروني للإرسال (TEM) ، والتلألؤ الكاثوليكي ، والتلألؤ الضوئي [3 ، 14 ، 15]. لذلك ، من أجل قمع تكوين الحفرة ، هناك حاجة إلى فهم واضح لآليات تكوين الحفرة ويجب تقييم البنية المجهرية للحفر التي لوحظت في أفلام III-nitride المختلفة التي تزرع على ركيزة الياقوت بالتفصيل. في هذا العمل ، قمنا بالتحقيق في تكوين الحفرة الذي نشأ من مصادر مختلفة في الهياكل غير المتجانسة InGaN / GaN و AlGaN / GaN مع تركيبات In و Al المختلفة باستخدام TEM.
ثانيًا. تجريبي
نمت جميع العينات على ركائز من الياقوت على مستوى C مع طبقة نواة GaN بسمك 25 نانومتر بواسطة مفاعل تبخير كيميائي عضوي معدني أفقي يعمل بضغط منخفض. تم استخدام Trimethylgallium و trimethylindium و trimethylaluminum and الأمونيا كمصدر للسلائف لـ Ga و In و Al و N ، على التوالي. من أجل تحليل تأثير الضغط على آلية تكوين الحفرة في نيتريد III ، تمت زراعة طبقات InxGa1 − xN السميكة (∼ 800 ˚A) في درجات حرارة تتراوح من 830 درجة مئوية (xفي = 35٪) حتى 880 درجة مئوية (xفي = 10 ٪) وطبقات AlxGa1 − xN السميكة (1000 A) تمت زراعتها عند 1040 درجة مئوية بعد زراعة طبقة GaN الأساسية المشبعة Si بسمك ∼2 مم عند 1080 درجة مئوية. مؤلفات In و Al في Inxجا1 × سن و آلxجا1 × سكانت طبقات N 10 و 13 و 19 و 35٪ و 16 و 25 و 44 و 54٪ على التوالي.
من أجل توصيف تكوين حفرة النيتريد الثالث ، تم تحضير عينات TEM في مقطع عرضي على طول محور المنطقة [11-20] باستخدام تلميع ميكانيكي ثلاثي القوائم متبوعًا بدرجات حرارة منخفضة لطحن أيون Ar عند 4.5 كيلو فولت في Gatan DuoMill 660 DIF مع سرعة القطاع مراقبة. تم تقليل طاقة الأيونات تدريجياً خلال المراحل الأخيرة من التخفيف لتقليل تلف سطح العينات. تم تسجيل صور المجال الساطع (BF) وصور TEM (HRTEM) عالية الدقة على JEOL JEM- 2000EX TEM عند 200 كيلو فولت و JEOL JEM-3010EX عند 300 كيلو فولت.
ثالثا. النتائج والمناقشة
للتحقيق في تأثير تكوين Al على تكوين الحفرة ، صور مجهرية TEM للمجال الساطع المقطعي من Alxجا1 × ستم الحصول على طبقات N المزروعة بمختلف مواقع Al على الطبقة العازلة GaN كما هو موضح في الشكل 1. التركيب النظري الحرج Al على تشكيل الخلع غير الملائم في 1000 A Alxجا1 × سطبقة N المزروعة على طبقات GaN أقل من 15٪ [16]. لم يتم الكشف عن حفر في Alxجا1 × سطبقات N مع ما يصل إلى 25٪ من تكوين Al. يتم ملاحظة عيوب التراص والشقوق فقط في طبقات AlGaN بسبب السلالة غير الملائمة وفرق المعامل الحراري ، على التوالي (غير موضح). بالنسبة لـ Al0.44جا0.56عينة N / GaN ، ومع ذلك ، فإن سطح Al0.44جا0.56تُظهر الطبقة N العديد من الحفر غير المصاحبة للعيوب الهيكلية مثل خلع الخيوط وأعطال التراص وما إلى ذلك [الأشكال. 1 (ب) و (د)]. حجم هذه الحفر صغير جدًا ، يبلغ متوسط قطرها 7 نانومتر ومتوسط ارتفاع 3 نانومتر ، مقارنةً بالحفر الموجودة في طبقات InGaN المزروعة على GaN [13 ، 14 ، 16]. ويعتقد أن تشكيل حفر في Al0.44جا0.56يمكن أن يُعزى N / GaN إلى تموج السطح عن طريق زيادة الإجهاد غير الملائم المرن كما لوحظ في أنظمة أشباه الموصلات III-V و II-VI [5 ، 6].
كثافة الحفرة أكثر من 1010 سم−2 في السطح. من ناحية أخرى ، يتم إنشاء الاضطرابات غير الملائمة في واجهة Al0.54جا0.46عينة N / GaN من أجل الاسترخاء اللدن للسلالة غير الملائمة المخزنة كما هو موضح في الشكل 1 (ج). أيضًا ، يتم ملاحظة الحفر على شكل V المرتبطة بخلع الخيوط في القيعان مثل الهياكل غير المتجانسة InGaN / GaN. هذه الحفر على شكل حرف V لها هرم مفتوح سداسي الشكل ومقلوب بجدران جانبية [14 ، 16].
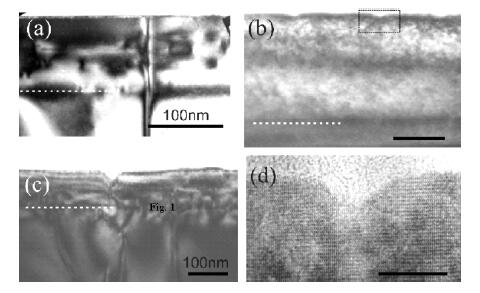
الشكل 1 صور المقطع العرضي للمجال الساطع TEM باستخدام g = 0002 من Alxجا1 × سنمت طبقات N بتكوين Al من (أ) 16٪ ، (ب) 44٪ ، و (ج) 54٪. (د) صورة HRTEM التي تم الحصول عليها من المستطيل المتقطع في (ب). تشير الخطوط المتقطعة إلى علامة Alxجا1 × سواجهة N / GaN.
نتيجة لذلك ، قمنا بتصنيف أصل تكوين الحفرة في Alxجا1 × سنمت N على الطبقة العازلة GaN إلى نموذجين كما هو موضح في الأشكال. 4 (أ) و (د). بالنسبة لـ Alxجا1 × سطبقة N بتكوين ∼40٪ Al ، يتم إنشاء الحفر بواسطة تموج السطح بسبب إجهاد الخلل المرن المخزن [الشكل. 4 (د)]. بالنسبة لـ Alxجا1 × سطبقة N مع أكثر من -50٪ من تركيبة Al ، ومع ذلك ، يتم إنشاء الحفر بشكل أساسي عند قمة اضطرابات الخيوط [الشكل. 4 ا)].
يوضح الشكل 2 الصور المجهرية المقطعية للمجال المشرق TEM من Inxجا1 × سنمت طبقات N بتركيبات مختلفة على الطبقة العازلة GaN. الحرج النظري في التكوين على تشكيل الخلع غير المتوافق لـ ∼800˚A Inxجا1 × سN المزروع في طبقات GaN أقل من 5٪ ، تحته تظهر طبقات InGaN نموًا متماسكًا [16]. لذلك ، نتوقع تكوين جميع Inxجا1 × ستمت دراسة طبقات N هنا للحصول على قيمة أكثر من الحرجة في التكوين على تكوين الخلع غير المناسب. في0.1جا0.9N / GaN ، لم يلاحظ أي عيوب هيكلية مثل الاضطرابات غير الملائمة ، وأعطال التراص ، والحفر ، وما إلى ذلك ، داخل طبقة In0.1Ga0.9N. مع زيادة أخرى في تكوين Inxجا1 × سطبقة N (xفي = 13٪) ، يتم إنشاء الحفر على شكل حرف V لتخفيف السلالة غير الملائمة المخزنة ، كما ورد سابقًا [14]. لقد تمت الإشارة إلى أن الحفرة على شكل حرف V متصلة دائمًا بخلع لولبي من الطبقة العازلة GaN في الأسفل وأن جزءًا صغيرًا فقط من خلع الخيوط يتسبب في تكوين حفر على شكل حرف V في طبقات InGaN و InGaN / GaN MQWs [14]. ومع ذلك ، فإن كثافة الحفر على شكل حرف V في In0.19جا0.81تحتوي الطبقة N في الشكل 2 (ج) على قيمة أكبر من كثافة خلع الخيوط في الطبقة العازلة GaN ، مما يشير إلى أن تكوين حفر على شكل حرف V في InGaN ذات التكوين العالي له أصل مختلف ، كما تم الإبلاغ سابقًا عن أنظمة InGaN / GaN MQW [13]. لقد أبلغنا أنه في InGaN / GaN MQWs ذات التكوين العالي (30٪ في التركيب) ، يتم إنشاء معظم الحفر على شكل V من تكديس حدود عدم التطابق الناتجة عن أخطاء التراص [13]. على الرغم من أن In0.19جا0.81يحتوي N / GaN المستخدم هنا على تركيبة أقل من 20٪ ، ينشأ جزء الحفر على شكل V من تكديس حدود غير متطابقة ناتجة عن أخطاء التراص بسبب زيادة سماكة طبقة InGaN [الشكل. 3 (أ)] مقارنة بـ InGaN / GaN MQW. في0.35جا0.65N / GaN ، حفر على شكل V بكثافة تزيد عن 1010 سم−2 يتم ملاحظتها على السطح. على عكس الحفر في0.19جا0.81عينة N / GaN ، في0.35جا0.65تحتوي مناطق N ذات الأسطح العلوية المسطحة (0001) بين الحفر على عدد كبير من أخطاء التراص وحدود عدم تطابق التراص التي تشكلت في مرحلة النمو الأولي لـ InGaN [الشكل. 3 (ب)] ، أي الهياكل العمودية بما في ذلك أخطاء التراص. لتخفيف عدم تطابق الشبكة الكبيرة بين In0.35جا0.65N و GaN ، الحرفان الأوليان In0.35جا0.65نمت الطبقة N مع مورفولوجيا الجزر ذات الأوجه ثلاثية الأبعاد (3D) [17]. تُرى كثافة عالية من أخطاء التراص في الجزر وتظهر الحدود بين الحبيبات الفرعية للجزر مثل نمو طبقة نواة GaN تنمو على طبقة من الياقوت الأزرق [18].
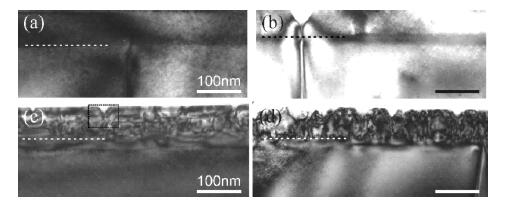
الشكل 2 صور مقطعية ذات مجال ساطع TEM باستخدام g = 0002 من Inxجا1 × سنمت طبقات N بتكوين In من (أ) 10٪ ، (ب) 13٪ ، (ج) 19٪ ، و (د) 35٪ على طبقة المخزن المؤقت GaN. تشير الخطوط المتقطعة إلى Inxجا1 × سواجهة N / GaN.
لذلك ، نعتقد أن الحفر في In0.35جا0.65تنتج عينة N / GaN عن مثل هذا النمو ثلاثي الأبعاد بسبب عدم توافق الشبكة عند النمو الأولي لطبقة InGaN.
نتيجة لذلك ، قمنا بتصنيف أصل تكوين الحفرة في Inxجا1-سنمت N على الطبقة العازلة GaN إلى ثلاثة نماذج كما هو موضح في الشكل 4 (أ) و (ب) و (ج). للفيxجا1-سطبقة N ذات تكوين منخفض ، يتم إنشاء حفر عند قمة خلع الخيوط [الشكل. 4 ا)]. للفيxجا1-سطبقة N مع وسط في التركيب ، يتم إنشاء الحفر بشكل أساسي من حدود عدم تطابق التراص الناتجة عن أخطاء التراص [الشكل. 4 (ب)]. زيادة أخرى في تكوين Inxجا1-سينتج عن الطبقة N نمو الجزيرة ثلاثية الأبعاد في المرحلة الأولية وتشكيل الحفرة في النمو المستمر [الشكل. 4 (ج)].
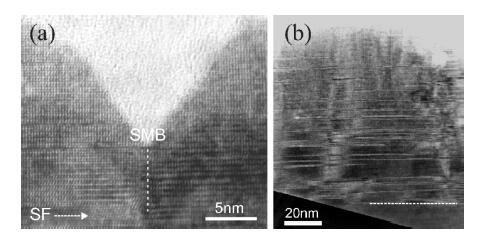
الشكل 3 (أ) صورة HRTEM التي تم الحصول عليها من زاوية مستقيمة متقطعة في الشكل 2 (ج). الحفرة الملحوظة على شكل V بها خطأ في التراص على مستوى (0001) في موضعها السفلي. (ب) صورة HRTEM التي تم الحصول عليها من In0.35جا0.65N في طبقة المخزن المؤقت GaN.
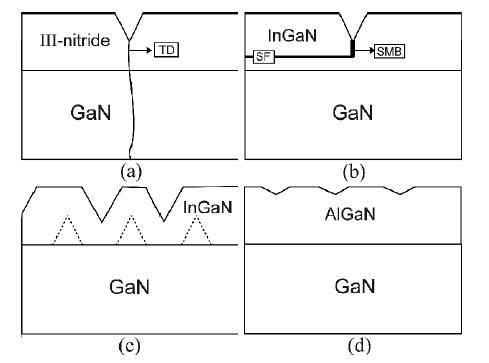
الشكل 4 نماذج تخطيطية لتشكيل الحفرة المتعلقة بـ (أ) خلع خيطي لوحظ في الهياكل غير المتجانسة InGaN / GaN و AlGaN / GaN ، (ب) حد عدم تطابق التراص الناجم عن أخطاء التراص و (ج) نمو الجزيرة ثلاثية الأبعاد في المرحلة الأولية لوحظ في بنية غير متجانسة InGaN / GaN ، و (د) تموج السطح بسبب إجهاد غير ملائم مرن لوحظ في بنية غير متجانسة AlGaN / GaN.
رابعا. ملخص
تشكيل الحفرة في Inxجا1-سن و آلxجا1-ستمت دراسة طبقات N بتركيبات In و Al المختلفة المزروعة على طبقات المخزن المؤقت GaN باستخدام TEM. لقد وجدنا أن الحفر قد تشكلت من أصول مختلفة مثل خلع الخيوط ، وتراكم حدود غير متطابقة ، ونمو الجزر ثلاثية الأبعاد ، وتموج السطح اعتمادًا على تركيبات In و Al.
شكر وتقدير
تم دعم هذا العمل بمنحة رقم R01-2002-000-00096-0 من مؤسسة العلوم والهندسة الكورية وبرنامج البحث الجامعي من وزارة المعلومات والاتصالات في جمهورية كوريا.
المراجع
[1] H. Morkoc ، نيتريد أشباه الموصلات والأجهزة (سبرينغر ، هايدلبرغ ، 1999).
[2] واي إس بارك ، جي كوري فيز. شركة 34 ، S199 (1999).
[3] هونج كونج تشو ، جي واي لي ، سي إس كيم ، جي إم يانج ، إن شارما وسي جيه همفريز ، جيه كريست. النمو 231 ، 466 (2001).
[4] هونج كونج تشو ، جي واي لي ، كانساس كيم وجي إم يانج ، جي كوري فيز. شركة 39 ، S165 (2001).
[5] P. Desjardins، H. Marchand، L. Isnard and RA Masut، J.Apple. فيز. 81 ، 3501 (1997).
[6] إم ميتسوهارا ، إم أوغاساوارا ، هـ. سوجيورا ، جي كريست. النمو 210 ، 463 (2000).
[7] JM Hartmann، B. Gallas، J. Zhang and JJ Harris، Semicond. علوم. تكنول. 15 ، 370 (2000).
[8] D. Doppalapudi، SN Basu، KF Ludwig، Jr. and TD Moustakas، J.Apple. فيز. 84 ، 1389 (1998).
[9] T. Takeuchi ، H. Takeuchi ، S. Sota ، H. Sakai ، H. Amano and I. Akasaki ، Jpn. J. أبل. فيز. 36 ، L177 (1997).
[10] جى بى سترينجفيلو ، جى كريست. النمو 58 ، 194 (1982). [11] سي أي تران ، آر إف كارليتشيك جونيور ، إم شورمان ، إيه أوسينسكي ، في. ميراي ، واي.لي ، آي إلياشيفيتش ، إم جي براون ، جي. نرينج ، آي فيرغسون ، ر. . النمو 195 ، 397 (1998).
[12] MG Cheong ، RJ Choi ، CS Kim ، HS Yoon ، C.-H. هونغ ، إ. سوه ، إتش جي لي ، إتش كيه تشو ، جي واي لي ، جي كوري فيز. شركة 38 ، 701 (2001).
[13] هونج كونج تشو ، جي واي لي ، جنرال موتورز يانغ وسي إس كيم ، أبل. فيز. بادئة رسالة. 79 ، 215 (2001).
[14] XH Wu، CR Elsass، A. Abare، M. Mack، S. Keller، PM Petroff، SP DenBaars، and JS Speck and SJ Rosner، Appl. فيز. بادئة رسالة. 72 ، 692 (1998).
[15] جي بوزينا ، جيه بي بيرغمان ، ب. مونيمار ، ت. تاكيوتشي ، هـ. أمانو وإي. أكاساكي ، ج. أب. فيز. 88 ، 2677 (2000).
[16] JW Matthews و AE Blakeslee و J. Cryst. النمو 32 ، 265 (1974).
[17] Z. Liliental-Weber ، M. Benamara ، J. Washburn ، JZ Domagala ، J. Bak-Misiuk ، EL Piner ، J.C Roberts and SM Bedair ، J. Electron. ماطر. 30 ، 439 (2001).
[18] K. Lorenz ، M. Gonsalves ، Wook Kim ، V. Narayanan and S. Mahajan ، Appl. فيز. بادئة رسالة. 77 ، 3391 (2000).
