يتم توفير البنية غير المتجانسة GaAsSb / InGaAs / InP من قبل مزارع MBE ذو البنية epi PAM-XIAMEN لتصنيع المستشعر البصري. ثابت شعرية زرنيخيد الغاليوم (GaAsSb) مطابق تمامًا للثابت الشبكي لـ ركيزة InP، لذلك فمن السهل للنمو فوق المحور على ركيزة InP مع التوحيد الجيد. يمكن تعديل الطول الموجي للاستجابة لكاشف الشبكة الفائقة InGaAs / GaAsSb من النوع II عن طريق تغيير سماكة الطبقة وهيكل كل مادة في الشبكة الفائقة. الشبكات الفائقة GaAsSb / InGaAs هي نظام المواد المفضل لنوع جديد من أجهزة الكشف عن الأشعة تحت الحمراء ذات الموجة القصيرة. فيما يلي قائمة بالمواصفات من PAM-XIAMEN:
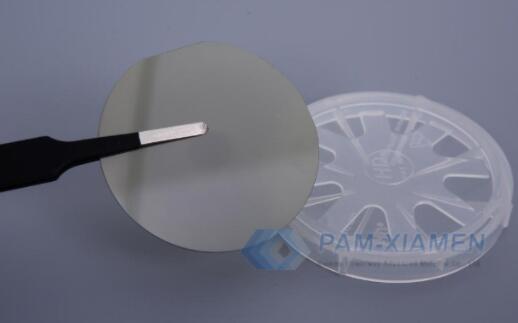
1. مواصفات GaAsSb / InGaAs Superlattices على ركيزة InP
PAM161124 – SLS
| طبقة | تركيب | سماكة | فترات | الناقل تركيز | المقوي |
| طبقة الغطاء | InGaAs أو InAlAs | – | 1 | – | كن مخدر |
| لاعب | SL-GaAsSb / InGaAs | – | – | – | كن مخدر |
| أنا نشط | SL-GaAsSb / InGaAs | – | – | – | – |
| ن طبقة | SL-GaAsSb / InGaAs | – | 50 | – | مخدر سي |
| العازلة | InGaAs | 50 نانومتر | – | – | مخدر سي |
| أسفل | InGaAs أو InAlAs | – | – | ن = 1E18 | مخدر سي |
| المادة المتفاعلة | ان بي (100) | 350um | – | – | مخدر سي |
2. تصنيع رقائق GaAsSb / InP Epitaxial
InGaAs غير المقصودة هي من النوع n ، وتركيز خلفية i-InGaAs لتقنية MBE أقل بكثير من MOCVD. يمكن أن تصل تقنيتنا إلى 7-9E14 سم3. إذا كنت بحاجة إلى تركيز أقل للناقل ، فسنقوم بتعويض i-InGaAs عن طريق تعاطي المنشطات Be.
GaAsSb غير المقصود هو نوع p ، وتركيز خلفية i-InGaAs لتقنية MBE ما يقرب من 1-5E15 سم3، وهو أقل بكثير من MOCVD. ومن السهل تحقيق تركيز أقل في الخلفية عن طريق تعاطي المنشطات Si.
يمكن أن تكون طبقة i-InGaAs خفيفة من النوع p ، والتي يكون تركيزها 1-5E15cm3 عن طريق المنشطات كن. عادةً ، بالنسبة لجهاز الميكروويف المستند إلى InP ، نقوم فقط بزراعة 200 نانومتر InAlAs للطبقة العازلة ، ويكفي ذلك للقضاء على الخلع والعيوب والبقع وخشونة السطح وما إلى ذلك ، لذلك نعتقد أن 500 نانومتر InGaAs كافية للطبقة العازلة ، وسوف نقدم EPD < 500 InP الركيزة بالنسبة لك. سمك رقاقة EPI الخاص بك أكثر من 4.5um ، خاصة السبائك الثلاثية. يحتاج إلى مهارات بارزة لتنميته.
بالنسبة إلى التلامس الأومي للمواصفات المذكورة أعلاه ، فإن الاتصال الأومي لـ InGaAs من النوع p أفضل من InAlAs من النوع p. ومعدن Ti / Pt / Au هو الأفضل للمعادن. بالإضافة إلى ذلك ، فإن الاتصال الأومي لـ InGaAs من النوع n أفضل من InAlAs من النوع n. يعتبر معدن AuGeNi / Au هو الأفضل للمعادن ، تمامًا مثل التلامس الأومي n-GaAs. للحصول على اتصال أومي جيد مع InGaAs من النوع p ، يجب أن يتوقف حفر ميسا أكثر أو أقل في منتصف الطبقة. بقدر ما تكون طبقة InGaAs أكثر سمكًا ، يمكن القيام بذلك بسهولة.
3. آثار تناول المنشطات على خصائص أجهزة إزالة InGaAs / GaAsSb
توجد علاقة طردية بين تركيز الموجة الحاملة في منطقة امتصاص أجهزة الكشف الكهروضوئية وأداء الكاشف. يحدد تركيز الناقل في منطقة الامتصاص العمر الافتراضي وطول الانتشار لحاملات الأقلية ، مما يؤثر على الكفاءة الكمية ومعدل الكشف للكاشف. في كاشف الشبكة الفائقة من النوع InGaAs / GaAsSb II ، يتم استخدام الشبكة الفائقة كمنطقة امتصاص ، وحاملات الخلفية في الشبكة الفائقة الجوهرية موصلة من النوع n ، مما يعني أن ناقلات الأقلية للكاشف عبارة عن ثقوب ، وانتشار الثقوب . الطول أصغر من طول انتشار الإلكترونات. إذا كانت ناقلات الأقلية في منطقة الامتصاص عبارة عن إلكترونات ، فيمكن زيادة طول انتشار ناقلات الأقلية. لذلك ، استخدمنا النوع p Be لتعويض مادة الشبكة الفائقة ، ودرسنا العلاقة بين درجات حرارة المنشطات المختلفة وخصائص InGaAs / GaAsSb جيدًا الكم. وجدنا أن تركيز المنشطات للشبكة الفائقة حساس لدرجة حرارة Be.
لمزيد من المعلومات ، يرجى الاتصال بنا على البريد الإلكتروني على victorchan@powerwaywafer.com و powerwaymaterial@gmail.com.

