إن الطبقة غير المتجانسة المحورية المزروعة على ركيزة GaAs (100) لها مغزى كبير في مجال الإلكترونيات الضوئية ، خاصة في مجال أجهزة الكشف عن الأشعة تحت الحمراء والليزر. تتميز InAs ببعض الخصائص المحتملة ، مثل التنقل العالي للإلكترون وفجوة الطاقة الضيقة ، ويمكن استخدام العديد من المعادن كملامسات أومية لـ InAs ، مما يجعلها مادة جذابة للغاية.PAM-شيامنيوفر نمو heteroepitaxy لفيلم InAs القائم على GaAs ، مع أخذ الهيكل التالي كمثال. المزيد من الهياكل النانوية غير المتجانسة المحور من GaAs منا ، يرجى زيارة:https://www.powerwaywafer.com/gaas-wafers. بالإضافة إلى ذلك ، يمكننا توفير نمو فوق المحور للهيكل الذي تحتاجه.
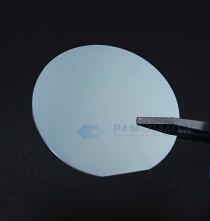
1. فيلم مغاير المحاور من InAs
PAMP19169 - إيناس
|
غشاء رقيق InAs على الركيزة GaAs |
||||
| طبقة | مادة | نوع التوصيل | سماكة | المقاومية |
| Epi | InAs، undoped | نوع N. | – | 1E16 |
| المادة المتفاعلة | 2 "GaAs (100) | شبه العازلة | 0.35um | |
ملاحظة:
إذا كنت بحاجة إلى إثارة أغشية رقيقة من GaAs و InP و InAs من جانب الركيزة باستخدام ضوء ليزر 523 نانومتر ، يجب أن تفكر في معامل الامتصاص وسمك الركيزة. يجب أن يكون للركيزة لكل فيلم رقيق معامل امتصاص منخفض حتى لا تفقد الكثير من الفوتونات التي تصل إلى الأغشية الرقيقة أو لا ينبغي أن يكون سمك الركيزة سميكًا.
2. عملية النمو Heteroepitaxy Growth من InAs على GaAs
بسبب InAs على GaAs (100) الركيزة heteroepitaxy مع عدم تطابق كبير في الشبكة (حوالي 7 ٪) ، يجب أن يتبع النمو وضع SK.
أي ، مع زيادة سمك طبقة النمو تدريجياً ، تتراكم طاقة التشويه المرن داخل البلورة بشكل مستمر. عندما تتجاوز قيمة الطاقة حدًا معينًا ، فإن البلورة ثنائية الأبعاد ذات الطبقات تنهار تمامًا في ومضة ، تاركة فقط طبقة رقيقة من طبقة النمو (طبقة ترطيب) على سطح الركيزة GaAs. في ظل العمل المشترك للطاقة السطحية وطاقة الواجهة وطاقة التشويه للنظام بأكمله ، ستتم إعادة تجميع بقية المواد البلورية InAs تلقائيًا على سطح طبقة الترطيب لتشكيل "جزيرة" جسم بلوري ثلاثي الأبعاد خالٍ من الخلع "بمقياس نانومتر.
لتنمو طبقة فوقية عالية الجودة InAs ، يجب الانتباه إلى النقاط التالية:
- تحكم في درجة حرارة النمو. ستؤدي درجة الحرارة المرتفعة جدًا إلى تحلل InAs ، وهو أمر يصعب نموه ، في حين أن درجة الحرارة المنخفضة جدًا ستجعل سطح الطبقة فوق المحورية خشنة للغاية. بشكل عام ، درجة حرارة نمو الطبقة فوق المحورية InAs هي 480 ℃ ؛
- V / III له تأثير كبير على نمو مواد InAs. يمكن زراعة الطبقة الفوقية ذات السطح اللامع وحركة الإلكترون العالية مع الحفاظ على V / III الغنية والصغيرة. وبالمثل ، يمكن زراعة طبقات فوقية InAs عالية الجودة مع الحفاظ على الثراء الكبير V / III.
3. أسئلة وأجوبة حول Heteroepitaxy من InAs Thin Films
س 1:ما رأيك في المادة السفلية المناسبة لإيداع الأغشية الرقيقة من InAs و GaAs عليها؟ أنا أستخدم ليزر 1045 و 523 نانومتر لإثارة أغشية رقيقة من جانب الركيزة.
ا:الركيزة المناسبة لترسيب الأغشية الرقيقة لـ InAs و GaAs هي الركيزة GaAs أو InAs.
س 2:هل يجب أن أضع طبقة واقية على طبقة رقيقة من InAs أثناء عملية التكعيب؟
ا:قطع وفقا لسطح الانقسام من رقاقة فوقية InAs / GaAs ، لا تحتاج إلى حماية.
س 3:لتنظيف الرقاقة بعد عملية التكعيب ، ما هو الإجراء المناسب الذي يجب علي اتباعه لتجنب إزالة فيلم InAs؟
ا:قم بتنظيف رقاقة التصلب غير المتجانسة InAs وفقًا لتسلسل الأسيتون والإيثانول والماء منزوع الأيونات بعد القطع.
Remark:
The Chinese government has announced new limits on the exportation of Gallium materials (such as GaAs, GaN, Ga2O3, GaP, InGaAs, and GaSb) and Germanium materials used to make semiconductor chips. Starting from August 1, 2023, exporting these materials is only allowed if we obtains a license from the Chinese Ministry of Commerce. Hope for your understanding and cooperation!
لمزيد من المعلومات ، يرجى الاتصال بنا على البريد الإلكتروني علىvictorchan@powerwaywafer.com و powerwaymaterial@gmail.com.

