نمت FZ مقاومة عالية رقاقة السيليكون يتم تقديمه بواسطة PAM-XIAMEN لتصنيع MEMS (النظام الميكانيكي الكهربائي الصغير). رقاقة السيليكون هي المادة الشائعة لتصنيع الدوائر المتكاملة في الإلكترونيات الاستهلاكية. نظرًا لتوافرها وأسعارها التنافسية بجودة عالية من مادة السيليكون ، فهي جذابة جدًا لتطبيقات النظم الكهروميكانيكية الصغرى (MEMS). المزيد من معلمات رقاقة السيليكون MEMS ، يرجى الاطلاع على الجدول أدناه:

ويفر ممس
1. مواصفات رقاقة MEMS
PAMP21445-SI
| بند | 4 "رقاقة Si HRS |
| طريقة النمو | منطقة حرة |
| نوع | جوهري / غير مخدد |
| سماكة | 525 ± 25 ميكرومتر |
| اتجاه | <100> |
| المقاومية | > 60000 أوم * سم |
| تشطيب السطح | DSP |
يوضح الرسم البياني المقاومة الشعاعية لرقاقة السيليكون MEMS:
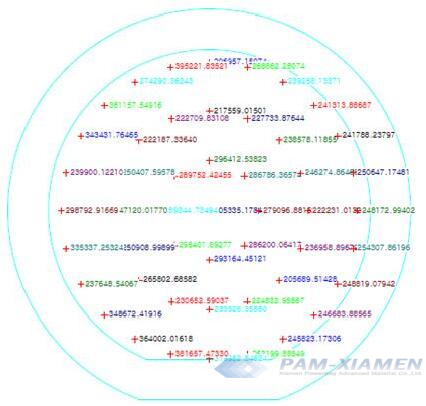
توزيع المقاومة الشعاعية لرقاقة MEMS
رقاقة Si MEMS بتسامح جيد للمقاومة نمت من FZ لا تحتوي على أكسجين ، مما يجعلها ممتازة للخلية الشمسية ذات الهيكل عالي الكفاءة ، وجهاز RF MEMS والصمام الثنائي الضوئي. بالإضافة إلى ذلك ، يحتوي السيليكون أحادي البلورة على القليل من تبديد الطاقة. ستعمل تقنية ربط بسكويت الويفر MEMS على ربط الرقائق في MEMS ، مما يقلل من حجم المنتج ووزنه ، ويزيد من راحة المنتج القائم على MEMS.
2. حول النظام الميكانيكي الكهروميكانيكي
MEMS هو جهاز أو نظام صغير ، يدمج واجهات الاتصالات ، وأجهزة الاستشعار الدقيقة ، والهياكل الميكانيكية الدقيقة ، والمشغلات الدقيقة ، ومصادر الطاقة الصغيرة ، ودوائر معالجة الإشارات والتحكم ، والأجهزة المتكاملة الإلكترونية عالية الأداء.
تركز MEMS على الآلات فائقة الدقة ، بما في ذلك الإلكترونيات الدقيقة والمواد والميكانيكا والكيمياء والميكانيكا وما إلى ذلك. تغطي تخصصاتها مختلف فروع الفيزياء والكيمياء والميكانيكا مثل القوة والكهرباء والضوء والمغناطيسية والصوت والسطح على نطاق صغير.
الأنواع الشائعة من منتجات MEMS لها مقياس تسارع MEMS ، ميكروفون MEMS ، جيروسكوب MEMS ، مستشعر ضغط MEMS ، مستشعر بصري MEMS ، مستشعر رطوبة MEMS ، مستشعرات غاز MEMS ، محرك دقيق ، مضخة صغيرة ، هزاز صغير ، إلخ.
3. إجهاد رقاقة السيليكون في تطبيقات النظم الكهروميكانيكية الصغرى (MEMS)
في تطبيقات النظم الكهروميكانيكية الصغرى (MEMS) ، يلزم وجود رقاقة سليكون بلورية واحدة للحصول على ضغط بسيط. إذا كان الضغط في رقاقة السيليكون المفردة كبيرًا جدًا ، فإن طبقة بنية MEMS سوف تتشوه أو تتكسر ، مما يتسبب في فشل الجهاز. لذلك ، بالنسبة لرقائق الويفر MEMS ، أصبح التحكم في ظروف عملية التحضير لرقائق السيليكون عالية المقاومة لجعلها أقل ضغطًا قضية رئيسية في عملية تصنيع MEMS.
لتقليل إجهاد رقاقات السيليكون للمفاتيح الضوئية MEMS ، يجب أن نبدأ بالجوانب التالية. في عملية سحب الكريستال السليكوني ، نظرًا لأن الجزء الخارجي من البلورة يبرد بشكل أسرع من الداخل ، يتم إنشاء تدرج كبير في درجة الحرارة في الاتجاه الشعاعي للبلورة ، وينتج عن ذلك ضغط حراري كبير. لذلك ، يجب استخدام تقنية المعالجة الحرارية لتقليل أو إزالة الضغط الحراري للبلور. . في الوقت نفسه ، فإن تركيز المنشطات غير المتكافئ سيؤدي أيضًا إلى الضغط الداخلي لرقاقة MEMS. يجب التحكم في التوحيد الشعاعي للمقاومة لتحقيق الغرض من تقليل الضغط الحراري للبلورة. بالإضافة إلى ذلك ، سيتم أيضًا إنشاء ضغط ميكانيكي معين أثناء معالجة رقائق السيليكون. يمكن تقليل الضغط الميكانيكي لرقائق السيليكون MEMS عن طريق تحسين معلمات المعالجة.
لمزيد من المعلومات ، يرجى الاتصال بنا على البريد الإلكتروني على victorchan@powerwaywafer.com و powerwaymaterial@gmail.com.

