Fotomaskeemne med antireflekterende krom er tilgængelig. Fotomasker bruges hovedsageligt i integrerede kredsløb, fladskærme (inklusive LCD, LED, OLED), printkort og andre områder. Fotomasken er en mønstermester anvendes i fotolitografiprocessen ved fremstilling af mikroelektronik. Her er specifikationer for fotomaskeblank til din reference:
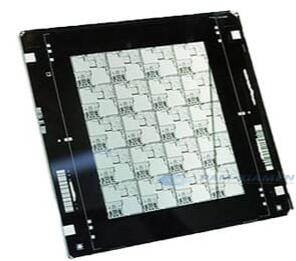
nr. 1 Fotomasker PAM190302-MASKH
nr. 1-1 Siliciumwafers med IC-strukturer (ASIC11) ved 0,35 mikron designstandarder;
Nr. 1-2 Siliciumwafers med IC-strukturer (ASIC12) ved 0,35 mikron designstandarder;
Bemærk:
Diameteren af underlaget >= 150 mm. type/dopingblanding, orientering, tykkelse, resistivitet, forside, bagside, flad(e) bestemmes af producenten for at give de nødvendige elementbaseparametre (transistorer, modstande, kondensatorer) specificeret i designsættet. Producenten leverer et designsæt, der er egnet til udvikling af IC-topologi. Kunden udfører udviklingen i overensstemmelse med Design Kit og sender oplysningerne til producenten i GDS-format. Producenten producerer et sæt fotomasker i overensstemmelse med oplysningerne i GDS-formatet. Producenten fremstiller pladerne ved hjælp af et sæt fotomasker og i henhold til kravet til Design Kit.
nr. 1-3 Fotomaske Blank
størrelse 152 x 152 x mm, skala 5: 1, designet til fotolitografi med designstandarder på 0,35 μm;
Grundlæggende skabelonkrav
Formål: binære skabeloner til projektion f/l
Substratstørrelse: 6 "x6" x0,25 ", kvarts
Udstyrstype: 5x, NIKON NSR 2205i11D
Eksponeringsfelt: 110 mm x 110 mm
Pellicle: Ja, NIK49P-122-1K17 / HFLC, ensidet beskyttelse mod krom (to-vejs beskyttelse efter behov)
Minimum kritisk størrelse: 1,75 mikron
Reproducerbarhed af kritiske dimensioner: 0,05 µm (3σ)
Registreringsnøjagtighed (registrering): 0,1 µm
Defekt: 0,1 / cm2 (1 mikron)
Nr. 2 Chromium Photomask på Quartz PAM200313-MASKH
nr. 2-1 Mindst kompleks: Strip & Ship;
CD >= 5um;
Store åbne områder; Skrivegitter: Standard
Materiale: kvarts, antireflekterende krom. Ingen pellicle.
nr. 2-2 Moderat en:
5x sigtemiddel; 6"x6"x0,12" kvarts;
Ingen defekter større end 2,5um;
Mindre end 1,25um defekt
CD >= 5um; linjer/mellemrum/ottekanter;
Write Grid: Bør vedligeholde CD
Materiale: kvarts, antireflekterende krom. Ingen pellicle.
nr. 2-3Den mest komplekse:
5x sigtemiddel; 6"x6"x0,12" kvarts;
Ingen defekter større end 1,25um;
Mindre end 0,625um defekt
CD >= 2,5 um; linjer/mellemrum/ ottekanter;
Write Grid: Bør vedligeholde CD
Materiale: kvarts, antireflekterende krom. Ingen pellicle.
Der vil ikke være nogen pellicle nødvendig i disse fotomaskeemner, og sigtemaskens størrelse vil være 6" x 6" og 0,12" i tykkelsen. Mine funktionsstørrelser på masker er 2,5um og 5um. Fotomaske (trådkors) er til fremstilling af litografiprocessen, der skal bruges i stepmaskiner.
De tekniske parametre for fotomaskeemne opfylder kravene i tabel 1 og tabel 2.
|
Tabel 1 Fotomaske kvalitetsniveauparametre |
||||||||||||||||
| Grad | D | C | B | A | S | T | U | V | W | W+P | X | X+P | Y | Y+P | Z | Z+P |
| Tolerance | ±0.3 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.1 | ±0.05 | ±0.04 | ±0.035 | ±0.035 | ±0.032 | ±0.032 | ±0.028 | ±0.028 | ±0.022 | ±0.022 |
| Betyde at målrette | ±0.3 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.075 | ±0.05 | ±0.04 | ±0.03 | ±0.03 | ±0.028 | ±0.028 | ±0.025 | ±0.025 | ±0.02 | ±0.02 |
| ensartethed | 0.2 | 0.2 | 0.2 | 0.15 | 0.1 | 0.075 | 0.05 | 0.04 | 0.035 | 0.035 | 0.035 | 0.035 | 0.03 | 0.03 | 0.025 | 0.025 |
| Registrering | ±0.4 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.075 | ±0.05 | ±0.06 | ±0.055 | ±0.055 | ±0.05 | ±0.05 | ±0.045 | ±0.045 | ±0.04 | ±0.04 |
| Defekt størrelse | 1.5 | 1.5 | 1 | 0.8 | 0.6 | 0.4 | 0.4 | 0.35 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Defektdensitet | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 |
| Kantdefekt | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Kantruhed | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Hjørne afrunding | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| PSM fase | / | / | / | / | / | / | / | / | / | 180±4 | / | 180±3 | / | 180±3 | / | 180±3 |
| PSM trans | / | / | / | / | / | / | / | / | / | 6±0,4 | / | 6±0,3 | / | 6±0,3 | / | 6±0,3 |
Bemærk:
Parametrene er anvendelige til skala sigtemiddel; kvalitetsniveauet er rangeret fra lavt til højt:
- 0,5um proces understøtter op til S-niveau; 0,35um proces understøtter op til U niveau, 0,18um proces understøtter op til X niveau;
- Almindelig glasmaske gælder kun for klasse D.
| Tabel 2 Krav til fotomaskekvalitet | ||||||||
| 1:1 hovedmaske | 1:1 Elektronstrålescanning | UT maske | ||||||
| Grad | PB | PA | EB | EA | ES | uc | UB | UA |
| CD spec | >2.5 | 1,2~2,5 | >1.5 | 1,2~1,5 | <1.2 | >2 | 1,5~2,0 | <1.5 |
| Tolerance | ±0.25 | ±0.2 | ±0.2 | ±0.15 | ±0.1 | ±0.25 | ±0.2 | ±0.15 |
| ensartethed | 0.3 | 0.3 | 0.3 | 0.25 | 0.2 | 0.25 | 0.2 | 0.15 |
| Registrering | ±0.8 | ±0.8 | ±0.2 | ±0.15 | ±0.1 | ±0.2 | ±0.15 | ±0.1 |
| Defekt størrelse | 2 | 2 | 1.5 | 1.5 | 1.0 | 2 | 1.5 | 1 |
| Defektdensitet (stk/in2) | 2 | 1 | 2 | 1 | 0.5 | 0 | 0 | 0 |
Bemærk:
Kravet gælder for 1:1 maske, og kvalitetsniveauet er rangeret fra lavt til højt;
UT-maske gælder kun for kvartsmateriale; almindelig glasmaske kan anvendes på højeste niveau B.
No.3 Fotolitografi Blank PAM200326-MASKH
Glasunderlag:
Størrelse: 50x50mm +/-0,2mm;
Tykkelse: 3,67 mm +/- 0,02 mm
Materiale: KVARTS
Ingen Spec. på Fladhed: 1/4 ~ 1/2 bølgelængde
Fri for afslag på kanter
Startsubstrat 7X7inch X 150mil
Standard sigtekors blank Coating 3.0 OD AR Krom
nr. 4 Fotomaske på Quartz PAM200602-MASKH
nr. 4-1 Foto maske
Maskestørrelse 5" X5"
MASKESUBSTRAT MATERIALER: Kvarts
Litografi: elektronstråle
Maskepolaritet: BF
Funktionstolerance: 0,02um
Funktionsstørrelse: 0,4um
Nøjagtighed: 0,12 um
Fremstillingsgitter: 0,005um, 0,02um
nr. 4-2 Fotomaske Blank
Maskestørrelse 5" X5"
MASKESUBSTRAT MATERIALER Kvarts
Litografi: laser
Maskepolaritet: DF
Funktionstolerance: 0,5um
Funktionsstørrelse: 10 um, 3um eller 5um
Nøjagtighed: 0,12 um
Fremstillingsnet: 0,02um
nr. 5 Quartz med LR Krom PAM200811-MASKH
Maskestørrelse = 5″x 5″x 0,09″
Materiale = Kvarts med LR Krom
Orientering: RR Ned.
Data Mørk.
Kritisk dimension (CD): 4 µm +/- 0,5 µm (for alle masker)
Defekter: 0 > 5 µm
Bemærk venligst:
Quartz med LR Chrome er til fremstilling af Mask Aligner (NUV fotolitografi 350-450 nm bølgelængde);
Data til maskeskalering er 1:01, fordi maskejustering har skalering 1:1 i stedet for 5:1;
Maskematerialet er Quartz med LR Chrome, og Chrome-siden vender nedad (Real Read (RR) nedad);
Ved layoutdesign bruges Metallag nummer 28, og arealet af metallag i designlayouterne skal være krom på fotomasken.
For mere information, kontakt os venligst e-mail på victorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

