Gennem løbende indsats,PAM-XIAMEN har udviklet COP-fri i stor skalaCZ silicium(Si) oblater, og kontrollerede effektivt genereringen af COP i barren ved at forbedre krystaltrækkets termiske felt, hvorved der opnåedes ydeevneforbedring og strømforbrugsreduktion. Påføringsprocessen for 8-tommer siliciumwafer er større, så den er ikke følsom over for COP; 12-tommer silicium wafer påføringsprocessen er mindre og mere følsom over for krystalkvalitet. Generelt set stiller processen under 40nm højere krav til krystalkvalitet, så der er mere efterspørgsel efter COP-Free. Specifikationerne for COP-fri wafer til salg er som følger:

1. COP Free Wafer Datablad
| Types of COP Free Wafer | Polished | Annealed | epitaksi |
| Diameter | 8” & 12” | 12” | 8” & 12” |
| Orientation | (100), (110) or (111) | ||
| Ledningstype | N & P | ||
2. Hvad er COP for CZ-Si Wafer?
COP (crystal originated particles/pits) er primær defekt i silicium enkeltkrystal. Denne defekt er en gitterdefekt afsløret efter kogepolering af siliciumwafere med SC-1 (NH4OH:H2O2:H2O-1:1 5) opløsning ved 85 °C i 4 timer. Efter behandling af siliciumwaferen med SC-1 opløsning blev overfladelaget af siliciumwaferen ætset væk med 150 nm. Tætheden af COP-defekter kan detekteres af en laserscanningspartikeltæller.
COP-defekter er oktaedriske mikrohulrum, som vist i figur 1, størrelsen af COP er 0,12~0,30um. Etch pits af COP-defekter kan generelt opdeles i to kategorier: den ene er monotype, den anden er bitype.
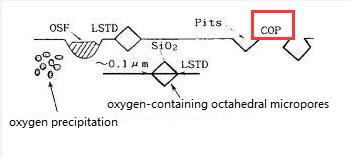
Fig. 1 Skematisk over COP-defekter
3. Hvorfor har CZ Wafers COP-defekter?
Dannelsen af den primære defekt COP er tæt forbundet med dannelsen af iltudfældning. Årsagerne er:
(1) De store primære defekter i CZ-silicium er ikke fundet i iltfrit FZ-silicium;
(2) På grundlag af beregningen af den frie energi af mikrohulrum er det bevist, at mikrohulrum ikke kan dannes ensartet fra nøgne ledige stillinger;
(3) Under CZ-siliciumvækst over et ret bredt temperaturområde er oxygen overmættet og udfældes derfor. Ved at bruge det energidispersive røntgenspektrum af TEM kan der udføres elementær analyse af COP-defekter, og det viser sig, at nogle COP-defekter indeholder ilt. Dette indikerer, at mekanismen for tomrumsdannelse også er relateret til iltudfældning.
Derudover er væksthastigheden af COP-defekter den hurtigste i området 900~1100 °C, så tiden brugt i dette temperaturområde bestemmer størrelsen af væksten af COP-defekter. Hurtig passage gennem dette temperaturområde kan effektivt forhindre væksten af COP-defekter. Men eftersom enkeltkrystaller har tendens til at vokse inden for et bestemt trækhastighedsområde, såsom trækhastigheden af stærkt doteret Sb er generelt 0,6-1,2 mm/min. Og det generelle termiske felttemperaturområde på 900 ~ 1100 ° C er bredere, så COP-defektstørrelsen er bundet til at vokse under hele vækstprocessen af den enkelte krystal. Størrelsen af COP-defekter er også påvirket af rengøringstiderne ved den efterfølgende waferbehandling. Efter rengøring i SC1 i 5-6 gange stiger antallet og størrelsen af COP-defekter eksponentielt.
4. Hvordan får man krystal-oprindelige-gruber-fri wafer?
Der har været mange forskningslitteratur om at eliminere eller reducere COP'erne for at få COP-frie substrater, hvilket kan opsummeres som:
(1) Generer nitrogen-doteret silicium enkeltkrystal;
(2) Hydrogen- eller argonglødning for at eliminere overflade-COP-defekter;
(3) Juster den langsgående temperatur af det termiske felt Gradient, hvilket reducerer COP-defektdensiteten og krymper COP-defektstørrelsen.
Nogle undersøgelser har påpeget, at når koncentrationen af doteringsmiddelbor overstiger en kritisk værdi, vil dannelsen af COP effektivt blive undertrykt, hvorefter der opnås COP-fri krystalskiver. Størrelsen af denne kritiske værdi er relateret til diameteren af barren. For eksempel, for en 200 mm silicium barre, er den kritiske værdi 4,8×1018 atom/cm3; for en 150 mm barre er den 6,3×1018 atom/cm3.
Undersøgelser har også vist, at højtemperaturudglødning i hydrogen- og argon-atmosfærer effektivt kan reducere hul-type mikrodefekter (såsom COP'er) på overfladen af siliciumwafers og derved forbedre GOI for MOS-enhedsapplikationer. Da overfladen af siliciumwaferen (inklusive overfladen af COP'en) er dækket med et lag af naturligt oxid, uanset om der anvendes en hydrogenatmosfære eller en argonatmosfære, under høj temperatur, så længe siliciumwaferen opvarmes til en høj temperatur 1200°C bliver det naturlige oxidlag på overfladen af waferen termisk ustabilt og dissocierer for at generere yderligere siliciumatomer. Disse ekstra siliciumatomer vil udfylde positionerne af COP'erne, så disse hul-type mikrodefekter gradvist bliver mindre eller endda forsvinder, hvorved der opnås silicium COP fri wafer eller lav COP Si wafer.
For mere information, kontakt os venligst e-mail på victorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

