Siliciumcarbid (SiC) wafer er tilgængelige, for mere wafer information, klik venligsthttps://www.powerwaywafer.com/sic-wafer. Ydeevnen af SiC wafer udskæring bestemmer forarbejdningsniveauet for efterfølgende udtynding og polering. Udskæring er tilbøjelig til revner på overfladen og undergrunden af SiC-waferen, hvilket øger fragmenteringshastigheden og fremstillingsomkostningerne for waferen. Derfor er styring af revneskaden på overfladen af SiC-waferen af stor betydning for at fremme udviklingen af siliciumcarbid-enhedsfremstillingsteknologi.
1. Faktorer, der påvirker kvaliteten af SiC-wafer-udskæring
Siliciumcarbidskæringskvaliteten påvirkes af følgende faktorer:
1) Saveprocesparametrene;
2) Størrelsen af de konsoliderede slibepartikler;
3) Fremføringsbevægelsen af emnet;
4) Ukorrekt kontrol af savwirens hastighed.
Alle faktorerne kan forårsage overfladerevneskade på SiC-skiven under skiveskæringsprocessen. Og overfladerevneskader er tæt forbundet med skivekvaliteten. 4H-SiC barre udskæring kan producere overfladerevner, som hovedsageligt er opdelt i underjordiske laterale revneskader og median revneskader, som vist i figuren nedenfor. Mens revneskaden øger omkostningerne ved efterfølgende forarbejdning, er det let at udvide yderligere og få SiC-waferen til at gå i stykker.
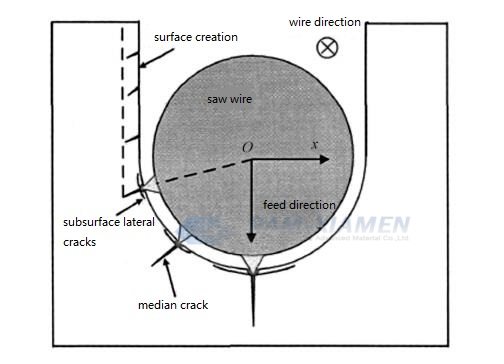
Fig. Overfladerevneskader på savning af SiC-skiver
Epitaksial vækst på siliciumcarbidsubstrat, enhedsfremstillingsproces og enhedsydelse er alle relateret til krystalorientering. For at undgå sprøde revner i wafere forårsaget af orienteringsfølsomhed under barreudskæring, skal krystalorienteringsdetektion udføres før udskæring af siliciumcarbidbarre.
2. Løsninger til at sikre kvaliteten af SiC Wafer Slicing
For at sikre kvaliteten af SiC-skiver anbefaler vi dig følgende løsninger:
For det første dyrkes SiC-barrer generelt på SiC-{0001}-planet, og skæring langs SiC-krystalplanet parallelt med vækstretningen af barren kan effektivt reducere tætheden af gevindskrueforskydninger på skiveoverfladen og forbedre skivekvaliteten.
Så er kontrollen af savprocesparametrene under udskæringen også afgørende for udskæringskvaliteten. Reduktion af tilspændingshastigheden og fremføringskraften kan reducere den normale trykspænding af slibekornene, forøgelse af savtrådens hastighed kan reducere den tangentielle trykspænding af slibemiddelkornene og reducere sliddet af savtråden og belægningen og afkastningen af slibekornene i et lille område. Det er dog nødvendigt at overveje savwirens skadesgrad og savningseffektiviteten grundigt.
Derudover er det nødvendigt at opretholde tilstrækkelig og ensartet kølevæske for at reducere den resterende termiske spænding, reducere vibrationen af savtråden og undgå ustabilitet i slibespændingsfeltet.
For mere information, kontakt os venligst e-mail påvictorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

