PAM-XIAMEN kan tilbyde AlGaAs / GaAs p-HEMT (pseudomorphic high elektron mobility transistor) heterostruktur epitaksial wafer dyrket ved MBE eller MOCVD proces. Heterostrukturen har en højmobilitetsledningskanal dannet af todimensionel elektrongas, som er et ideelt materiale til trådløse applikationer. Linjebredden af vores GaAs pHEMT-proces er omkring 0,15-0,5μm, meget lav, men med ultrahøj frekvens og lav støj karakteristika, og driftsfrekvensen kan være så høj som 100GHz. De specifikke specifikationer for GaAs pHEMT epiaksi wafer er som følger, vi kan også levere tilpasset GaAs epi-wafere:

1. GaAs pHEMT Wafer Specifications
No. 1 LN pHEMT Epi Structure (PAM160711-GAAS)
| Lag | Materiale | x | dopingmiddel | Concentration | Tykkelse (A) | Bemærkninger |
| 12 | n+-GaAs | – | Si | 5,0E+18 cm-3 | 500 | – |
| 11 | n-AlAs | – | Si | – | – | – |
| 10 | n-Alxga1-xSom | 0.22 | Si | – | – | – |
| 9 | Si | – | Si | 5,0E+12 cm-2 | – | – |
| 8 | Alxga1-xSom | 0.22 | – | – | 30 | – |
| 7 | Ixga1-xSom | – | – | – | – | – |
| 6 | GaAs | – | – | – | – | – |
| 5 | AlAs | – | – | – | – | – |
| 4 | GaAs | – | – | – | – | – |
| 3 | AlAs | – | – | – | – | – |
| 2 | Alxga1-xAs/GaAs | 0.22 | – | – | 185/15 | 10 X SL'er |
| 1 | GaAs | – | – | – | 5000 | – |
| SI GaAs substrat | ||||||
No.2 Power pHEMT Epitxial Structure (PAM160711-GAAS)
| Lag | Materiale | x | dopingmiddel | Concentration | Tykkelse (A) | Bemærkninger |
| 13 | n+-GaAs | – | Si | – | 500 | – |
| 12 | n-AlAs | – | – | – | – | – |
| 11 | GaAs | – | – | – | – | |
| 10 | n-Alxga1-xSom | 0.24 | Si | – | – | – |
| 9 | Si | – | Si | 3,0E+12 cm-2 | – | – |
| 8 | Alxga1-xSom | – | – | – | 25 | – |
| 7 | Ixga1-xSom | – | – | – | – | – |
| 6 | Alxga1-xSom | – | – | – | 30 | – |
| 5 | Si | – | Si | 1,0E+12 cm-2 | – | – |
| 4 | Alxga1-xSom | – | – | – | – | – |
| 3 | GaAs | – | – | – | – | – |
| 2 | Alxga1-xSom | 0.24 | – | – | – | – |
| 1 | GaAs | – | – | – | – | – |
| SI GaAs substrat | ||||||
No.3 GaAs Epi Wafers for pHEMTs (PAM161121-PHEMT)
| Layer material with doping | Tykkelse (A) | Doping level | Composition | Note |
| n+-GaAs | 400 | – | – | – |
| AlAs | – | – | – | – |
| GaAs | – | – | – | – |
| n-AIGaAs | – | 3E+17cm-3 | – | – |
| GaAs | 9 | – | – | – |
| Si | – | – | – | – |
| GaAs | – | – | – | – |
| i-AIGaAs | – | – | – | Spacer |
| i-GaAs | – | – | – | – |
| i-InGaAs | – | – | – | – |
| i-GaAs | – | – | – | – |
| i-AIGaAs | – | – | 0.24 | – |
| GaAs | – | – | – | |
| Si | – | 1.5E+12cm-2 | – | – |
| GaAs | 9 | – | – | – |
| i-AIGaAs | – | – | – | – |
| AIGaAs 100A/GaAs 20A superlattice 15 periods | – | – | – | – |
| i-GaAs | – | less than 5E+14cm-3 | – | – |
| S.I. GaAs substrate |
We also can provide InP-based pHEMT epitaxial wafer:
PAM160526-INP
| Lag | Materiale | Concentration | Tykkelse |
| 8 | N+ Inxga1-xSom | – | 20nm |
| 7 | N+ InP etch stopper | – | – |
| 6 | i-InxAl1-xAs Schottky barrier | – | – |
| 5 | Si-delta-doping | n=6×1012 cm-2 | – |
| 4 | i-InxAl1-xAs spacer | – | – |
| 3 | i-Inxga1-xAs channel | – | – |
| 2 | IxAl1-x As buffer | – | 300nm |
| 1 | metamorphic buffer (linearly graded from substrate to
Ixga1-x As) |
– | – |
| InP substrate |
I de senere år, med populariseringen og anvendelsen af mobilkommunikation og trådløse internetsystemer, er en stærk efterspørgsel efter halvlederenhedsprodukter blevet stimuleret. Halvlederepitaksiale materialer er et vigtigt grundlag for enheder, der bruges i trådløs kommunikation. For at imødekomme markedets krav til produktkvalitet og omkostninger er det meget vigtigt at udvikle en høj kapacitet og stabil proces. GaAs pHEMT har fremragende ydeevne i lederen af trådløse applikationer og har bevæget sig mod masseproduktion. Derfor spiller udviklingen af en effektiv epitaksial proces en vigtig rolle i at reducere omkostninger og markedets responstid. Molecular beam epitaxy (MBE) er den vigtigste tekniske metode til dyrkning af GaAs pHEMT epitaksiale materialer. Sammenlignet med andre vækstmetoder, såsom metal organisk kemisk dampaflejring (MOCVD), har MBE højere kontrolnøjagtighed og stabilitet.
2. Om GaAs pHEMT epitaksialt materiale
2-DEG i pHEMT er mere begrænset end den almindelige HEMT: der er en dobbelt restriktion på begge sider af potentialbrønden, så den har en højere elektronoverfladetæthed (ca. 2 gange højere). Samtidig er elektronmobiliteten også højere end i GaAs. Derfor er ydeevnen af pHEMT mere overlegen. Dobbelt heterojunction GaAs pHEMT epitaksial struktur forbedrer ikke kun temperaturstabiliteten af enhedens tærskelspænding, men forbedrer også enhedens output volt-ampere karakteristika, så enheden har en større udgangsmodstand, en højere transkonduktans og en større strømhåndteringskapacitet og højere driftsfrekvens, lavere støj og så videre.
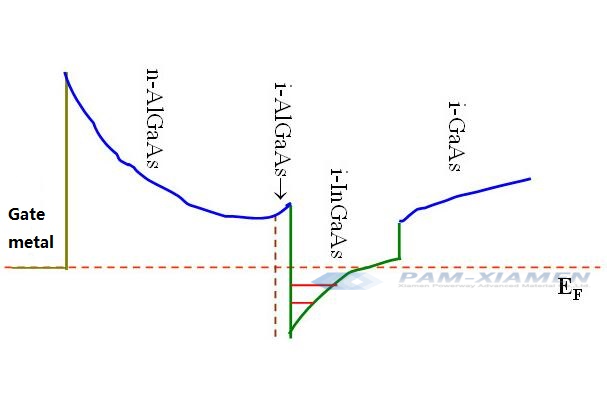
Energibånddiagram af pHEMT Heterojunction
Kanalmobiliteten af GaAs pHEMT epitaksiale materialer er en af de vigtigste indikatorer. Forøgelse af kanalmobiliteten kan effektivt forbedre DC- og RF-ydelsen af galliumarsenid pHEMT-produkter (såsom GaAs pHEMT-transistor, GaAs pHEMT-forstærker og MMIC), hvilket har stor effekt på applikationsparametre såsom transkonduktans, on-state modstand, cut-off frekvens, støjtal, RF-forstærkning og effektkonverteringseffektivitet.
3. Om GaAs pHEMT
pHEMT er en forbedret struktur af transistorer med høj elektronmobilitet (HEMT), også kendt som pseudo-matchede transistorer med høj elektronmobilitet (pHEMT), som er en radiofrekvens GaAs-effekttransistor lavet ved hjælp af et specielt epitaksialt lag dyrket på GaAs, der kan opnå lav spænding og høj effektivitet, når det bruges i mobiltelefoner og radiofrekvensmodemmer.
GaAs pHEMT-applikation er i mikrobølge- og millimeterbølgefrekvensbånd på grund af de fremragende egenskaber med høj elektronmobilitet, høj strømmodulationseffektivitet og lavt tab. Da enhedens driftsfrekvens går ind i millimeterbølgefrekvensbåndet, bliver indflydelsen af parasitiske effekter på enhedens ydeevne meget tydelig. Model er grundlaget for kredsløbsdesign, og metoden til nøjagtigt at udtrække modelparametre for transistor højfrekvente parasiteffekter har altid været et forskningshotspot i industrien.
Med den kontinuerlige udvikling af 5G trådløs kommunikationskomponenter og -infrastruktur vil GaAs pHEMT-teknologi spille en nøglerolle for at opfylde de mange karakteristika ved nye trådløse netværk. I udviklingen af 5G-nøglekomponenter fortsætter vi med at forbedre vores GaAs pHEMT-procesflow for at levere et komplet udvalg af relaterede produkter inden for lineære digitale radioer, V-bånd, E-bånd og W-bånd radarapplikationer.

For mere information, kontakt os venligst e-mail på victorchan@powerwaywafer.com og powerwaymaterial@gmail.com.
