GaAsSb / InGaAs / InP-heterostruktur leveres af epi-struktur MBE-producenten PAM-XIAMEN til fremstilling af optiske sensorer. Gallium arsenid antimonid (GaAsSb) gitterkonstanten er fuldstændig matchet med gitterkonstanten for InP substrat, så det er let for epitaksial vækst på InP-substrat med god ensartethed. Responsbølgelængden af type-II InGaAs / GaAsSb supergitterdetektoren kan justeres ved at ændre lagtykkelsen og strukturen af hvert materiale i supergitteret. GaAsSb / InGaAs supergitter er det foretrukne materialesystem til en ny type kortbølgede infrarøde detektorer. Her er angivet specifikationerne fra PAM-XIAMEN:
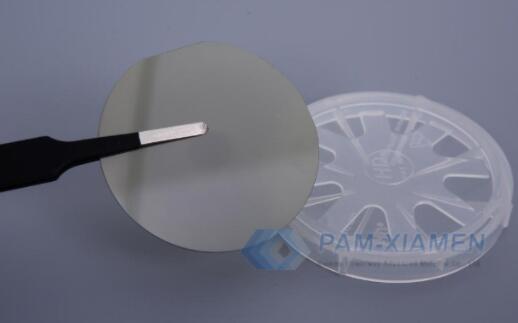
1. Specifikation af GaAsSb / InGaAs Supergitter på InP Substrat
PAM161124 – SLS
| Lag | Sammensætning | Tykkelse | perioder | Carrier Koncentration | dopingmiddel |
| Hættelag | InGaAs eller InAlAs | – | 1 | – | Bliv dopet |
| P lag | SL-GaAsSb/InGaAs | – | – | – | Bliv dopet |
| i-Active | SL-GaAsSb/InGaAs | – | – | – | – |
| n lag | SL-GaAsSb/InGaAs | – | 50 | – | Si-dopet |
| Buffer | InGaAs | 50 nm | – | – | Si-dopet |
| Bottom | InGaAs eller InAlAs | – | – | n=1E18 | Si-dopet |
| substrat | InP(100) | 350um | – | – | Si-dopet |
2. Fremstilling af GaAsSb/InP epitaksial wafer
De utilsigtede InGaAs er n-type, baggrundskoncentrationen af i-InGaAs for MBE-teknologi er meget lavere end MOCVD. Vores teknologi kan nå op på 7-9E14cm3. Hvis du har brug for lavere bærerkoncentration, kompenserer vi i-InGaAs ved at dope Be.
Den utilsigtede GaAsSb er p-type, baggrundskoncentrationen af i-InGaAs for MBE-teknologi er næsten 1-5E15cm3, hvilket er meget lavere end MOCVD. Og det er nemt at opnå lavere baggrundskoncentration ved at dope Si.
i-InGaAs-laget kan være en lille p-type, hvilken koncentration er 1-5E15cm3 ved at dope Be. Normalt, for InP-baserede mikrobølgeovne, dyrker vi kun 200 nm InAlAs til bufferlag, og det er nok til at eliminere dislokation, defekt, pletter og overfladeruhed osv. Så vi mener, at 500 nm InGaAs er nok til bufferlag, og vi vil levere EPD< 500 InP substrat til dig. Din EPI-wafertykkelse er mere end 4,5 um, især ternær legering. Den har brug for fremragende færdigheder for at dyrke den.
Hvad angår ohmsk kontakt til ovenstående spec, er den ohmske kontakt af p-type InGaAs bedre end p-type InAlAs. Og Ti/Pt/Au-metal er det bedste til metallisering. Derudover er den ohmske kontakt af n-type InGaAs bedre end n-type InAlAs. AuGeNi/Au metal er det bedste til metallisering, ligesom n-GaAs ohmsk kontakt. For god ohmsk kontakt til p-type InGaAs skal mesa-ætsningen stoppe mere eller mindre i midten af laget. Så tykkere InGaAs-laget som nemt det kunne gøres.
3. Effekter af Be Doping på egenskaberne af InGaAs / GaAsSb epilag
Der er en direkte sammenhæng mellem bærerkoncentrationen i absorptionsområdet for fotovoltaiske detektorer og detektorens ydeevne. Bærerkoncentrationen i absorptionsområdet bestemmer levetiden og diffusionslængden af minoritetsbærere og påvirker således kvanteeffektiviteten og detektorens detektionshastighed. I InGaAs / GaAsSb II type supergitterdetektoren bruges supergitteret som absorptionsområdet, og baggrundsbærerne i det indre supergitter er n-type ledende, hvilket betyder, at detektorens minoritetsbærere er huller, og diffusionen af huller. . Længden er mindre end diffusionslængden af elektroner. Hvis minoritetsbærerne i absorptionsområdet er elektroner, kan diffusionslængden af minoritetsbærerne øges. Derfor brugte vi p-type Be til at kompensere supergittermaterialet og studerede forholdet mellem forskellige Be-dopingtemperaturer og egenskaberne af InGaAs / GaAsSb kvantebrønd. Vi fandt ud af, at dopingkoncentrationen af supergitteret er følsom over for Be-temperaturen.
For mere information, kontakt os venligst e-mail på victorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

