Med den stigende udvikling af halvlederenheder viser silicium og siliciumbaserede materialer stadig deres overlegne egenskaber, og det vil stadig være et vigtigt materiale til halvlederenheder og integrerede kredsløb. Med den faldende størrelse af enheder er resistiviteten, urenhedsfordelingen, filmtykkelsen og kvalitetskontrollen af silicium og siliciumbaserede materialer ekstremt vigtige. Brug af spredningsmodstandsprofilering (SRP) til at teste og analysere silicium- og siliciumbaserede materialer er mere intuitivt og effektivt end andre testmetoder.PAM-XIAMEN kan tilbydesiliciumskivermed spredning af modstandsprofileringstjenester om nødvendigt.
SRP er også kendt som spredningsmodstandsanalyse (SRA), det vil sige diffusionsmodstandsfordeling er en metode til at teste elektriske parametre som diffusionsmodstand, resistivitet, bærerkoncentrationsfordeling osv. af halvledermaterialer med højere opløsning, som hører til en eksperimentel sammenligningsmetode.
1. Grundlæggende principper for SRP – profilering af spredningsmodstand (baseret på siliciumwafer)
Trinnene i spredningsmodstandsprofilen er at måle spredningsmodstanden af en række punktkontakter (Rs er forholdet mellem potentialefaldet mellem den ledende metalsonde og et referencepunkt på siliciumwaferen og strømmen, der strømmer gennem sonden), og brug derefter kalibreringskurven til at bestemme. Resistiviteten af den testede prøve nær kontaktpunktet for spredningsmodstandssonden konverteres til bærerkoncentrationen svarende til rækken af testpunkter.
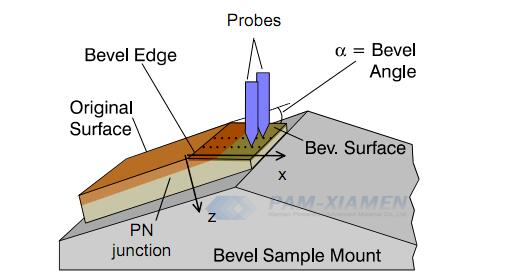
Skematisk profilering af spredningsmodstandsprobeteknik
For at forbedre den rumlige opløsning og på samme tid i overensstemmelse med de forskellige målmålingsdybder, kan retningen af prøvens tværsnit slibes i en række vinkler, og ændringen af resistivitet inden for 5 nm fra opløsningsdybden retning kan måles efter slibning af siliciumwaferen.
Tag den epitaksiale siliciumwafer for eksempel:
| Vare | Parameter | Spec | Enhed | |
| 1 | vækst Metode | CZ | ||
| 2 | Diameter | 100+/-0,5 | mm | |
| 3 | Type-dopant | P- Bor | ||
| 4 | Resistivitet | 0,002 – 0,003 | ohm-cm | |
| 5 | Resistivitet Radial variation | <10 | % | |
| 6 | Crystal Orientering | <111> 4 +/- 0,5 | grad | |
| 7 | Primær lejlighed | Orientering | Semi | grad |
| Længde | Semi | mm | ||
| 8 | Sekundær Flat | Orientering | Semi | grad |
| Længde | semi | mm | ||
| 9 | Tykkelse | 525 +/- 25 | um | |
| 10 | TTV | ≦10 | um | |
| 11 | Sløjfe | ≦40 | um | |
| 12 | Warp | ≦40 | um | |
| 13 | Forside | poleret | ||
| 14 | Bagsiden | ætset | ||
| 15 | Overflade udseende | ingen ridser, dis, kantafslag, appelsinskal, defekter, forurening | ||
| 16 | Kantprofil | Kantafrunding | ||
| 17 | Partikel (>0,3 μm) | N / A | ea/wf | |
| 18 | ||||
| 19 | Epi-lag 1 | N Phos | ||
| 20 | Resistivity | 3,8 – 5,2 | ohm cm | |
| 21 | Tykkelse | 29,0 – 35,0 | um | |
| 22 | Epi Layer 2 | N Phos | ||
| 23 | Resistivity | 0,0014 – 0,0026 | ohm cm | |
| 24 | Tykkelse | 36,0 – 44,0 | ||
Note:The epi wafer can be processed and fabricated into Circuit Protection TVS Diodes, they are very similar to that of a schottky diode. When the first epi layer is too thin to get the proper performance and break down Voltage and the TVS circuit won’t regulate. Transient voltage suppressor diodes are very popular devices used to instantaneously clamp transient voltages (e.g., ESD events) to safe levels before they can damage a circuit. The are designed to react much faster then your typical zener or schottky diode.
Vi tester ovenstående specifikation ved SRP-test og opnår modstanden og tykkelsen af epilagene. Se venligst vedhæftede diagram nedenfor:
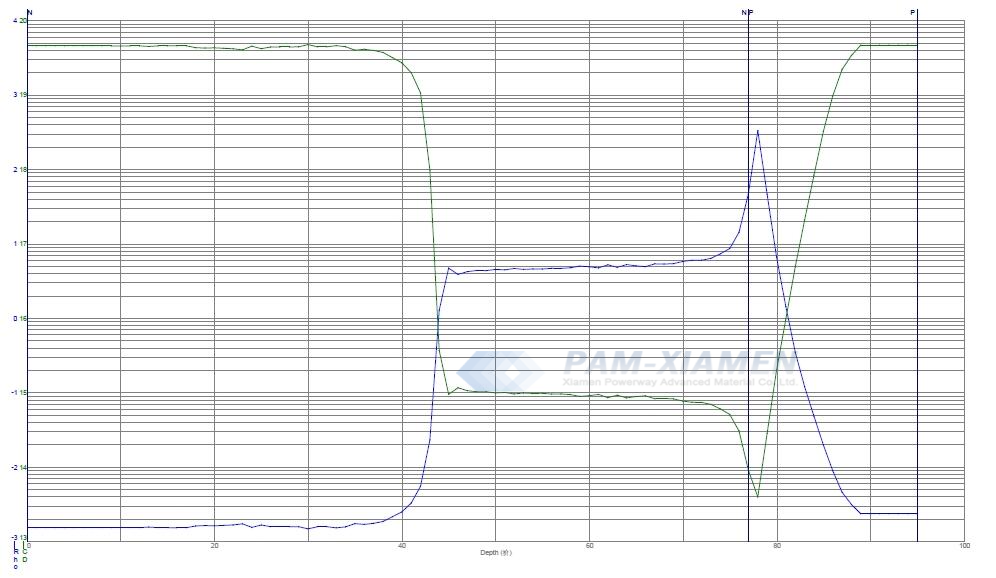
2. Fordele og ulemper ved måling af spredningsmodstandsprofil
Teknikere:
- Fremragende rumlig opløsning;
- Kortfattet og intuitiv test;
- Bredt resistivitetstestområde;
- Kan bruges som flerlagsprofil
Ulemper:
- Destruktiv test
3. Anvendelser af spredningsmodstandsprofilering og -analyse
SRP er mere og mere udbredt i epitaksial wafer og IC mønster wafer test på grund af dens overlegne rumlige opløsning. SRP-teknologi kan måle ikke kun den langsgående modstandsændring af epitaksial wafer, men også epitaksial lagtykkelse, overgangsområde og mellemlagsbredde.
Resistiviteten (eller koncentrationen) og dybdefordelingen af epitaksiale lag såsom Si, InP, GaAs, SiC osv. testes med spredemodstandsprofileringsmetoden. Ved at kende tykkelsen af det epitaksiale lag, bredden af overgangsområdet og substratets resistivitet og den epitaksiale wafers resistivitet i en vis dybde, er det muligt at diagnosticere kvaliteten af den epitaksiale wafer.
Bemærk venligst, at SRP kun måler den aktiverede partielle dopingkoncentration.

For mere information, kontakt os venligst e-mail påvictorchan@powerwaywafer.com og powerwaymaterial@gmail.com.
