Nanofabrication Photoresist
PAM-XIAMEN Tilbud fotoresist plade med fotoresist
- Beskrivelse
Beskrivelse
nanofabrikation
PAM-XIAMEN Tilbudfotoresistplade medfotoresist
En fotoresist er et lysfølsomt materiale, der bruges i flere processer, f.eksfotolitografiog fotoengraving for at danne en mønsterbelægning på en overflade, hvilket er afgørende i hele den elektroniske industri.
En positiv resist er en type fotoresist, hvor den del af fotoresisten, der udsættes for lys, bliver opløselig for fotoresistudvikleren. Den ueksponerede del af fotoresisten forbliver uopløselig for fotoresistudvikleren.
En negativ fotoresist er en type fotoresist, hvor den del af fotoresisten, der udsættes for lys, bliver uopløselig for fotoresistudvikleren. Den ikke eksponerede del af fotoresisten opløses af fotoresistudvikleren.
Baseret på fotoresists kemiske struktur kan de klassificeres i tre typer: Photopolymeric, photodecomposing, photocrosslinking, photoresist.
Photoresist Applications:
Mikrokontaktudskrivning
Fremstilling af printkort (PCB)
Mønster og ætsning af underlag
Microelectronics
photoresist Microposit
Futurrex
andre fotoresister,
Kontakt os for detaljerede oplysninger
Underlagsiliciumsubstrat 2 ″ 3 ″ 4 ″ 5 ″ 6 ″ 8 ″
kvartssubstrat SSP / DSP
glassubstrat N / P
SiO2-substrat 100/110/111
andet substrat,
kontakt os for detaljerede oplysninger
Forskelle mellem positiv og negativ modstand
| Karakteristisk | Positiv | Negativ |
| Klæbning til silicium | Fair | Fremragende |
| Relative omkostninger | Dyrere | Billigere |
| Udviklerbase | vandig | Økologisk |
| Opløselighed i udvikleren | Det udsatte område er opløseligt | Det udsatte område er uopløseligt |
| Mindste funktion | 0,5 um | 2 um |
| Trin dækning | Bedre | Nederste |
| Våd kemisk modstand | Fair | Fremragende |
En enkelt iteration affotolitografi combines several steps in sequence. Modern cleanrooms use automated, robotic wafer track systems to coordinate the process. The procedure described here omits some advanced treatments, such as thinning agents or edge-bead removal.Basic procedure
Rengøring
Hvis der er organiske eller uorganiske forureninger på skiveoverfladen, fjernes de sædvanligvis ved våd kemisk behandling, f.eks. RCA-renseproceduren baseret på opløsninger, der indeholder brintperoxid. Andre opløsninger fremstillet med trichlorethylen, acetone eller methanol kan også bruges til rengøring.
Forberedelse
Waferen opvarmes oprindeligt til en temperatur, der er tilstrækkelig til at afdrive al fugtighed, der kan være til stede på waferoverfladen, 150 ° C i ti minutter er tilstrækkelig. Skiver, der har opbevaret, skal rengøres kemisk for at fjerne forurening. En flydende eller gasformig "adhæsionspromotor", såsom Bis (trimethylsilyl) amin ("hexamethyldisilazane", HMDS), anvendes til at fremme vedhæftning af fotoresist til waferen. Overfladelaget af siliciumdioxid på skiven reagerer med HMDS for at danne tri-methyleret siliciumdioxid, et stærkt vandafvisende lag, ikke i modsætning til det vokslag på en bils maling. Dette vandafvisende lag forhindrer den vandige udvikler i at trænge ind mellem fotoresistlaget og skivens overflade og forhindrer således såkaldt løft af små fotoresiststrukturer i (udviklende) mønster. For at sikre, at billedet udvikles, dækkes det bedst og placeres over en varm plade og lader det tørre, mens temperaturen stabiliseres ved 120 ° C.
Ansøgning om fotoresist
Waferen er dækket med fotoresist ved centrifugering. En viskøs, flydende opløsning af fotoresist fordeles på skiven, og skiven centrifugeres hurtigt for at frembringe et ensartet tykt lag. Spinbelægningen kører typisk ved 1200 til 4800 o / min i 30 til 60 sekunder og producerer et lag mellem 0,5 og 2,5 mikrometer tykt. Spinbelægningsprocessen resulterer i et ensartet tyndt lag, sædvanligvis med ensartethed inden for 5 til 10 nanometer. Denne ensartethed kan forklares ved detaljeret væskemekanisk modellering, der viser, at modstanden bevæger sig meget hurtigere i toppen af laget end i bunden, hvor viskose kræfter binder resisten til waferoverfladen. Således skubbes det øverste lag af resist hurtigt ud fra skivekanten, mens bundlaget stadig kryber langsomt radialt langs skiven. På denne måde fjernes enhver "bump" eller "ryg" af resist, hvilket efterlader et meget fladt lag. Den endelige tykkelse bestemmes også af fordampningen af flydende opløsningsmidler fra resisten. Til meget små, tætte egenskaber (<125 eller derover nm) er det nødvendigt med lavere modstandstykkelser (<0,5 mikrometer) for at overvinde sammenbrudseffekter ved høje aspektforhold; typiske aspektforhold er <4: 1.
Den fotomodstandsbelagte wafer forbehandles derefter for at fjerne overskydende fotoresistopløsningsmiddel, typisk ved 90 til 100 ° C i 30 til 60 sekunder på en varmeplade.
Eksponering og udvikling
Efter forbagning udsættes fotoresisten for et mønster af intenst lys. Eksponeringen for lys forårsager en kemisk ændring, der gør det muligt at fjerne noget af fotoresisten ved hjælp af en speciel løsning, kaldet “fremkalder” analogt med fotografisk fremkalder. Positiv fotoresist, den mest almindelige type, bliver opløselig i udvikleren, når den udsættes; med negativ fotoresist er ueksponerede regioner opløselige i udvikleren.
En bage efter eksponering (PEB) udføres inden udvikling, typisk for at hjælpe med at reducere stående bølgefænomener forårsaget af det ødelæggende og konstruktive interferensmønster for det indfaldende lys. I dyb ultraviolet litografi anvendes kemisk amplificeret resist (CAR) kemi. Denne proces er meget mere følsom over for PEB-tid, temperatur og forsinkelse, da det meste af "eksponerings" -reaktionen (skabelse af syre, hvilket gør polymeren opløselig i den grundlæggende fremkalder) faktisk forekommer i PEB.
Udviklingskemi leveres på en spinner, ligesom fotoresist. Udviklere indeholdt oprindeligt ofte natriumhydroxid (NaOH). Natrium betragtes imidlertid som en yderst uønsket forurening i MOSFET-fabrikation, fordi det nedbryder de isolerende egenskaber ved gateoxider (specifikt kan natriumioner migrere ind og ud af porten, ændre transistorens tærskelspænding og gøre det sværere eller lettere at dreje transistoren tændes over tid). Metalionfrie udviklere, såsom tetramethylammoniumhydroxid (TMAH), anvendes nu.
Den resulterende skive "hårdt bages" derefter, hvis der blev anvendt en ikke-kemisk forstærket resist, typisk ved 120 til 180 ° C [citat behov] i 20 til 30 minutter. Den hårde bage størkner den resterende fotoresist for at skabe et mere holdbart beskyttende lag ved fremtidig ionimplantation, våd kemisk ætsning eller plasmaetsning.
ætsning
Ved ætsning fjerner et flydende ("vådt") eller plasma ("tørt") kemisk middel det øverste lag af substratet i de områder, der ikke er beskyttet af fotoresist. Ved halvlederfabrikation anvendes tør ætsningsteknikker generelt, da de kan gøres anisotrope for at undgå signifikant underskæring af fotoresistmønsteret. Dette er vigtigt, når bredden af de funktioner, der skal defineres, svarer til eller mindre end tykkelsen på det materiale, der ætses (dvs. når billedforholdet nærmer sig enhed). Våde ætseprocesser er generelt isotropiske, hvilket ofte er uundværligt for mikroelektromekaniske systemer, hvor ophængede strukturer skal "frigøres" fra det underliggende lag.
Udviklingen af anisotropisk tør-etsningsproces med lav defektivitet har gjort det muligt at overføre de stadig mindre funktioner, der er defineret fotolitografisk i resisten, til underlagsmaterialet.
Fjernelse af fotoresist
Når en fotoresist ikke længere er nødvendig, skal den fjernes fra underlaget. Dette kræver normalt en flydende "resist stripper", som kemisk ændrer resisten, så den ikke længere klæber til substratet. Alternativt kan fotoresist fjernes med et plasma, der indeholder ilt, som oxiderer det. Denne proces kaldes ashing og ligner tør ætsning. Anvendelse af 1-methyl-2-pyrrolidon (NMP) opløsningsmiddel til fotoresist er en anden metode, der anvendes til at fjerne et billede. Når resisten er opløst, kan opløsningsmidlet fjernes ved opvarmning til 80 ° C uden at efterlade nogen rest.
Microposit S1800 G2-serie fotoresist
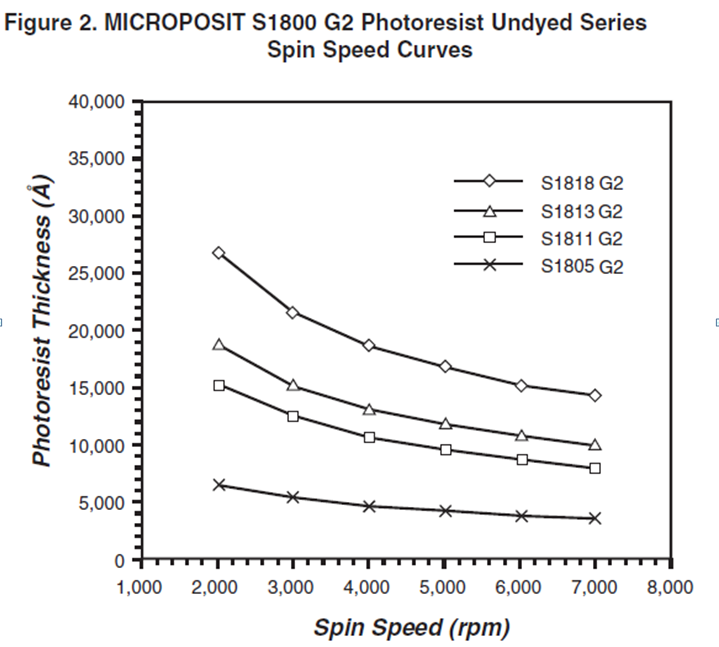
Microposit S1800 G2-serie fotoresist
NEGATIV MODSTAND NR9-6000PY

NEGATIV MODSTAND NR9-6000P