Fotomaskenrohling mit Antireflex-Chrom ist erhältlich. Fotomasken werden hauptsächlich in integrierten Schaltungen, Flachbildschirmen (einschließlich LCD, LED, OLED), Leiterplatten und anderen Bereichen verwendet. Die Fotomaske ist a Mustermeister im Fotolithografieprozess in der Mikroelektronik-Fertigung verwendet. Hier sind die Spezifikationen des Fotomaskenrohlings als Referenz:
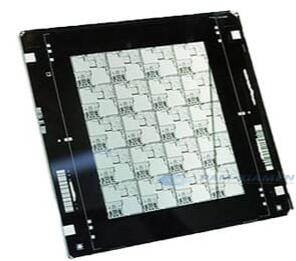
Nr. 1 Fotomasken PAM190302-MASKH
Nr. 1-1 Siliziumwafer mit IC-Strukturen (ASIC11) bei 0,35 Mikrometer Designstandards;
Nr. 1-2 Siliziumwafer mit IC-Strukturen (ASIC12) bei 0,35 Mikrometer Designstandards;
Hinweis:
Der Durchmesser des Substrats >= 150mm. die Art / Dotierungsbeimischung, Ausrichtung, Dicke, spezifischer Widerstand, Vorderfläche, Rückfläche, Abflachung (s) wird vom Hersteller bestimmt, um die im Design Kit angegebenen erforderlichen Elementbasisparameter (Transistoren, Widerstände, Kondensatoren) bereitzustellen. Der Hersteller stellt ein Design Kit bereit, das für die Entwicklung von IC-Topologien geeignet ist. Der Kunde führt die Entwicklung gemäß Design Kit durch und übermittelt die Informationen im GDS-Format an den Hersteller. Der Hersteller stellt einen Satz Fotomasken gemäß den Angaben im GDS-Format her. Der Hersteller stellt die Platten unter Verwendung eines Satzes von Fotomasken und gemäß der Design-Kit-Anforderung her.
Nr. 1-3 Fotomaske leer
Größe 152 x 152 x mm, Maßstab 5:1, ausgelegt für Photolithographie mit Designstandards von 0,35 µm;
Grundlegende Vorlagenanforderungen
Zweck: binäre Vorlagen für die Projektion f / l
Substratgröße: 6 "x6" x0,25", Quarz
Gerätetyp: 5x, NIKON NSR 2205i11D
Belichtungsfeld: 110 mm x 110 mm
Pellicle: Ja, NIK49P-122-1K17 / HFLC, einseitiger Chromschutz (beidseitiger Schutz auf Anfrage)
Kritische Mindestgröße: 1,75 Mikrometer
Reproduzierbarkeit kritischer Abmessungen: 0,05 µm (3σ)
Registrierungsgenauigkeit (Registrierung): 0,1 µm
Defekt: 0,1 / cm²2 (1 Mikrometer)
Nr. 2 Chrom-Fotomaske auf Quarz PAM200313-MASKH
Nr. 2-1 Am wenigsten komplex: Strip & Ship;
CD >= 5um;
Weite offene Bereiche; Schreibraster: Standard
Material: Quarz, entspiegeltes Chrom. Kein Häutchen.
Nr. 2-2 Moderate:
5x Absehen; 6"x6"x0,12" Quarz;
Keine Defekte größer als 2,5um;
Kleiner als 1,25um Defekt
CD >= 5um; Linien/Zwischenräume/Achtecke;
Write Grid: Sollte CD beibehalten
Material: Quarz, entspiegeltes Chrom. Kein Häutchen.
Nr. 2-3Die komplexeste:
5x Absehen; 6"x6"x0,12" Quarz;
Keine Defekte größer als 1,25um;
Kleiner als 0,625 um Defekt
CD >= 2,5um; Linien/Leerzeichen/ Achtecke;
Write Grid: Sollte CD beibehalten
Material: Quarz, entspiegeltes Chrom. Kein Häutchen.
Bei diesen Photomaskenrohlingen ist kein Häutchen erforderlich und die Absehenmaskengröße beträgt 6 x 6 Zoll und 0,12 Zoll dick. Die Mindestmerkmalsgrößen auf Masken sind 2,5 um und 5 um. Fotomaske (Retikel) dient zur Herstellung des Lithographieprozesses, der in Steppermaschinen verwendet wird.
Die technischen Parameter des Photomaskenrohlings erfüllen die Anforderungen in Tabelle 1 und Tabelle 2.
|
Tabelle 1 Parameter für die Qualitätsstufe der Fotomaske |
||||||||||||||||
| Klasse | D | C | B | A | S | T | U | V | W | W+P | X | X+P | Y | Y+P | Z | Z+P |
| Toleranz | ±0.3 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.1 | ±0.05 | ±0.04 | ±0.035 | ±0.035 | ±0.032 | ±0.032 | ±0.028 | ±0.028 | ±0.022 | ±0.022 |
| Zielstrebig | ±0.3 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.075 | ±0.05 | ±0.04 | ±0.03 | ±0.03 | ±0.028 | ±0.028 | ±0.025 | ±0.025 | ±0.02 | ±0.02 |
| Gleichmäßigkeit | 0.2 | 0.2 | 0.2 | 0.15 | 0.1 | 0.075 | 0.05 | 0.04 | 0.035 | 0.035 | 0.035 | 0.035 | 0.03 | 0.03 | 0.025 | 0.025 |
| Anmeldung | ±0.4 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.075 | ±0.05 | ±0.06 | ±0.055 | ±0.055 | ±0.05 | ±0.05 | ±0.045 | ±0.045 | ±0.04 | ±0.04 |
| Fehlergröße | 1.5 | 1.5 | 1 | 0.8 | 0.6 | 0.4 | 0.4 | 0.35 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Defektdichte | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 |
| Kantenfehler | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Kantenrauheit | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Eckenrundung | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| PSM-Phase | / | / | / | / | / | / | / | / | / | 180±4 | / | 180±3 | / | 180±3 | / | 180±3 |
| PSM-Trans | / | / | / | / | / | / | / | / | / | 6±0,4 | / | 6±0,3 | / | 6±0,3 | / | 6±0,3 |
Hinweis:
Die Parameter gelten für Skalenabsehen; das Qualitätsniveau wird von niedrig bis hoch eingestuft:
- 0,5-um-Prozess unterstützt bis zum S-Level; 0,35-um-Prozess unterstützt bis zum U-Level, 0,18-um-Prozess unterstützt bis zum X-Level;
- Gewöhnliche Glasmasken gelten nur für Klasse D.
| Tabelle 2 Anforderungen an die Qualität der Fotomaske | ||||||||
| 1:1 Hauptmaske | 1:1 Elektronenstrahlscannen | UT-Maske | ||||||
| Klasse | PB | PA | EB | EA | ES | uc | UB | UA |
| CD-Spezifikation | >2.5 | 1,2 ~ 2,5 | >1.5 | 1,2~1,5 | <1.2 | >2 | 1,5~2,0 | <1.5 |
| Toleranz | ±0.25 | ±0.2 | ±0.2 | ±0.15 | ±0.1 | ±0.25 | ±0.2 | ±0.15 |
| Gleichmäßigkeit | 0.3 | 0.3 | 0.3 | 0.25 | 0.2 | 0.25 | 0.2 | 0.15 |
| Anmeldung | ±0.8 | ±0.8 | ±0.2 | ±0.15 | ±0.1 | ±0.2 | ±0.15 | ±0.1 |
| Fehlergröße | 2 | 2 | 1.5 | 1.5 | 1.0 | 2 | 1.5 | 1 |
| Defektdichte (pcs/in2) | 2 | 1 | 2 | 1 | 0.5 | 0 | 0 | 0 |
Hinweis:
Die Anforderung gilt für eine 1:1-Maske, und das Qualitätsniveau wird von niedrig bis hoch eingestuft;
Die UT-Maske ist nur auf Quarzmaterial anwendbar; Eine gewöhnliche Glasmaske gilt für die höchste Stufe B.
Nr.3 Photolithographie Blanko PAM200326-MASKH
Glassubstrat:
Größe: 50x50mm +/-0,2mm;
Dicke: 3,67 mm +/- 0,02 mm
Material: QUARZ
Keine spez. auf Ebenheit: 1/4 ~ 1/2 Wellenlänge
Frei von Chips an den Kanten
Ausgangssubstrat 7X7inch X 150mil
Standard-Absehenrohling Beschichtung 3.0 OD AR Chrom
Nr. 4 Fotomaske auf Quarz PAM200602-MASKH
Nr. 4-1 Fotomaske
Maskengröße 5" X5"
MATERIALIEN DES MASKENUNTERGRUNDS: Quarz
Lithographie: Elektronenstrahl
Maskenpolarität: BF
Merkmalstoleranz: 0,02 um
Funktionsgröße: 0.4um
Genauigkeit: 0,12 um
Herstellungsraster: 0,005 um, 0,02 um
Nr. 4-2 Fotomaske leer
Maskengröße 5" X5"
MASKENUNTERGRUNDMATERIALIEN Quarz
Lithographie: Laser
Maskenpolarität: DF
Merkmalstoleranz: 0.5um
Feature-Größe: 10 µm, 3 µm oder 5 µm
Genauigkeit: 0,12 um
Herstellungsraster: 0,02 um
Nr. 5 Quarz mit LR Chrom PAM200811-MASKH
Maskengröße = 5″x 5″x 0,09″
Material = Quarz mit LR Chrome
Ausrichtung: RR Unten.
Daten dunkel.
Kritische Dimension (CD): 4 µm +/- 0,5 µm (für alle Masken)
Defekte: 0 > 5 µm
Bitte beachten Sie:
Der Quarz mit LR Chrome ist für die Herstellung von Mask Aligner (NUV-Fotolithographie 350-450 nm Wellenlänge);
Die Datenskalierung für die Maske beträgt 1:01, da die Maskenausrichtung eine Skalierung von 1:1 anstelle von 5:1 hat;
Maskenmaterial ist Quarz mit LR Chrome, und die Chrome-Seite zeigt nach unten (Real Read (RR) nach unten);
Beim Layout-Design wird die Metallschicht Nummer 28 verwendet, und der Bereich der Metallschicht in den Design-Layouts sollte auf der Fotomaske Chrom sein.
Für weitere Informationen kontaktieren Sie uns bitte per E-Mail unter victorchan@powerwaywafer.com und powerwaymaterial@gmail.com.

