Durch kontinuierliche Bemühungen,PAM-XIAMEN hat großflächig COP-frei entwickeltCZ-Silizium(Si)-Wafer, und kontrollierte effektiv die COP-Erzeugung im Barren durch Verbesserung des thermischen Feldes des Kristallziehens, wodurch eine Leistungsverbesserung und eine Reduzierung des Energieverbrauchs erreicht wurden. Der 8-Zoll-Siliziumwafer-Anwendungsprozess ist größer und daher unempfindlich gegenüber COP; Der 12-Zoll-Siliziumwafer-Anwendungsprozess ist kleiner und empfindlicher für die Kristallqualität. Im Allgemeinen hat der Prozess unter 40 nm höhere Anforderungen an die Kristallqualität, daher besteht eine größere Nachfrage nach COP-frei. Die Spezifikationen des COP-freien Wafers zum Verkauf lauten wie folgt:

1. COP-freies Wafer-Datenblatt
| Types of COP Free Wafer | Polished | Annealed | Epitaxy |
| Durchmesser | 8” & 12” | 12” | 8” & 12” |
| Orientation | (100), (110) or (111) | ||
| Conduction Type | N & P | ||
2. Was ist der COP eines CZ-Si-Wafers?
COP (von Kristallen stammende Partikel/Pits) ist ein Hauptdefekt in Silizium-Einkristallen. Dieser Defekt ist ein Gitterdefekt, der nach 4-stündigem Kochpolieren von Siliziumwafern mit SC-1-Lösung (NH4OH:H2O2:H2O-1:15) bei 85 °C aufgedeckt wurde. Nach der Behandlung des Siliziumwafers mit SC-1-Lösung wurde die Oberflächenschicht des Siliziumwafers um 150 nm weggeätzt. Die Dichte von COP-Defekten kann durch einen Laserscanning-Partikelzähler erfasst werden.
COP-Defekte sind oktaedrische Mikrohohlräume, wie in Abbildung 1 gezeigt, die Größe von COP beträgt 0,12 bis 0,30 um. Die Ätzgrübchen von COP-Defekten können im Allgemeinen in zwei Kategorien eingeteilt werden: eine ist Monotype, die andere ist Bitype.
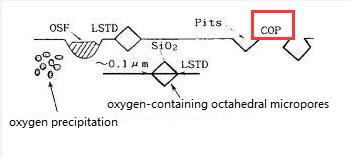
Abb. 1 Schematische Darstellung von COP-Defekten
3. Warum haben CZ-Wafer COP-Defekte?
Die Bildung des primären Defekts COP steht in engem Zusammenhang mit der Bildung von Sauerstoffniederschlägen. Die Gründe sind:
(1) Die großen Primärdefekte in CZ-Silizium wurden in sauerstofffreiem FZ-Silizium nicht gefunden;
(2) Anhand der Berechnung der freien Energie von Mikrohohlräumen ist bewiesen, dass sich Mikrohohlräume nicht gleichmäßig aus nackten Leerstellen bilden können;
(3) Während des Wachstums von CZ-Silizium wird über einen ziemlich weiten Temperaturbereich Sauerstoff übersättigt und fällt daher aus. Unter Verwendung des energiedispersiven Röntgenspektrums von TEM kann eine Elementaranalyse von COP-Defekten durchgeführt werden, und es wird festgestellt, dass einige COP-Defekte Sauerstoff enthalten. Dies weist darauf hin, dass der Mechanismus der Hohlraumbildung auch mit der Sauerstoffausfällung zusammenhängt.
Darüber hinaus ist die Wachstumsrate von COP-Defekten im Bereich von 900 bis 1100 °C am schnellsten, sodass die in diesem Temperaturbereich verbrachte Zeit die Größe des Wachstums von COP-Defekten bestimmt. Ein schnelles Durchlaufen dieses Temperaturbereichs kann das Wachstum von COP-Defekten wirksam verhindern. Da jedoch Einkristalle dazu neigen, innerhalb eines bestimmten Ziehgeschwindigkeitsbereichs zu wachsen, beträgt die Ziehgeschwindigkeit von stark dotiertem Sb im Allgemeinen 0,6–1,2 mm/min. Und der allgemeine Temperaturbereich des thermischen Felds von 900 bis 1100 ° C ist breiter, sodass die COP-Defektgröße während des gesamten Wachstumsprozesses des Einkristalls wachsen muss. Die Größe von COP-Defekten wird auch durch die Reinigungszeiten der nachfolgenden Waferbearbeitung beeinflusst. Nach 5- bis 6-maliger Reinigung in SC1 steigt die Anzahl und Größe der COP-Defekte exponentiell an.
4. Wie erhält man Wafer ohne Kristalle?
Es gab viele Forschungsliteratur zur Eliminierung oder Verringerung der COPs, um COP-freie Substrate zu erhalten, die wie folgt zusammengefasst werden können:
(1) Stickstoff-dotierten Silizium-Einkristall erzeugen;
(2) Wasserstoff- oder Argonglühen, um Oberflächen-COP-Defekte zu beseitigen;
(3) Passen Sie die Längstemperatur des thermischen Feldgradienten an, wodurch die COP-Defektdichte verringert und die COP-Defektgröße verringert wird.
Einige Studien haben darauf hingewiesen, dass, wenn die Konzentration des Dotierstoffs Bor einen kritischen Wert überschreitet, die Erzeugung von COP effektiv unterdrückt wird, wodurch COP-freie Kristallwafer erhalten werden. Die Größe dieses kritischen Werts hängt mit dem Durchmesser des Barrens zusammen. Beispielsweise beträgt der kritische Wert für einen 200-mm-Siliziumblock 4,8 × 1018 Atom/cm3; für einen 150-mm-Barren sind es 6,3 × 1018 Atom/cm3.
Studien haben auch gezeigt, dass das Hochtemperaturglühen in Wasserstoff- und Argonatmosphären lochartige Mikrodefekte (wie COPs) auf der Oberfläche von Siliziumwafern effektiv reduzieren kann, wodurch der GOI für MOS-Geräteanwendungen verbessert wird. Da die Oberfläche des Siliziumwafers (einschließlich der Oberfläche des COP) mit einer Schicht aus natürlichem Oxid bedeckt ist, ob unter Verwendung einer Wasserstoffatmosphäre oder einer Argonatmosphäre, unter hoher Temperatur, solange der Siliziumwafer auf eine hohe Temperatur erhitzt wird von etwa 1200°C wird die natürliche Oxidschicht auf der Oberfläche des Wafers thermisch instabil und dissoziiert, um zusätzliche Siliziumatome zu erzeugen. Diese zusätzlichen Siliziumatome füllen die Positionen der COPs, so dass diese lochartigen Mikrodefekte allmählich kleiner werden oder sogar verschwinden, wodurch ein Silizium-COP-freier Wafer oder ein Si-Wafer mit niedrigem COP erhalten wird.
Für weitere Informationen kontaktieren Sie uns bitte per E-Mail unter victorchan@powerwaywafer.com und powerwaymaterial@gmail.com.

