Hyung Koun Cho∗
Institut für Metallurgietechnik, Dong-A University, Busan 604-714
Jeong Yong Lee
Institut für Materialwissenschaften und -technik,
Korea Advanced Institute of Science and Technology, Daejon 305-701
Wir haben die Bildung von V-förmigen Vertiefungen in Nitridfilmen wie InGaN/GaN und AlGaN/GaN, die auf Saphirsubstraten aufgewachsen sind, mit Transmissionselektronenmikroskopie untersucht. Der Mechanismus der Grubenbildung hängt stark von den Indium- (In) und Aluminium-(Al)-Zusammensetzungen in In . abxGa1−xN und AlxGa1−xN Schichten bzw. Mit zunehmender Indiumzusammensetzung entstanden V-förmige Vertiefungen aus dem Scheitel von Einfädelversetzungen zu den Stapelfehlanpassungsgrenzen, die durch Stapelfehler und das dreidimensionale Inselwachstum im Anfangsstadium aufgrund der großen Gitterfehlanpassung induziert wurden. Mit zunehmender Aluminiumzusammensetzung variierte auch der Ursprung der Grübchen von der Oberflächenwelligkeit aufgrund der elastischen Fehlanpassungsdehnung bis zum Scheitelpunkt der Gewindeversetzungen.
PACS-Nummern: 61.72.Ff, 68.55.Ln, 68.55.-a
Schlüsselwörter: Grube, Nitrid, TEM, AlGaN, InGaN
I. EINLEITUNG
Auf Wurtzit GaN basierende (GaN, InGaN und AlGaN) Halbleiter werden derzeit aufgrund einiger Eigenschaften wie der großen direkten Bandlücke, der hohen thermischen Stabilität und der starken interatomaren Anleihen [1, 2]. Für inxGa1−xN und AlxGa1−xN-Schichten, die auf GaN aufgewachsen sind, kann eine Zunahme der Indium-(In)- und Aluminium-(Al)-Zusammensetzungen unvermeidlich zu Fehlanpassungsspannungen in Filmen führen. Ab einer kritischen Dicke werden durch plastische Relaxation mehrere strukturelle Defekte wie Fehlanpassungen, Stapelfehler, V-förmige Vertiefungen usw. erzeugt [3, 4]. Jedoch kann auch bei geringeren Dicken eine elastische Relaxation durch die Bildung von Inseln, Oberflächenwellen usw. induziert werden, wie bei InGaP/InAsP, In0.77Ga0.23As/InGaAs, SiGe/Si usw. beobachtet [5–7 ].Darüber hinaus kann eine Zunahme der In-Zusammensetzung zu einer chemischen Inhomogenität des In . führenxGa1−xN-Wannenschichten aufgrund der schlechten Mischbarkeit zwischen InN und GaN [8, 9].Die geringe Löslichkeit von In in GaN wurde mit dem Modell von Stringfellow [10] zu weniger als 6 % bei 800 ◦C berechnet.Diese Eigenschaften können die optischen und strukturellen Eigenschaften von Geräten erheblich beeinflussen [11, 12].
Vor kurzem haben wir zwei Modelle zur Bildung von V-förmigen Vertiefungen in InGaN/GaN-Mehrfachquantenquellen (MQWs) mit hoher In-Zusammensetzung veröffentlicht [13]. Auch die Unerwünschtheit und die Auswirkung auf die Emissionseigenschaften dieser Pits wurden zuvor durch Transmissionselektronenmikroskopie (TEM), Kathodenlumineszenz und Photolumineszenz nachgewiesen [3, 14, 15]. Zur Unterdrückung der Pit-Bildung ist daher ein klares Verständnis der Mechanismen der Pit-Bildung erforderlich, und die Mikrostruktur der Pits, die in verschiedenen auf Saphir-Substrat gewachsenen III-Nitrid-Filmen beobachtet werden, muss im Detail bewertet werden. In dieser Arbeit haben wir die Pit-Bildung aus unterschiedlichen Quellen in InGaN/GaN- und AlGaN/GaN-Heterostrukturen mit verschiedenen In- und Al-Zusammensetzungen mittels TEM untersucht.
II. EXPERIMENTAL
Alle Proben wurden auf Saphirsubstraten der c-Ebene mit einer nominell 25 nm dicken GaN-Keimbildungsschicht durch einen horizontalen metallorganischen chemischen Gasphasenabscheidungsreaktor, der bei niedrigem Druck betrieben wurde, gezüchtet. Trimethylgallium, Trimethylindium, Trimethylaluminium und Ammoniak wurden als Ausgangsvorläufer für Ga, In, Al bzw. N verwendet. Um den Einfluss der Spannung auf den Mechanismus der Pitbildung in III-Nitriden zu analysieren, wurden dicke InxGa1−xN-Schichten (∼ 800 ˚A) bei Temperaturen von 830 ◦C (xIn = 35 %) bis 880 ◦C (xIn = 10 %) und dicke AlxGa1−xN-Schichten (1000 A) wurden bei 1040 ◦C gewachsen, nachdem die Si-dotierte darunterliegende GaN-Schicht von ∼2 mm Dicke bei 1080 ◦C gewachsen war. Die In- und Al-Kompositionen im InxGa1−xN und AlxGa1−xN-Schichten betrugen 10, 13, 19 und 35 % bzw. 16, 25, 44 bzw. 54 %.
Um die Grübchenbildung von III-Nitriden zu charakterisieren, wurden TEM-Proben im Querschnitt entlang der [11-20]-Zonenachse durch mechanisches Tripod-Polieren, gefolgt von Ar-Ionenfräsen bei niedriger Temperatur bei 4,5 kV in einem Gatan DuoMill 660 DIF mit Sektorgeschwindigkeit . hergestellt Kontrolle. Die Ionenenergie wurde während der letzten Verdünnungsstufen allmählich reduziert, um die Oberflächenbeschädigung der Proben zu minimieren. Hellfeld (BF) Bilder und hochauflösende TEM (HRTEM) Bilder wurden auf einem JEOL JEM-2000EX TEM bei 200 kV und JEOL JEM-3010EX bei 300 kV aufgenommen.
III. RESULTATE UND DISKUSSION
Um den Einfluss der Al-Zusammensetzung auf die Pit-Bildung zu untersuchen, wurden Querschnitts-Hellfeld-TEM-Aufnahmen des AlxGa1−xN-Schichten, die mit verschiedenen Al-Zusammensetzungen auf der GaN-Pufferschicht gewachsen waren, wurden wie in Fig. 1 gezeigt erhaltenxGa1−xDie auf GaN-Schichten aufgewachsene N-Schicht beträgt weniger als 15 % [16]. Im Al . werden keine Pits festgestelltxGa1−xN-Schichten mit bis zu 25 % Al-Zusammensetzung. Nur Stapelfehler und Risse in den AlGaN-Schichten werden aufgrund der Fehlanpassungsspannung bzw. des Temperaturkoeffizientenunterschieds beobachtet (nicht gezeigt). Für die Al0.44Ga0.56N/GaN-Probe jedoch die Oberfläche des Al0.44Ga0.56Die N-Schicht zeigt viele Grübchen, die nicht mit strukturellen Defekten verbunden sind, wie z. 1(b) und (d)]. Die Größe dieser Pits ist mit einem durchschnittlichen Durchmesser von 7 nm und einer durchschnittlichen Höhe von 3 nm sehr klein im Vergleich zu Pits in auf GaN gewachsenen InGaN-Schichten [13, 14, 16]. Es wird angenommen, dass die Bildung von Gruben in Al0.44Ga0.56N/GaN kann der Oberflächenwelligkeit durch die erhöhte elastische Fehlanpassung zugeschrieben werden, wie sie in III-V- und II-VI-Halbleitersystemen beobachtet wird [5, 6].
Die Pitdichte beträgt mehr als 1010 cm−2 in der Oberfläche. Andererseits werden Fehlanpassungsversetzungen an der Grenzfläche des Al . erzeugt0.54Ga0.46N/GaN-Probe, um die gespeicherte Fehlanpassungsspannung plastisch zu entspannen, wie in Fig. 1(c) gezeigt. Außerdem werden V-förmige Vertiefungen beobachtet, die mit Durchdringungsversetzungen an den Böden verbunden sind, wie InGaN/GaN-Heterostrukturen. Diese V-förmigen Pits haben eine offene sechseckige, umgekehrte Pyramide mit Seitenwänden [14, 16].
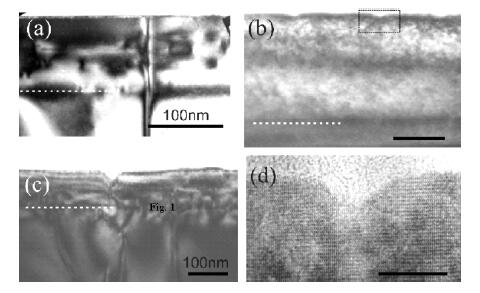
Abb. 1 Hellfeld-TEM-Querschnittsaufnahmen mit g = 0002 aus dem AlxGa1−xN-Schichten gewachsen mit der Al-Zusammensetzung von (a) 16 %, (b) 44 % und (c) 54 %. (d) HRTEM-Bild, das aus dem gestrichelten Rechteck in (b) erhalten wurde. Die gestrichelten Linien zeigen die AlxGa1−xN/GaN-Schnittstelle.
Infolgedessen klassifizierten wir den Ursprung der Grubenbildung im AlxGa1−xAuf der GaN-Pufferschicht gewachsenes N in zwei Modelle, wie in den Fig. 1 und 2 gezeigt. 4(a) und (d). Für die AlxGa1−xN-Schicht mit ∼40 % Al-Zusammensetzung, Pits werden durch die Oberflächenwelligkeit aufgrund der gespeicherten elastischen Fehlanpassungsdehnung erzeugt [Abb. 4(d)]. Für die AlxGa1−xN-Schicht mit mehr als ∼50 % Al-Zusammensetzung, jedoch werden Grübchen hauptsächlich am Scheitel von Einfädelversetzungen erzeugt [Abb. 4(a)].
Abbildung 2 zeigt die Querschnitts-Hellfeld-TEM-Aufnahmen des InxGa1−xN-Schichten, die mit verschiedenen In-Zusammensetzungen auf der GaN-Pufferschicht aufgewachsen sind. Die theoretische kritische In-Zusammensetzung bei der Bildung der Fehlanpassungsversetzung des ∼800˚A InxGa1−xAuf GaN-Schichten gewachsenes N beträgt weniger als 5 %, darunter zeigen die InGaN-Schichten ein kohärentes Wachstum [16]. Daher erwarten wir die In-Zusammensetzung aller InxGa1−xDie hier untersuchten N-Schichten haben einen höheren Wert als die kritische In-Zusammensetzung bei der Bildung der Fehlanpassungsversetzung. Für in0.1Ga0.9N/GaN, innerhalb der In0,1Ga0,9N-Schicht wurden keine strukturellen Defekte wie Fehlanpassungsversetzungen, Stapelfehler, Vertiefungen usw. beobachtet. Mit einer weiteren Erhöhung der In-Zusammensetzung des InxGa1−xN-Schicht (xIn = 13%), werden die V-förmigen Vertiefungen erzeugt, um die gespeicherte Fehlanpassungsspannung zu entspannen, wie zuvor berichtet [14]. Es wurde berichtet, dass ein V-förmiges Pit immer mit einer Threading-Versetzung aus der GaN-Pufferschicht unten verbunden ist und nur ein kleiner Bruchteil der Threading-Versetzungen die Bildung der V-förmigen Pits in den InGaN-Schichten verursacht und die InGaN/GaN-MQWs [14]. Die Dichte der V-förmigen Vertiefungen im In0.19Ga0.81Die N-Schicht in Fig. 2(c) hat einen größeren Wert als die Durchdringungsversetzungsdichte in der GaN-Pufferschicht, was darauf hindeutet, dass die Bildung von V-förmigen Vertiefungen im InGaN mit hoher In-Zusammensetzung einen anderen Ursprung hat, wie zuvor für berichtet die InGaN/GaN-MQW-Systeme [13]. Wir berichteten, dass in InGaN/GaN-MQWs mit hoher In-Zusammensetzung (∼ 30 % In-Zusammensetzung) die meisten V-förmigen Vertiefungen durch Stapelfehlanpassungsgrenzen erzeugt werden, die durch Stapelfehler induziert werden [13]. Obwohl die In0.19Ga0.81Das hier verwendete N/GaN hat eine In-Zusammensetzung von weniger als 20 %, der Teil der V-förmigen Pits stammt von Stapelfehlanpassungsgrenzen, die durch Stapelfehler aufgrund der erhöhten InGaN-Schichtdicke induziert werden [Abb. 3(a)] im Vergleich zum InGaN/GaN-MQW. Für in0.35Ga0.65N/GaN, V-förmige Vertiefungen mit einer Dichte von mehr als 1010 cm−2 werden an der Oberfläche beobachtet. Anders als die Gruben im In0.19Ga0.81N/GaN-Probe, die In0.35Ga0.65N-Gebiete mit flachen (0001) oberen Oberflächen zwischen Pits weisen eine große Anzahl von Stapelfehlern und Stapelfehlanpassungsgrenzen auf, die in der anfänglichen Wachstumsphase von InGaN gebildet werden [Abb. 3(b)], d. h. säulenförmige Strukturen einschließlich Stapelfehlern. Um die große Gitterfehlanpassung zwischen In0.35Ga0.65N und GaN, das anfängliche In0.35Ga0.65Die N-Schicht wurde mit der Morphologie von dreidimensionalen (3D) facettierten Inseln gezüchtet [17]. Eine hohe Dichte von Stapelfehlern ist in den Inseln deutlich zu erkennen und die Grenzen zwischen den Unterkörnern durch Inseln sind sichtbar wie das Wachstum einer auf Saphirsubstrat gewachsenen GaN-Nukleationsschicht [18].
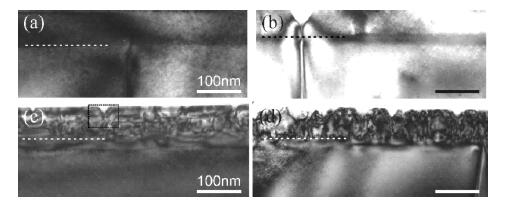
Abb. 2 Hellfeld-TEM-Querschnittsaufnahmen mit g = 0002 aus dem InxGa1−xN-Schichten, die mit der In-Zusammensetzung von (a) 10 %, (b) 13 %, (c) 19 % und (d) 35 % auf der GaN-Pufferschicht aufgewachsen sind. Die gestrichelten Linien zeigen die InxGa1−xN/GaN-Schnittstelle.
Daher denken wir, dass die Gruben in der In0.35Ga0.65N/GaN-Proben werden durch ein solches 3D-Wachstum aufgrund der Gitterfehlanpassung beim anfänglichen Wachstum der InGaN-Schicht verursacht.
Als Ergebnis haben wir den Ursprung der Grubenbildung im In . klassifiziertxGa1-xAuf der GaN-Pufferschicht gewachsenes N in drei Modelle, wie in Fig. 4(a), (b) und (c) gezeigt. Für die InxGa1-xN-Schicht mit geringer In-Zusammensetzung, Pits werden am Scheitelpunkt der Einfädelungsversetzungen erzeugt [Abb. 4(a)]. Für die InxGa1-xN-Schicht mit mittlerer Zusammensetzung, Pits werden hauptsächlich durch Stapelfehlanpassungsgrenzen erzeugt, die durch Stapelfehler induziert werden [Abb. 4(b)]. Eine weitere Zunahme der In-Zusammensetzung des InxGa1-xDie N-Schicht führt zum 3D-Inselwachstum im Anfangsstadium und zur Pit-Bildung beim kontinuierlichen Wachstum [Abb. 4(c)].
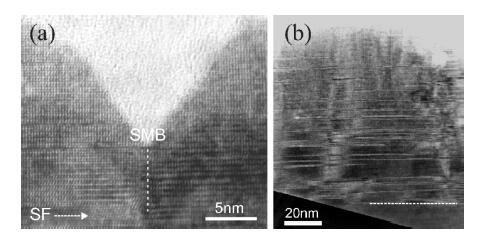
Abb. 3 (a) HRTEM-Bild aus dem gestrichelten Rechteck in Abb. 2(c). Die beobachtete V-förmige Grube weist in ihrer unteren Position eine Stapelstörung auf (0001)-Ebenen auf. (b) HRTEM-Bild aus dem In0.35Ga0.65N auf der GaN-Pufferschicht.
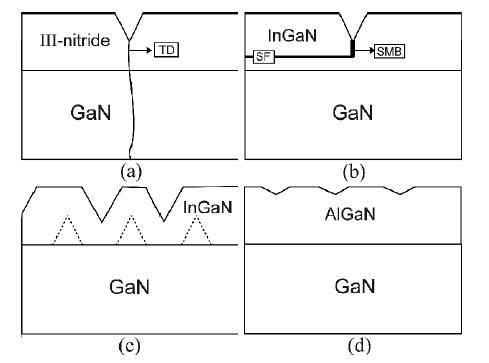
Abb. 4 Schematische Modelle für die Pit-Bildung im Zusammenhang mit (a) einer in InGaN/GaN- und AlGaN/GaN-Heterostrukturen beobachteten Threading-Versetzung, (b) einer durch Stapelfehler induzierten Stapelfehlanpassungsgrenze und (c) dem 3d-Inselwachstum im Anfangsstadium in einer InGaN/GaN-Heterostruktur beobachtet, und (d) die Oberflächenwelligkeit aufgrund der elastischen Fehlanpassungsspannung, die in einer AlGaN/GaN-Heterostruktur beobachtet wurde.
IV. ZUSAMMENFASSUNG
Die Grubenbildung in InxGa1-xN und AlxGa1-xAuf den GaN-Pufferschichten aufgewachsene N-Schichten mit verschiedenen In- und Al-Zusammensetzungen wurden unter Verwendung von TEM untersucht. Wir stellten fest, dass Vertiefungen aus verschiedenen Gründen wie Gewindeversetzungen, Stapelfehlanpassungsgrenzen, 3D-Inselwachstum und Oberflächenwelligkeit in Abhängigkeit von der In- und Al-Zusammensetzung gebildet wurden.
Danksagung
Diese Arbeit wurde durch das Stipendium Nr. R01-2002-000-00096-0 der Korea Science & Engineering Foundation und das Universitätsforschungsprogramm des Ministeriums für Information und Kommunikation der Republik Korea unterstützt.
VERWEISE
[1] H. Morkoc, Nitride Semiconductors and Devices (Springer, Heidelberg, 1999).
[2] YS Park, J. Korean Phys. Soz. 34, S199 (1999).
[3] HK Cho, JY Lee, CS Kim, GM Yang, N. Sharma und CJ Humphreys, J. Cryst. Wachstum 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim und GM Yang, J. Korean Phys. Soz. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard und RA Masut, J. Appl. Phys. 81, 3501 (1997).
[6] M. Mitsuhara, M. Ogasawara und H. Sugiura, J. Cryst. Wachstum 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang und JJ Harris, Semicond. Wissenschaft techn. 15, 370 (2000).
[8] D. Doppalapudi, SN Basu, KF Ludwig, Jr. und TD Moustakas, J. Appl. Phys. 84, 1389 (1998).
[9] T. Takeuchi, H. Takeuchi, S. Sota, H. Sakai, H. Amano und I. Akasaki, Jpn. J. Appl. Phys. 36, L177 (1997).
[10] GB Stringfellow, J. Cryst. Growth 58, 194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson und R. Stall, J. Cryst . Wachstum 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Hong, E.-K. Suh, HJ Lee, HK Cho und JY Lee, J. Korean Phys. Soz. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang und CS Kim, Appl. Phys. Lette. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars und JS Speck und SJ Rosner, Appl. Phys. Lette. 72, 692 (1998).
[15] G. Pozina, JP Bergman, B. Monemar, T. Takeuchi, H. Amano und I. Akasaki, J. Appl. Phys. 88, 2677 (2000).
[16] JW Matthews und AE Blakeslee, J. Cryst. Growth 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, J. Z. Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts und SM Bedair, J. Electron. Mater. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan und S. Mahajan, Appl. Phys. Lette. 77, 3391 (2000).
