PAM-XIAMEN puede ofrecer obleas epitaxiales de heteroestructura p-HEMT (transistor pseudomórfico de alta movilidad de electrones) de AlGaAs / GaAs cultivadas mediante el proceso MBE o MOCVD. La heteroestructura tiene un canal de conducción de alta movilidad formado por gas de electrones bidimensionales, que es un material ideal para aplicaciones inalámbricas. El ancho de línea de nuestro proceso pHEMT de GaAs es de aproximadamente 0,15-0,5 μm, muy bajo pero con características de frecuencia ultra alta y bajo ruido, y la frecuencia de funcionamiento puede llegar hasta 100 GHz. Las especificaciones específicas de la oblea de epiaxia GaAs pHEMT son las siguientes, también podemos proporcionar Epi-obleas de GaAs:

1. GaAs pHEMT Wafer Specifications
No. 1 LN pHEMT Epi Structure (PAM160711-GAAS)
| Capa | Materiales | x | dopante | Concentration | Espesor (A) | Observaciones |
| 12 | n+-GaAs | – | Si | 5,0E + 18 cm-3 | 500 | – |
| 11 | n-AlAs | – | Si | – | – | – |
| 10 | n-AlxGeorgia1-xComo | 0.22 | Si | – | – | – |
| 9 | Si | – | Si | 5,0E + 12 cm-2 | – | – |
| 8 | AlxGeorgia1-xComo | 0.22 | – | – | 30 | – |
| 7 | EnxGeorgia1-xComo | – | – | – | – | – |
| 6 | GaAs | – | – | – | – | – |
| 5 | Pobre de mí | – | – | – | – | – |
| 4 | GaAs | – | – | – | – | – |
| 3 | Pobre de mí | – | – | – | – | – |
| 2 | AlxGeorgia1-xAs / GaAs | 0.22 | – | – | 185/15 | 10 X SL |
| 1 | GaAs | – | – | – | 5000 | – |
| Sustrato de SI GaAs | ||||||
No.2 Power pHEMT Epitxial Structure (PAM160711-GAAS)
| Capa | Materiales | x | dopante | Concentration | Espesor (A) | Observaciones |
| 13 | n+-GaAs | – | Si | – | 500 | – |
| 12 | n-AlAs | – | – | – | – | – |
| 11 | GaAs | – | – | – | – | |
| 10 | n-AlxGeorgia1-xComo | 0.24 | Si | – | – | – |
| 9 | Si | – | Si | 3,0E + 12 cm-2 | – | – |
| 8 | AlxGeorgia1-xComo | – | – | – | 25 | – |
| 7 | EnxGeorgia1-xComo | – | – | – | – | – |
| 6 | AlxGeorgia1-xComo | – | – | – | 30 | – |
| 5 | Si | – | Si | 1.0E + 12 cm-2 | – | – |
| 4 | AlxGeorgia1-xComo | – | – | – | – | – |
| 3 | GaAs | – | – | – | – | – |
| 2 | AlxGeorgia1-xComo | 0.24 | – | – | – | – |
| 1 | GaAs | – | – | – | – | – |
| Sustrato de SI GaAs | ||||||
No.3 GaAs Epi Wafers for pHEMTs (PAM161121-PHEMT)
| Layer material with doping | Espesor (A) | Doping level | Composition | Note |
| n+-GaAs | 400 | – | – | – |
| Pobre de mí | – | – | – | – |
| GaAs | – | – | – | – |
| n-AIGaAs | – | 3E+17cm-3 | – | – |
| GaAs | 9 | – | – | – |
| Si | – | – | – | – |
| GaAs | – | – | – | – |
| i-AIGaAs | – | – | – | Spacer |
| i-GaAs | – | – | – | – |
| i-InGaAs | – | – | – | – |
| i-GaAs | – | – | – | – |
| i-AIGaAs | – | – | 0.24 | – |
| GaAs | – | – | – | |
| Si | – | 1.5E+12cm-2 | – | – |
| GaAs | 9 | – | – | – |
| i-AIGaAs | – | – | – | – |
| AIGaAs 100A/GaAs 20A superlattice 15 periods | – | – | – | – |
| i-GaAs | – | less than 5E+14cm-3 | – | – |
| S.I. GaAs substrate |
We also can provide InP-based pHEMT epitaxial wafer:
PAM160526-INP
| Capa | Materiales | Concentration | Espesor |
| 8 | N+ InxGeorgia1-xComo | – | 20nm |
| 7 | N+ InP etch stopper | – | – |
| 6 | i-InxAl1-xAs Schottky barrier | – | – |
| 5 | Si-delta-doping | n=6×1012 cm-2 | – |
| 4 | i-InxAl1-xAs spacer | – | – |
| 3 | i-InxGeorgia1-xAs channel | – | – |
| 2 | EnxAl1-x As buffer | – | 300nm |
| 1 | metamorphic buffer (linearly graded from substrate to
EnxGeorgia1-x As) |
– | – |
| InP substrate |
En los últimos años, con la popularización y aplicación de las comunicaciones móviles y los sistemas inalámbricos de Internet, se ha estimulado una fuerte demanda de productos de dispositivos semiconductores. Los materiales epitaxiales semiconductores son una base importante para los dispositivos utilizados en las comunicaciones inalámbricas. Para cumplir con los requisitos del mercado en cuanto a calidad y costo del producto, es muy importante desarrollar un proceso estable y de alta capacidad. GaAs pHEMT tiene un rendimiento excelente en el líder de las aplicaciones inalámbricas y se ha movido hacia la producción en masa. Por lo tanto, el desarrollo de un proceso epitaxial eficiente juega un papel importante en la reducción de costos y el tiempo de respuesta del mercado. La epitaxia de haz molecular (MBE) es el principal método técnico para cultivar materiales epitaxiales pHEMT de GaAs. En comparación con otros métodos de crecimiento, como la deposición de vapor químico orgánico metálico (MOCVD), MBE tiene una mayor precisión y estabilidad de control.
2. Acerca del material epitaxial pHEMT de GaAs
El 2-DEG en pHEMT es más restringido que el HEMT ordinario: hay una restricción doble en ambos lados del pozo de potencial, por lo que tiene una mayor densidad de superficie de electrones (aproximadamente 2 veces mayor). Al mismo tiempo, la movilidad de los electrones también es mayor que en GaAs. Por lo tanto, el rendimiento de pHEMT es más superior. La estructura epitaxial de doble heterounión GaAs pHEMT no solo mejora la estabilidad de temperatura del voltaje umbral del dispositivo, sino que también mejora las características de voltio-amperio de salida del dispositivo, de modo que el dispositivo tiene una mayor resistencia de salida, una mayor transconductancia y una mayor capacidad de manejo actual y mayor frecuencia de operación, menor ruido, etc.
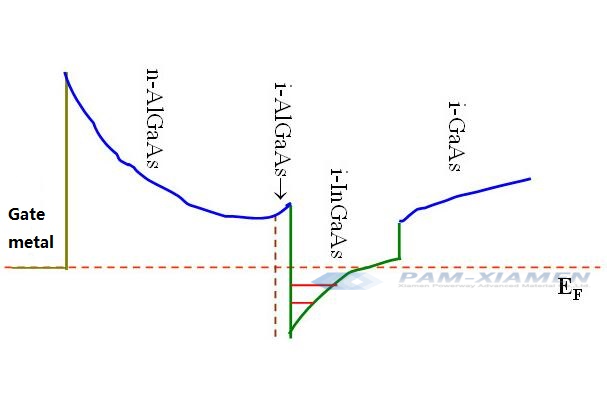
Diagrama de bandas de energía de la heterounión pHEMT
La movilidad del canal de los materiales epitaxiales pHEMT de GaAs es uno de los indicadores más importantes. El aumento de la movilidad del canal puede mejorar eficazmente el rendimiento de CC y RF de los productos pHEMT de arseniuro de galio (como el transistor pHEMT de GaAs, el amplificador pHEMT de GaAs y MMIC), lo que tiene grandes efectos en los parámetros de aplicación como la transconductancia, la resistencia en estado activado, el corte frecuencia, factor de ruido, ganancia de RF y eficiencia de conversión de potencia.
3. Acerca de GaAs pHEMT
pHEMT es una estructura mejorada de transistor de alta movilidad de electrones (HEMT), también conocido como transistores pseudo-emparejados de alta movilidad de electrones (pHEMT), que es un transistor de potencia de GaAs de radiofrecuencia fabricado con una capa epitaxial especial cultivada en GaAs que puede lograr un voltaje bajo y alta eficiencia cuando se utiliza en teléfonos móviles y módems de radiofrecuencia.
La aplicación de GaAs pHEMT es en bandas de frecuencia de ondas milimétricas y microondas debido a las excelentes propiedades de alta movilidad de electrones, alta eficiencia de modulación de corriente y baja pérdida. A medida que la frecuencia de funcionamiento del dispositivo entra en la banda de frecuencia de la onda milimétrica, la influencia de los efectos parásitos en el rendimiento del dispositivo se vuelve muy obvia. El modelo es la base del diseño de circuitos, y el método de extraer con precisión los parámetros del modelo de los efectos parásitos de alta frecuencia del transistor siempre ha sido un punto clave de investigación en la industria.
Con el desarrollo continuo de la infraestructura y los componentes de comunicación inalámbrica 5G, la tecnología GaAs pHEMT jugará un papel clave para cumplir con las múltiples características de las nuevas redes inalámbricas. En el desarrollo de componentes clave 5G, continuamos mejorando nuestro flujo de proceso GaAs pHEMT para proporcionar una gama completa de productos relacionados en radios digitales lineales, aplicaciones de radar de banda V, banda E y banda W.

Para obtener más información, contáctenos por correo electrónico a victorchan@powerwaywafer.com y powerwaymaterial@gmail.com.
