Las estructuras de InxGeorgia1-xComoyP1 año (indium gallium arsenide phosphide) quantum well epitaxially grown on Sustrato de InP se puede comprar o personalizar en PAM-XIAMEN. Al ajustar la composición de xey, el rango de longitud de onda de cobertura es de 870 nm (GaAs) a 3,5 um (InAs), que incluye las longitudes de onda de comunicación de fibra óptica de 1,3 um y 1,55 um. Las fuentes de luz semiconductora de 1,3 y 1,55um para la comunicación por fibra óptica utilizan principalmente materiales de pozo cuántico InGaAsP. Este material compuesto se puede utilizar en dispositivos fotónicos. A continuación se enumeran más detalles para las obleas de InP junto con algo de crecimiento epitaxial en la parte superior:
1. Estructuras basadas en InGaAsP Quantum Well (PAM170109-IGP)
Estructura 1: Epistacks InGaAsP / InP
| En p | Sustrato tipo n, altamente dopado en S (1018cm−3) | |
| En p | Material SCH, ligeramente dopado o sin dopar | |
| hsch | Altura de la capa InP SCH (ambos lados) | 200 nm |
| En1−xGeorgiaxComoyP1−y | Material QW | |
| x | Fracción de Ga 0,25% de deformación compresiva | – |
| y | Como fracción 0,25% de deformación compresiva | – |
| Pozo cuántico Eg | Gap Energy de InGaAsP | – |
| hqw | Altura de InGaAsP QW incrustada | 5 nm |
| En p | Tipo p de contacto óhmico superior altamente dopado (1018cm−3) | |
| htop | Altura del contacto óhmico superior | – |
Estructura 2: Entrada epitaxial1−xGeorgiaxComoyP1−y Crecimiento en InP
| En p | Sustrato tipo n, altamente dopado en S (1018cm−3) | |
| En p | Material SCH, ligeramente dopado o sin dopar | |
| hsch | Altura de la capa InP SCH (ambos lados) | – |
| En1−xGeorgiaxComoyP1−y | Material QW | |
| x | Fracción de Ga 0,25% de deformación compresiva | – |
| y | Como fracción 0,25% de deformación compresiva | – |
| Pozo cuántico Eg | Gap Energy de InGaAsP | – |
| hqw | Altura de InGaAsP QW incrustada | 4 nm |
| En p | Tipo p de contacto óhmico superior altamente dopado (1018cm−3) | |
| htop | Altura del contacto óhmico superior | 500 nm |
Estructura 3: QW InGaAsP basados en InP
| En p | Sustrato tipo n, altamente dopado en S (1018cm−3) | |
| En1−xGeorgiaxComoyP1−y | Material SCH | |
| x | SCH Ga Fracción de celosía emparejada | – |
| y | SCH como cuadrícula de fracciones igualadas | – |
| SCH Eg | SCH Gap Energy de InGaAsP | 1 eV |
| hsch | Altura de la capa de InGaAsP SCH (ambos lados) | – |
| En 1−xGeorgiax Comoy P1−y | Material QW | |
| x | Fracción de Ga 0,25% de deformación compresiva | – |
| y | Como fracción 0,25% de deformación compresiva | – |
| Pozo cuántico Eg | Gap Energy de InGaAsP | – |
| hqw | Altura de InGaAsP QW incrustada | 5 millas náuticas |
| En p | Tipo p de contacto óhmico superior altamente dopado (1018cm−3) | |
| htop | Altura del contacto óhmico superior | – |
Nota:
No hay muchas capas: una capa SCH de InP, un pozo cuántico GaxIn1-xAsyP1-y estrecho, una segunda capa SCH de InP y una capa superior de InP muy dopada para contacto óhmico.
El segundo diseño es el mismo que el primero, pero el grosor del InGaAsP QW es diferente.
El tercer y último diseño está reemplazando la capa InP SCH con InGaAsP con una fracción diferente. De lo contrario, todo lo demás debería ser igual al diseño 1.
2. Acerca de las propiedades del fosfuro de arseniuro de galio indio
EnxGeorgia1-xComoyP1 año is quaternary solid solution with a narrow band gap. The following figure shows the relationship between refractive index n and wavelength for different composition InGaAsP lattice matched to InP at 300K:
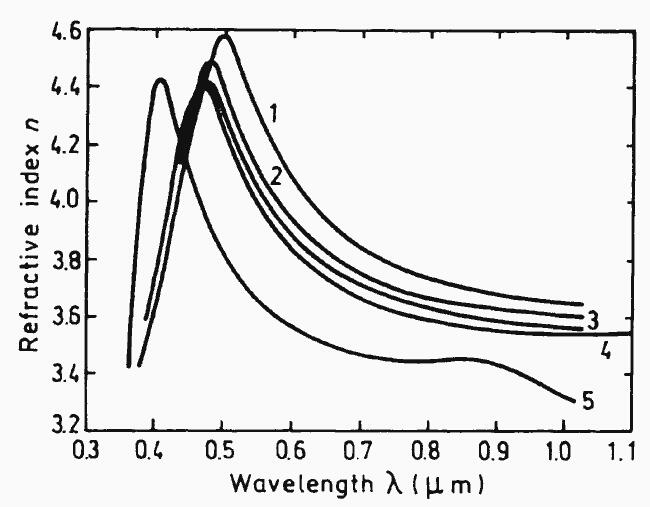
Índice de refracción n versus longitud de onda para diferentes aleaciones de composición ajustadas en celosía a InP. 300 K
La relación para el índice de refracción n de GaxIn1-xAsyP1-y versus la energía del fotón a 300 K se muestra como el diagrama:

Índice de refracción n frente a la energía de los fotones para diferentes aleaciones de composición ajustadas en celosía a InP. 300 K.
3. Acerca del material GaxIn1-xAsyP1-y
En términos generales, InGaAsP pertenece al sistema cuaternario, que está compuesto por arseniuro de indio, fosfuro de indio, arseniuro de galio y fosfuro de galio.
Los pozos cuánticos (QW) de InGaAsP, incluido el pozo cuántico único y el pozo cuántico múltiple, pueden cultivarse mediante MOCVD de baja presión en sustrato de InP. Y el pozo cuántico se cultiva con una composición de InGaAsP de 1.3- um y 1.5- um, con barrera de InP. Para diferentes estructuras, el espesor de la capa QW de fosfuro de arseniuro de galio y indio cambia de 18 a 1300 Å. Las estructuras se analizan por fotoluminiscencia a baja temperatura, mostrando un pico luminoso claro y nítido y las medias anchuras de 4,8-1,3 meV.
Los materiales GaxIn1-xAsyP1-y emiten principalmente luz de excitones libres. A temperatura ambiente, el tiempo de relajación de la emisión del portador de los materiales de fosfuro de arseniuro de galio y indio alcanza 10,4 ns y aumenta con el aumento de la potencia de excitación.
Los CI fotónicos o PIC fabricados en material InP generalmente adoptan la aleación GaxIn1-xAsyP1-y para hacer la estructura del pozo cuántico, la guía de ondas y otras estructuras fotónicas. La constante de celosía de InGaAsP se adapta al sustrato de InP, lo que hace posible el crecimiento de una película delgada epitaxial en una oblea de InP. El pozo cuántico GaxIn1-xAsyP1-y se utiliza casi como un componente óptico (como fotodetector y modulador) en las comunicaciones de banda C, así como en los dispositivos de infrarrojo cercano de 1,55um.
Para obtener más información, contáctenos por correo electrónico a victorchan@powerwaywafer.com y powerwaymaterial@gmail.com.


