Une ébauche de photomasque avec chrome antireflet est disponible. Les photomasques sont principalement utilisés dans les circuits intégrés, les écrans plats (y compris LCD, LED, OLED), les cartes de circuits imprimés et d'autres domaines. Le photomasque est un maître de modèle utilisé dans le processus de photolithographie dans la fabrication de microélectronique. Voici les spécifications du masque photo vierge pour votre référence :
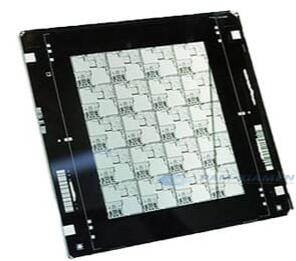
N° 1 Masques photo PAM190302-MASKH
N° 1-1 Plaquettes de silicium avec des structures IC (ASIC11) à des normes de conception de 0,35 micron ;
N°1-2 Plaquettes de silicium avec des structures IC (ASIC12) à des normes de conception de 0,35 micron ;
Remarque:
Le diamètre du substrat >= 150mm. le type/le mélange de dopage, l'orientation, l'épaisseur, la résistivité, la surface avant, la surface arrière, plat(s) est déterminé par le fabricant pour fournir les paramètres de base de l'élément requis (transistors, résistances, condensateurs) spécifiés dans le kit de conception. Le fabricant fournit un kit de conception adapté au développement de la topologie IC. Le client réalise le développement conformément au Design Kit et transmet les informations au fabricant au format GDS. Le fabricant produit un ensemble de photomasques conformément aux informations au format GDS. Le fabricant fabrique les plaques à l'aide d'un ensemble de photomasques et selon les exigences du Design Kit.
N° 1-3 Masque photo vierge
format 152 x 152 x mm, échelle 5 : 1, conçu pour la photolithographie avec des normes de conception de 0,35 μm ;
Exigences de base du modèle
Objectif: modèles binaires pour la projection f / l
Taille du substrat : 6 "x6" x0.25", quartz
Type d'équipement : 5x, NIKON NSR 2205i11D
Champ d'exposition : 110 mm x 110 mm
Pellicule : Oui, NIK49P-122-1K17 / HFLC, protection unilatérale contre le chrome (protection bidirectionnelle sur demande)
Taille critique minimale : 1,75 microns
Reproductibilité des dimensions critiques : 0,05 µm (3σ)
Précision d'enregistrement (enregistrement): 0,1 µm
Défaut : 0,1/cm2 (1 micron)
Photomasque au chrome n°2 sur quartz PAM200313-MASKH
N°2-1 Le moins complexe : Strip & Ship ;
CD >= 5um ;
Vastes aires ouvertes; Grille d'écriture : standard
Matière : quartz, chrome antireflet. Pas de pellicule.
N° 2-2 Modéré :
5x réticule ; 6"x6"x0,12" Quartz;
Aucun défaut de plus de 2,5 um ;
Défaut inférieur à 1,25 um
CD >= 5um ; lignes/espaces/octogones ;
Grille d'écriture : doit conserver le CD
Matière : quartz, chrome antireflet. Pas de pellicule.
N° 2-3Le plus complexe :
5x réticule ; 6"x6"x0,12" Quartz;
Aucun défaut supérieur à 1,25 um ;
Défaut inférieur à 0,625um
CD >= 2,5um ; lignes/espaces/octogones ;
Grille d'écriture : doit conserver le CD
Matière : quartz, chrome antireflet. Pas de pellicule.
Il n'y aura pas de pellicule nécessaire dans ces ébauches de photomasque, et la taille du masque de réticule sera de 6" x 6" et 0,12" d'épaisseur. Les tailles minimales des caractéristiques sur les masques sont de 2,5 um et 5 um. Le photomasque (réticule) est destiné à la fabrication du processus de lithographie à utiliser dans les machines pas à pas.
Les paramètres techniques du photomasque vierge répondent aux exigences des tableaux 1 et 2.
|
Tableau 1 Paramètres de niveau de qualité du masque photo |
||||||||||||||||
| Qualité | D | C | B | A | S | T | U | V | W | W+P | X | X+P | Y | A+P | Z | Z+P |
| Tolérance | ±0.3 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.1 | ±0.05 | ±0.04 | ±0.035 | ±0.035 | ±0.032 | ±0.032 | ±0.028 | ±0.028 | ±0.022 | ±0.022 |
| Moyen à cibler | ±0.3 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.075 | ±0.05 | ±0.04 | ±0.03 | ±0.03 | ±0.028 | ±0.028 | ±0.025 | ±0.025 | ±0.02 | ±0.02 |
| Uniformité | 0.2 | 0.2 | 0.2 | 0.15 | 0.1 | 0.075 | 0.05 | 0.04 | 0.035 | 0.035 | 0.035 | 0.035 | 0.03 | 0.03 | 0.025 | 0.025 |
| Inscription | ±0.4 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.075 | ±0.05 | ±0.06 | ±0.055 | ±0.055 | ±0.05 | ±0.05 | ±0.045 | ±0.045 | ±0.04 | ±0.04 |
| Taille du défaut | 1.5 | 1.5 | 1 | 0.8 | 0.6 | 0.4 | 0.4 | 0.35 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| densité de défauts | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 |
| Défaut de bord | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Rugosité des bords | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Arrondi de coin | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Phase PSM | / | / | / | / | / | / | / | / | / | 180±4 | / | 180±3 | / | 180±3 | / | 180±3 |
| PSM trans | / | / | / | / | / | / | / | / | / | 6±0.4 | / | 6±0,3 | / | 6±0,3 | / | 6±0,3 |
Remarque:
Les paramètres sont applicables au réticule d'échelle ; le niveau de qualité est classé de faible à élevé :
- Le processus de 0,5 um prend en charge jusqu'au niveau S ; Le processus de 0,35 um prend en charge jusqu'au niveau U, le processus de 0,18 um prend en charge jusqu'au niveau X ;
- Le masque en verre ordinaire ne s'applique qu'à la classe D.
| Tableau 2 Exigences pour la qualité du photomasque | ||||||||
| 1:1 Masque principal | Balayage par faisceau d'électrons 1:1 | masque UT | ||||||
| Qualité | PB | Pennsylvanie | EB | EA | ES | uc | UB | UA |
| Spécifications du CD | >2.5 | 1,2 ~ 2,5 | >1.5 | 1,2 ~ 1,5 | <1.2 | >2 | 1.5~2.0 | <1.5 |
| Tolérance | ±0.25 | ±0.2 | ±0.2 | ±0.15 | ±0.1 | ±0.25 | ±0.2 | ±0.15 |
| Uniformité | 0.3 | 0.3 | 0.3 | 0.25 | 0.2 | 0.25 | 0.2 | 0.15 |
| Inscription | ±0.8 | ±0.8 | ±0.2 | ±0.15 | ±0.1 | ±0.2 | ±0.15 | ±0.1 |
| Taille du défaut | 2 | 2 | 1.5 | 1.5 | 1.0 | 2 | 1.5 | 1 |
| Densité de défaut (pcs/in2) | 2 | 1 | 2 | 1 | 0.5 | 0 | 0 | 0 |
Remarque:
L'exigence s'applique au masque 1:1, et le niveau de qualité est classé de faible à élevé ;
Le masque UT ne s'applique qu'au matériau en quartz; Le masque en verre ordinaire est applicable au plus haut niveau B.
No.3 Photolithographie Blank PAM200326-MASKH
Substrat en verre :
Taille : 50x50 mm +/- 0,2 mm ;
Épaisseur : 3.67mm +/-0.02mm
Matériel: QUARTZ
Pas de spéc. sur la planéité : 1/4 ~ 1/2 longueur d'onde
Sans éclat sur les bords
Substrat de départ 7X7 pouces X 150mil
Revêtement blanc de réticule standard 3.0 OD AR Chrome
Masque photo n°4 sur Quartz PAM200602-MASKH
N° 4-1 Masque photo
Taille du masque 5" X5"
MATÉRIAUX DE SUBSTRAT DE MASQUE : Quartz
Lithographie : faisceau d'électrons
Polarité du masque : BF
Tolérance de fonctionnalité : 0,02 um
Taille de la caractéristique : 0,4 um
Précision : 0,12 um
Grille de fabrication : 0,005 um, 0,02 um
N° 4-2 Masque photo vierge
Taille du masque 5" X5"
MASQUE SUBSTRAT MATÉRIAUX Quartz
Lithographie : laser
Polarité du masque : DF
Tolérance de fonctionnalité: 0.5um
Taille caractéristique : 10 um, 3 um ou 5 um
Précision : 0,12 um
Grille de fabrication : 0,02 um
Quartz n° 5 avec Chrome LR PAM200811-MASKH
Taille du masque = 5″x 5″x 0,09″
Matériau = Quartz avec Chrome LR
Orientation : RR Bas.
Données sombres.
Dimension Critique (CD) : 4 µm +/- 0,5 µm (pour tous les masques)
Défauts : 0 > 5 µm
Notez s'il vous plaît:
Le quartz avec LR Chrome est destiné à la fabrication de l'aligneur de masque (longueur d'onde de 350-450 nm de photolithographie NUV);
La mise à l'échelle des données à masquer est de 1:01 car l'aligneur de masque a une mise à l'échelle 1:1, au lieu de 5:1 ;
Le matériau du masque est du quartz avec LR Chrome et le côté chromé est orienté vers le bas (Real Read (RR) vers le bas);
Dans la conception de la mise en page, la couche métallique numéro 28 est utilisée et la zone de la couche métallique dans les mises en page de conception doit être chromée sur le masque photo.
Pour plus d'informations, veuillez nous contacter par e-mail à victorchan@powerwaywafer.com et powerwaymaterial@gmail.com.

