PAM-XIAMEN peut proposer une plaquette épitaxiale à hétérostructure AlGaAs / GaAs p-HEMT (transistor pseudomorphique à haute mobilité électronique) développée par procédé MBE ou MOCVD. L'hétérostructure a un canal de conduction à haute mobilité formé par un gaz d'électrons bidimensionnel, qui est un matériau idéal pour les applications sans fil. La largeur de ligne de notre procédé GaAs pHEMT est d'environ 0,15 à 0,5 μm, très faible mais avec des caractéristiques ultra-haute fréquence et à faible bruit et la fréquence de fonctionnement peut atteindre 100 GHz. Les spécifications spécifiques de la plaquette d'épiaxie GaAs pHEMT sont les suivantes, nous pouvons également fournir des produits personnalisés GaAs épi-wafers:

1. GaAs pHEMT Wafer Specifications
No. 1 LN pHEMT Epi Structure (PAM160711-GAAS)
| Couche | Matériel | x | dopant | Concentration | Épaisseur (A) | Remarques |
| 12 | n+-GaAs | – | Si | 5.0E+18 cm-3 | 500 | – |
| 11 | n-AlAs | – | Si | – | – | – |
| 10 | n-AlxGéorgie1 foisComme | 0.22 | Si | – | – | – |
| 9 | Si | – | Si | 5.0E+12 cm-2 | – | – |
| 8 | AlxGéorgie1 foisComme | 0.22 | – | – | 30 | – |
| 7 | DansxGéorgie1 foisComme | – | – | – | – | – |
| 6 | GaAs | – | – | – | – | – |
| 5 | Hélas | – | – | – | – | – |
| 4 | GaAs | – | – | – | – | – |
| 3 | Hélas | – | – | – | – | – |
| 2 | AlxGéorgie1 foisAs/GaAs | 0.22 | – | – | 185/15 | 10 X SL |
| 1 | GaAs | – | – | – | 5000 | – |
| Substrat SI GaAs | ||||||
No.2 Power pHEMT Epitxial Structure (PAM160711-GAAS)
| Couche | Matériel | x | dopant | Concentration | Épaisseur (A) | Remarques |
| 13 | n+-GaAs | – | Si | – | 500 | – |
| 12 | n-AlAs | – | – | – | – | – |
| 11 | GaAs | – | – | – | – | |
| 10 | n-AlxGéorgie1 foisComme | 0.24 | Si | – | – | – |
| 9 | Si | – | Si | 3.0E+12 cm-2 | – | – |
| 8 | AlxGéorgie1 foisComme | – | – | – | 25 | – |
| 7 | DansxGéorgie1 foisComme | – | – | – | – | – |
| 6 | AlxGéorgie1 foisComme | – | – | – | 30 | – |
| 5 | Si | – | Si | 1.0E+12 cm-2 | – | – |
| 4 | AlxGéorgie1 foisComme | – | – | – | – | – |
| 3 | GaAs | – | – | – | – | – |
| 2 | AlxGéorgie1 foisComme | 0.24 | – | – | – | – |
| 1 | GaAs | – | – | – | – | – |
| Substrat SI GaAs | ||||||
No.3 GaAs Epi Wafers for pHEMTs (PAM161121-PHEMT)
| Layer material with doping | Épaisseur (A) | Doping level | Composition | Note |
| n+-GaAs | 400 | – | – | – |
| Hélas | – | – | – | – |
| GaAs | – | – | – | – |
| n-AIGaAs | – | 3E+17cm-3 | – | – |
| GaAs | 9 | – | – | – |
| Si | – | – | – | – |
| GaAs | – | – | – | – |
| i-AIGaAs | – | – | – | Spacer |
| i-GaAs | – | – | – | – |
| i-InGaAs | – | – | – | – |
| i-GaAs | – | – | – | – |
| i-AIGaAs | – | – | 0.24 | – |
| GaAs | – | – | – | |
| Si | – | 1.5E+12cm-2 | – | – |
| GaAs | 9 | – | – | – |
| i-AIGaAs | – | – | – | – |
| AIGaAs 100A/GaAs 20A superlattice 15 periods | – | – | – | – |
| i-GaAs | – | less than 5E+14cm-3 | – | – |
| S.I. GaAs substrate |
We also can provide InP-based pHEMT epitaxial wafer:
PAM160526-INP
| Couche | Matériel | Concentration | Épaisseur |
| 8 | N+ InxGéorgie1 foisComme | – | 20nm |
| 7 | N+ InP etch stopper | – | – |
| 6 | i-InxAl1 foisAs Schottky barrier | – | – |
| 5 | Si-delta-doping | n=6×1012 cm-2 | – |
| 4 | i-InxAl1 foisAs spacer | – | – |
| 3 | i-InxGéorgie1 foisAs channel | – | – |
| 2 | DansxAl1 fois As buffer | – | 300nm |
| 1 | metamorphic buffer (linearly graded from substrate to
DansxGéorgie1 fois As) |
– | – |
| InP substrate |
Ces dernières années, avec la popularisation et l'application des systèmes de communication mobile et d'Internet sans fil, une forte demande de produits de dispositifs à semi-conducteurs a été stimulée. Les matériaux épitaxiaux semi-conducteurs sont une base importante pour les dispositifs utilisés dans les communications sans fil. Afin de répondre aux exigences du marché en matière de qualité et de coût des produits, il est très important de développer un procédé stable et de grande capacité. GaAs pHEMT a d'excellentes performances dans le leader des applications sans fil et s'est orienté vers la production de masse. Par conséquent, le développement d'un processus d'épitaxie efficace joue un rôle important dans la réduction des coûts et du temps de réponse du marché. L'épitaxie par faisceau moléculaire (MBE) est la principale méthode technique de croissance des matériaux épitaxiaux GaAs pHEMT. Par rapport à d'autres méthodes de croissance, telles que le dépôt chimique en phase vapeur métal-organique (MOCVD), le MBE a une précision et une stabilité de contrôle plus élevées.
2. À propos du matériau épitaxié GaAs pHEMT
Le 2-DEG en pHEMT est plus restreint que le HEMT ordinaire : il y a une double restriction des deux côtés du puits de potentiel, il a donc une densité de surface électronique plus élevée (environ 2 fois plus élevée). Dans le même temps, la mobilité des électrons est également plus élevée que celle du GaAs. Par conséquent, la performance de pHEMT est plus supérieure. La structure épitaxiale à double hétérojonction GaAs pHEMT améliore non seulement la stabilité de température de la tension de seuil du dispositif, mais améliore également les caractéristiques de tension-ampère de sortie du dispositif, de sorte que le dispositif a une plus grande résistance de sortie, une plus grande transconductance et une plus grande capacité de traitement actuelle et fréquence de fonctionnement plus élevée, moins de bruit, etc.
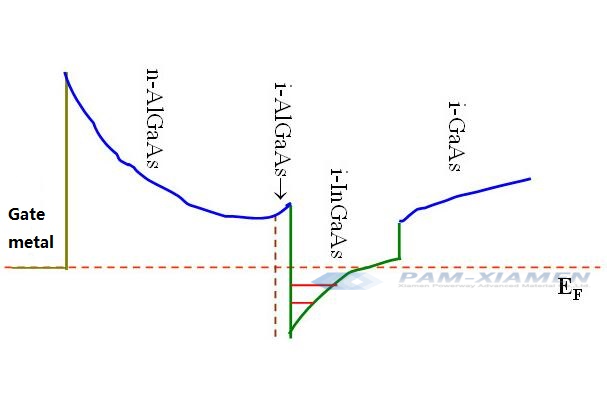
Diagramme de bande d'énergie de l'hétérojonction pHEMT
La mobilité des canaux des matériaux épitaxiaux GaAs pHEMT est l'un des indicateurs les plus importants. L'augmentation de la mobilité des canaux peut améliorer efficacement les performances DC et RF des produits pHEMT à l'arséniure de gallium (tels que le transistor GaAs pHEMT, l'amplificateur GaAs pHEMT et MMIC), ce qui a de grands effets sur les paramètres d'application tels que la transconductance, la résistance à l'état passant, la coupure fréquence, facteur de bruit, gain RF et efficacité de conversion de puissance.
3. À propos de GaAs pHEMT
pHEMT est une structure améliorée de transistor à haute mobilité électronique (HEMT), également connu sous le nom de transistors à haute mobilité électronique pseudo-appariés (pHEMT), qui est un transistor de puissance GaAs radiofréquence fabriqué à l'aide d'une couche épitaxiale spéciale développée sur GaAs peut atteindre une basse tension et haute efficacité lorsqu'il est utilisé dans les téléphones cellulaires et les modems radiofréquence.
L'application GaAs pHEMT est dans les bandes de fréquences des micro-ondes et des ondes millimétriques en raison des excellentes propriétés de mobilité élevée des électrons, de l'efficacité de modulation de courant élevée et de la faible perte. Lorsque la fréquence de fonctionnement de l'appareil entre dans la bande de fréquence des ondes millimétriques, l'influence des effets parasites sur les performances de l'appareil devient très évidente. Le modèle est la base de la conception de circuits, et la méthode d'extraction précise des paramètres de modèle des effets parasites haute fréquence des transistors a toujours été un point névralgique de la recherche dans l'industrie.
Avec le développement continu des composants et de l'infrastructure de communication sans fil 5G, la technologie GaAs pHEMT jouera un rôle clé pour répondre aux multiples caractéristiques des nouveaux réseaux sans fil. Dans le développement de composants clés 5G, nous continuons d'améliorer notre flux de processus GaAs pHEMT pour fournir une gamme complète de produits connexes dans les applications de radios numériques linéaires, de bande V, de bande E et de bande W.

Pour plus d'informations, veuillez nous contacter par e-mail à victorchan@powerwaywafer.com et powerwaymaterial@gmail.com.
