La demande de photodétecteurs fabriqués sur une plaquette PIN InGaAs/InP fonctionnant à environ 1300 nm ~ 1550 nm a considérablement augmenté. C'est donc une excellente nouvelle pour les fonderies de plaquettes de semi-conducteurs, commePAM-XIAMEN, qui proposent un substrat semi-conducteur et une plaquette épitaxiale pour la fabrication de dispositifs électroniques et de puissance. La plaquette InGaAs pour photodétecteur PIN est l'une des plaques d'épitaxie importantes de PAM-XIAMEN. Prenez des structures épitaxiales spécifiques pour le photodétecteur InGaAs ci-dessous, par exemple :

1. Epitaxy Structure of InGaAs/InP Photodetector
N° 1 Hétérostructure InGaAs/InP
| Matériel | X | Épaisseur (nm) | dopant | Concentration de dopage |
| InP | 1000 | N (soufre) | 3e16 | |
| In (x) GaAs | 0.53 | 3000 | U / D | 5e14 |
| InP | 500 | N (soufre) | 3e16 | |
| substrat | SI (Fe) |
Plaquette de photodétecteur InGaAs n ° 2
PAM200624-INGAAS
| Matériel | Dopage (cm-3) | Épaisseur (nm) |
| P++InGaAs | – | 100 |
| P+InGaAs | – | – |
| i-InGaAs | – | – |
| n+InP | 5 * 1018(Si) | – |
| i-InGaAs | Pas de dopage | – |
| i-InP | – | – |
| Semi-isolant InP | Fe | substrat |
Remarque:
1) Cette structure peut être utilisée comme détecteur de longueur d'onde 1550nm (PD);
2) Il est préférable d'utiliser Zn dopé pour P + InGaAs, ce qui serait mieux pour la caractéristique PD, et que la couche InP soit ajoutée sous P + InGaAs. Si vous souhaitez conserver la conception d'origine, il est recommandé d'ajouter une couche de P AlInAs sous P + InGaAs sur la base de la conception d'origine, ce qui peut également améliorer les caractéristiques PD ;
3) La structure du détecteur avec contact est illustrée par le schéma :
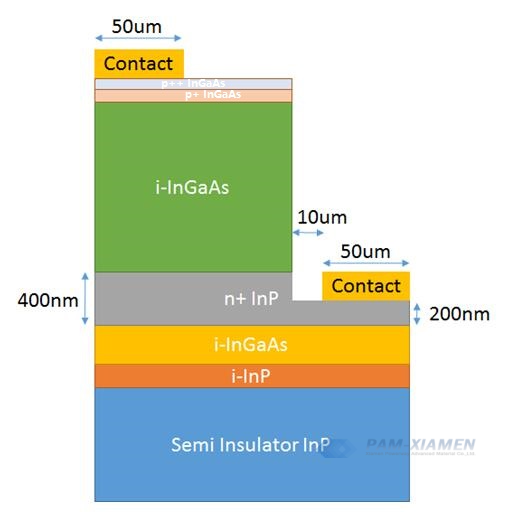
No. 3 InGaAs on InP Substrate for Single-Photon Photodetector
PAMP20345-INGAAS
Heterostructure for a single-photon photodetector with an absorption region based on InGaAs on an indium phosphide substrate
Manufacturing technology – MOCVD
Dia – 50.8 mm
Substrate material – InP
Substrate thickness – 350+/-25um
| Non | Type of doping | Matériel | Thickness, nm | Doping, cm-3 | Note |
| 1 | n | InP | 500±25 | – | |
| 2 | n | InGaAs | – | – | |
| 3 | InGaAlAs | – | In is 0.53, the molar fraction of Al is 0.01, the molar fraction of Ga is 0.46, no doping. | ||
| 4 | n+++ | InAlGaAs | – | 1E15 | |
| 5 | p | InP | – | – | |
| 6 | InP | 3700 |
The SEMI-EJ is shown as diagram:

Mark:
The PL wavelength of this structure is – 1.55um, and the wavelength range is – 1.0-1.7 um;
Concentration tolerance should be +/-15%.
No.4 PIN Wafer to Fabricate Waveguide Photo-Detector
PAM200519 – INGAAS
Based on InP substrate:
n-InP: 250nm Nc>~
In0.55Ga0.45As: ~nm Nc~
p-InP: ~nm Nc>10^18
Roughness of epi-layer, Ra<0.5nm
Single side polished
2. Structure épitaxiale InGaAs pour photodétecteur
La structure Epi InGaAs No.1 1550nm pour PIN est discutée en détail. La structure du matériau est une double hétérojonction InP/InGaAs/InP, et la structure de la broche est développée par la technologie épitaxiale. La couche InP au-dessus de la couche d'absorption InGaAs est un matériau à large bande interdite, qui est transparent à la lumière avec des longueurs d'onde de 1,31 um et 1,55 um, et les porteurs photo-générés ne sont qu'en Il est produit en matériau InGaAs, ce qui évite la génération et la diffusion de porteurs minoritaires générés par la lumière.
This structure has obvious advantages over that of single heterojunction detectors in terms of quantum efficiency and frequency response. The most important thing in the design of the epitaxial structure is the design of the absorption layer. It must have enough thickness to ensure high responsivity and small junction capacitance, and it must be as thin as possible to shorten the carrier transit time to improve response bandwidth of InGaAs photodetector, so the thickness of the absorbing layer should be selected as a compromise.
The change in the absorption coefficient of semiconductor materials with wavelength is shown in the figure. For InGaAs materials, the absorption coefficient at 1310nm wavelength is 1.15um-1, and the absorption coefficient at 1550nm wavelength is 0.67um-1.
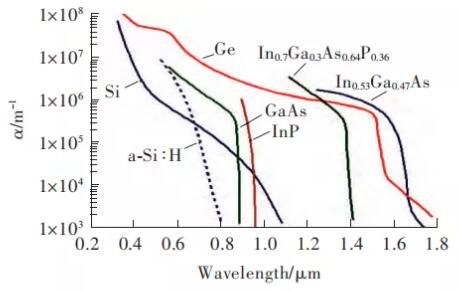
When growing the epitaxial stack, different InP substrates, tels que le type N et semi-isolant, peuvent être utilisés pour faire croître les couches épitaxiales en fonction de la conception des contacts. Une couche tampon et de contact est développée sur le substrat InP, puis une couche absorbante InGaAs est développée. Le niveau de dopage et l'épaisseur du tampon, du contact et de la couche absorbante sont optimisés pour la longueur d'onde de fonctionnement. Selon les caractéristiques du photodétecteur InGaAs requis et le choix de la longueur d'onde de coupure, l'épi-couche peut être composée d'empilements supplémentaires : régions de charge d'espace, interfaces et capuchons. Ces couches sont développées pour contrôler la dérive, la diffusion et la recombinaison des porteurs ainsi que pour empêcher les fuites de courant de surface.
3. Relations entre la longueur d'onde et l'indice de réfraction d'InGaAs
Le diagramme suivant montre que plus la longueur d'onde du matériau InGaAs est longue, plus l'indice de réfraction est petit. Plus d'informations sur les paramètres détaillés, veuillez envoyer un e-mail àtech@powerwaywafer.com.
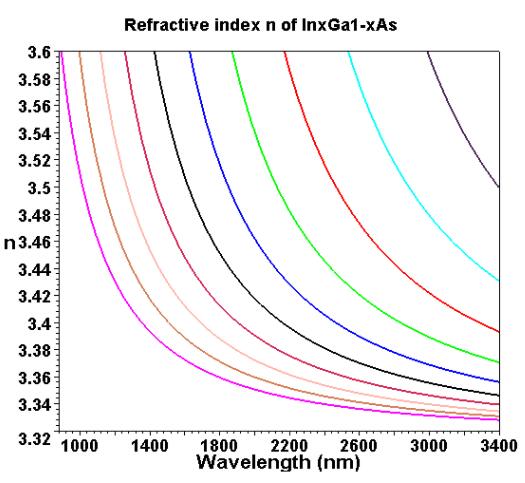
4. Matériau InGaAs/InP pour photodétecteur PIN
Parmi les matériaux semi-conducteurs naturels, seul Ge (avec une bande interdite de 0,66 eV, correspondant au bord d'absorption de 1,88 um) peut être utilisé pour fabriquer des photodétecteurs utilisés dans la bande de grande longueur d'onde (1,3-1,6 μm) de communication par fibre optique. Cependant, la bande interdite de Ge est relativement petite et le dispositif fabriqué a un bruit plus élevé lorsqu'il fonctionne à température ambiante ou au-dessus. Le photodétecteur fonctionnant à la longue longueur d'onde de 1,31 um à 1,55 um utilise généralement un matériau InGaAs/InP. La bande interdite du matériau InGaAs est de 0,75 eV et son spectre d'absorption peut couvrir la bande de communication par fibre optique de 1,00 à 1,65 um, y compris les fenêtres à faible dispersion de 1,3 um et à faible perte de 1,55 um de la fibre de quartz. En conséquence, InGaAs est un matériau idéal pour les photodétecteurs dans la bande de communication optique.
InGaAs peut obtenir une correspondance complète du réseau avec le matériau InP, de sorte qu'une couche épitaxiale de haute qualité peut être développée sur le substrat InP, et la mobilité électronique du matériau InGaAs est très élevée. Ces caractéristiques confèrent au photodétecteur InGaAs PIN une vitesse de réponse extrêmement élevée et un faible courant d'obscurité.
Le développement réussi de la photodiode PIN InGaAs surmonte les lacunes du grand courant d'obscurité et des caractéristiques de température médiocres de la photodiode Ge, et fournit un dispositif clé de bonne qualité pour la transmission à long relais et la technologie de transmission à plusieurs longueurs d'onde de la communication optique.
5. Direction de l'injection de lumière du photodétecteur InGaAs
Pour la direction d'injection de lumière, le photodétecteur PIN basé sur une plaquette épi InGaAs/InP a deux méthodes : l'une est l'injection de lumière arrière, c'est-à-dire que la lumière pénètre à partir du substrat InP de type N ; l'autre est le type à injection de lumière avant, c'est-à-dire que la lumière entre par le type P. Pour les dispositifs d'injection de lumière arrière, le substrat InP (Eg = 1,35 eV) est une couche transmettant la lumière pour les grandes longueurs d'onde et le coefficient de réflexion de surface est faible. Si les paramètres du matériau sont correctement contrôlés, les porteurs photo-générés peuvent être directement générés dans la couche d'appauvrissement. Cette structure présente les avantages d'un rendement quantique élevé et d'une faible capacité de jonction.
Cependant, dans cette structure, la lumière incidente est éloignée de la jonction PN, et la divergence de la lumière provoque une absorption sur la paroi latérale du photodétecteur InGaAs ultrarapide, ce qui affecte les caractéristiques de fréquence. De plus, l'efficacité quantique et le courant d'obscurité du dispositif sont fortement limités par la croissance du matériau, la répétabilité est médiocre et le processus de fabrication est plus compliqué. Comparé au dispositif d'injection de lumière arrière, le dispositif d'injection de lumière avant a un processus plus simple, la lumière incidente est très proche de la jonction PN et l'effet de couplage est bon. Ses lacunes telles que le contrôle de la profondeur de la jonction de diffusion et la grande capacité de jonction peuvent être surmontées grâce à une conception de paramètres raisonnable pour le réseau de tranches de photodétecteurs InGaAs et certaines technologies de processus spéciales.
Pour plus d'informations, veuillez nous contacter par e-mail à victorchan@powerwaywafer.com et powerwaymaterial@gmail.com.

