Grazie alla sua eccellente resistenza elettrica, termica e alle radiazioni, il carburo di silicio è diventato un potenziale materiale per applicazioni in ambienti ad alta frequenza, alta potenza e forti radiazioni. I condensatori MOS sono un mezzo importante per studiare le superfici e le interfacce dei semiconduttori, nonché la struttura di base dei MOSFET. Pertanto, la ricerca sistematica sui condensatori SiC MOS è di grande importanza per migliorare la resistenza alle radiazioni dei dispositivi elettronici basati su SiC e la durata dei dispositivi. In qualità di uno dei principali produttori di wafer epitassiali,PAM-XIAMENpuò fornire un processo di produzione di wafer epi SiC per condensatori MOS. Vedere la tabella seguente per i parametri specifici:
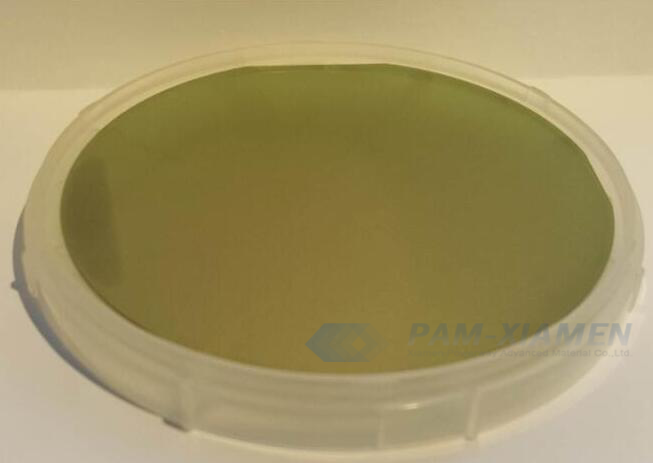
1. Specifiche del wafer epitassiale SiC 4HN
PAM210218 – MOSC
| SL n. | Specificazione | |
| 1 | Materiale wafer | Carburo di silicio 4H |
| 2 | Configurazione del wafer | N+ con epi |
| 3 | Numero di Epi-Layer | 2 strati |
| Livello 1: livello tampone | ||
| Strato 2: strato superiore | ||
| 4 | Spessore strato 2 | 5/8/10um±10% |
| 5 | Strato 2 drogante | Azoto |
| 6 | Uniformità di spessore | <=5% |
| 7 | Densità dei difetti superficiali | <1/cm2 |
| 8 | Strato 2 Concentrazione di drogaggio | 1,0 × 1016cm-3+/-20% |
| 9 | Uniformità di concentrazione | <=10% |
| 10 | Spessore strato 1 | 0,5um±10% |
| 11 | Strato 1 drogante | Azoto |
| 12 | Strato 1 Concentrazione di drogaggio | 1,0 × 1018centimetro-3+/-50% |
| 13 | Superficie frontale | Si-face |
| 14 | Tipo di conduttività del substrato | Tipo n fortemente drogato |
| 15 | drogante | Azoto |
| 16 | cristallo Orientamento | (0001)±0,25° |
| 17 | Fuori orientamento | 4° verso <11-20> |
| 18 | Densità Micropipe | ≤1 cm-2 |
| 19 | Resistività elettrica | 0,015~0,028 ohm-cm |
| 20 | Diametro | 100±0,4 mm |
| 21 | Spessore | 350±25um |
| 22 | TTV | 10 ehm |
| 23 | LTV | 4 ehm |
| 24 | Ordito | ≤35um |
| 25 | Orientamento piatto primaria | <11-20> |
| 26 | Secondaria Orientamento piatto | <1-100> |
| 27 | Finitura superficiale Si-face | CMP lucido |
| 28 | Finitura superficiale C-face | Lucidato otticamente |
2. Come controllare la concentrazione di doping dell'epistrato nel processo di produzione di SiC Epi Wafer?
Il controllo del tipo di drogaggio e della concentrazione degli strati epitassiali è fondamentale per le prestazioni dei dispositivi di potenza SiC, che determinano direttamente importanti parametri elettrici come la resistenza specifica nello stato On e la tensione di blocco dei dispositivi successivi. Il metodo dell'epitassia competitivo scoperto dai ricercatori può modificare efficacemente la concentrazione di drogaggio di tipo N e tipo P in un ampio intervallo ed è ampiamente utilizzato nella produzione pratica. Qui spieghiamo brevemente il principio dell'azoto (N) e dell'alluminio (Al) rispettivamente come elementi droganti di tipo N e di tipo P.
Durante la produzione di wafer epitassia, gli atomi di azoto (N) competono con gli atomi di carbonio (C) per le posizioni del reticolo. Per ridurre la concentrazione drogante di atomi di azoto (N), la concentrazione di atomi di carbonio (C) nella sorgente di gas epitassiale dovrebbe essere aumentata; al contrario, per ridurre la concentrazione di atomi di carbonio (C) nella sorgente di gas epitassiale, la concentrazione drogante di atomi di azoto (N) dovrebbe essere aumentata. Mentre gli atomi di alluminio (Al) competono con gli atomi di silicio (Si) per le posizioni del reticolo, è possibile aumentare la concentrazione di atomi di silicio (Si) nella sorgente di gas epitassiale per ridurre la concentrazione di drogaggio degli atomi di alluminio (Al); Al contrario, è possibile ridurre la concentrazione di atomi di silicio (Si) nella sorgente di gas epitassiale per aumentare la concentrazione di drogaggio degli atomi di alluminio (Al).
Nell'elaborazione dell'epitassia SiC, la fonte di gas comunemente utilizzata per le sorgenti di Si è SiCl4 o SiH4; La fonte di gas comunemente usata per la fonte C è CCl4 o C3H8. Possiamo controllare il rapporto di flusso dei due per controllare il rapporto componente C/Si, controllando così efficacemente la concentrazione drogante di diversi elementi.
Inoltre, la concentrazione di drogaggio dello strato epitassiale di SiC è correlata alla portata della sorgente di gas, alla pressione del gas e alla temperatura di crescita nel processo CVD. Prendi il drogaggio dell'azoto (N) come esempio per ulteriori spiegazioni. Il drogaggio con azoto (N) può essere ottenuto rapidamente introducendo azoto (N2) nella crescita epitassiale CVD. Dalla Fig.1, possiamo sapere che la concentrazione di drogaggio su entrambe le superfici Si e C è positivamente proporzionale alla portata di N2 entro quattro ordini di grandezza a un rapporto componente C/Si fisso. La concentrazione di drogaggio del processo di produzione di wafer epi SiC copre l'intervallo di drogaggio di E14-E18, che è più comunemente utilizzato nei dispositivi.

Fig. 1Relazione tra concentrazione di drogaggio di azoto (N) e portata di azoto (N2) nell'epitassia 4H-SiC a 1550 ℃
È stata studiata la relazione tra la pressione del gas e la concentrazione di drogaggio del processo di produzione di wafer Epi SiC in una cavità CVD. Come mostrato in Fig. 2, la relazione tra la concentrazione e la pressione dell'elemento N viene studiata nelle condizioni di temperatura epitassiale di 1600 ℃, rapporto C/Si di 3,5 e portata di azoto di 12 ml/min. Qualunque sia l'epitassia del piano C o del piano Si di 4H-SiC, la concentrazione di drogaggio della produzione di wafer epi semiconduttori aumenta con l'aumentare della pressione.

Figura 2Relazione tra concentrazione di elementi N e pressione del processo di produzione di wafer SiC Epi
3. Domande frequenti sull'epitassia SiC per dispositivi MOS
Q:Sulla base delle specifiche da te fornite, la struttura del wafer 4H-SiC è la seguente:
Epistrato 4H-SiC del 2° strato (concentrazione di drogaggio = 1 x 10^16 cm-3)/ Epistrato 4H-SiC del 1° strato (concentrazione del drogaggio = 1 x 10^18 cm-3)/ wafer 4H-SiC (resistività = 0,015-0,028 ohmcm-3)
Stiamo progettando di utilizzare questo wafer per la fabbricazione in un condensatore MOS ed eseguire misurazioni della tensione di capacità.
Di solito per wafer di silicio (resistività = 1-10 ohm), depositeremo uno strato di ossido di metallo sopra il wafer di silicio. Successivamente, depositeremo il contatto metallico superiore e il contatto metallico inferiore per ottenere la struttura Al/ossido di metallo/silicio/metallo (condensatore MOS) ed eseguire misure di tensione-capacità.
Sulla base della nostra precedente comprensione dell'utilizzo del wafer di silicio, non saremo in grado di ottenere la curva capacità-tensione se la resistività del wafer di silicio è di 0,005 ohm (che è nota come wafer di silicio di tipo n altamente drogato).
Vorremmo chiedere la vostra opinione se il wafer 4H-SiC proposto è adatto al nostro lavoro di ricerca in quanto la resistività del wafer 4H-SiC è considerata altamente drogata (0,015-0,028 ohmcm-3) e il 1° strato di 4H-SiC l'epistrato ha un'alta concentrazione di drogante di 10^18 cm-3.
In realtà, lo spessore dell'epistrato 4H-SiC non è molto cruciale per il nostro lavoro di ricerca, ma dobbiamo avere la concentrazione di drogaggio nell'intervallo da 5 x 10^15 a 5 x 10^16 cm-3. Hai qualche prodotto standard prodotto dalla tua azienda che sarà più economico rispetto al wafer personalizzato?
A:1) La concentrazione di drogaggio dello strato epitassiale SiC è compresa tra 5 × 10 ^ 15 e 5 × 10 ^ 16 cm-3, che può essere raggiunta nella tecnologia epitassiale.
2) Per la resistività compresa tra 0,8 e 0,1 ohmcm-3, se non è possibile ottenere la curva di tensione capacitiva a causa della bassa resistività, si suggerisce che la concentrazione epitassiale consideri la minore concentrazione di drogaggio (maggiore resistività).
Per ulteriori informazioni, si prega di contattarci e-mail avictorchan@powerwaywafer.com e powerwaymaterial@gmail.com.

