Hyung Koun Cho∗
Dipartimento di Ingegneria Metallurgica, Università Dong-A, Busan 604-714
Jeong Yong Lee
Dipartimento di Scienza e Ingegneria dei Materiali,
Korea Advanced Institute of Science and Technology, Daejon 305-701
Abbiamo studiato la formazione di fossette a forma di V in film di nitruro come InGaN/GaN e AlGaN/GaN cresciuti su substrato di zaffiro mediante microscopia elettronica a trasmissione. Il meccanismo di formazione della fossa dipende fortemente dalle composizioni di indio (In) e alluminio (Al) in InxGa1−xN e AlxGa1−xN strati, rispettivamente. Con l'aumento della composizione dell'indio, i pozzi a forma di V hanno avuto origine dal vertice delle dislocazioni di filettatura ai confini del disadattamento di impilamento indotti da errori di impilamento e dalla crescita dell'isola tridimensionale nella fase iniziale a causa del grande disadattamento del reticolo. Con l'aumento della composizione dell'alluminio, anche l'origine delle fosse variava dall'ondulazione superficiale dovuta alla deformazione elastica disadattata al vertice delle dislocazioni della filettatura.
Numeri PACS: 61.72.Ff, 68.55.Ln, 68.55.-a
Parole chiave: Pit, nitruro, TEM, AlGaN, InGaN
I. INTRODUZIONE
I semiconduttori a base di GaN wurtzite (GaN, InGaN e AlGaN) sono attualmente oggetto di enormi ricerche come materiali promettenti per dispositivi optoelettronici, ad alta temperatura e ad alta potenza a causa di alcune proprietà come l'ampio gap di banda diretto, l'elevata stabilità termica e la forte interatomica legami [1, 2]. Per InxGa1−xN e AlxGa1−xstrati di N cresciuti su GaN, un aumento delle composizioni di indio (In) e alluminio (Al) può inevitabilmente causare deformazioni disadattate nei film. Al di là di uno spessore critico, diversi difetti strutturali come dislocazioni disadattate, faglie di impilamento, fosse a forma di V, ecc., sono generati dal rilassamento plastico [3, 4]. Tuttavia, anche a spessori inferiori, il rilassamento elastico può essere indotto dalla formazione di isole, ondulazione superficiale, ecc., come osservato in InGaP/InAsP, In0.77Ga0.23As/InGaAs, SiGe/Si e così via [5-7 ].Inoltre, un aumento della composizione di In può causare la disomogeneità chimica dell'InxGa1−xN well layer a causa della scarsa miscibilità tra InN e GaN [8, 9].La bassa solubilità di In in GaN è stata calcolata essere inferiore al 6% a 800 ◦C utilizzando il modello di Stringfellow [10].Queste proprietà possono influenzare significativamente le proprietà ottiche e strutturali dei dispositivi [11, 12].
Recentemente, abbiamo riportato due modelli della formazione di fosse a forma di V in pozzi quantistici multipli (MQW) di InGaN/GaN con alta composizione di In [13]. Inoltre, l'indesiderabilità e l'effetto sulle proprietà di emissione di questi pozzi sono stati precedentemente dimostrati mediante microscopia elettronica a trasmissione (TEM), catodoluminescenza e fotoluminescenza [3, 14, 15]. Per la soppressione della formazione di pit, quindi, è necessaria una chiara comprensione dei meccanismi di formazione di pit e deve essere valutata in dettaglio la microstruttura delle fosse osservate in vari film di nitruro III cresciuti su substrato di zaffiro. In questo lavoro, abbiamo studiato la formazione di fossa originata da diverse fonti in eterostrutture InGaN/GaN e AlGaN/GaN con varie composizioni di In e Al utilizzando TEM.
II. SPERIMENTALE
Tutti i campioni sono stati coltivati su substrati di zaffiro c-plane con uno strato di nucleazione di GaN di 25 nm di spessore nominale mediante un reattore di deposizione da vapore chimico metallorganico orizzontale operante a bassa pressione. Trimetilgallio, trimetilindio, trimetilalluminio e ammoniaca sono stati usati come precursori di origine per Ga, In, Al e N, rispettivamente. Al fine di analizzare l'effetto della deformazione sul meccanismo di formazione di fossette nei nitruri III, sono stati coltivati strati spessi di InxGa1−xN (∼ 800 ˚A) a temperature comprese tra 830 ◦C (xIn = 35 %) a 880 ◦C (xIn = 10%) e strati spessi di AlxGa1−xN (1000 A) sono stati cresciuti a 1040 C dopo aver fatto crescere lo strato di GaN sottostante drogato con Si di 2 mm di spessore a 1080 C. Le composizioni In e Al nell'InxGa1−xN e AlxGa1−xGli N strati erano rispettivamente 10, 13, 19 e 35 % e 16, 25, 44 e 54 %.
Per caratterizzare la formazione di pit di III-nitruri, i campioni TEM sono stati preparati in sezione trasversale lungo l'asse della zona [11-20] utilizzando la lucidatura meccanica del treppiede seguita dalla fresatura con ioni Ar a bassa temperatura a 4,5 kV in un Gatan DuoMill 660 DIF con velocità di settore controllo. L'energia ionica è stata gradualmente ridotta durante le fasi finali del diradamento per ridurre al minimo il danno superficiale dei campioni. Le immagini in campo chiaro (BF) e le immagini TEM ad alta risoluzione (HRTEM) sono state registrate su un JEOL JEM-2000EX TEM a 200 kV e JEOL JEM-3010EX a 300 kV.
III. RISULTATI E DISCUSSIONE
Per studiare l'effetto della composizione di Al sulla formazione di fossette, micrografie TEM in campo chiaro a sezione trasversale dall'AlxGa1−xSono stati ottenuti N strati cresciuti con varie composizioni di Al sullo strato tampone di GaN come mostrato in Fig. 1. La composizione teorica critica di Al sulla formazione della dislocazione disadattata nel 1000 A AlxGa1−xLo strato di N cresciuto su strati di GaN è inferiore al 15% [16]. Non sono state rilevate fosse nell'AlxGa1−xN strati con una composizione di Al fino al 25%. Negli strati di AlGaN si osservano solo difetti di impilamento e crepe dovute alla deformazione disadattata e alla differenza del coefficiente termico, rispettivamente (non mostrato). Per l'Al0.44Ga0.56Campione di N/GaN, invece, la superficie dell'Al0.44Ga0.56Lo strato N mostra molte fosse che non sono associate a difetti strutturali come dislocazioni di filettature, difetti di impilamento e così via [Figg. 1(b) e (d)]. La dimensione di queste fosse è molto piccola, un diametro medio di 7 nm e un'altezza media di ∼3 nm, rispetto a quella delle fosse negli strati di InGaN cresciuti su GaN [13, 14, 16]. Si ritiene che la formazione di fosse in Al0.44Ga0.56N/GaN può essere attribuito all'ondulazione superficiale dall'aumento della deformazione elastica disadattata come osservato nei sistemi a semiconduttore III-V e II-VI [5, 6].
La densità della fossa è superiore a 1010 cm−2 in superficie. D'altra parte, le dislocazioni disadattate sono generate all'interfaccia dell'Al0.54Ga0.46Campione di N/GaN per rilassare plasticamente il ceppo disadattato immagazzinato come mostrato in Fig. 1 (c). Inoltre, si osservano fossette a forma di V associate a dislocazioni di filettatura sul fondo come eterostrutture InGaN/GaN. Queste fosse a forma di V hanno una piramide rovesciata esagonale aperta con pareti laterali [14, 16].
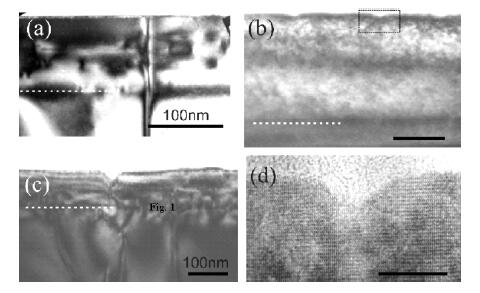
Fig. 1 Immagini TEM in campo chiaro in sezione trasversale usando g = 0002 dall'AlxGa1−xStrati di N cresciuti con la composizione di Al di (a) 16 %, (b) 44 % e (c) 54 %. (d) Immagine HRTEM ottenuta dal rettangolo tratteggiato in (b). Le linee tratteggiate indicano l'AlxGa1−xInterfaccia N/GaN.
Di conseguenza, abbiamo classificato l'origine della formazione del pozzo nell'AlxGa1−xN cresciuto sullo strato tampone GaN in due modelli come mostrato nelle Figg. 4(a) e (d). Per l'AlxGa1−xStrato N con una composizione ∼40% di Al, le fosse sono generate dall'ondulazione superficiale dovuta alla deformazione elastica disadattata immagazzinata [Fig. 4(d)]. Per l'AlxGa1−xStrato N con una composizione di Al superiore a ∼50%, tuttavia, le fosse sono generate principalmente al vertice delle dislocazioni della filettatura [Fig. 4(a)].
La figura 2 mostra le micrografie TEM in campo chiaro in sezione trasversale dall'InxGa1−xN strati cresciuti con varie composizioni di In sullo strato tampone GaN. La critica teorica In composizione sulla formazione della dislocazione disadattata del 800˚A InxGa1−xL'N cresciuto su strati di GaN è inferiore al 5%, al di sotto del quale gli strati di InGaN mostrano una crescita coerente [16]. Pertanto, ci aspettiamo la composizione In di tutti gli InxGa1−xN strati qui studiati per avere un valore maggiore della composizione In critica sulla formazione della dislocazione disadattata. Per In0.1Ga0.9N/GaN, all'interno dello strato In0.1Ga0.9N non sono stati osservati difetti strutturali come dislocazioni disadattate, difetti di impilamento, fossette, ecc. Con un ulteriore aumento della composizione In dell'InxGa1−xN strati (xIn = 13%), le fosse a forma di V sono generate per rilassare il ceppo disadattato immagazzinato, come riportato in precedenza [14]. È stato riportato che un pozzo a forma di V è sempre connesso con una dislocazione della filettatura dallo strato tampone di GaN nella parte inferiore e solo una piccola frazione delle dislocazioni della filettatura provoca la formazione delle fosse a forma di V negli strati di InGaN e i MQW InGaN/GaN [14]. Tuttavia, la densità delle fosse a forma di V nell'In0.19Ga0.81Lo strato N in Fig. 2(c) ha un valore maggiore della densità di dislocazione della filettatura nello strato tampone GaN, il che indica che la formazione di fosse a forma di V nell'InGaN con alta composizione di In ha un'origine diversa, come riportato in precedenza per i sistemi InGaN/GaN MQW [13]. Abbiamo riportato che nei MQW di InGaN/GaN con alta composizione di In (∼ 30 % di composizione), la maggior parte dei pit a forma di V sono generati da limiti di disadattamento di impilamento indotti da errori di impilamento [13]. Sebbene l'In0.19Ga0.81L'N/GaN qui utilizzato ha una composizione In inferiore al 20%, la parte di fosse a forma di V origina dall'impilamento dei limiti di disadattamento indotti da errori di impilamento dovuti all'aumento dello spessore dello strato di InGaN [Fig. 3(a)] rispetto all'InGaN/GaN MQW. Per In0.35Ga0.65N/GaN, fossette a forma di V con una densità superiore a 1010 cm−2 si osservano in superficie. A differenza dei box nell'In0.19Ga0.81Campione N/GaN, l'In0.35Ga0.65N regioni con superfici superiori piatte (0001) tra le fosse hanno un gran numero di faglie di impilamento e limiti di disadattamento di impilamento formati nella fase di crescita iniziale di InGaN [Fig. 3(b)], cioè strutture colonnari che includono faglie di accatastamento. Per rilassare il grande disallineamento del reticolo tra In0.35Ga0.65N e GaN, l'iniziale In0.35Ga0.65Lo strato N è stato cresciuto con la morfologia di isole sfaccettate tridimensionali (3D) [17]. Un'alta densità di faglie impilate è chiaramente visibile nelle isole e i confini tra i sottograni per isole sono visibili come la crescita di uno strato di nucleazione di GaN cresciuto su un substrato di zaffiro [18].
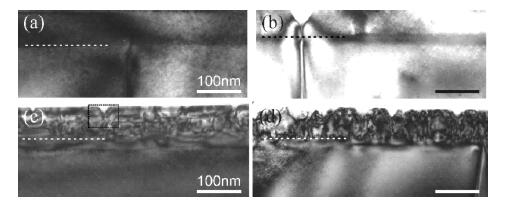
Fig. 2 Immagini TEM in campo chiaro in sezione trasversale usando g = 0002 dall'InxGa1−xStrati N cresciuti con la composizione In di (a) 10%, (b) 13%, (c) 19% e (d) 35% sullo strato tampone GaN. Le linee tratteggiate indicano InxGa1−xInterfaccia N/GaN.
Pertanto, pensiamo ai box in In0.35Ga0.65I campioni di N/GaN sono causati da una tale crescita 3D dovuta al disadattamento del reticolo alla crescita iniziale dello strato di InGaN.
Di conseguenza, abbiamo classificato l'origine della formazione di fosse nell'InxGa1-xN cresciuto sullo strato tampone GaN in tre modelli come mostrato in Fig. 4 (a), (b) e (c). Per l'InxGa1-xStrato N a basso contenuto di In, si generano fossette al vertice delle dislocazioni di filettatura [Fig. 4(a)]. Per l'InxGa1-xStrato N con mezzo Nella composizione, i pit sono principalmente generati dai confini del disadattamento di impilamento indotti da errori di impilamento [Fig. 4(b)]. Un ulteriore aumento della composizione In dell'InxGa1-xLo strato N determina la crescita dell'isola 3D nella fase iniziale e la formazione di fosse nella crescita continua [Fig. 4(c)].
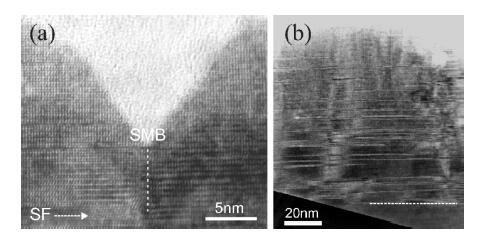
Fig. 3 (a) Immagine HRTEM ottenuta dal rettangolo tratteggiato in Fig. 2 (c). Il pozzo a forma di V osservato ha una faglia di accatastamento sui piani (0001) nella sua posizione inferiore. (b) Immagine HRTEM ottenuta dall'In0.35Ga0.65N sullo strato tampone GaN.
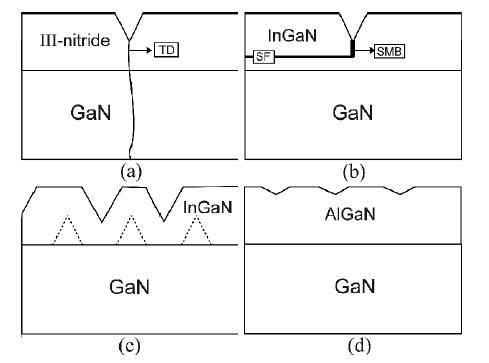
Fig. 4 Modelli schematici per la formazione di fosse relativi a (a) una dislocazione della filettatura osservata nelle eterostrutture InGaN/GaN e AlGaN/GaN, (b) un confine di disadattamento di impilamento indotto da faglie di impilamento e (c) la crescita dell'isola 3d nella fase iniziale osservato in un'eterostruttura di InGaN/GaN e (d) l'ondulazione superficiale dovuta alla deformazione elastica di disadattamento osservata in un'eterostruttura di AlGaN/GaN.
IV. RIEPILOGO
La formazione del pozzo in InxGa1-xN e AlxGa1-xGli strati N con varie composizioni di In e Al cresciuti sugli strati tampone di GaN sono stati studiati utilizzando TEM. Abbiamo scoperto che le fosse si sono formate da varie origini come dislocazioni di filettatura, accatastamento di limiti di disallineamento, crescita di isole 3D e ondulazione della superficie a seconda delle composizioni di In e Al.
RINGRAZIAMENTI
Questo lavoro è stato sostenuto da una sovvenzione n. R01-2002- 000-00096-0 della Korea Science & Engineering Foundation e dal programma di ricerca universitaria del Ministero dell'informazione e della comunicazione nella Repubblica di Corea.
RIFERIMENTI
[1] H. Morkoc, Nitride Semiconductors and Devices (Springer, Heidelberg, 1999).
[2] YS Park, J. coreano Phys. Soc. 34, S199 (1999).
[3] HK Cho, JY Lee, CS Kim, GM Yang, N. Sharma e CJ Humphreys, J. Cryst. Crescita 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim e GM Yang, J. Korean Phys. Soc. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard e RA Masut, J. Appl. Fis. 81, 3501 (1997).
[6] M. Mitsuhara, M. Ogasawara e H. Sugiura, J. Cryst. Crescita 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang e JJ Harris, Semicond. Sci. Tecnol. 15, 370 (2000).
[8] D. Doppalapudi, SN Basu, KF Ludwig, Jr. e TD Moustakas, J. Appl. Fis. 84, 1389 (1998).
[9] T. Takeuchi, H. Takeuchi, S. Sota, H. Sakai, H. Amano e I. Akasaki, Jpn. J. Appl. Fis. 36, L177 (1997).
[10] GB Stringfellow, J. Cryst. Crescita 58, 194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson e R. Stall, J. Cryst . Crescita 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Hong, E.-K. Suh, HJ Lee, HK Cho e JY Lee, J. Korean Phys. Soc. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang e CS Kim, appl. Fis. Lett. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars e JS Speck e SJ Rosner, Appl. Fis. Lett. 72, 692 (1998).
[15] G. Pozina, JP Bergman, B. Monemar, T. Takeuchi, H. Amano e I. Akasaki, J. Appl. Fis. 88, 2677 (2000).
[16] JW Matthews e AE Blakeslee, J. Cryst. Crescita 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, JZ Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts e SM Bedair, J. Electron. madre. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan e S. Mahajan, Appl. Fis. Lett. 77, 3391 (2000).
