窒素をドープした4HNタイプのSiCウェーハが利用可能で、サイズは2インチから4インチです。 ダミーウエハースとプライムウエハースがあります。 高品質の単結晶SiCウェーハは、MBE成長研究、エレクトロニクス、オプトエレクトロニクス産業で利用できます。 SiCウェーハは、独自の電気的特性と優れた熱的特性を備えた次世代の半導体材料です。 シリコンウェーハやGaAsウェーハと比較して、nドープ炭化ケイ素ウェーハ高温および高出力デバイスに適しています。
1.4HN型SiCウェーハの仕様
1.1 4H NタイプSIC、2インチウェーハ仕様
| 基板特性 | S4H-51-N-PWAM-250 S4H-51-N-PWAM-330 S4H-51-N-PWAM-430 |
| 説明 | A/B生産グレードC/D研究グレードDダミーグレード4HSiC基板 |
| ポリタイプ | 4H |
| 直径 | (50.8±0.38)mmで |
| 厚さ | (250±25)μm(330±25)μm(430±25)μm |
| キャリアタイプ | n型 |
| ドーパント | 窒素 |
| 比抵抗(RT) | A / B:0.012 –0.028Ω・cm; C:0.012–0.1Ω・cm; D:0.02–0.3Ω・cm |
| 表面粗さ | <0.5 nm(Si-face CMP Epi-ready); <1 nm(C面光学研磨) |
| FWHM | A <30アーク秒B / C / D <50アーク秒 |
| マイクロパイプ密度 | A+≤1cm-2A≤10cm-2B≤30cm-2C≤50cm-2D≤100cm-2 |
| 面方位 | |
| 軸上 | <0001>±0.5° |
| 軸オフ | 0.5°±<11-20>に向かって4度または8° |
| プライマリオリエンテーションフラット | 平行{1-100}±5° |
| プライマリフラット長 | (16±1.7)mm |
| 二次オリエンテーションフラット | Si面:90°cw。 オリエンテーションフラットから±5° |
| C面:90°反時計回り。 オリエンテーションフラットから±5° | |
| セカンダリフラット長 | (8±1.7)mm |
| 表面仕上げ | シングルまたはダブルフェース研磨 |
| パッケージング | シングルウェーハボックスまたはマルチウェーハボックス |
| 使用可能な領域 | A:≥90%; B:≥85%; C:≥80%; D:≥70% |
| エッジ除外 | 1ミリメートル |
1.24H-SICウェーハ、Nタイプ、3インチウェーハ仕様
| 基板特性 | S4H-76-N-PWAM-330 S4H-76-N-PWAM-430 |
| 説明 | A/B生産グレードC/D研究グレードDダミーグレード4HSiC基板 |
| ポリタイプ | 4H |
| 直径 | (76.2±0.38)mmで |
| 厚さ | (350±25)μm(430±25)μm |
| キャリアタイプ | n型 |
| ドーパント | 窒素 |
| 比抵抗(RT) | 0.015 - 0.028Ω・cmで |
| 表面粗さ | <0.5 nm(Si-face CMP Epi-ready); <1 nm(C面光学研磨) |
| FWHM | A <30アーク秒B / C / D <50アーク秒 |
| マイクロパイプ密度 | A+≤1cm-2A≤10cm-2B≤30cm-2C≤50cm-2D≤100cm-2 |
| TTV /ボウ/ワープ | <25μmで |
| 面方位 | |
| 軸上 | <0001>±0.5° |
| 軸オフ | 0.5°±<11-20>に向かって4度または8° |
| プライマリオリエンテーションフラット | 5.0°±<11-20> |
| プライマリフラット長 | ±3.17ミリメートル22.22ミリメートル 0.875″±0.125″ |
| 二次オリエンテーションフラット | Si面:90°cw。 オリエンテーションフラットから±5° |
| C面:90°反時計回り。 オリエンテーションフラットから±5° | |
| セカンダリフラット長 | 11.00±1.70ミリメートル |
| 表面仕上げ | シングルまたはダブルフェース研磨 |
| パッケージング | シングルウェーハボックスまたはマルチウェーハボックス |
| スクラッチ | なし |
| 使用可能な領域 | ≥90% |
| エッジ除外 | 2ミリメートル |
1.34HNタイプSIC4インチウェーハ仕様
| 基板特性 | S4H-76-N-PWAM-330 S4H-76-N-PWAM-430 |
| 説明 | A/B生産グレードC/D研究グレードDダミーグレード4HSiC基板 |
| ポリタイプ | 4H |
| 直径 | (76.2±0.38)mmで |
| 厚さ | (350±25)μm(430±25)μm |
| キャリアタイプ | n型 |
| ドーパント | 窒素 |
| 比抵抗(RT) | 0.015 - 0.028Ω・cmで |
| 表面粗さ | <0.5 nm(Si-face CMP Epi-ready); <1 nm(C面光学研磨) |
| FWHM | A <30アーク秒B / C / D <50アーク秒 |
| マイクロパイプ密度 | A+≤1cm-2A≤10cm-2B≤30cm-2C≤50cm-2D≤100cm-2 |
| TTV /ボウ/ワープ | <の45μm |
| 面方位 | |
| 軸上 | <0001>±0.5° |
| 軸オフ | 0.5°±<11-20>に向かって4度または8° |
| プライマリオリエンテーションフラット | 5.0°±<11-20> |
| プライマリフラット長 | ±2.00ミリメートル32.50ミリメートル |
| 二次オリエンテーションフラット | Si面:90°cw。 オリエンテーションフラットから±5° |
| C面:90°反時計回り。 オリエンテーションフラットから±5° | |
| セカンダリフラット長 | 18.00±2.00ミリメートル |
| 表面仕上げ | シングルまたはダブルフェース研磨 |
| パッケージング | シングルウェーハボックスまたはマルチウェーハボックス |
| スクラッチ | なし |
| 使用可能な領域 | ≥90% |
| エッジ除外 | 2ミリメートル |
PAM-XIAMENは、次の仕様も提供できます。
4H NタイプSiC基板、5mm * 5mm、10mm * 10mmウェーハ仕様:厚さ:330μm/430μm
4H N型SiC薄膜、15mm * 15mm、20mm * 20mmウェーハ仕様:厚さ:330μm/430μm
a面SiCウェーハ、サイズ:40mm * 10mm、30mm * 10mm、20mm * 10mm、10mm * 10mm、以下の仕様:
4H NタイプSiCウェーハ厚さ:330μm/430μmまたはカスタム
2.4H-SiCの特性について
2.14H-SiCプロパティVS. 6H-SiCプロパティ
| ポリタイプ | 単結晶4H | 単結晶6H |
| 格子パラメータ | = 3.076Å | = 3.073Å |
| C = 10.053Å | C = 15.117Å | |
| スタッキングシーケンス | ABCB | ABCACB |
| バンドギャップ | 3.26 eVの | 3.03 eVの |
| 密度 | 3.21・103 kg / m3 | 3.21・103 kg / m3 |
| サーム。 膨張係数 | 4~5×10 -6 / K | 4~5×10 -6 / K |
| 屈折率 | なし= 2.719 | なし= 2.707 |
| NE = 2.777 | NE = 2.755 | |
| 誘電率 | 9.6 | 9.66 |
| 熱伝導率 | 490 W / mKで | 490 W / mKで |
| ブレークダウン電界 | 2〜4・108 V / m | 2〜4・108 V / m |
| 飽和ドリフト速度 | 2.0・105 m / s | 2.0・105 m / s |
| 電子移動度 | 800cm2 / V・S | 400cm2 / V・S |
| 正孔移動度 | 115cm2 / V・S | 90cm2 / V・S |
| モース硬度 | ~9 | ~9 |
2.24HN型SiCウェーハの光学特性
4H SiCの屈折率は、波長の増加とともに減少します。
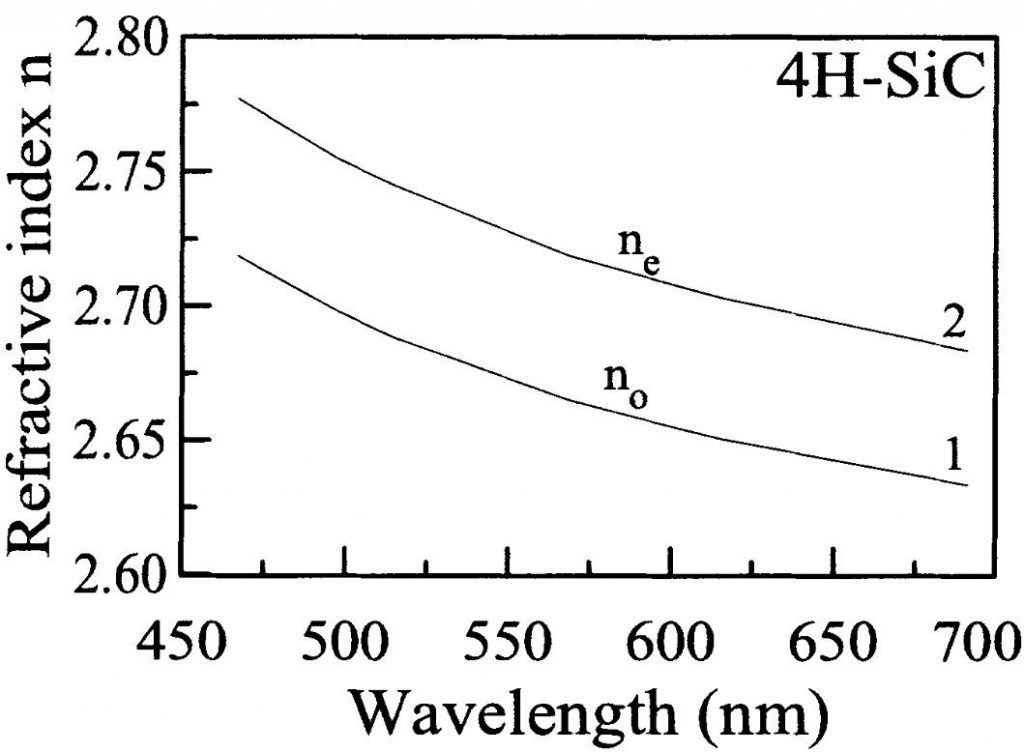
温度が上昇すると、4HSiCバンドギャップは減少します。

2.34HSiCサブスタートの熱特性
4HSiCの熱伝導率は温度とともに変化します。 温度が低い(約40℃)と、4HN型SiCウェーハの熱伝導率が上昇します。 ただし、気温が40℃を超えると、ゆっくりと下がり始めます。

詳細については、メールでお問い合わせください。 victorchan@powerwaywafer.com と powerwaymaterial@gmail.com.

