抽象
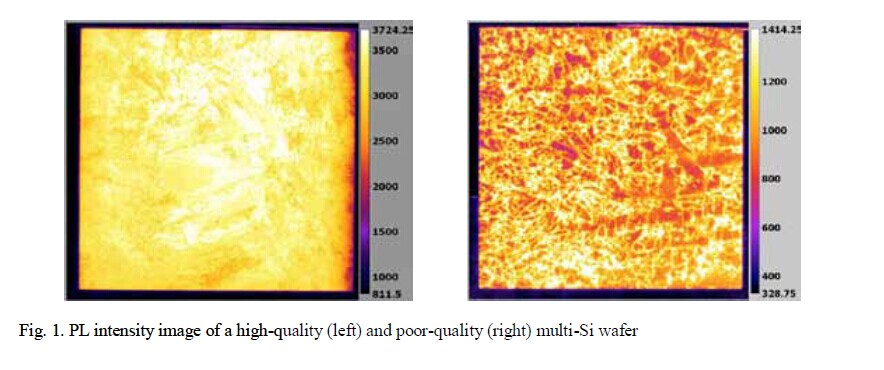



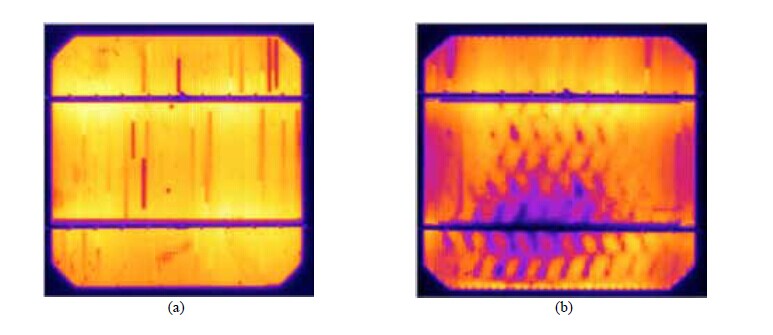
.jpg)

抽象
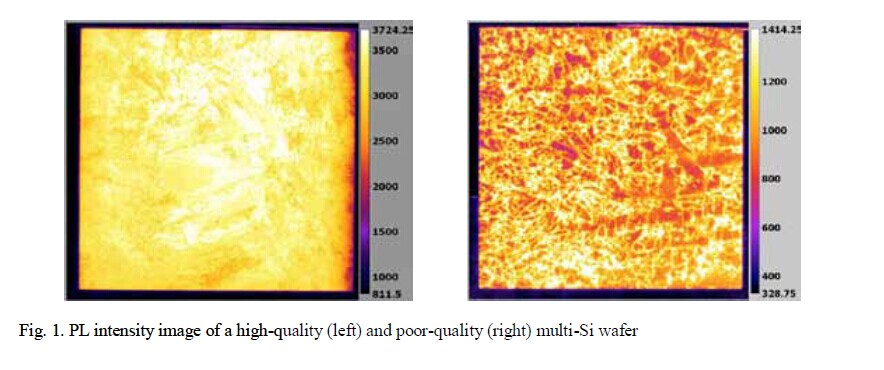



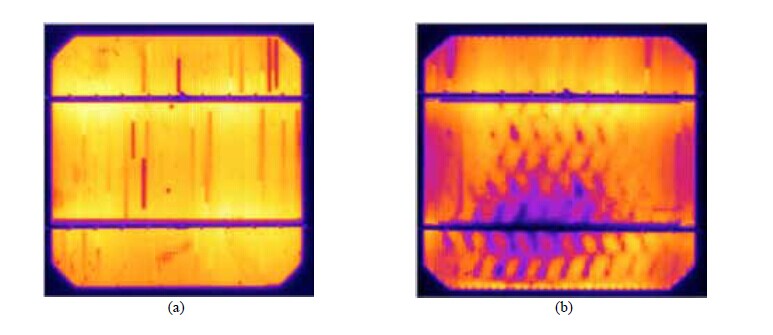
.jpg)

PAM XIAMEN offers 3″FZ Prime Silicon Wafer Thickness: 350±15um. 3″ Si epi-ready wafer Si wafer FZ Diameter: 76mm Thickness: 350±15um Dopant: P Orientation: (100) Resistivity: 500-1000 Ohm*cm Double side polished, epi-ready laser mark with numbering from N1k- 001 to NN1k- 200 for alll 200pcs [...]
PAM XIAMEN offers GaAs(100) Si- doped crystal . GaAs – Growing Method: VGF (100) Si doped, N-type, 2″ dia x 0.35mm, 2sp,cc: (1.07-3.89) x 10^18 /cm^3 GaAs – Growing Method: VGF (100) Si doped, N-type, 2″ dia x 0.35mm, 1sp,cc: (1.65-3.59) x 10^18 /cm^3 [...]
Compared to 4H-SiC, although the bandgap of 3C silicon carbide (3C SiC) is lower, its carrier mobility, thermal conductivity, and mechanical properties are better than those of 4H-SiC. Moreover, the defect density at the interface between the insulating oxide gate and 3C-SiC is lower, which is [...]
PAM XIAMEN offers 3″ Silicon EPI Wafers. Substrate EPI Comment Size Type Res Ωcm Surf. Thick μm Type Res Ωcm 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 90 n- Si:P 41±10% n/n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 18 n- Si:P 5±10% n/n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 96 n- Si:P 30±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 100 n- Si:P 21±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 100 n- Si:P 16 ±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 100 n- Si:P 12±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 100 n- Si:P 20±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 135 n- Si:P 35±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 140 n- Si:P 31±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 145 n- Si:P 38±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 145 n- Si:P 25±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 150 n- Si:P 44±10% n/n+ 3″Øx508μm n- Si:As[111] 0.001-0.005 P/E 158 n- Si:P 67±10% n/n+ 3″Øx381μm n- Si:Sb[111] 0.005-0.020 P/E 8 n- Si:P 0.63±10% n/n+ 3″Øx381μm n- Si:Sb[111] 0.005-0.020 P/E 22.5 n- Si:P 0.07±10% n/n+ 3″Øx381μm n- Si:Sb[111] 0.005-0.020 P/E 30 n- Si:P 6.75±10% n/n+ 3″Øx330μm n- Si:Sb[111] 0.005-0.018 P/E 75 n- Si:P 40±10% n/n/n+ 3″Øx330μm n- Si:Sb[111] 0.005-0.018 P/E 25 n- Si:P 2.5±10% n/n/n+ For [...]
炭化ケイ素 (SiC) 材料は、バンドギャップ幅や臨界破壊電界強度などの重要な特性において大きな利点があり、高電圧ショットキー ダイオードの製造に使用できます。 現在、650V ~ 1700V の SiC ショットキー ダイオードは、民生、産業、自動車などの分野で広く使用されています。 ショットキー [...]
PAM XIAMEN offers (100) orientation Silicon Substrates. Below is just a small selection. Let us know if you can use or if we can quote you on another spec. Item Material Orient. Diam (mm) Thck (μm) Surf. Resistivity Ωcm Comment PAM2841 Intrinsic Si:- [100] 4″ 300 P/E FZ 16,000-20,000 SEMI Prime, 1Flat, Empak cst, Back-side polish is imperfect PAM2842 Intrinsic Si:- [100] 4″ 500 P/E FZ 13,000-20,000 SEMI Prime, 1Flat, Empak cst, TTV<5μm, [...]
| クッキー | デュレーション | 説明 |
|---|---|---|
| cookielawinfo-チェックボックス分析 | 11ヶ月 | この Cookie は、GDPR Cookie Consent プラグインによって設定されます。 Cookie は、「分析」カテゴリの Cookie に対するユーザーの同意を保存するために使用されます。 |
| cookielawinfo-チェックボックス-機能的 | 11ヶ月 | Cookie は、GDPR Cookie の同意によって設定され、カテゴリ「機能」の Cookie に対するユーザーの同意を記録します。 |
| cookielawinfo-チェックボックス-必要 | 11ヶ月 | この Cookie は、GDPR Cookie Consent プラグインによって設定されます。 Cookie は、Cookie に対するユーザーの同意を「必要」カテゴリに保存するために使用されます。 |
| cookielawinfo-チェックボックス-その他 | 11ヶ月 | この Cookie は、GDPR Cookie Consent プラグインによって設定されます。 Cookie は、カテゴリ「その他」の Cookie に対するユーザーの同意を保存するために使用されます。 |
| cookielawinfo-チェックボックス-パフォーマンス | 11ヶ月 | この Cookie は、GDPR Cookie Consent プラグインによって設定されます。 Cookie は、「パフォーマンス」カテゴリの Cookie に対するユーザーの同意を保存するために使用されます。 |
| 閲覧済み_cookie_policy | 11ヶ月 | Cookie は GDPR Cookie Consent プラグインによって設定され、ユーザーが Cookie の使用に同意したかどうかを保存するために使用されます。 個人データは一切保存されません。 |
