継続的な努力を通じて、PAM-XIAMENは大規模なCOPフリーを開発しましたCZシリコン(Si)ウェーハ、結晶引っ張りの熱場を改善することにより、インゴット内のCOPの発生を効果的に制御し、性能の向上と消費電力の削減を実現します。 8インチのシリコンウェーハの塗布プロセスは大きいため、COPの影響を受けません。 12インチのシリコンウェーハの塗布プロセスはより小さく、結晶品質により敏感です。 一般的に、40nm未満のプロセスでは結晶品質に対する要件が高くなるため、COPフリーの需要が高まります。 販売中のCOPフリーウェーハの仕様は以下のとおりです。

1.COPフリーウェーハデータシート
| Types of COP Free Wafer | Polished | Annealed | エピタキシー |
| 直径 | 8” & 12” | 12” | 8” & 12” |
| Orientation | (100), (110) or (111) | ||
| Conduction Type | N & P | ||
2. CZ-SiウェーハのCOPとは何ですか?
COP(結晶由来の粒子/ピット)は、シリコン単結晶の主要な欠陥です。 この欠陥は、シリコンウェーハをSC-1(NH4OH:H2O2:H2O-1:1 5)溶液で85°Cで4時間ボイルポリッシングした後に明らかになった格子欠陥です。 シリコンウェーハをSC-1溶液で処理した後、シリコンウェーハの表面層を150nmエッチングして除去した。 COP欠陥の密度は、レーザースキャニングパーティクルカウンターで検出できます。
図1に示すように、COP欠陥は八面体のマイクロボイドであり、COPのサイズは0.12〜0.30umです。 COP欠陥のエッチピットは、一般に2つのカテゴリに分類できます。1つはモノタイプ、もう1つはバイタイプです。
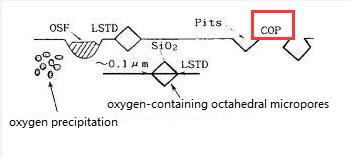
図1COP欠陥の概略図
3. CZウェーハにCOP欠陥があるのはなぜですか?
一次欠陥COPの形成は、酸素析出の形成と密接に関連しています。 理由は次のとおりです。
(1)CZシリコンの大きな一次欠陥は、無酸素FZシリコンでは見つかりませんでした。
(2)マイクロボイドの自由エネルギーの計算に基づいて、マイクロボイドは裸の空孔から均一に形成できないことが証明されています。
(3)CZシリコンの成長中、かなり広い温度範囲で、酸素が過飽和になり、沈殿します。 TEMのエネルギー分散型X線スペクトルを使用して、COP欠陥の元素分析を行うことができ、一部のCOP欠陥には酸素が含まれていることがわかります。 これは、ボイド形成のメカニズムが酸素の沈殿にも関係していることを示しています。
また、COP欠陥の成長速度は900〜1100°Cの範囲で最も速いため、この温度範囲で費やされた時間がCOP欠陥の成長のサイズを決定します。 この温度領域を急速に通過することで、COP欠陥の成長を効果的に防ぐことができます。 ただし、単結晶は特定の引張速度範囲内で成長する傾向があるため、たとえば、高濃度にドープされたSbの引張速度は、一般に0.6〜1.2 mm/minです。 また、900〜1100°Cの一般的な熱場温度範囲はより広いため、COP欠陥サイズは単結晶の成長プロセス全体で成長することになります。 COP欠陥のサイズは、その後のウェーハ処理の洗浄時間にも影響されます。 SC1で5〜6回洗浄した後、COP欠陥の数とサイズは指数関数的に増加します。
4.結晶由来のピットフリーウェーハを入手するにはどうすればよいですか?
COPを排除または減少させてCOPを含まない基質を得るには、多くの研究文献があります。これは次のように要約できます。
(1)窒素ドープシリコン単結晶を生成します。
(2)表面COP欠陥を排除するための水素またはアルゴンアニーリング。
(3)熱場勾配の縦方向の温度を調整し、COP欠陥密度を減らし、COP欠陥サイズを縮小します。
いくつかの研究は、ドーパントホウ素の濃度が臨界値を超えると、COPの生成が効果的に抑制され、COPフリーの結晶ウェーハが得られることを指摘しています。 この臨界値のサイズは、インゴットの直径に関連しています。 たとえば、200mmのシリコンインゴットの場合、臨界値は4.8×10です。18 原子/cm3; 150mmインゴットの場合、6.3×10です。18 原子/cm3.
研究によると、水素およびアルゴン雰囲気での高温アニーリングは、シリコンウェーハの表面のホールタイプの微小欠陥(COPなど)を効果的に低減し、それによってMOSデバイスアプリケーションのGOIを向上させることができます。 シリコンウェーハの表面(COPの表面を含む)は天然酸化物の層で覆われているため、シリコンウェーハが高温に加熱されている限り、水素雰囲気またはアルゴン雰囲気を使用するかどうかにかかわらず、高温下で約1200°Cの場合、ウェーハ表面の天然酸化物層は熱的に不安定になり、解離して追加のシリコン原子を生成します。 これらの余分なシリコン原子はCOPの位置を埋めるので、これらのホールタイプの微小欠陥は徐々に小さくなり、さらには消えて、シリコンCOPフリーウェーハまたは低COPSiウェーハが得られます。
詳細については、メールでお問い合わせください。 victorchan@powerwaywafer.com と powerwaymaterial@gmail.com.

