GaAsSb / InGaAs / InPヘテロ構造は、光学センサー製造用のエピ構造MBE栽培者PAM-XIAMENによって提供されます。 ガリウムヒ素アンチモニド(GaAsSb)の格子定数は、 InP基板、したがって、良好な均一性を備えたInP基板上でのエピタキシャル成長が容易です。 タイプIIInGaAs / GaAsSb超格子検出器の応答波長は、超格子内の各材料の層の厚さと構造を変更することで調整できます。 GaAsSb / InGaAs超格子は、新しいタイプの短波赤外線検出器に適した材料システムです。 PAM-XIAMENの仕様は次のとおりです。
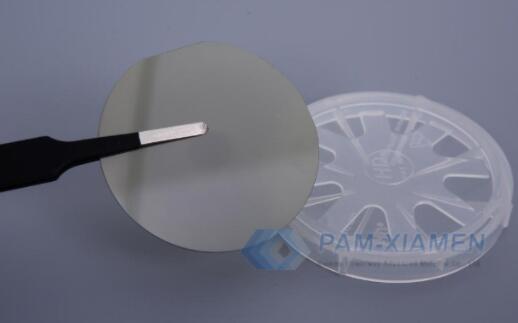
1.InP基板上のGaAsSb / InGaAs超格子の仕様
PAM161124 – SLS
| 層 | 組成 | 厚さ | 期間 | キャリア濃度 | ドーパント |
| キャップレイヤー | InGaAsまたはInAlAs | – | 1 | – | ドープされる |
| Pレイヤー | SL-GaAsSb / InGaAs | – | – | – | ドープされる |
| i-アクティブ | SL-GaAsSb / InGaAs | – | – | – | – |
| nレイヤー | SL-GaAsSb / InGaAs | – | 50 | – | Siドープ |
| バッファー | InGaAs | 50nm | – | – | Siドープ |
| ボトム | InGaAsまたはInAlAs | – | – | n = 1E18 | Siドープ |
| 基板 | InP(100) | 350um | – | – | Siドープ |
2. GaAsSb / InPエピタキシャルウェーハの製造
意図しないInGaAsはn型であり、MBE技術用のi-InGaAsのバックグラウンド濃度はMOCVDよりもはるかに低くなっています。 私たちの技術は7-9E14cmに達することができます3。 より低いキャリア濃度が必要な場合は、Beをドーピングすることでi-InGaAsを補償します。
意図しないGaAsSbはp型であり、MBE技術のi-InGaAsのバックグラウンド濃度はほぼ1-5E15cmです。3、これはMOCVDよりもはるかに低いです。 また、Siをドープすることでバックグラウンド濃度を下げるのは簡単です。
i-InGaAs層は、濃度が1〜5E15cmのわずかなp型にすることができます。3 Beをドーピングすることによって。 通常、InPベースのマイクロ波デバイスの場合、バッファ層には200nm InAlAsしか成長せず、転位、欠陥、汚れ、表面粗さなどを排除するのに十分です。したがって、バッファ層には500nm InGaAsで十分であり、EPD <を提供します。あなたのための500InP基板。 EPIウェーハの厚さは、特に三元合金で4.5umを超えています。 それを成長させるには優れたスキルが必要です。
上記仕様のオーミック接触に関しては、p型InGaAsのオーミック接触がp型InAlAsよりも優れています。 また、金属化にはTi / Pt / Au金属が最適です。 さらに、n型InGaAsのオーミック接触はn型InAlAsよりも優れています。 AuGeNi / Au金属は、n-GaAsオーミックコンタクトと同様に、メタライゼーションに最適です。 p型InGaAsとの良好なオーミック接触のために、メサエッチングは層の中央で多かれ少なかれ停止する必要があります。 InGaAs層をできるだけ厚くすることができます。
3. InGaAs / GaAsSbエピ層の特性に及ぼすBeドーピングの影響
光起電力検出器の吸収領域のキャリア濃度と検出器の性能の間には直接的な関係があります。 吸収領域のキャリア濃度は、少数キャリアの寿命と拡散長を決定するため、検出器の量子効率と検出率に影響を与えます。 InGaAs / GaAsSb II型超格子検出器では、吸収領域として超格子を使用し、固有超格子のバックグラウンドキャリアはn型導電性であるため、検出器の少数キャリアは正孔であり、正孔の拡散。 長さは電子の拡散長よりも短いです。 吸収領域の少数キャリアが電子である場合、少数キャリアの拡散長を長くすることができます。 したがって、超格子材料を補償するためにp型Beを使用し、異なるBeドーピング温度とInGaAs / GaAsSb量子井戸の特性との関係を研究しました。 超格子のドーピング濃度はBe温度に敏感であることがわかった。
詳細については、メールでお問い合わせください。 victorchan@powerwaywafer.com と powerwaymaterial@gmail.com.

