エピタキシャル GaNテンプレート Al2O3(サファイア)基板上に成長し、カスタマイズ可能なスタックが高品質で低欠陥密度で利用できます。 添付されているのは、当社が製造したさまざまな厚さ、キャリアタイプ、およびキャッピング層を備えたサファイア基板ウェーハ上のいくつかのタイプのGaN薄膜のリストです。
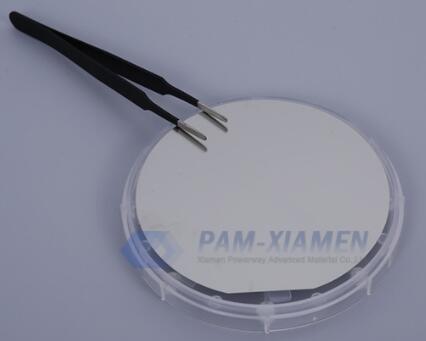
1.GaN薄膜エピタキシーPAM160107-GANの仕様
No.1サファイア基板上のエピタキシャルGaN
| 層 | 材料 | 厚さ | ドーピング |
| 2 | GaN系 | 5 µm | – |
| 1 | Cドープ-GaNバッファ | – | 5E18-1E19 |
| サファイア基板 |
備考:厚さの許容誤差は4um +/- 1umであり、キャリア濃度は3E17未満である必要があります(ドープされていないため、ドーピング濃度ではありません)。 キャリア濃度を10未満にしたい場合16、それは可能ですが、生産を調整する必要があり、コストが高くなります。
No.2Al2O3基板上のエピタキシャルGaN
| 層 | 材料 | 厚さ | ドーピング |
| 2 | GaN系 | – | n- <1017cm-3 |
| 1 | U-GaNバッファー | 1〜2 µm | – |
| サファイア基板 |
備考:通常のキャリア濃度は(5-8)E16(ドーピング濃度ではない)である必要があります。 また、キャリア濃度を変更することはできません。
サファイア上のNo.3GaNエピ層
| 層 | 材料 | 厚さ | ドーピング |
| 4 | GaN系 | – | p + 1019CM-3マグネシウム |
| 3 | GaN系 | 5 µm | – |
| 2 | GaN系 | – | N + 1019CM-3 |
| 1 | U-GaNバッファー | 1〜2 µm | – |
| サファイア基板 |
No.4サファイア上の単結晶GaN
| 層 | 材料 | 厚さ | ドーピング |
| 3 | GaN系 | – | n- <1016CM-3 |
| 2 | GaN系 | 1 µm | – |
| 1 | U-GaNバッファー | 1〜2 µm | – |
| サファイア基板 |
No.5サファイア上のGaN薄膜
| 層 | 材料 | 厚さ | ドーピング |
| 4 | AlNの | – | UID |
| 3 | GaN系 | – | n- <1016CM-3 |
| 2 | GaN系 | 1 µm | – |
| 1 | U-GaNバッファー | 1〜2 µm | – |
| サファイア基板 |
No.6サファイアベースのGaNテンプレート
| 層 | 材料 | 厚さ | ドーピング |
| 3 | AlNの | – | UID |
| 2 | GaN系 | 0.250 µm | – |
| 1 | Cドープ-GaNバッファ | 1〜2 µm | 5E18-1E19 |
| サファイア基板 |
備考:No.3からNo.6までのGaNテンプレートウェーハでは、10E16cm未満のキャリア密度を達成できます。-3 特定の異なるレイヤーで。
サファイア基板上に成長したNo.7窒化ガリウム薄膜
| 層 | 材料 | 厚さ | ドーピング |
| 4 | GaN系 | – | p + 1019CM-3マグネシウム |
| 3 | GaN系 | 10 µm | – |
| 2 | GaN系 | – | N + 1019CM-3 |
| 1 | U-GaNバッファー | 1〜2 µm | – |
| サファイア基板 |
2.Al2O3上にGaN膜を成長させるためのバッファ層
すべてのGaNエピタキシーウェーハには1〜2μmのバッファ層が必要ですか? たとえば、ウェーハNo.6:100A AlNキャップと0.25um GaNの場合、これは1〜2 umのバッファ層の上に直接セットされますか? GaN /サファイアウェーハはすべて11〜2umのバッファ層を必要とします。正確なものはNo.6である必要があります:100AAlNキャップ/0.25umGaN/バッファ層-GaN /サファイア。 GaNとサファイア基板の間の格子不整合の問題のため、これらすべてのGaN薄膜基板ウェーハにはバッファ層が必要です。
3.GaN膜成長のための活性化アニーリングの方法
たとえば、p型GaN薄膜の活性化アニーリングを考えてみましょう。成長後の活性化アニーリングはp型GaNでは実行されません。RTAを介して830度で10分間アニーリングしてアクティブにすることができます。 そしてMgのドーピング濃度は2E19cmです3。 活性化後のキャリア濃度は4.4E17になります。 具体的には:
Mg活性化のためのRTAの周囲では、成長したGaN薄膜を高純度のN2 / O2ガス混合物でアニールし、N2:O2流量比の活性化は4:1、総量5slm(標準リットル/分)です。 アニーリング温度は830度、時間は10分です。 このプロセスは、チューブタイプの焼きなまし炉ではなく、急速加熱焼きなまし炉で行われます。
活性化後の単結晶GaN膜の自由キャリア濃度は、金属接点で5 * 5mmを切断するホール効果によって測定できます。
4. サファイア上のGaN薄膜に関するFAQ
Q1:サファイアテンプレート上の GaN のドーピング (n 型) 濃度と、達成可能な可視光透過率はどれくらいですか?
>5×10は可能ですか?17/CM3 可視光線透過率80%以上?
:サファイア上のn型GaNテンプレートのドーピング濃度は>1E20ですが、透過率は以下であり、片面研磨では、両面研磨の場合はさらに良くなります。
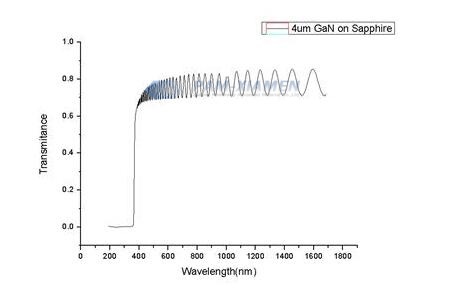
サファイア上のN型GaNの透過率
Q2:私たちは以前、以下のようにこれらの Ga 極性 GaN テンプレートを購入しました。 基板上の平面に対する GaN 結晶の方向を教えていただけないでしょうか。 GaNの平面はa方向ですか、それともm方向ですか?
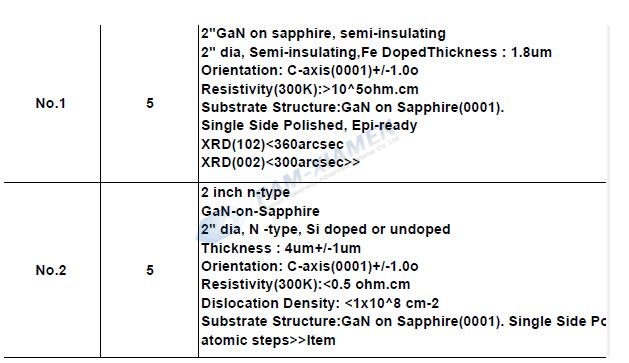
あ:No.1 GaN on Sapphire テンプレートでは、平面方向は A 面、16mm です。
サファイア上の No.2 GaN テンプレートでは、フラットな配向は M 面、16mm です。以下を参照してください。
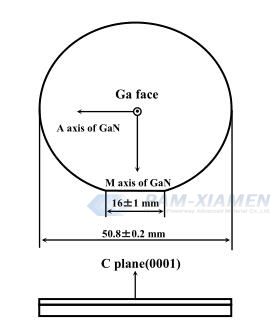
サファイア基板上の平面に対するGaN結晶の方向
Q3:現在、達成可能なサファイア上の GaN 薄膜の最大厚さは 15 um ですか?
:はい、サファイア上に成長した厚さ 15um の GaN エピ層はより安全です。
詳細については、メールでお問い合わせください。 victorchan@powerwaywafer.com と powerwaymaterial@gmail.com.

