SiCウェーハとGaNウェーハの応用分野は、主に電力分野、無線周波数分野、オプトエレクトロニクス分野、その他の分野に分けられます。 その中でも、電力視野と高周波視野が最も重要な用途であり、SiC材料を使用する利点は明らかです。 これらの2つの分野は以前に紹介されており、オプトエレクトロニクスデバイス用のGaNとSiCの半導体ウェーハ製造技術については次のパートで説明します。
1. の観点からの半導体ウェーハ製造 発光
まず、半導体ウェーハの製造工程を発光から始めましょう。 半導体にはバンドギャップがあり、レーザー光を放射するために使用できます。
実用的なレーザーには、ポンプ源、作動物質、共振空洞の3つの要素があります。 ポンプ源は電源のようなもので、レーザー光を放出するために作動材料にエネルギーを与えます。 共振空洞により、レーザーを重ね合わせてより高い出力の光を得ることができます。 しかし、核となるのは、反転分布構造を実現できるエネルギーレベルである作業材料です。
レーザーは誘導放出の一種であるため、反転分布を実現できる必要があります。 半導体ウェーハの処理ステップには、他にも遷移プロセスがあります。 誘導放出のプロセスが十分である場合にのみ、レーザーを表示できます。 その他のプロセスには、自然放出、緩和、その他のプロセスが含まれます。
反転分布を実現するために、一般的なエネルギー準位構造は3レベル構造です。 したがって、エネルギーレベル間のさまざまなプロセスを制御できます。
たとえば、レーザーの実現。 電子は、ポンプ源を介して低エネルギーレベルから高エネルギーレベルにポンプで送られます。 電子は高エネルギーレベルで不安定であり、電子は比較的安定した中間エネルギーレベルを追加することによって中間エネルギーレベルで停止します。 十分な電子があるとき、光は非常に強くなります。 共振空洞の作用下で、それは連続的に増幅されます。これは、誘導放出によって増幅された光です-レーザー。
2.ケース分析半導体ウェーハ 製作 上の 光電子デバイス
1300nm(1.3um)のレーザー出力を達成するために、半導体レーザーが作られました。 半導体ウェーハの製造方法では、必要なレーザーを0.954eV InAsで出力し、エネルギー変化を電気エネルギーに変換してGaAsにし、出力レーザー、最後にInAs出力レーザーに変換します。
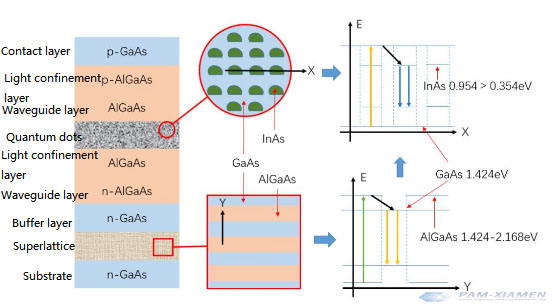
GaAs半導体ウェーハ製造プロセス全体(上の図)、最初は基礎となる構造です。
GaAsとAlGaAsは交互に配置され、超格子になるのに十分な薄さです。 Al元素の導入により、GaAsのエネルギー準位を1.424eVから2.168eVに調整することができ、対応する高エネルギー準位を得ることができます。 GaAsは、ポンプレーザーを出力するための中間エネルギーレベルとして使用されます。 電気の作用下で、電子は継続的にAlGaAsの高エネルギーレベルに励起され、次にGaAsの中間エネルギーレベルからジャンプダウンします。
次に、それは上部構造です:
レーザーの出力は、InAsのサイズをナノメートルレベルに準備することで得られます。これにより、エネルギーギャップが0.354eVから0.954eV(0.954eV = 1240nm・eV / 1300nm)に増加し、優れた中間エネルギーレベルになります。 ポンプ源は、下の超格子から得られるGaAsレーザーです。 GaAsによって生成されたレーザーの作用下で、電子は連続的にGaAsの高エネルギーレベルに励起され、次にInAsの中間エネルギーレベルからジャンプダウンします。
3.GaNと発光
ルミ光子が吸収されました。 これをより便利に達成するために、一般的に使用されるエネルギー準位は、直接バンドギャップを有する構造を有する。
実際、上記の発光GaAsとInPに加えて、第3世代の半導体材料GaNにも直接バンドギャップがあります。 一般的な半導体のデータを以下の表に示します。
| 材料 | バンドギャップ | バンドギャップタイプ | 内訳フィールド強度 MV / cm |
電子の移動
割合 |
穴の移動
割合 |
飽和電子ドリフト率 107cm / s |
熱伝導率 w /(cm-K) |
静的誘電率 | 硬度 | |
| 初代 | シ | 1.12 | 間接 | 0.3 | 1600 | 430 | 1 | 1.48 | 11.9 | 7 |
| Geの | 0.67 | 間接 | 0.1 | 3900 | 1900 | 0.6 | 16.0 | 6.0 | ||
| 第2世代 | GaAsの | 1.42 | 直接 | 0.4 | 8500 | 400 | 1.3 | 0.55 | 13.1 | 4 |
| InP | 1.344 | 直接 | 0.45 | – | – | – | 0.68 | 12.5 | – | |
| 第三世代 | GaN系 | 3.39 | 直接 | 2.6 | 1000 | 200 | 2.5 | 1.3 | 9 | – |
| AIN | 6.2 | 直接 | 1.2 | 300 | 14 | 1.4 | 2.85 | 9.14 | – | |
| Ga2O3 | 4.8 | 直接 | 8 | 300 | – | – | 0.3 | – | – | |
| 4H-SiCの | 3.26 | 間接 | 3 | 500 | 120 | 2.5 | 3.4 | 10.1 | 9.25 | |
| 6H-SiCの | 2.86 | 1.2 | 260 | 50 | ||||||
| 3C-SiC | 2.2 | 1.2 | 900 | 320 | ||||||
| 最後 | ダイヤモンド | 5.5 | 間接 | 20 | 2800 | 1300 | 2.7 | 22 | 5.7 | 10.0 |
- GaNはPAM-XIAMENからのものです。
GaNはGaAsやInPよりも大きなバンドギャップを持っています。 このバンドギャップを調整することにより、より広い範囲の光出力を得ることができます。
GaAsのバンドギャップは1.42eVです。これは、873nm未満の光が生成されることを意味します。 大きな吸収があり、光強度は半導体ウェーハ製造システムでは機能しません。
InPのバンドギャップは1.344eVです。これは、925nm未満の光が生成されることを意味します。 吸収が大きくなり、この時点では光の強度は機能しません。
GaNのバンドギャップは3.4eVです。これは、364nm未満の光が生成されることを意味します。 吸収が大きくなり、この時点では光の強度は機能しません。
可視光と紫外線を生成できるのがGaNの利点です。 半導体ウェーハ製造プロセスでの可視光の使用:青色LEDは、InとAlをエピタキシャルGaN; より低い波長の光はより大きなエネルギーを持ち、滅菌、マーキング、切断などの専門的な用途があります。
GaNデバイスを準備するために、SiC基板再び選択されました。 半導体ウェーハ製造にSiC基板を選択する理由の詳細については、以下を参照してください。無線周波数デバイスにおけるSiCアプリケーション.
詳細については、メールでお問い合わせください。 victorchan@powerwaywafer.com と powerwaymaterial@gmail.com.

