PAM XIAMEN은 실리콘 기판, 사파이어 기판, 탄화규소(SiC) 기판과 같은 다양한 기판에 2인치 GaN(질화갈륨) HEMT 에피택시 웨이퍼를 제공합니다. 이 GaN 에피택시 웨이퍼는 HEMT(고전자 이동성 트랜지스터)용입니다.
우리는 공장에서 직접 판매하므로 시장에서 가장 좋은 가격을 제공 할 수 있습니다. 고품질 GaN HEMT 에피 웨이퍼. 전 세계의 고객들은 PAM XIAMEN Supply를 선호하는 GaN 에피 웨이퍼 제조업체 및 질화갈륨 생산업체로 신뢰해 왔습니다.
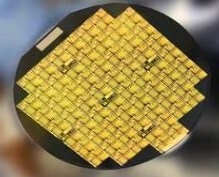
1. HEMT용 GaN 에피 웨이퍼 사양
전도성 SiC 웨이퍼(GaN/SiC)의 AlGaN/GaN HEMT 2
2 in 사파이어 웨이퍼의 AlGaN/GaN HEMT
2인치 반절연 SiC 웨이퍼(GaN/SiC)의 AlGaN/GaN HEMT
2인치 Si 웨이퍼(GaN/Si)의 AlGaN/GaN HEMT
또한 PAM-XIAMEN은 다음과 같이 GaN HEMT 에피 웨이퍼를 제공할 수 있습니다.
전원, D-모드시에 질화 갈륨: GaN HEMT Epitaxy Wafer on Si 기판 구조는 GaN/AlGaN으로 인해 높은 전자 이동도라는 중요한 특성을 가지고 있습니다. 이종 접합 구조.
전력, E- 모드를위한 GaN on Si: 전압을 인가하지 않고 Si 웨이퍼 위에 GaN을 제작하여 향상된 HEMT 소자를 얻을 수 있습니다.
RF용 Si 상의 GaN: Si 웨이퍼 상의 GaN HEMT는 실리콘 상의 GaN의 HEMT 에피택시 웨이퍼 상의 고출력, 고주파 소자에 명백한 장점이 있다.
GaN on Sapphire for Power: sapphire 위의 GaN HEMT Epitaxy Wafer는 전력소자용입니다.
RF 용 사파이어에서의 GaN: 이 HEMT GaN 에피 웨이퍼는 무선 주파수 소자 제작용입니다.
RF 용의 SiC에서의 GaN: III-N 재료 성장 및 장치를 위한 반절연 SiC 웨이퍼에서 성장한 HEMT 스택.
2. 2인치 GaN 기반 HEMT 에피 웨이퍼에 대한 산업 표준
질화갈륨은 고전압 및 고온에서 작업할 수 있는 견고하고 안정적인 기술을 제공하므로 GaN은 많은 산업, 방위, 의료 및 상업 응용 분야를 개척하는 데 매우 적합합니다.
2.1 질화갈륨 에피 웨이퍼의 표면 품질
에피택셜 웨이퍼의 표면에 오염이 없어야 하며, 에피택셜 웨이퍼의 표면은 매끄럽고 밝아야 합니다.
2.2 질화갈륨 웨이퍼 치수
GaN 에피택시 웨이퍼의 외부 치수는 표 1의 요구 사항을 충족해야 합니다.
표 1 GaN HEMT 에피택시 웨이퍼의 외형 치수
| 매개 변수 | 직경 | 플랫 |
| 명세서 | 50.8mm ± 0.5mm | 16.0mm ± 1.0mm |
표 2 AlGaN/GaN HEMT 에피택시 웨이퍼의 전기적 특성
| 아니. | 등록 | 매개 변수 | 요구 사항 | |
| 최저한의 | 최고 | |||
| 홀 테스트 | 캐리어 모빌리티 | 1800cm2/ Vs | / | |
| 2DEG 면적 밀도 | 6*1012센티미터-2 | / | ||
| 제곱 저항 | / | 500Ω/□ | ||
| 2 | XRD 로킹 커브 절반 높이 너비 | 002 | / | 250초 |
| 102 | / | 250초 | ||
| 3 | 원자현미경 테스트 | 거칠기 | / | 0.5nm |
2.3 GaN 에피택셜층의 두께와 두께의 표준편차
에피택셜 층의 두께는 PL 매핑 테스트 시스템을 사용하여 측정됩니다.
테스트 표시 가능 영역의 직경: ≤50mm;
테스트 해상도: 0.1mm~5mm;
테스트 스캔 속도: 1~30pts/s;
레이저 파장: 266nm;
레이저 출력: 4.1mW~22.24mW;
레이저 출력 밀도: 52W/cm2~283.5W/cm2;
슬릿 폭: 0.01mm~2mm.
매개변수는 표 2의 전기적 특성을 준수합니다.
2.4 GaN HEMT 에피택시 웨이퍼에 대한 홀 테스트
홀 테스트는 HEMT용 질화갈륨 웨이퍼의 캐리어 이동도, 2DEG 면적 밀도 및 제곱 저항을 측정합니다.
자기장 강도: 0.45T 영구 자석;
저항 범위: 1u ohm*cm~10M ohm*cm;
저항 범위: 0.1m 옴~10G 옴;
캐리어 농도: 1E+7cm-3~1E+21cm-3
가동성: 1E-2cm2/(볼트*초)~1E+7cm2/(볼트*초);
시험 결과는 표 2의 요구 사항과 일치합니다.
2.5 HEMT 스택이 있는 GaN 에피택셜 웨이퍼에 대한 XRD 테스트
이중 결정 회절은 벌크 재료의 002면 및 102면 요동 곡선을 측정하는 데 사용됩니다.
절반 높이의 넓은 스캔 범위는 -35°~170°입니다.
스캐닝 속도 0.006°/min~120°/min;
최소 스텝 각도 0.0001°;
측정 정확도 ≤0.0002°;
2각 반복성 0.0005°;
각도 위치 결정 속도 1500°/min(20).
GaN 에피택셜 웨이퍼에 대한 XRD 로킹 곡선 절반 높이 너비의 결과는 표 2의 요구 사항을 충족합니다.
3. GaN/AIGaN HEMT 에피 웨이퍼 개발
GaN 에피택시 웨이퍼 시장에서 GaN/AIGaN HEMT 기술의 초기 개발은 주로 에피택셜 층 재료의 품질 향상, 최상의 기판 재료 선택 및 개발 단위 프로세스 개발을 포함한 세 가지 주요 영역에 집중되어 있습니다. 광전자공학 분야에서 질화갈륨 및 질화갈륨알루미늄 헤테로에피택셜의 많은 개발은 초기 금속 유기 화학 기상 증착 방법을 기반으로 합니다. 그러나 다중 갈륨 질화물 전자 장치의 경우 MBE 및 MOCVD 성장 방법이 가능한 것으로 간주됩니다. 사파이어의 가용성으로 인해 GaN HEMT 에피택셜 성장의 가장 진보된 방법이 사파이어에서 실현되었습니다. 그러나 질화갈륨 제조에 사용되는 상용 HEMT 장치는 저비용 Si 기판 또는 4H 및 6H SiC 기판을 사용하여 고출력 성능과 열전도율이 우수합니다. SiC 기판의 전력 장치 기술 수준은 2.9GHz, 800W 및 3.5GHz에서 500W에 도달할 수 있습니다.
AlGaN/GaN HEMT는 높은 항복 전압을 가지므로 큰 누설 전압을 사용할 수 있으며, 이는 RF 전력 인버터의 출력 임피던스를 크게 하고 매칭이 쉽고 손실이 적은 매칭 회로로 이어집니다. 높은 표면 전하는 큰 전류 밀도로 이어지고, 트랜지스터 면적의 감소는 게이트 표면의 큰 전력 밀도로 이어지고, 높은 포화 드리프트 속도는 높은 포화 전류 밀도와 게이트 전력 밀도로 이어져 결과적으로 출력 전력의 단위 커패시턴스를 감소시킵니다. 낮은 출력 커패시턴스와 드레인-소스 임피던스는 GaN 에피택셜 웨이퍼의 HEMT를 스위칭 증폭기에 매우 적합하게 만듭니다.
자세한 내용은 다음 주소로 이메일을 보내주십시오. victorchan@powerwaywafer.com 과 powerwaymaterial@gmail.com.

