추상
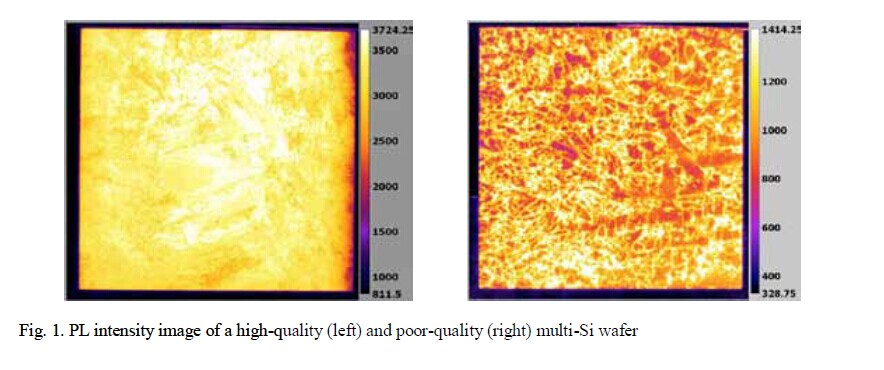



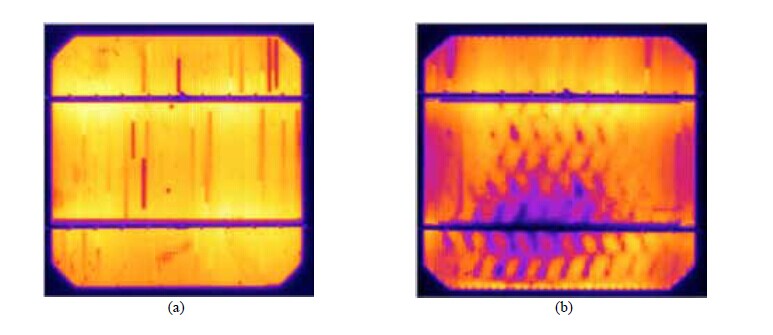
.jpg)

추상
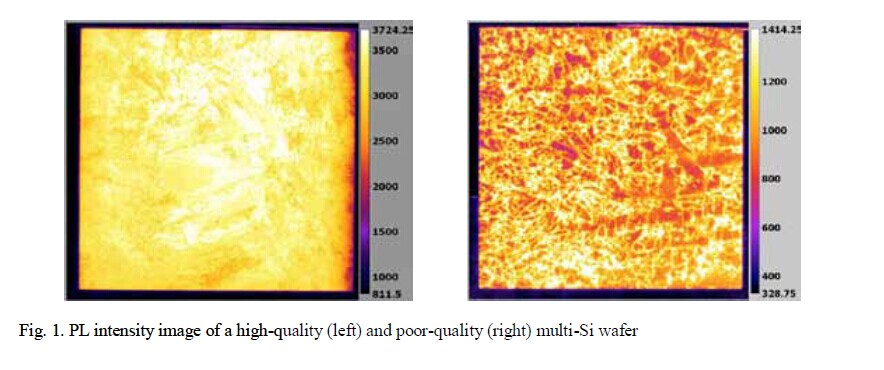



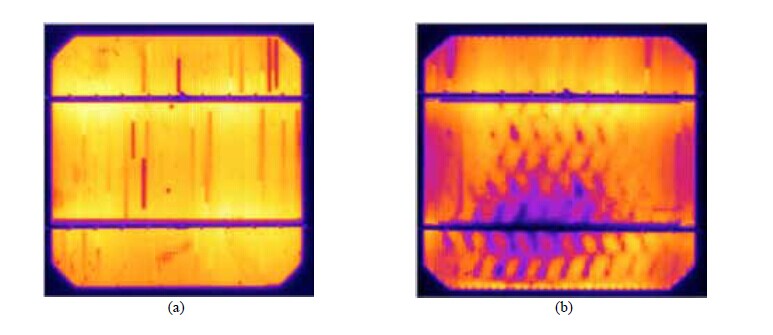
.jpg)

Xiamen Powerway Advanced Material Co.,Ltd., a leading supplier of ultra-high purity crystalline gallium nitride (GaN) and aluminum gallium nitride (AlGaN) materials and other related products and services announced the new availability of 2″/4” size AlGaN–GaN HEMTs Grown on Sapphire Substrates,which is on mass production [...]
PAM XIAMEN offers 2″ Silicon Wafer. Material Orient. Diam. Thck (μm) Surf. Resistivity Ωcm Comment n-type Si:P [111] 2″ 330 P/E 3-7 SEMI Prime n-type Si:P [111] 2″ 275 P/P 2.5-3.5 SEMI Prime n-type Si:P [111] 2″ 5000 P/E 2.0-3.1 Prime, NO Flats, Individual cst n-type Si:P [111] 2″ 5000 P/E 2-3 Prime, NO Flats, Individual cst n-type Si:P [111-8°] 2″ 280 P/E 1.3-1.8 SEMI Prime, n-type Si:P [111-3.5°] 2″ 280 P/E 1-30 SEMI Prime, n-type Si:P [111-2.5°] 2″ 500 C/C 1-20 SEMI Prime n-type Si:P [111] 2″ 7500 P/E 1-10 SEMI Prime, , Individual cst n-type Si:Sb [111-3°] 2″ 300 P/E ~0.02 SEMI Prime n-type Si:Sb [111-1° towards[112]] 2″ 500 P/E 0.017-0.026 SEMI Prime, n-type Si:Sb [111-2°] 2″ 200 P/E ~0.01 SEMI Prime, n-type Si:Sb [111] 2″ 280 P/E 0.01-0.02 SEMI Prime, n-type Si:Sb [111-2°] 2″ 280 P/E 0.008-0.020 SEMI Prime, n-type Si:As [111] 2″ 300 P/E 0.0030-0.0034 SEMI Prime, n-type Si:As [111] 2″ 300 P/E 0.001-0.005 SEMI Prime, n-type Si:As [111-4°] 2″ 350 P/E 0.001-0.005 SEMI [...]
SiC wafers are available for power electronics, scientific or industrial applications, specifications as: https://www.powerwaywafer.com/sic-wafer/sic-wafer-substrate.html SiC is a binary compound formed in a 1:1 ratio of Si and C elements, consisting of 50% silicon (Si) and 50% carbon (C). Its basic structural unit is the Si-C [...]
PAM XIAMEN offers 6″ Silicon EPI Wafers. Substrate EPI Comment Size Type Res Ωcm Surf. Thick μm Type Res Ωcm 6″Øx675μm n- Si:P[100] 0.001-0.002 P/EOx 3.2 ±0.2 n- Si:P 0.32-0.46 n+/n++ For more information, please visit our website: https://www.powerwaywafer.com, send us email at sales@powerwaywafer.com and powerwaymaterial@gmail.com Found in 1990, Xiamen Powerway Advanced Material Co., Ltd (PAM-XIAMEN) is a leading manufacturer of semiconductor material in China.PAM-XIAMEN develops advanced crystal [...]
GaN 박막은 N2를 캐리어로 사용하고 디메틸히드라진을 N 소스로 사용하는 저온/압력 MOVPE 공정을 사용하여 2인치 직경의 웨이퍼에 걸쳐 우수한 균일성을 가지고 ZnO/c-Al2O3에서 성장했습니다. 유사한 GaN 층의 5mm×5mm 섹션을 소다석회 유리 기판에 직접 융합 결합했습니다.
Through continuous efforts, PAM-XIAMEN has developed large-scale COP-free CZ silicon (Si) wafers, and effectively controlled the generation of COP in the ingot by improving the thermal field of crystal pulling, thereby achieving performance improvement and power consumption reduction. The 8-inch silicon wafer application process [...]
| 쿠키 | 지속 | 설명 |
|---|---|---|
| 쿠키법정보-체크박스-분석 | 11개월 | 이 쿠키는 GDPR 쿠키 동의 플러그인에 의해 설정됩니다. 쿠키는 "분석" 범주에 쿠키에 대한 사용자 동의를 저장하는 데 사용됩니다. |
| 쿠키법정보-체크박스-기능 | 11개월 | 쿠키는 "기능" 범주의 쿠키에 대한 사용자 동의를 기록하기 위해 GDPR 쿠키 동의에 의해 설정됩니다. |
| 쿠키법정보-체크박스-필요 | 11개월 | 이 쿠키는 GDPR 쿠키 동의 플러그인에 의해 설정됩니다. 쿠키는 쿠키에 대한 사용자 동의를 "필수" 범주에 저장하는 데 사용됩니다. |
| 쿠키법정보-체크박스-기타 | 11개월 | 이 쿠키는 GDPR 쿠키 동의 플러그인에 의해 설정됩니다. 쿠키는 쿠키에 대한 사용자 동의를 "기타" 범주에 저장하는 데 사용됩니다. |
| 쿠키법정보-체크박스-성능 | 11개월 | 이 쿠키는 GDPR 쿠키 동의 플러그인에 의해 설정됩니다. 쿠키는 쿠키에 대한 사용자 동의를 "성능" 범주에 저장하는 데 사용됩니다. |
| Viewed_cookie_policy | 11개월 | 쿠키는 GDPR 쿠키 동의 플러그인에 의해 설정되며 사용자가 쿠키 사용에 동의했는지 여부를 저장하는 데 사용됩니다. 어떠한 개인 데이터도 저장하지 않습니다. |
