Disebabkan oleh rintangan elektrik, haba dan sinaran yang sangat baik, silikon karbida telah menjadi bahan yang berpotensi untuk aplikasi dalam persekitaran sinaran frekuensi tinggi, berkuasa tinggi dan kuat. Kapasitor MOS ialah cara penting untuk mengkaji permukaan dan antara muka semikonduktor, serta struktur asas MOSFET. Oleh itu, penyelidikan sistematik mengenai kapasitor SiC MOS adalah sangat penting untuk meningkatkan rintangan sinaran peranti elektronik berasaskan SiC dan hayat perkhidmatan peranti. Sebagai salah satu pengeluar wafer epitaxial terkemuka,PAM-XIAMENboleh menyediakan proses pembuatan wafer SiC epi untuk kapasitor MOS. Lihat jadual berikut untuk parameter tertentu:
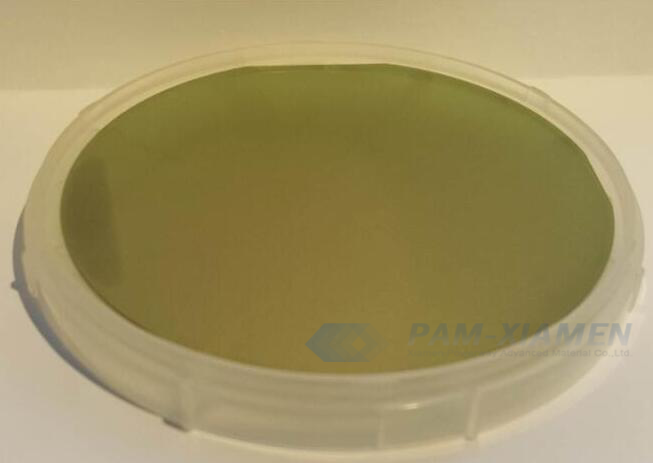
1. Spesifikasi Wafer Epitaxial 4HN SiC
PAM210218 – MOSC
| SL No. | Spesifikasi | |
| 1 | Bahan Wafer | 4H-Silicon Carbide |
| 2 | Konfigurasi Wafer | N+ dengan epi |
| 3 | Bilangan Epi-Lapisan | 2 lapisan |
| Lapisan 1: lapisan penampan | ||
| Lapisan 2: lapisan atas | ||
| 4 | Ketebalan Lapisan 2 | 5/8/10 um±10% |
| 5 | Dopan Lapisan 2 | Nitrogen |
| 6 | Keseragaman Ketebalan | <=5% |
| 7 | Ketumpatan Kecacatan Permukaan | <1/sm2 |
| 8 | Kepekatan Doping Lapisan 2 | 1.0 × 1016cm-3+/-20% |
| 9 | Keseragaman Kepekatan | <=10% |
| 10 | Ketebalan Lapisan 1 | 0.5 um±10% |
| 11 | Dopan Lapisan 1 | Nitrogen |
| 12 | Kepekatan Doping Lapisan 1 | 1.0 × 1018cm-3+/-50% |
| 13 | Permukaan Depan | Si-muka |
| 14 | Jenis Kekonduksian Substrat | Jenis-n yang didopkan berat |
| 15 | Dopant | Nitrogen |
| 16 | Orientasi Kristal | (0001)±0.25° |
| 17 | Luar Orientasi | 4° ke arah <11-20> |
| 18 | Ketumpatan Mikropaip | ≤1 sm-2 |
| 19 | Kerintangan Elektrik | 0.015~0.028 ohm-cm |
| 20 | diameter | 100±0.4 mm |
| 21 | ketebalan | 350±25 um |
| 22 | TTV | ≤10 um |
| 23 | LTV | ≤4 um |
| 24 | Warp | ≤35 um |
| 25 | Orientasi Rata Utama | <11-20> |
| 26 | Orientasi Rata Menengah | <1-100> |
| 27 | Kemasan Permukaan Si-face | CMP digilap |
| 28 | Kemasan Permukaan C-face | Digilap secara optik |
2. Bagaimana untuk Mengawal Kepekatan Doping Epilayer dalam Proses Pengilangan Wafer SiC Epi?
Mengawal jenis doping dan kepekatan lapisan epitaxial adalah penting untuk prestasi peranti kuasa SiC, yang secara langsung menentukan parameter elektrik yang penting seperti rintangan-on tertentu dan voltan menyekat peranti berikutnya. Kaedah epitaksi kompetitif yang ditemui oleh penyelidik boleh mengubah kepekatan doping N-jenis dan P-jenis dengan berkesan dalam julat yang besar, dan digunakan secara meluas dalam pengeluaran praktikal. Di sini, kami menerangkan secara ringkas prinsip nitrogen (N) dan aluminium (Al) sebagai unsur doping jenis-N dan P-jenis.
Semasa pembuatan wafer epitaksi, atom nitrogen (N) bersaing dengan atom karbon (C) untuk kedudukan kekisi. Untuk mengurangkan kepekatan doping atom nitrogen (N), kepekatan atom karbon (C) dalam sumber gas epitaxial perlu ditingkatkan; sebaliknya, untuk mengurangkan kepekatan atom karbon (C) dalam sumber gas epitaxial, kepekatan doping atom nitrogen (N) perlu ditingkatkan. Walaupun atom aluminium (Al) bersaing dengan atom silikon (Si) untuk kedudukan kekisi, anda boleh meningkatkan kepekatan atom silikon (Si) dalam sumber gas epitaxial untuk mengurangkan kepekatan doping atom aluminium (Al); Sebaliknya, anda boleh mengurangkan kepekatan atom silikon (Si) dalam sumber gas epitaxial untuk meningkatkan kepekatan doping atom aluminium (Al).
Dalam pemprosesan epitaksi SiC, sumber gas yang biasa digunakan untuk sumber Si ialah SiCl4 atau SiH4; Sumber gas yang biasa digunakan untuk sumber C ialah CCl4 atau C3H8. Kita boleh mengawal nisbah aliran kedua-duanya untuk mengawal nisbah komponen C/Si, dengan itu mengawal kepekatan doping unsur yang berbeza dengan berkesan.
Selain itu, kepekatan doping lapisan epitaxial SiC berkaitan dengan kadar aliran sumber gas, tekanan gas dan suhu pertumbuhan dalam proses CVD. Ambil doping nitrogen (N) sebagai contoh untuk penjelasan lanjut. Doping nitrogen (N) boleh dicapai dengan cepat dengan memasukkan nitrogen (N2) ke dalam pertumbuhan epitaxial CVD. Daripada Rajah.1, kita boleh tahu bahawa kepekatan doping pada kedua-dua permukaan Si dan C adalah berkadar positif dengan kadar aliran N2 dalam empat susunan magnitud pada nisbah komponen C/Si tetap. Kepekatan doping proses pembuatan wafer SiC epi meliputi julat doping E14-E18, yang paling biasa digunakan dalam peranti.

Rajah 1Hubungan antara kepekatan doping nitrogen (N) dan kadar aliran nitrogen (N2) dalam epitaksi 4H-SiC pada 1550 ℃
Hubungan antara tekanan gas dan kepekatan doping proses pembuatan wafer SiC epi dalam rongga CVD telah dikaji. Seperti yang ditunjukkan dalam Rajah 2, hubungan antara kepekatan unsur N dan tekanan disiasat di bawah keadaan suhu epitaxial 1600 ℃, nisbah C/Si 3.5, dan kadar aliran nitrogen 12 ml/min. Walau apa pun pada satah C atau epitaksi satah Si 4H-SiC, kepekatan doping pembuatan wafer semikonduktor epi meningkat dengan peningkatan tekanan.

Rajah 2Hubungan antara kepekatan unsur N dan tekanan Proses Pembuatan Wafer SiC Epi
3. Soalan Lazim tentang SiC Epitaxy untuk Peranti MOS
S:Berdasarkan spesifikasi yang anda berikan, struktur wafer 4H-SiC adalah seperti di bawah:
Epilayer 4H-SiC lapisan ke-2 (Kepekatan doping = 1 x 10^16 cm-3)/ epilayer 4H-SiC lapisan pertama (Kepekatan doping = 1 x 10^18 cm-3)/ wafer 4H-SiC (rintangan = 0.015-0.028 ohm cm-3)
Kami merancang untuk menggunakan wafer ini untuk fabrikasi ke dalam kapasitor MOS dan melakukan pengukuran voltan kemuatan.
Biasanya untuk wafer Silicon (resistivity= 1-10 ohm), kami akan mendepositkan lapisan oksida logam di atas wafer silikon. Selepas itu, kami akan mendepositkan sesentuh logam atas dan sesentuh logam bawah untuk mendapatkan struktur Al/Metal Oksida/Silikon/Logam (MOS capacitor) dan melakukan pengukuran voltan kemuatan.
Berdasarkan pemahaman kami sebelum ini menggunakan wafer silikon, kami tidak akan dapat memperoleh lengkung kapasitans-voltan jika kerintangan wafer silikon ialah 0.005 ohm (yang dikenali sebagai wafer Silikon jenis-n berdop tinggi).
Kami ingin meminta pendapat anda sama ada wafer 4H-SiC yang dicadangkan sesuai untuk kerja penyelidikan kami kerana kerintangan wafer 4H-SiC dianggap sebagai berdop tinggi (0.015-0.028 ohmcm-3) dan lapisan pertama 4H-SiC epilayer mempunyai kepekatan doping yang tinggi 10^18 cm-3.
Sebenarnya, ketebalan epilayer 4H-SiC tidak begitu penting untuk kerja penyelidikan kami tetapi kami perlu mempunyai kepekatan doping dalam julat 5 x 10^15 hingga 5 x 10^16 cm-3. Adakah anda mempunyai produk standard yang dikeluarkan oleh syarikat anda yang akan lebih murah jika dibandingkan dengan wafer tersuai?
A:1) Kepekatan doping lapisan epitaxial SiC adalah antara 5×10 ^ 15 dan 5×10 ^ 16 cm-3, yang boleh dicapai dalam teknologi epitaxial.
2) Bagi kerintangan antara 0.8 dan 0.1 ohmcm-3, jika lengkung voltan kemuatan tidak dapat diperoleh kerana kerintangan yang rendah, adalah dicadangkan bahawa kepekatan epitaxial harus mempertimbangkan kepekatan doping yang lebih rendah (rintangan yang lebih tinggi).
Untuk maklumat lanjut, sila hubungi kami e-mel divictorchan@powerwaywafer.com dan powerwaymaterial@gmail.com.

