Hyung Koun Cho∗
Jabatan Kejuruteraan Metalurgi, Universiti Dong-A, Busan 604-714
Jeong Yong Lee
Jabatan Sains dan Kejuruteraan Bahan,
Institut Sains dan Teknologi Termaju Korea, Daejon 305-701
Kami telah menyiasat pembentukan lubang berbentuk V dalam filem nitrida seperti InGaN/GaN dan AlGaN/GaN yang ditanam pada substrat nilam menggunakan mikroskop elektron penghantaran. Mekanisme pembentukan pit sangat bergantung kepada komposisi indium (In) dan aluminium (Al) dalam InxGa1−xN dan AlxGa1−xN lapisan, masing-masing. Dengan peningkatan komposisi indium, lubang berbentuk V berasal dari puncak kehelan benang kepada sempadan ketidakpadanan susunan yang disebabkan oleh kesalahan susun dan pertumbuhan pulau tiga dimensi pada peringkat awal disebabkan oleh ketidakpadanan kekisi yang besar. Dengan peningkatan komposisi aluminium, asal lubang-lubang juga berbeza-beza daripada beralun permukaan akibat terikan ketidaksesuaian elastik kepada puncak kehelan benang.
Nombor PACS: 61.72.Ff, 68.55.Ln, 68.55.-a
Kata kunci: Pit, Nitride, TEM, AlGaN, InGaN
I. PENGENALAN
Semikonduktor berasaskan Wurtzite GaN (GaN, InGaN, dan AlGaN) sedang dalam penyiasatan besar sebagai bahan yang menjanjikan untuk peranti optoelektronik, suhu tinggi dan berkuasa tinggi kerana beberapa sifat seperti jurang jalur langsung yang besar, kestabilan haba yang tinggi dan interatomik yang kuat bon [1, 2]. Untuk InxGa1−xN dan AlxGa1−xLapisan N yang ditumbuhkan pada GaN, peningkatan dalam komposisi indium (In) dan aluminium (Al) tidak dapat dielakkan menyebabkan ketegangan tidak sesuai dalam filem. Di luar ketebalan kritikal, beberapa kecacatan struktur seperti terkehel tidak sesuai, ralat susun, lubang berbentuk V, dsb., dihasilkan oleh kelonggaran plastik [3, 4]. Walau bagaimanapun, juga pada ketebalan yang lebih kecil, kelonggaran anjal mungkin disebabkan oleh pembentukan pulau, pengambangan permukaan, dsb., seperti yang diperhatikan dalam InGaP/InAsP, In0.77Ga0.23As/InGaAs, SiGe/Si, dan sebagainya [5–7]. ].Di samping itu, peningkatan dalam komposisi In boleh menyebabkan ketidakhomogenan kimia InxGa1−xLapisan telaga N disebabkan oleh kebolehcampuran yang lemah antara InN dan GaN [8, 9].Keterlarutan rendah In dalam GaN dikira kurang daripada 6 % pada 800 ◦C menggunakan model Stringfellow [10].Sifat-sifat ini boleh mempengaruhi sifat optik dan struktur peranti dengan ketara [11, 12].
Baru-baru ini, kami melaporkan dua model pembentukan lubang berbentuk V dalam telaga kuantum berbilang InGaN/GaN (MQWs) dengan komposisi In tinggi [13]. Juga, ketidakinginan dan kesan ke atas sifat pelepasan lubang ini sebelum ini ditunjukkan oleh mikroskop elektron penghantaran (TEM), katodeluminesen, dan fotoluminesen [3, 14, 15]. Untuk penindasan pembentukan pit, oleh itu, pemahaman yang jelas tentang mekanisme pembentukan pit diperlukan dan struktur mikro lubang yang diperhatikan dalam pelbagai filem III-nitrida yang ditanam pada substrat nilam mesti dinilai secara terperinci. Dalam kerja ini, kami menyiasat pembentukan lubang yang berasal dari sumber yang berbeza dalam heterostruktur InGaN / GaN dan AlGaN / GaN dengan pelbagai komposisi In dan Al menggunakan TEM.
II. PERCUBAAN
Semua sampel telah ditanam pada substrat nilam satah c dengan lapisan nukleasi GaN tebal nominal 25 nm oleh reaktor nyahkedudukan wap kimia metalorganik mendatar yang beroperasi pada tekanan rendah. Trimethylgallium, trimethylindium, trimethylaluminum, dan ammonia telah digunakan sebagai prekursor sumber untuk Ga, In, Al, dan N, masing-masing. Untuk menganalisis kesan terikan pada mekanisme pembentukan lubang dalam III-nitrida, lapisan tebal InxGa1−xN (∼ 800 ˚A) telah ditanam pada suhu antara 830 ◦C (xDalam = 35 %) hingga 880 ◦C (xDalam = 10 %) dan lapisan tebal AlxGa1−xN (1000 A) ditanam pada suhu 1040 ◦C selepas menumbuhkan lapisan GaN asas terdop Si dengan ketebalan ~2 mm pada 1080 ◦C. Komposisi In dan Al dalam InxGa1−xN dan AlxGa1−xN lapisan ialah 10, 13, 19, dan 35 % dan 16, 25, 44, dan 54 %, masing-masing.
Untuk mencirikan pembentukan pit III- nitrida, spesimen TEM telah disediakan dalam keratan rentas sepanjang paksi zon [11-20] menggunakan penggilap mekanikal Tripod diikuti dengan pengilangan ion Ar suhu rendah pada 4.5 kV dalam Gatan DuoMill 660 DIF dengan kelajuan sektor kawalan. Tenaga ion dikurangkan secara beransur-ansur semasa peringkat akhir penipisan untuk meminimumkan kerosakan permukaan sampel. Imej medan terang (BF) dan imej TEM (HRTEM) resolusi tinggi telah dirakam pada JEOL JEM- 2000EX TEM pada 200 kV dan JEOL JEM-3010EX pada 300 kV.
III. KEPUTUSAN DAN PERBINCANGAN
Untuk menyiasat kesan komposisi Al pada pembentukan pit, mikrograf TEM medan terang keratan rentas dari AlxGa1−xLapisan N yang ditanam dengan pelbagai komposisi Al pada lapisan penimbal GaN diperolehi seperti ditunjukkan dalam Rajah 1. Komposisi Al kritikal teori mengenai pembentukan kehelan yang tidak sesuai dalam 1000 A AlxGa1−xLapisan N yang ditanam pada lapisan GaN adalah kurang daripada 15 % [16]. Tiada lubang dikesan dalam AlxGa1−xN lapisan dengan sehingga 25 % komposisi Al. Hanya kerosakan susun dan rekahan dalam lapisan AlGaN yang diperhatikan disebabkan oleh ketegangan yang tidak sesuai dan perbezaan pekali haba, masing-masing (tidak ditunjukkan). Untuk Al0.44Ga0.56Sampel N/GaN, bagaimanapun, permukaan Al0.44Ga0.56Lapisan N menunjukkan banyak lubang yang tidak dikaitkan dengan kecacatan struktur seperti kehelan benang, kerosakan susun, dan sebagainya [Gamb. 1(b) dan (d)]. Saiz lubang ini sangat kecil, diameter purata 7 nm dan ketinggian purata ~ 3 nm, berbanding dengan lubang dalam lapisan InGaN yang ditanam pada GaN [13, 14, 16]. Adalah dipercayai bahawa pembentukan lubang di Al0.44Ga0.56N/GaN boleh disifatkan kepada pengaliran permukaan oleh ketegangan ketidaksesuaian elastik yang meningkat seperti yang diperhatikan dalam sistem semikonduktor III-V dan II-VI [5, 6].
Ketumpatan lubang adalah lebih daripada 1010 cm−2 di permukaan. Sebaliknya, kehelan salah muat dijana pada antara muka Al0.54Ga0.46Sampel N/GaN untuk mengendurkan secara plastis terikan ketidaksesuaian yang disimpan seperti ditunjukkan dalam Rajah 1(c). Juga, lubang berbentuk V yang dikaitkan dengan kehelan benang di bahagian bawah diperhatikan seperti heterostruktur InGaN/GaN. Lubang berbentuk V ini mempunyai heksagon terbuka, piramid terbalik dengan dinding sisi [14, 16].
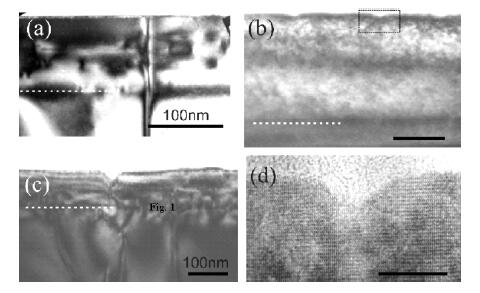
Rajah 1 Imej TEM medan terang keratan rentas menggunakan g = 0002 daripada AlxGa1−xN lapisan ditanam dengan komposisi Al sebanyak (a) 16 %, (b) 44 %, dan (c) 54 %. (d) Imej HRTEM diperoleh daripada segi empat tepat putus-putus dalam (b). Garis putus-putus menunjukkan AlxGa1−xAntara muka N/GaN.
Akibatnya, kami mengklasifikasikan asal usul pembentukan lubang dalam AlxGa1−xN ditanam pada lapisan penimbal GaN kepada dua model seperti ditunjukkan dalam Rajah. 4(a) dan (d). Untuk AlxGa1−xLapisan N dengan ~40 % komposisi Al, lubang dijana oleh gelombang permukaan disebabkan oleh ketegangan ketidaksesuaian elastik yang disimpan [Gamb. 4(d)]. Untuk AlxGa1−xLapisan N dengan lebih daripada ~ 50 % komposisi Al, bagaimanapun, lubang terutamanya dijana pada puncak kehelan benang [Gamb. 4(a)].
Rajah 2 menunjukkan mikrograf TEM medan terang keratan rentas daripada InxGa1−xLapisan N yang ditanam dengan pelbagai komposisi In pada lapisan penimbal GaN. Komposisi kritikal dalam teori mengenai pembentukan kehelan yang tidak sesuai bagi ~800˚A DalamxGa1−xN yang ditanam pada lapisan GaN adalah kurang daripada 5%, di bawahnya lapisan InGaN menunjukkan pertumbuhan yang koheren [16]. Oleh itu, kami mengharapkan komposisi Dalam semua DalamxGa1−xN lapisan dikaji di sini mempunyai nilai lebih daripada komposisi kritikal dalam pembentukan kehelan yang tidak sesuai. Untuk In0.1Ga0.9N/GaN, tiada kecacatan struktur seperti terkehel tidak sesuai, ralat susun, lubang, dsb., diperhatikan dalam lapisan In0.1Ga0.9N. Dengan peningkatan lagi dalam komposisi Dalam dalamxGa1−xN lapisan (xDalam = 13%), lubang berbentuk V dijana untuk melegakan ketegangan yang tidak sesuai yang disimpan, seperti yang dilaporkan sebelum ini [14]. Telah dilaporkan bahawa lubang berbentuk V sentiasa disambungkan dengan kehelan benang dari lapisan penimbal GaN di bahagian bawah dan hanya sebahagian kecil daripada kehelan benang menyebabkan pembentukan lubang berbentuk V dalam lapisan InGaN dan MQW InGaN/GaN [14]. Walau bagaimanapun, ketumpatan lubang berbentuk V dalam In0.19Ga0.81Lapisan N dalam Rajah 2(c) mempunyai nilai yang lebih besar daripada ketumpatan kehelan benang dalam lapisan penimbal GaN, yang menunjukkan bahawa pembentukan lubang berbentuk V dalam InGaN dengan komposisi In tinggi mempunyai asal yang berbeza, seperti yang dilaporkan sebelum ini untuk sistem InGaN/GaN MQW [13]. Kami melaporkan bahawa dalam MQW InGaN/GaN dengan komposisi tinggi (~ 30 % Dalam komposisi), kebanyakan lubang berbentuk V dijana daripada sempadan ketidakpadanan susun yang disebabkan oleh kesalahan susun [13]. Walaupun In0.19Ga0.81N/GaN yang digunakan di sini mempunyai komposisi dalam kurang daripada 20 %, bahagian lubang berbentuk V berasal daripada sempadan ketidakpadanan susunan yang disebabkan oleh kerosakan susun disebabkan oleh peningkatan ketebalan lapisan InGaN [Gamb. 3(a)] berbanding dengan InGaN/GaN MQW. Untuk In0.35Ga0.65N/GaN, lubang berbentuk V dengan ketumpatan lebih daripada 1010 cm−2 diperhatikan pada permukaan. Berbeza dengan lubang-lubang dalam In0.19Ga0.81N/GaN sampel, In0.35Ga0.65Kawasan N dengan permukaan atas rata (0001) di antara lubang mempunyai sejumlah besar kesalahan susun dan sempadan ketidakpadanan susunan yang terbentuk pada peringkat pertumbuhan awal InGaN [Rajah 1b. 3(b)], iaitu, struktur kolumnar termasuk sesar susun. Untuk melonggarkan ketidakpadanan kekisi besar antara In0.35Ga0.65N dan GaN, permulaan In0.35Ga0.65Lapisan N telah ditanam dengan morfologi pulau segi tiga dimensi (3D) [17]. Ketumpatan tinggi sesar susun jelas kelihatan di pulau-pulau dan sempadan antara subgrain mengikut pulau kelihatan seperti pertumbuhan lapisan nukleasi GaN yang ditanam pada substrat nilam [18].
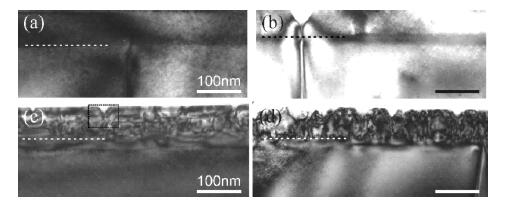
Rajah 2 Imej TEM medan terang keratan rentas menggunakan g = 0002 daripada InxGa1−xLapisan N yang ditanam dengan komposisi Dalam (a) 10 %, (b) 13 %, (c) 19 %, dan (d) 35 % pada lapisan penimbal GaN. Garis putus-putus menunjukkan InxGa1−xAntara muka N/GaN.
Oleh itu, kami fikir lubang dalam In0.35Ga0.65Sampel N/GaN disebabkan oleh pertumbuhan 3D sedemikian disebabkan ketidaksesuaian kekisi pada pertumbuhan awal lapisan InGaN.
Akibatnya, kami mengklasifikasikan asal pembentukan lubang dalam InxGa1-xN ditanam pada lapisan penimbal GaN kepada tiga model seperti ditunjukkan dalam Rajah 4(a), (b), dan (c). Untuk InxGa1-xLapisan N dengan komposisi rendah, lubang dijana pada puncak kehelan benang [Gamb. 4(a)]. Untuk InxGa1-xLapisan N dengan sederhana Dalam komposisi, lubang terutamanya dijana daripada sempadan ketidakpadanan susun yang disebabkan oleh kesalahan susun [Rajah. 4(b)]. Peningkatan selanjutnya dalam komposisi DalamxGa1-xLapisan N menghasilkan pertumbuhan pulau 3D pada peringkat awal dan pembentukan pit pada pertumbuhan berterusan [Rajah. 4(c)].
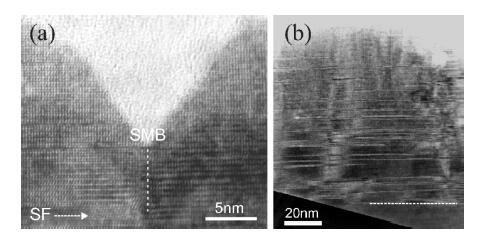
Rajah 3 (a) Imej HRTEM diperolehi daripada sudut segiempat tepat putus-putus dalam Rajah 2(c). Lubang berbentuk V yang diperhatikan mempunyai sesar susun pada (0001) satah di kedudukan bawahnya. (b) Imej HRTEM diperoleh daripada In0.35Ga0.65N pada lapisan penimbal GaN.
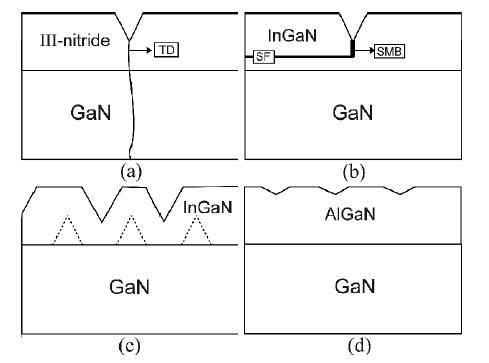
Rajah 4 Model skematik untuk pembentukan pit yang berkaitan dengan (a) kehelan benang yang diperhatikan dalam heterostruktur InGaN/GaN dan AlGaN/GaN, (b) sempadan ketidakpadanan susunan yang disebabkan oleh sesar susun dan (c) pertumbuhan pulau 3d pada peringkat awal diperhatikan dalam heterostruktur InGaN/GaN, dan (d) gelombang permukaan disebabkan oleh ketegangan ketidaksesuaian elastik yang diperhatikan dalam heterostruktur AlGaN/GaN.
IV. RINGKASAN
Pembentukan lubang di InxGa1-xN dan AlxGa1-xLapisan N dengan pelbagai komposisi In dan Al yang ditanam pada lapisan penimbal GaN dikaji menggunakan TEM. Kami mendapati bahawa lubang terbentuk daripada pelbagai asal seperti kehelan benang, menyusun sempadan tidak padan, pertumbuhan pulau 3D dan beralun permukaan bergantung pada komposisi In dan Al.
PENGHARGAAN
Kerja ini disokong oleh geran No. R01-2002- 000-00096-0 daripada Yayasan Sains & Kejuruteraan Korea dan Program Penyelidikan Universiti daripada Kementerian Penerangan & Komunikasi di republik Korea.
RUJUKAN
[1] H. Morkoc, Semikonduktor dan Peranti Nitrida (Springer, Heidelberg, 1999).
[2] YS Park, J. Fizik Korea. Soc. 34, S199 (1999).
[3] HK Cho, JY Lee, CS Kim, GM Yang, N. Sharma dan CJ Humphreys, J. Cryst. Pertumbuhan 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim dan GM Yang, J. Korean Phys. Soc. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard dan RA Masut, J. Appl. Fizik. 81, 3501 (1997).
[6] M. Mitsuhara, M. Ogasawara dan H. Sugiura, J. Cryst. Pertumbuhan 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang dan JJ Harris, Semicond. Sci. Technol. 15, 370 (2000).
[8] D. Doppalapudi, SN Basu, KF Ludwig, Jr. dan TD Moustakas, J. Appl. Fizik. 84, 1389 (1998).
[9] T. Takeuchi, H. Takeuchi, S. Sota, H. Sakai, H. Amano dan I. Akasaki, Jpn. J. Appl. Fizik. 36, L177 (1997).
[10] GB Stringfellow, J. Cryst. Pertumbuhan 58, 194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson dan R. Stall, J. Cryst . Pertumbuhan 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Hong, E.-K. Suh, HJ Lee, HK Cho dan JY Lee, J. Korean Phys. Soc. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang dan CS Kim, Appl. Fizik. Lett. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars, dan JS Speck dan SJ Rosner, Appl. Fizik. Lett. 72, 692 (1998).
[15] G. Pozina, JP Bergman, B. Monemar, T. Takeuchi, H. Amano dan I. Akasaki, J. Appl. Fizik. 88, 2677 (2000).
[16] JW Matthews dan AE Blakeslee, J. Cryst. Pertumbuhan 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, JZ Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts dan SM Bedair, J. Electron. Mater. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan dan S. Mahajan, Appl. Fizik. Lett. 77, 3391 (2000).
