Dengan perkembangan peranti semikonduktor yang semakin meningkat, bahan berasaskan silikon dan silikon masih menunjukkan sifat unggul mereka, dan ia masih akan menjadi bahan penting untuk peranti semikonduktor dan litar bersepadu. Dengan saiz peranti yang semakin berkurangan, kerintangan, pengagihan kekotoran, ketebalan filem dan kawalan kualiti bahan berasaskan silikon dan silikon adalah amat penting. Menggunakan pemprofilan rintangan penyebaran (SRP) untuk menguji dan menganalisis bahan berasaskan silikon dan silikon adalah lebih intuitif dan berkesan daripada kaedah ujian lain.PAM-XIAMEN boleh tawarkanwafer silikondengan menyebarkan perkhidmatan profil rintangan jika perlu.
SRP juga dikenali sebagai analisis rintangan penyebaran (SRA), iaitu, taburan rintangan resapan ialah kaedah untuk menguji parameter elektrik seperti rintangan resapan, kerintangan, taburan kepekatan pembawa, dan lain-lain bahan semikonduktor dengan resolusi yang lebih tinggi, yang tergolong dalam eksperimen. kaedah perbandingan.
1. Prinsip Asas SRP – Pemprofilan Rintangan Penyebaran (Berdasarkan Wafer Silikon)
Langkah-langkah penyebaran profil rintangan adalah untuk mengukur rintangan hamparan siri titik sesentuh (Rs ialah nisbah kejatuhan potensi antara probe logam konduktif dan titik rujukan pada wafer silikon kepada arus yang mengalir melalui probe), dan kemudian gunakan lengkung penentukuran untuk menentukan Kerintangan sampel yang diuji berhampiran titik sentuhan probe rintangan sebaran ditukar kepada kepekatan pembawa sepadan dengan siri titik ujian.
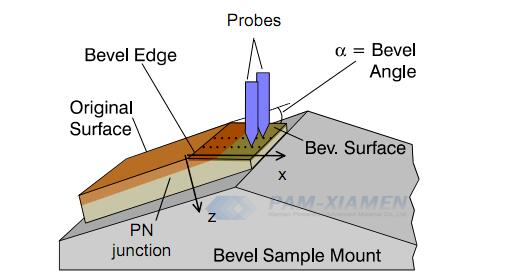
Skema Pemprofilan Teknik Prob Rintangan Penyebaran
Untuk meningkatkan resolusi spatial dan pada masa yang sama mengikut kedalaman ukuran sasaran yang berbeza, arah keratan rentas sampel boleh dikisar ke dalam satu siri sudut, dan perubahan kerintangan dalam 5 nm dari kedalaman resolusi. arah boleh diukur selepas mengisar wafer silikon.
Ambil wafer epitaxial silikon sebagai contoh:
| Perkara | parameter | Spec | Unit | |
| 1 | Menghubungi pertumbuhan | CZ | ||
| 2 | diameter | 100+/-0.5 | mm | |
| 3 | Jenis-Dopan | P- Boron | ||
| 4 | Kerintangan | 0.002 – 0.003 | ohm-cm | |
| 5 | Variasi Jejari Kerintangan | <10 | % | |
| 6 | Crystal Orientation | <111> 4 +/- 0.5 | ijazah | |
| 7 | Flat Utama | orientasi | Semi | ijazah |
| Negara | Semi | mm | ||
| 8 | Flat menengah | Orientasi | Semi | ijazah |
| Panjang | separa | mm | ||
| 9 | ketebalan | 525 +/- 25 | mikron | |
| 10 | TTV | ≦10 | mikron | |
| 11 | Bow | ≦40 | mikron | |
| 12 | Warp | ≦40 | mikron | |
| 13 | Permukaan Depan | digilap | ||
| 14 | Bahagian belakang | terukir | ||
| 15 | Rupa Permukaan | tiada rekahan, jerebu, kerepek tepi, kulit oren, kecacatan, pencemaran | ||
| 16 | Profil Tepi | Pembundaran Tepi | ||
| 17 | Zarah (>0.3μm) | N / A | ea/wf | |
| 18 | ||||
| 19 | Epi Lapisan 1 | N Phos | ||
| 20 | kerintangan | 3.8 – 5.2 | ohm cm | |
| 21 | ketebalan | 29.0 – 35.0 | um | |
| 22 | Epi Lapisan 2 | N Phos | ||
| 23 | kerintangan | 0.0014 – 0.0026 | ohm cm | |
| 24 | ketebalan | 36.0 – 44.0 | ||
Note:The epi wafer can be processed and fabricated into Circuit Protection TVS Diodes, they are very similar to that of a schottky diode. When the first epi layer is too thin to get the proper performance and break down Voltage and the TVS circuit won’t regulate. Transient voltage suppressor diodes are very popular devices used to instantaneously clamp transient voltages (e.g., ESD events) to safe levels before they can damage a circuit. The are designed to react much faster then your typical zener or schottky diode.
Kami menguji spesifikasi di atas dengan ujian SRP dan mendapatkan rintangan dan ketebalan epilayers. Sila lihat gambarajah yang dilampirkan di bawah:
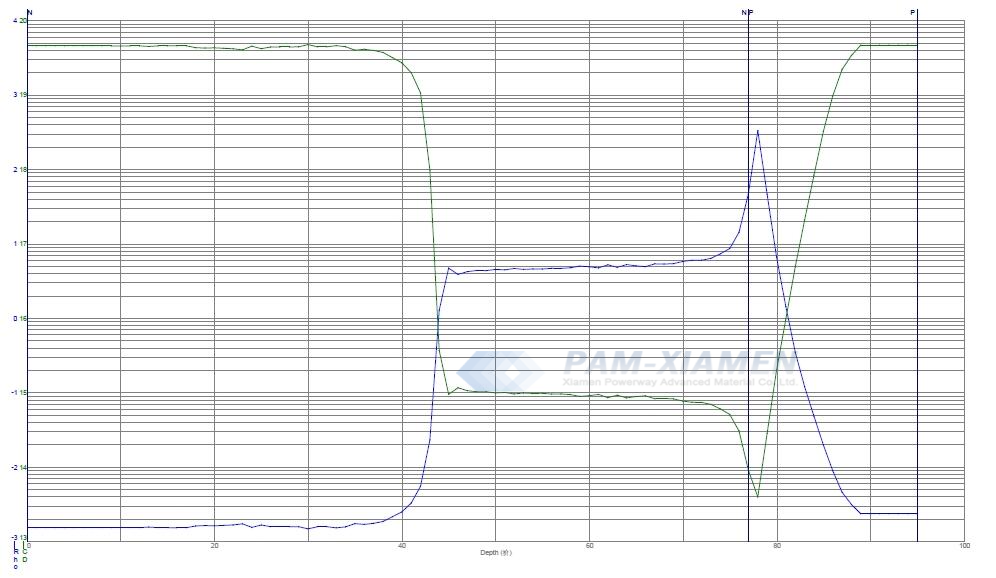
2. Kebaikan dan Keburukan Pengukuran Profil Rintangan Penyebaran
Kelebihan:
- Resolusi spatial yang sangat baik;
- Ujian ringkas dan intuitif;
- Julat ujian kerintangan yang luas;
- Boleh digunakan sebagai profil berbilang lapisan
Keburukan:
- Ujian yang merosakkan
3. Aplikasi Pemprofilan dan Penganalisisan Rintangan Penyebaran
SRP semakin banyak digunakan dalam wafer epitaxial dan ujian wafer corak IC kerana resolusi spatialnya yang unggul. Teknologi SRP boleh mengukur bukan sahaja perubahan rintangan longitudinal wafer epitaxial, tetapi juga ketebalan lapisan epitaxial, kawasan peralihan dan lebar interlayer.
Kerintangan (atau kepekatan) dan taburan kedalaman lapisan epitaxial seperti Si, InP, GaAs, SiC, dll., diuji dengan kaedah pemprofilan rintangan penyebaran. Mengetahui ketebalan lapisan epitaxial, lebar kawasan peralihan dan kerintangan substrat dan kerintangan wafer epitaxial pada kedalaman tertentu, adalah mungkin untuk mendiagnosis kualiti wafer epitaxial.
Sila ambil perhatian bahawa SRP hanya mengukur kepekatan doping separa yang diaktifkan.

Untuk maklumat lanjut, sila hubungi kami e-mel divictorchan@powerwaywafer.com dan powerwaymaterial@gmail.com.
