Através de esforços contínuos,A PAM-XIAMEN desenvolveuSilício CZ(Si) bolachas, e controlou efetivamente a geração de COP no lingote, melhorando o campo térmico de extração de cristal, obtendo assim melhoria de desempenho e redução de consumo de energia. O processo de aplicação do wafer de silício de 8 polegadas é maior, portanto não é sensível ao COP; o processo de aplicação do wafer de silício de 12 polegadas é menor e mais sensível à qualidade do cristal. De um modo geral, o processo abaixo de 40nm tem requisitos mais altos de qualidade de cristal, então há mais demanda por COP-Free. As especificações da bolacha livre de COP para venda são as seguintes:

1. Folha de Dados de Wafer Livre COP
| Types of COP Free Wafer | Polished | Annealed | epitaxia |
| Diameter | 8” & 12” | 12” | 8” & 12” |
| Orientação | (100), (110) or (111) | ||
| Conduction Type | N & P | ||
2. O que é COP de CZ-Si Wafer?
COP (partículas/poços originados de cristal) é o defeito primário em monocristal de silício. Este defeito é um defeito de rede revelado após o polimento de wafers de silício com solução SC-1 (NH4OH:H2O2:H2O-1:1 5) a 85 °C por 4 horas. Depois de tratar o wafer de silício com solução SC-1, a camada superficial do wafer de silício foi gravada em 150 nm. A densidade dos defeitos COP pode ser detectada por um contador de partículas de varredura a laser.
Os defeitos do COP são micro-vazios octaédricos, conforme mostrado na Figura 1, o tamanho do COP é 0,12~0,30um. Os poços de ataque dos defeitos COP geralmente podem ser divididos em duas categorias: um é monotipo, o outro é bitipo.
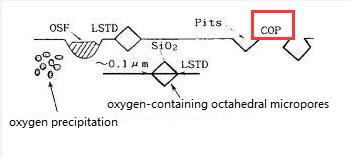
Fig. 1 Esquema de Defeitos COP
3. Por que as bolachas CZ têm defeitos de COP?
A formação do defeito primário COP está intimamente relacionada com a formação da precipitação de oxigênio. Os motivos são:
(1) Os grandes defeitos primários no silício CZ não foram encontrados no silício FZ livre de oxigênio;
(2) Com base no cálculo da energia livre dos microvazios, fica provado que os microvazios não podem se formar uniformemente a partir de vazios;
(3) Durante o crescimento do silício CZ, em uma faixa de temperatura bastante ampla, o oxigênio é supersaturado e, portanto, precipita. Usando o espectro de raios X dispersivo de energia do TEM, a análise elementar dos defeitos do COP pode ser realizada e verifica-se que alguns defeitos do COP contêm oxigênio. Isso indica que o mecanismo de formação de vazios também está relacionado à precipitação de oxigênio.
Além disso, a taxa de crescimento dos defeitos COP é a mais rápida na faixa de 900~1100 °C, então o tempo gasto nesta faixa de temperatura determina o tamanho do crescimento dos defeitos COP. A passagem rápida por essa região de temperatura pode impedir efetivamente o crescimento de defeitos COP. No entanto, como os monocristais tendem a crescer dentro de uma certa faixa de velocidade de tração, como a velocidade de tração de Sb fortemente dopado é geralmente 0,6-1,2 mm/min. E a faixa de temperatura geral do campo térmico de 900 ~ 1100 ° C é mais ampla, então o tamanho do defeito COP tende a crescer durante todo o processo de crescimento do cristal único. O tamanho dos defeitos do COP também é afetado pelos tempos de limpeza do processamento subsequente do wafer. Depois de limpo em SC1 por 5-6 vezes, o número e o tamanho dos defeitos COP aumentam exponencialmente.
4. Como obter a bolacha sem caroço originada por cristal?
Tem havido muitas literaturas de pesquisa na eliminação ou diminuição dos COPs para obter substratos livres de COP, que podem ser resumidos como:
(1) Gerar um único cristal de silício dopado com nitrogênio;
(2) Recozimento com hidrogênio ou argônio para eliminar defeitos de COP de superfície;
(3) Ajuste a temperatura longitudinal do gradiente do campo térmico, reduzindo a densidade do defeito do COP e diminuindo o tamanho do defeito do COP.
Alguns estudos apontaram que quando a concentração de boro dopante excede um valor crítico, a geração de COP será efetivamente suprimida, obtendo-se então pastilhas de cristal livres de COP. O tamanho deste valor crítico está relacionado ao diâmetro do lingote. Por exemplo, para um lingote de silício de 200 mm, o valor crítico é 4,8 × 1018 átomo/cm3; para um lingote de 150 mm, é 6,3 × 1018 átomo/cm3.
Estudos também mostraram que o recozimento de alta temperatura em atmosferas de hidrogênio e argônio pode efetivamente reduzir microdefeitos do tipo buraco (como COPs) na superfície de pastilhas de silício, melhorando assim o GOI para aplicações de dispositivos MOS. Uma vez que a superfície do wafer de silício (incluindo a superfície do COP) é coberta com uma camada de óxido natural, seja usando uma atmosfera de hidrogênio ou uma atmosfera de argônio, sob alta temperatura, desde que o wafer de silício seja aquecido a alta temperatura de cerca de 1200°C, a camada de óxido natural na superfície do wafer torna-se termicamente instável e dissocia-se para gerar átomos de silício adicionais. Esses átomos de silício extras preencherão as posições dos COPs, de modo que esses microdefeitos do tipo buraco gradualmente se tornem menores ou até desapareçam, obtendo assim a pastilha de silício livre de COP ou baixa pastilha de Si COP.
Para obter mais informações, entre em contato conosco pelo e-mail victorchan@powerwaywafer.com e powerwaymaterial@gmail.com.

