Devido à sua excelente resistência elétrica, térmica e à radiação, o carboneto de silício tornou-se um material potencial para aplicações em ambientes de alta frequência, alta potência e forte radiação. Os capacitores MOS são um meio importante de estudar superfícies e interfaces de semicondutores, bem como a estrutura básica dos MOSFETs. Portanto, a pesquisa sistemática sobre capacitores SiC MOS é de grande importância para melhorar a resistência à radiação de dispositivos eletrônicos baseados em SiC e a vida útil dos dispositivos. Como um dos principais fabricantes de wafer epitaxial,PAM-XIAMENpode fornecer o processo de fabricação de SiC epi wafer para capacitores MOS. Consulte a tabela a seguir para obter parâmetros específicos:
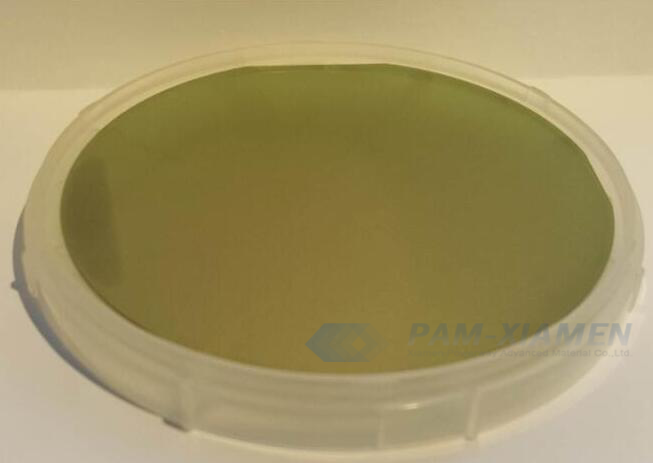
1. Especificação da bolacha epitaxial 4HN SiC
PAM210218 – MOSC
| Sim. Não. | Especificação | |
| 1 | Material da bolacha | Carboneto de Silício 4H |
| 2 | Configuração do Wafer | N+ com epi |
| 3 | Número de Epi-Camadas | 2 camadas |
| Camada 1: camada de buffer | ||
| Camada 2: camada superior | ||
| 4 | Espessura da Camada 2 | 5/8/10 um ± 10% |
| 5 | Camada 2 Dopante | Azoto |
| 6 | Uniformidade de Espessura | <=5% |
| 7 | Densidade de defeito de superfície | <1/cm2 |
| 8 | Concentração de Dopagem da Camada 2 | 1,0 × 1016cm-3+/-20% |
| 9 | Uniformidade de Concentração | <=10% |
| 10 | Espessura da Camada 1 | 0,5 um±10% |
| 11 | Camada 1 Dopante | Azoto |
| 12 | Concentração de Dopagem da Camada 1 | 1,0 × 1018cm-3+/-50% |
| 13 | Superfície frontal | Si-face |
| 14 | Tipo de condutividade do substrato | Tipo n fortemente dopado |
| 15 | dopante | Azoto |
| 16 | Orientação Cristal | (0001)±0,25° |
| 17 | Fora da Orientação | 4° em direção a <11-20> |
| 18 | Densidade do Microtubo | ≤1 cm-2 |
| 19 | Resistividade elétrica | 0,015~0,028 ohm-cm |
| 20 | Diâmetro | 100±0,4 mm |
| 21 | Espessura | 350±25 um |
| 22 | TTV | ≤10 um |
| 23 | LTV | ≤4 um |
| 24 | Urdidura | ≤35 um |
| 25 | Orientação Plana Primária | <11-20> |
| 26 | Orientação Plana Secundária | <1-100> |
| 27 | Acabamento de Superfície Si-face | CMP polido |
| 28 | Acabamento de Superfície C-face | Polido opticamente |
2. Como controlar a concentração de dopagem da epicamada no processo de fabricação de SiC Epi Wafer?
Controlar o tipo de dopagem e a concentração das camadas epitaxiais é crucial para o desempenho dos dispositivos de potência SiC, que determinam diretamente parâmetros elétricos importantes, como resistência específica e tensão de bloqueio dos dispositivos subsequentes. O método de epitaxia competitiva descoberto pelos pesquisadores pode efetivamente alterar a concentração de dopagem do tipo N e do tipo P em uma ampla faixa e é amplamente utilizado na produção prática. Aqui, explicamos brevemente o princípio do nitrogênio (N) e do alumínio (Al) como elementos de dopagem tipo N e tipo P, respectivamente.
Durante a fabricação da bolacha de epitaxia, os átomos de nitrogênio (N) competem com os átomos de carbono (C) pelas posições da rede. Para reduzir a concentração de dopagem de átomos de nitrogênio (N), a concentração de átomos de carbono (C) na fonte de gás epitaxial deve ser aumentada; em contraste, para reduzir a concentração de átomos de carbono (C) na fonte de gás epitaxial, a concentração de dopagem de átomos de nitrogênio (N) deve ser aumentada. Enquanto os átomos de alumínio (Al) competem com os átomos de silício (Si) pelas posições da rede, você pode aumentar a concentração de átomos de silício (Si) na fonte de gás epitaxial para reduzir a concentração de dopagem dos átomos de alumínio (Al); Em contraste, você pode reduzir a concentração de átomos de silício (Si) na fonte de gás epitaxial para aumentar a concentração de dopagem de átomos de alumínio (Al).
No processamento de epitaxia de SiC, a fonte de gás comumente usada para fontes de Si é SiCl4 ou SiH4; A fonte de gás comumente usada para fonte de C é CCl4 ou C3H8. Podemos controlar a taxa de fluxo dos dois para controlar a taxa de componente C/Si, controlando assim efetivamente a concentração de dopagem de diferentes elementos.
Além disso, a concentração de dopagem da camada epitaxial de SiC está relacionada com a vazão da fonte de gás, pressão do gás e temperatura de crescimento no processo CVD. Tome a dopagem de nitrogênio (N) como um exemplo para maiores explicações. A dopagem com nitrogênio (N) pode ser rapidamente alcançada pela introdução de nitrogênio (N2) no crescimento epitaxial CVD. A partir da Fig.1, podemos saber que a concentração de dopagem nas superfícies de Si e C é positivamente proporcional à taxa de fluxo de N2 dentro de quatro ordens de grandeza em uma proporção fixa de componente C/Si. A concentração de dopagem do processo de fabricação de wafer SiC epi cobre a faixa de dopagem de E14-E18, que é mais comumente usada em dispositivos.

Figura 1Relação entre a concentração de dopagem de nitrogênio (N) e a taxa de fluxo de nitrogênio (N2) na epitaxia 4H-SiC a 1550 ℃
Foi estudada a relação entre a pressão do gás e a concentração de dopagem do processo de fabricação de wafer SiC epi em uma cavidade CVD. Conforme mostrado na Fig. 2, a relação entre a concentração do elemento N e a pressão é investigada sob as condições de temperatura epitaxial de 1600 ℃, relação C/Si de 3,5 e taxa de fluxo de nitrogênio de 12 ml/min. Seja qual for a epitaxia do plano C ou do plano Si de 4H-SiC, a concentração de dopagem da fabricação de wafer semicondutor epi aumenta com o aumento da pressão.

Figura 2Relação entre a concentração do elemento N e a pressão do processo de fabricação de SiC Epi Wafer
3. FAQ sobre SiC Epitaxy for MOS Device
Q:Com base nas especificações fornecidas por você, a estrutura do wafer 4H-SiC é a seguinte:
Epicamada 4H-SiC da 2ª camada (concentração de doping = 1 x 10^16 cm-3)/ Epicamada 4H-SiC da 1ª camada (concentração de doping = 1 x 10^18 cm-3)/ wafer 4H-SiC (resistividade = 0,015-0,028 ohm cm-3)
Estamos planejando usar este wafer para fabricar um capacitor MOS e realizar medições de capacitância-tensão.
Normalmente para bolacha de silício (resistividade = 1-10 ohm), depositaremos uma camada de óxido de metal no topo da bolacha de silício. Depois disso, depositaremos o contato de metal superior e o contato de metal inferior para obter a estrutura Al/Óxido Metálico/Silício/Metal (capacitor MOS) e realizar medições de capacitância-tensão.
Com base em nosso entendimento anterior usando wafer de silício, não seremos capazes de obter a curva capacitância-tensão se a resistividade do wafer de silício for 0,005 ohm (que é conhecido como wafer de silício tipo n altamente dopado).
Gostaríamos de pedir sua opinião se o wafer 4H-SiC proposto é adequado para nosso trabalho de pesquisa, pois a resistividade do wafer 4H-SiC é considerada altamente dopada (0,015-0,028 ohmcm-3) e a 1ª camada de 4H-SiC epilayer está tendo uma alta concentração de dopagem de 10^18 cm-3.
Na verdade, a espessura da epicamada 4H-SiC não é muito importante para o nosso trabalho de pesquisa, mas precisamos ter a concentração de dopagem na faixa de 5 x 10^15 a 5 x 10^16 cm-3. Você tem algum produto padrão produzido pela sua empresa que será mais barato quando comparado com o wafer customizado?
UMA:1) A concentração de dopagem da camada epitaxial de SiC está entre 5×10 ^ 15 e 5×10 ^ 16 cm-3, o que pode ser alcançado na tecnologia epitaxial.
2) Para a resistividade entre 0,8 e 0,1 ohmcm-3, caso não seja possível obter a curva capacitância-tensão devido à baixa resistividade, sugere-se que a concentração epitaxial considere a menor concentração de dopagem (maior resistividade).
Para mais informações, por favor contacte-nos e-mail emvictorchan@powerwaywafer.com e powerwaymaterial@gmail.com.

