Hyung Koun Cho ∗
Departamento de Engenharia Metalúrgica, Dong-A University, Busan 604-714
Jeong Yong Lee
Departamento de Ciência e Engenharia de Materiais,
Instituto Avançado de Ciência e Tecnologia da Coreia, Daejon 305-701
Nós investigamos a formação de poços em forma de V em filmes de nitreto como InGaN / GaN e AlGaN / GaN crescidos em substrato de safira usando microscopia eletrônica de transmissão. O mecanismo de formação de fossas depende fortemente das composições de índio (In) e alumínio (Al) em InxGa1 − xN e AlxGa1 − xN camadas, respectivamente. Com o aumento da composição do índio, os poços em forma de V originaram-se do vértice dos deslocamentos de rosqueamento para os limites de incompatibilidade de empilhamento induzidos por falhas de empilhamento e o crescimento tridimensional da ilha no estágio inicial devido à grande incompatibilidade de rede. Com o aumento da composição do alumínio, a origem das covas também variou desde a ondulação da superfície devido à deformação elástica do desajuste até o vértice dos deslocamentos de rosca.
Números PACS: 61,72.Ff, 68,55.Ln, 68,55.-a
Palavras-chave: Pit, Nitride, TEM, AlGaN, InGaN
I. INTRODUÇÃO
Semicondutores baseados em GaN Wurtzite (GaN, InGaN e AlGaN) estão atualmente sob enorme investigação como materiais promissores para dispositivos optoeletrônicos, de alta temperatura e de alta potência devido a algumas propriedades, como grande banda direta direta, alta estabilidade térmica e forte interatômica ligações [1, 2]. Para emxGa1 − xN e AlxGa1 − xCamadas de N crescidas em GaN, um aumento nas composições de índio (In) e alumínio (Al) podem inevitavelmente causar deformações inadequadas em filmes. Além de uma espessura crítica, vários defeitos estruturais, como deslocamentos desajustados, falhas de empilhamento, poços em forma de V, etc., são gerados pela relaxação plástica [3, 4]. No entanto, também em espessuras menores, o relaxamento elástico pode ser induzido pela formação de ilhas, ondulação da superfície, etc., conforme observado em InGaP / InAsP, In0,77Ga0,23As / InGaAs, SiGe / Si e assim por diante [5-7 ]Além disso, um aumento na composição pode causar a falta de homogeneidade química do InxGa1 − xN camadas de poços devido à baixa miscibilidade entre InN e GaN [8, 9].A baixa solubilidade de In em GaN foi calculada para ser inferior a 6% a 800 ◦C usando o modelo de Stringfellow [10].Essas propriedades podem influenciar significativamente as propriedades ópticas e estruturais dos dispositivos [11, 12].
Recentemente, relatamos dois modelos de formação de poços em forma de V em poços quânticos múltiplos InGaN / GaN (MQWs) com alta composição de In [13]. Além disso, a indesejabilidade e o efeito nas propriedades de emissão desses poços foram previamente demonstrados por microscopia eletrônica de transmissão (TEM), catodeluminescência e fotoluminescência [3, 14, 15]. Para a supressão da formação de fossas, portanto, um entendimento claro dos mecanismos de formação de fossas é necessário e a microestrutura das cavidades observada em vários filmes de nitreto III crescidos em substrato de safira deve ser avaliada em detalhes. Neste trabalho, investigamos a formação de fossas originadas de diferentes fontes em heteroestruturas InGaN / GaN e AlGaN / GaN com várias composições de In e Al usando TEM.
II. EXPERIMENTAL
Todas as amostras foram cultivadas em substratos de safira de plano C com uma camada de nucleação de GaN de 25 nm de espessura nominal por um reator de deposição de vapor químico metalorgânico horizontal operando a baixa pressão. Trimetilgálio, trimetilíndio, trimetilalumínio e amônia foram usados como os precursores de fonte para Ga, In, Al e N, respectivamente. A fim de analisar o efeito da deformação no mecanismo de formação de fossas em III-nitretos, camadas espessas de InxGa1 − xN (∼ 800 ˚A) foram cultivadas em temperaturas variando de 830 ◦C (xEm = 35%) a 880 ◦C (xEm = 10%) e camadas grossas de AlxGa1-xN (1000 A) foram cultivadas a 1040 ◦C após o crescimento da camada subjacente de GaN dopada com Si de ∼2 mm de espessura a 1080 ◦C. As composições In e Al no InxGa1 − xN e AlxGa1 − xAs camadas de N eram de 10, 13, 19 e 35% e 16, 25, 44 e 54%, respectivamente.
A fim de caracterizar a formação de fossas de III-nitretos, espécimes TEM foram preparados em seção transversal ao longo do eixo da zona [11-20] usando polimento mecânico de tripé seguido por moagem de íon de Ar em baixa temperatura a 4,5 kV em um Gatan DuoMill 660 DIF com velocidade de setor ao controle. A energia iônica foi gradualmente reduzida durante os estágios finais de desbaste para minimizar os danos à superfície das amostras. Imagens de campo claro (BF) e imagens TEM de alta resolução (HRTEM) foram registradas em um JEOL JEM-2000EX TEM a 200 kV e JEOL JEM-3010EX a 300 kV.
III. RESULTADOS E DISCUSSÃO
Para investigar o efeito da composição de Al na formação do poço, micrografias TEM de campo claro transversal do AlxGa1 − xCamadas de N crescidas com várias composições de Al na camada tampão de GaN foram obtidas como mostrado na Fig. 1. A composição teórica crítica de Al na formação do deslocamento desajustado no Al 1000 AxGa1 − xA camada de N crescida em camadas de GaN é inferior a 15% [16]. Nenhum poço é detectado no AlxGa1 − xCamadas N com composição de até 25% de Al. Apenas falhas de empilhamento e rachaduras nas camadas AlGaN são observadas devido à deformação de desajuste e à diferença do coeficiente térmico, respectivamente (não mostrado). Para o Al0.44Ga0.56Amostra N / GaN, no entanto, a superfície do Al0.44Ga0.56A camada N mostra muitos poços que não estão associados a defeitos estruturais, como deslocamentos de rosca, falhas de empilhamento e assim por diante [Figs. 1 (b) e (d)]. O tamanho desses poços é muito pequeno, um diâmetro médio de 7 nm e uma altura média de ∼3 nm, em comparação com os poços em camadas InGaN crescidas em GaN [13, 14, 16]. Acredita-se que a formação de poços em Al0.44Ga0.56N / GaN pode ser atribuído à ondulação da superfície pelo aumento da deformação elástica desajustada, conforme observado em sistemas semicondutores III-V e II-VI [5, 6].
A densidade do poço é superior a 1010 cm−2 na superfície. Por outro lado, deslocamentos desajustados são gerados na interface do Al0.54Ga0.46Amostra N / GaN a fim de relaxar plasticamente a cepa desajustada armazenada como mostrado na Fig. 1 (c). Além disso, poços em forma de V associados a deslocamentos de rosca no fundo são observados como heteroestruturas InGaN / GaN. Essas cavidades em forma de V têm uma pirâmide hexagonal aberta invertida com paredes laterais [14, 16].
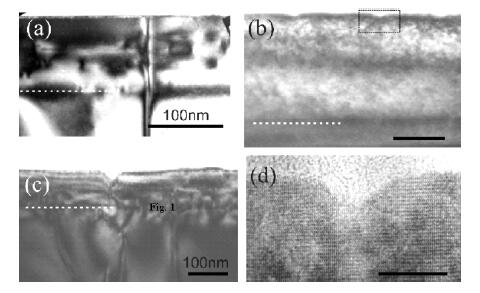
Fig. 1 Imagens TEM de campo claro transversal usando g = 0002 do AlxGa1 − xCamadas N crescidas com a composição de Al de (a) 16%, (b) 44% e (c) 54%. (d) Imagem HRTEM obtida a partir do retângulo tracejado em (b). As linhas tracejadas indicam o AlxGa1 − xInterface N / GaN.
Em conseqüência, classificamos a origem da formação do poço no AlxGa1 − xN cresceu na camada tampão de GaN em dois modelos, como mostrado nas Figs. 4 (a) e (d). Para o AlxGa1 − xCamada N com ∼40% de composição de Al, poços são gerados pela ondulação da superfície devido à deformação elástica desajustada armazenada [Fig. 4 (d)]. Para o AlxGa1 − xCamada N com mais de ∼50% de composição de Al, no entanto, as pontuações são geradas principalmente no vértice dos deslocamentos de rosca [Fig. 4 (a)].
A Figura 2 mostra as micrografias TEM de campo claro em seção transversal do InxGa1 − xCamadas N crescidas com várias composições In na camada tampão GaN. A crítica teórica Em composição sobre a formação do deslocamento desajustado do ∼800˚A EmxGa1 − xO N crescido em camadas de GaN é inferior a 5%, abaixo do qual as camadas de InGaN mostram um crescimento coerente [16]. Portanto, esperamos que a composição In de todos os InxGa1 − xN camadas estudadas aqui para ter um valor mais do que a composição crítica de In na formação do deslocamento desajustado. Para em0.1Ga0.9N / GaN, nenhum defeito estrutural, como deslocamentos desajustados, falhas de empilhamento, poços, etc., foram observados dentro da camada In0.1Ga0.9N. Com um aumento adicional na composição In do InxGa1 − xCamada N (xEm = 13%), os poços em forma de V são gerados para relaxar a cepa desajustada armazenada, conforme relatado anteriormente [14]. Foi relatado que uma fossa em forma de V está sempre conectada com um deslocamento de rosqueamento da camada tampão de GaN na parte inferior e apenas uma pequena fração dos deslocamentos de rosqueamento causa a formação de poços em forma de V nas camadas InGaN e os MQWs InGaN / GaN [14]. No entanto, a densidade dos poços em forma de V no In0.19Ga0.81A camada N na Fig. 2 (c) tem um valor maior do que a densidade de deslocamento de rosca na camada tampão de GaN, o que indica que a formação de poços em forma de V no InGaN com alta composição de In tem uma origem diferente, conforme relatado anteriormente para os sistemas InGaN / GaN MQW [13]. Relatamos que nos MQWs InGaN / GaN com composição alta (∼ 30% Na composição), a maioria dos poços em forma de V são gerados a partir de limites de incompatibilidade de empilhamento induzidos por falhas de empilhamento [13]. Embora o em0.19Ga0.81N / GaN usado aqui tem uma composição In de menos de 20%, a parte dos poços em forma de V se originam de limites de incompatibilidade de empilhamento induzidos por falhas de empilhamento devido ao aumento da espessura da camada InGaN [Fig. 3 (a)] em comparação com o InGaN / GaN MQW. Para em0.35Ga0.65N / GaN, poços em forma de V com uma densidade de mais de 1010 cm−2 são observados na superfície. Ao contrário dos poços no In0.19Ga0.81Amostra N / GaN, o In0.35Ga0.65N regiões com superfícies superiores planas (0001) entre os poços têm um grande número de falhas de empilhamento e limites de incompatibilidade de empilhamento formados no estágio de crescimento inicial de InGaN [Fig. 3 (b)], isto é, estruturas colunares incluindo falhas de empilhamento. Para relaxar a grande incompatibilidade de rede entre0.35Ga0.65N e GaN, o In inicial0.35Ga0.65A camada N cresceu com a morfologia de ilhas facetadas tridimensionais (3D) [17]. Uma alta densidade de falhas de empilhamento é claramente vista nas ilhas e os limites entre os subgrãos por ilhas são visíveis como o crescimento de uma camada de nucleação de GaN crescida em substrato de safira [18].
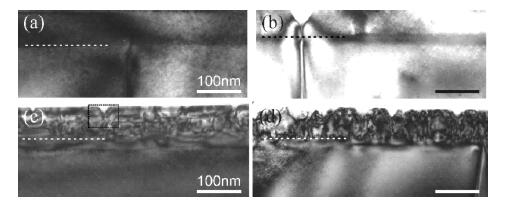
Fig. 2 Imagens TEM de campo claro transversal usando g = 0002 do InxGa1 − xCamadas N crescidas com a composição In de (a) 10%, (b) 13%, (c) 19% e (d) 35% na camada tampão de GaN. As linhas tracejadas indicam oxGa1 − xInterface N / GaN.
Portanto, pensamos que os poços no In0.35Ga0.65Amostras N / GaN são causadas por tal crescimento 3D devido ao desajuste da rede no crescimento inicial da camada InGaN.
Como resultado, classificamos a origem da formação de fossas no InxGa1-xN cresceu na camada tampão de GaN em três modelos, conforme mostrado na Fig. 4 (a), (b) e (c). Para o InxGa1-xCamada N com baixa composição, pontuações são geradas no vértice dos deslocamentos de rosca [Fig. 4 (a)]. Para o InxGa1-xCamada N com composição média, os poços são gerados principalmente a partir dos limites de incompatibilidade de empilhamento induzidos por falhas de empilhamento [Fig. 4 (b)]. Um aumento adicional na composição do InxGa1-xA camada N resulta no crescimento da ilha 3D no estágio inicial e na formação de fossas no crescimento contínuo [Fig. 4 (c)].
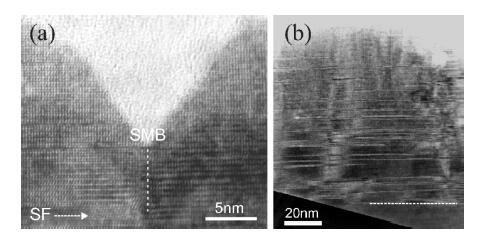
Fig. 3 (a) Imagem HRTEM obtida a partir do retângulo tracejado da Fig. 2 (c). A cava em forma de V observada tem uma falha de empilhamento nos planos (0001) em sua posição inferior. (b) Imagem HRTEM obtida do In0.35Ga0.65N na camada de buffer GaN.
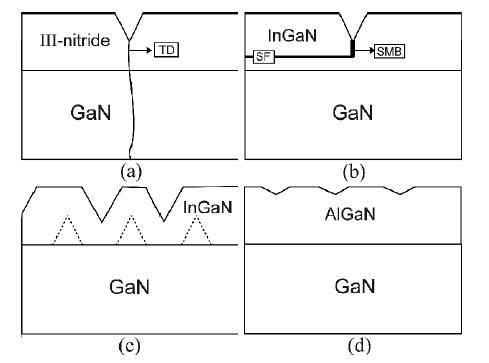
Fig. 4 Modelos esquemáticos para a formação de fossos relacionados com (a) um deslocamento de rosqueamento observado em heteroestruturas InGaN / GaN e AlGaN / GaN, (b) um limite de incompatibilidade de empilhamento induzido por falhas de empilhamento e (c) o crescimento da ilha 3d no estágio inicial observada em uma heteroestrutura InGaN / GaN, e (d) a ondulação da superfície devido à deformação elástica inadequada observada em uma heteroestrutura AlGaN / GaN.
4. RESUMO
A formação do poço em InxGa1-xN e AlxGa1-xCamadas N com várias composições In e Al crescidas nas camadas tampão GaN foram estudadas usando TEM. Descobrimos que os poços foram formados a partir de várias origens, como deslocamentos de rosca, limites de incompatibilidade de empilhamento, crescimento da ilha 3D e ondulação da superfície dependendo das composições de In e Al.
AGRADECIMENTOS
Este trabalho foi apoiado por uma bolsa nº R01-2002- 000-00096-0 da Fundação de Ciência e Engenharia da Coreia e Programa de Pesquisa da Universidade do Ministério da Informação e Comunicação da República da Coreia.
REFERÊNCIAS
[1] H. Morkoc, Nitride Semiconductors and Devices (Springer, Heidelberg, 1999).
[2] YS Park, J. Korean Phys. Soc. 34, S199 (1999).
[3] HK Cho, JY Lee, CS Kim, GM Yang, N. Sharma e CJ Humphreys, J. Cryst. Growth 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim e GM Yang, J. Korean Phys. Soc. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard e RA Masut, J. Appl. Phys. 81, 3501 (1997).
[6] M. Mitsuhara, M. Ogasawara e H. Sugiura, J. Cryst. Growth 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang e JJ Harris, Semicond. Sci. Technol. 15, 370 (2000).
[8] D. Doppalapudi, SN Basu, KF Ludwig, Jr. e TD Moustakas, J. Appl. Phys. 84, 1389 (1998).
[9] T. Takeuchi, H. Takeuchi, S. Sota, H. Sakai, H. Amano e I. Akasaki, Jpn. J. Appl. Phys. 36, L177 (1997).
[10] GB Stringfellow, J. Cryst. Growth 58,194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson e R. Stall, J. Cryst . Growth 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Hong, E.-K. Suh, HJ Lee, HK Cho e JY Lee, J. Korean Phys. Soc. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang e CS Kim, Appl. Phys. Lett. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars e JS Speck e SJ Rosner, Appl. Phys. Lett. 72, 692 (1998).
[15] G. Pozina, JP Bergman, B. Monemar, T. Takeuchi, H. Amano e I. Akasaki, J. Appl. Phys. 88, 2677 (2000).
[16] JW Matthews e AE Blakeslee, J. Cryst. Growth 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, JZ Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts e SM Bedair, J. Electron. Mater. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan e S. Mahajan, Appl. Phys. Lett. 77, 3391 (2000).
