PAM-XIAMEN pode oferecer AlGaAs / GaAs p-HEMT (transistor pseudomórfico de alta mobilidade de elétrons), wafer epitaxial de heteroestrutura crescida por processo MBE ou MOCVD. A heteroestrutura possui um canal de condução de alta mobilidade formado por gás de elétron bidimensional, que é um material ideal para aplicações sem fio. A largura da linha de nosso processo GaAs pHEMT é de cerca de 0,15-0,5μm, muito baixa, mas com características de frequência ultra-alta e baixo ruído e a frequência de operação pode ser tão alta quanto 100 GHz. As especificações específicas do wafer epiaxi GaAs pHEMT são as seguintes, também podemos fornecer Epi-wafers de GaAs:

1. GaAs pHEMT Wafer Specifications
No. 1 LN pHEMT Epi Structure (PAM160711-GAAS)
| Camada | Material | x | dopante | Concentration | Espessura (A) | Observações |
| 12 | n+-GaAs | – | Si | 5,0E + 18 cm-3 | 500 | – |
| 11 | n-AlAs | – | Si | – | – | – |
| 10 | n-AlxGa1-xComo | 0.22 | Si | – | – | – |
| 9 | Si | – | Si | 5,0E + 12 cm-2 | – | – |
| 8 | AlxGa1-xComo | 0.22 | – | – | 30 | – |
| 7 | EmxGa1-xComo | – | – | – | – | – |
| 6 | GaAs | – | – | – | – | – |
| 5 | AlAs | – | – | – | – | – |
| 4 | GaAs | – | – | – | – | – |
| 3 | AlAs | – | – | – | – | – |
| 2 | AlxGa1-xAs / GaAs | 0.22 | – | – | 185/15 | 10 X SLs |
| 1 | GaAs | – | – | – | 5000 | – |
| Substrato SI GaAs | ||||||
No.2 Power pHEMT Epitxial Structure (PAM160711-GAAS)
| Camada | Material | x | dopante | Concentration | Espessura (A) | Observações |
| 13 | n+-GaAs | – | Si | – | 500 | – |
| 12 | n-AlAs | – | – | – | – | – |
| 11 | GaAs | – | – | – | – | |
| 10 | n-AlxGa1-xComo | 0.24 | Si | – | – | – |
| 9 | Si | – | Si | 3,0E + 12 cm-2 | – | – |
| 8 | AlxGa1-xComo | – | – | – | 25 | – |
| 7 | EmxGa1-xComo | – | – | – | – | – |
| 6 | AlxGa1-xComo | – | – | – | 30 | – |
| 5 | Si | – | Si | 1,0E + 12 cm-2 | – | – |
| 4 | AlxGa1-xComo | – | – | – | – | – |
| 3 | GaAs | – | – | – | – | – |
| 2 | AlxGa1-xComo | 0.24 | – | – | – | – |
| 1 | GaAs | – | – | – | – | – |
| Substrato SI GaAs | ||||||
No.3 GaAs Epi Wafers for pHEMTs (PAM161121-PHEMT)
| Layer material with doping | Espessura (A) | Doping level | Composition | Note |
| n+-GaAs | 400 | – | – | – |
| AlAs | – | – | – | – |
| GaAs | – | – | – | – |
| n-AIGaAs | – | 3E+17cm-3 | – | – |
| GaAs | 9 | – | – | – |
| Si | – | – | – | – |
| GaAs | – | – | – | – |
| i-AIGaAs | – | – | – | Spacer |
| i-GaAs | – | – | – | – |
| i-InGaAs | – | – | – | – |
| i-GaAs | – | – | – | – |
| i-AIGaAs | – | – | 0.24 | – |
| GaAs | – | – | – | |
| Si | – | 1.5E+12cm-2 | – | – |
| GaAs | 9 | – | – | – |
| i-AIGaAs | – | – | – | – |
| AIGaAs 100A/GaAs 20A superlattice 15 periods | – | – | – | – |
| i-GaAs | – | less than 5E+14cm-3 | – | – |
| S.I. GaAs substrate |
We also can provide InP-based pHEMT epitaxial wafer:
PAM160526-INP
| Camada | Material | Concentration | Thickness |
| 8 | N+ InxGa1-xComo | – | 20nm |
| 7 | N+ InP etch stopper | – | – |
| 6 | i-InxAl1-xAs Schottky barrier | – | – |
| 5 | Si-delta-doping | n=6×1012 cm-2 | – |
| 4 | i-InxAl1-xAs spacer | – | – |
| 3 | i-InxGa1-xAs channel | – | – |
| 2 | EmxAl1-x As buffer | – | 300nm |
| 1 | metamorphic buffer (linearly graded from substrate to
EmxGa1-x As) |
– | – |
| InP substrate |
Nos últimos anos, com a popularização e aplicação dos sistemas de comunicação móvel e Internet sem fio, uma forte demanda por produtos de dispositivos semicondutores foi estimulada. Os materiais epitaxiais semicondutores são uma base importante para dispositivos usados em comunicações sem fio. Para atender às exigências do mercado de qualidade e custo do produto, é muito importante desenvolver um processo estável e de alta capacidade. GaAs pHEMT tem excelente desempenho como líder em aplicações sem fio e mudou para a produção em massa. Portanto, o desenvolvimento de um processo epitaxial eficiente desempenha um papel importante na redução de custos e tempo de resposta do mercado. A epitaxia por feixe molecular (MBE) é o principal método técnico para o cultivo de materiais epitaxiais de GaAs pHEMT. Comparado com outros métodos de crescimento, como a deposição de vapor químico orgânico de metal (MOCVD), o MBE tem maior precisão e estabilidade de controle.
2. Sobre GaAs pHEMT Material Epitaxial
O 2-DEG em pHEMT é mais restrito do que o HEMT comum: há uma restrição dupla em ambos os lados do poço de potencial, portanto, ele tem uma densidade de superfície de elétrons mais alta (cerca de 2 vezes maior). Ao mesmo tempo, a mobilidade do elétron também é maior do que no GaAs. Portanto, o desempenho do pHEMT é mais superior. A estrutura epitaxial de GaAs pHEMT de dupla heterojunção não só melhora a estabilidade da temperatura da tensão de limiar do dispositivo, mas também melhora as características volt-ampere de saída do dispositivo, de modo que o dispositivo tenha uma resistência de saída maior, uma transcondutância maior e uma maior capacidade de manuseio atual e maior frequência de operação, menor ruído e assim por diante.
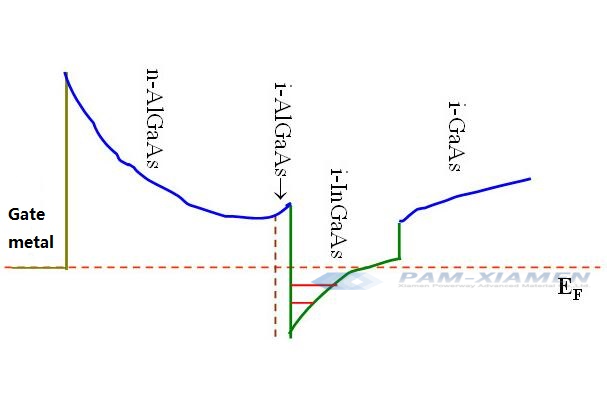
Diagrama de banda de energia de heterojunção pHEMT
A mobilidade do canal de materiais epitaxiais GaAs pHEMT é um dos indicadores mais importantes. O aumento da mobilidade do canal pode melhorar efetivamente o desempenho DC e RF dos produtos pHEMT de arsenieto de gálio (como o transistor GaAs pHEMT, amplificador GaAs pHEMT e MMIC), o que tem grandes efeitos nos parâmetros de aplicação, como transcondutância, resistência no estado, corte frequência, figura de ruído, ganho de RF e eficiência de conversão de energia.
3. Sobre GaAs pHEMT
pHEMT é uma estrutura aprimorada de transistor de alta mobilidade de elétrons (HEMT), também conhecido como transistores de alta mobilidade de elétrons pseudo-combinados (pHEMT), que é um transistor de potência GaAs de radiofrequência feito usando uma camada epitaxial especial crescida em GaAs pode atingir baixa tensão e alta eficiência quando usado em telefones celulares e modems de radiofrequência.
A aplicação do GaAs pHEMT é em bandas de frequência de ondas de microondas e milimétricas devido às excelentes propriedades de alta mobilidade de elétrons, alta eficiência de modulação de corrente e baixa perda. À medida que a frequência de operação do dispositivo entra na banda de frequência de onda milimétrica, a influência dos efeitos parasitários no desempenho do dispositivo torna-se muito óbvia. O modelo é a base do projeto do circuito, e o método de extrair com precisão os parâmetros do modelo dos efeitos parasitas de alta frequência do transistor sempre foi um ponto importante de pesquisa na indústria.
Com o desenvolvimento contínuo de componentes e infraestrutura de comunicação sem fio 5G, a tecnologia GaAs pHEMT desempenhará um papel fundamental para atender às múltiplas características das novas redes sem fio. No desenvolvimento de componentes-chave 5G, continuamos a melhorar nosso fluxo de processo GaAs pHEMT para fornecer uma gama completa de produtos relacionados em rádios digitais lineares, banda V, banda E e aplicações de radar de banda W.

Para obter mais informações, entre em contato conosco pelo e-mail victorchan@powerwaywafer.com e powerwaymaterial@gmail.com.
