Nanofabrication Photoresist
PAM-XIAMEN Oferece placa fotorresistente com fotorresistente
- Descrição
Descrição do produto
nanofabricação
Ofertas PAM-XIAMENfotoresistenteplaca comfotoresistente
Um fotorresiste é um material sensível à luz usado em vários processos, comofotolitografiae fotogravura, para formar um revestimento padronizado em uma superfície, o que é crucial em toda a indústria eletrônica.
Um resistor positivo é um tipo de fotorresiste no qual a parte do fotorresiste que é exposta à luz torna-se solúvel no revelador do fotorresiste. A parte não exposta do fotorresiste permanece insolúvel para o revelador do fotorresiste.
Um fotorresiste negativo é um tipo de fotorresiste no qual a porção do fotorresiste que é exposta à luz torna-se insolúvel para o revelador fotorresistente. A parte não exposta do fotorresiste é dissolvida pelo revelador do fotorresiste.
Com base na estrutura química dos fotorresistentes, eles podem ser classificados em três tipos: Fotopoliméricos, fotodecompostos, fotorreticulados, fotorresistentes.
Aplicações fotorresistentes:
Impressão de microcontato
Fabricação de placas de circuito impresso (PCB)
Padronização e gravação de substratos
microeletrônica
fotorresiste Microposit
Futurrex
outros fotorresistentes,
entre em contato conosco para informações detalhadas
Substrato substrato de silício 2″3″4″5″6″8″
substrato de quartzo SSP/DSP
substrato de vidro N/P
SiO2 substrato 100/110/111
outro substrato,
entre em contato conosco para informações detalhadas
Diferenças entre resistência positiva e negativa
| Característica | Positivo | Negativo |
| Adesão ao Silício | Feira | Excelente |
| Custo relativo | Mais caro | Menos caro |
| Base de desenvolvedores | Aquoso | Orgânico |
| Solubilidade no revelador | A região exposta é solúvel | A região exposta é insolúvel |
| Recurso Mínimo | 0,5 µm | 2 µm |
| Cobertura de Etapas | Melhor | Lower |
| Resistência química úmida | Feira | Excelente |
Uma única iteração defotolitografiacombina vários passos em sequência. Salas limpas modernas usam sistemas automatizados e robóticos de rastreamento de wafer para coordenar o processo. O procedimento descrito aqui omite alguns tratamentos avançados, como agentes de desbaste ou remoção de rebordo.Procedimento básico
Limpeza
Se houver contaminações orgânicas ou inorgânicas na superfície do wafer, elas geralmente são removidas por tratamento químico úmido, por exemplo, o procedimento de limpeza RCA baseado em soluções contendo peróxido de hidrogênio. Outras soluções feitas com tricloroetileno, acetona ou metanol também podem ser usadas para limpar.
Preparação
A bolacha é inicialmente aquecida a uma temperatura suficiente para remover qualquer umidade que possa estar presente na superfície da bolacha, 150°C por dez minutos é suficiente. Os wafers que estiveram armazenados devem ser limpos quimicamente para remover a contaminação. Um “promotor de adesão” líquido ou gasoso, tal como Bis(trimetilsilil)amina (“hexametildissilazano”, HMDS), é aplicado para promover a adesão do fotorresiste ao wafer. A camada superficial de dióxido de silício no wafer reage com o HMDS para formar dióxido de silício trimetilado, uma camada altamente repelente à água não muito diferente da camada de cera na pintura de um carro. Essa camada repelente à água evita que o revelador aquoso penetre entre a camada fotorresistente e a superfície do wafer, evitando assim o chamado levantamento de pequenas estruturas fotorresistentes no padrão (revelador). Para garantir a revelação da imagem, é melhor cobri-la e colocá-la sobre uma chapa quente e deixar secar estabilizando a temperatura em 120 °C.
Aplicação fotorresistente
O wafer é coberto com fotorresistente por revestimento giratório. Uma solução líquida e viscosa de fotorresistente é aplicada no wafer, e o wafer é girado rapidamente para produzir uma camada uniformemente espessa. O revestimento giratório normalmente funciona a 1200 a 4800 rpm por 30 a 60 segundos e produz uma camada entre 0,5 e 2,5 micrômetros de espessura. O processo de revestimento por rotação resulta em uma camada fina uniforme, geralmente com uniformidade de 5 a 10 nanômetros. Essa uniformidade pode ser explicada pela modelagem fluida-mecânica detalhada, que mostra que a resistência se move muito mais rapidamente no topo da camada do que na parte inferior, onde forças viscosas ligam a resistência à superfície do wafer. Assim, a camada superior de resistência é rapidamente ejetada da borda do wafer, enquanto a camada inferior ainda se arrasta lentamente radialmente ao longo do wafer. Desta forma, qualquer 'saliência' ou 'saliência' de resist é removido, deixando uma camada muito plana. A espessura final também é determinada pela evaporação dos solventes líquidos do resist. Para recursos muito pequenos e densos (< 125 ou mais nm), espessuras de resistência mais baixas (< 0,5 micrômetros) são necessárias para superar os efeitos de colapso em altas proporções; as proporções de aspecto típicas são < 4:1.
O wafer revestido com fotorresiste é então pré-cozido para eliminar o excesso de solvente fotorresistente, normalmente a 90 a 100 °C por 30 a 60 segundos em uma placa de aquecimento.
Exposição e desenvolvimento
After prebaking, the photoresist is exposed to a pattern of intense light. The exposure to light causes a chemical change that allows some of the photoresist to be removed by a special solution, called “developer” by analogy with photographic developer. Positive photoresist, the most common type, becomes soluble in the developer when exposed; with negative photoresist, unexposed regions are soluble in the developer.
A post-exposure bake (PEB) is performed before developing, typically to help reduce standing wave phenomena caused by the destructive and constructive interference patterns of the incident light. In deep ultraviolet lithography, chemically amplified resist (CAR) chemistry is used. This process is much more sensitive to PEB time, temperature, and delay, as most of the “exposure” reaction (creating acid, making the polymer soluble in the basic developer) actually occurs in the PEB.
The develop chemistry is delivered on a spinner, much like photoresist. Developers originally often contained sodium hydroxide (NaOH). However, sodium is considered an extremely undesirable contaminant in MOSFET fabrication because it degrades the insulating properties of gate oxides (specifically, sodium ions can migrate in and out of the gate, changing the threshold voltage of the transistor and making it harder or easier to turn the transistor on over time). Metal-ion-free developers such as tetramethylammonium hydroxide (TMAH) are now used.
A bolacha resultante é então “cozida duramente” se uma resistência não amplificada quimicamente foi usada, normalmente de 120 a 180 °C [carece de fontes] por 20 a 30 minutos. O cozimento duro solidifica o fotorresistente restante, para criar uma camada protetora mais durável em futuras implantações de íons, corrosão química úmida ou corrosão por plasma.
Gravura
No ataque químico, um agente químico líquido (“úmido”) ou plasma (“seco”) remove a camada superior do substrato nas áreas não protegidas pelo fotorresistente. Na fabricação de semicondutores, geralmente são usadas técnicas de corrosão a seco, pois podem ser anisotrópicas, a fim de evitar uma redução significativa do padrão fotorresistente. Isso é essencial quando a largura dos recursos a serem definidos é semelhante ou menor que a espessura do material que está sendo gravado (ou seja, quando a relação de aspecto se aproxima da unidade). Os processos de corrosão úmida são geralmente de natureza isotrópica, o que muitas vezes é indispensável para sistemas microeletromecânicos, onde estruturas suspensas devem ser “liberadas” da camada subjacente.
O desenvolvimento do processo de condicionamento seco anisotrópico de baixa defectividade permitiu que as características cada vez menores definidas fotolitograficamente no resist fossem transferidas para o material do substrato.
Remoção de fotorresistente
Depois que um fotorresiste não é mais necessário, ele deve ser removido do substrato. Isso geralmente requer um líquido “resiste stripper”, que altera quimicamente o resist para que ele não adira mais ao substrato. Alternativamente, o fotorresistente pode ser removido por um plasma contendo oxigênio, que o oxida. Esse processo é chamado de incineração e se assemelha à corrosão seca. O uso do solvente 1-Metil-2-pirrolidona (NMP) para fotorresistente é outro método usado para remover uma imagem. Quando a resistência estiver dissolvida, o solvente pode ser removido por aquecimento a 80 °C sem deixar nenhum resíduo.
Microposit S1800 G2 Series Photoresist
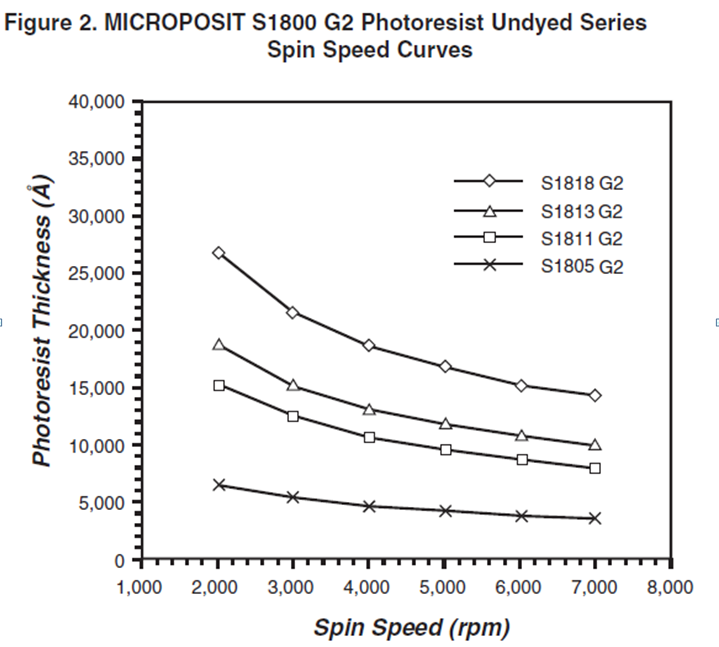
Microposit S1800 G2 Series Photoresist
RESISTÊNCIA NEGATIVA NR9-6000PY

RESISTÊNCIA NEGATIVA NR9-6000P