AlGaInP на основе GaAsпластина лазерного диода can be supplied by PAM-XIAMEN with a band of 635nm. The III-V AlGaInP semiconductor material that can be lattice matched with the GaAs substrate has a wide direct band gap (1.9~2.3eV), a wide range of luminous wavelengths and high luminous efficiency. AlGaInP is the best material for preparing high-brightness red, orange, and yellow lasers and light-emitting diodes (LEDs). Following is a 635nm visible diode laser epi structure of GaInP / AlGaInP for reference:
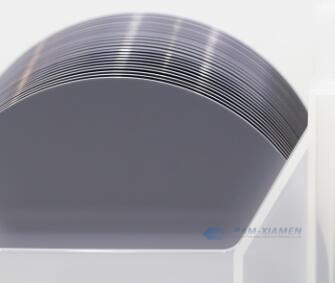
1. Эпиструктура лазерного диода AlGaInP на подложке GaAs
ПАМ210709-635ЛД
| Слой | Материал | Мольная доля (x) | Мольная доля (г) | Напряжение (%) | PL (нм) | Толщина слоя (мкм) | Легирование (Е+18/см3) | Тип | добавка |
| 12 | GaAs | 0.2 | >100 | P++ | C | ||||
| 11 | Прирост(Икс)P | 0.49 | – | – | p | Mg | |||
| 10 | (АльyПрирост(Икс)P | 0.485 | – | p | Mg | ||||
| 9 | АлИн(Икс)P | 0.485 | – | p | Mg | ||||
| 8 | АлИн(Икс)P | 0.485 | 0.3 | p | Mg | ||||
| 7 | (АльyПрирост(Икс)P | 0.485 | UD | ||||||
| 6 | Прирост(Икс)P | XX | 627 | UD | |||||
| 5 | (АльyПрирост(Икс)P | 0.485 | UD | ||||||
| 4 | АлИн(Икс)P | 0.485 | – | n | си | ||||
| 3 | АлИн(Икс)P | 0.485 | – | n | си | ||||
| 2 | Прирост(Икс)P | 0.49 | – | n | си | ||||
| 1 | GaAs | 0.5 | – | n | си |
2. Зачем выращивать структуру GaInP/AlGaInP LD на неугловой подложке GaAs?
Материалы GaInP / AlGaInP лазеров с квантовыми ямами ограничения деформации сжатия получены методом однократного эпитаксиального роста MOCVD. Использование деформации сжатия в активной области может снизить пороговый ток и рабочий ток при одновременном повышении эффективности. Поскольку материалы GaInP и AlGaInP могут легко образовывать метастабильные упорядоченные структуры в процессе эпитаксии MOCVD, чего следует по возможности избегать в лазерах, а неупорядоченные структуры имеют более узкую ширину спектральной линии усиления. Чтобы избежать образования упорядоченной структуры при выращивании MOCVD материалов GalnP / AlGaInP, в лазерах с квантовыми ямами AlGaInP обычно используются подложки GaAs, расположенные под углом. Более того, неугловая подложка может увеличить концентрацию легирования p-типа в удерживающем слое, тем самым увеличивая эффективный барьер электронов в активной области, уменьшая утечку носителей и помогая улучшить высокотемпературные характеристики устройства.
3. Зачем выращивать MQW из AlGaInP, а не из DH?
По сравнению с DH (двойной гетеропереход) структура MQW (множественная квантовая яма) AlGalnP может генерировать более высокую плотность носителей, тем самым увеличивая эффективность радиоактивной рекомбинации; эффективно сократить длину светоизлучающей области, тем самым уменьшая самопоглощение фотонов материалом. МКЯ GaInP / AlGaInP создает квантово-размерный эффект, предотвращает загрязнение материалов AlGaInP с высоким содержанием алюминия кислородом и эффективно уменьшает длину волны излучения при низком составе алюминия. Поэтому матрица лазерных диодов AlGaInP выращивается со структурой с несколькими квантовыми ямами вместо перехода лазерного диода AlGaInP, широко используемого в оптоэлектронных устройствах, таких как LD и LED и т. Д.
4. О легирующей примеси слоя AlInP в эпитаксиальной структуре AlGaInP LD
Для решения проблемы утечки носителей в качестве плакирующих слоев используется AlInP с наибольшей полосой пропускания. Из-за низкого показателя преломления он может сильно ограничивать волны светопроводимости. А слои AlInP необходимо сильно легировать p-типом или n-типом, получая максимально высокую электропроводность. Доказано, что из-за более низкой диффузионной способности и лучшей управляемости Mg более подходит для использования в качестве легирующей примеси p-типа для AlInP, чем Zn. Между тем, обнаружено, что добавление нелегированного барьера Mg в слои оболочки Al(Ga)InP может улучшить эффективность излучения лазерного диода AlGaInP.
Что касается легирования n-типа плакирующих слоев AlInP, обычно Si используется в качестве легирующей примеси n-типа для эпитаксиальных слоев AlInP.
Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресу victorchan@powerwaywafer.com и powerwaymaterial@gmail.com.

