PAM-XIAMEN может предложить эпитаксиальную пластину с гетероструктурой AlGaAs / GaAs p-HEMT (псевдоморфный транзистор с высокой подвижностью электронов), выращенную методом MBE или MOCVD. Гетероструктура имеет канал проводимости с высокой подвижностью, образованный двумерным электронным газом, который является идеальным материалом для беспроводных приложений. Ширина линии нашего процесса GaAs pHEMT составляет около 0,15-0,5 мкм, что очень мало, но со сверхвысокой частотой и низкими шумовыми характеристиками, а рабочая частота может достигать 100 ГГц. Конкретные характеристики эпиоксидной пластины GaAs pHEMT следующие, мы также можем предоставить индивидуальные Эпи-пластины из GaAs:

1. GaAs pHEMT Wafer Specifications
No. 1 LN pHEMT Epi Structure (PAM160711-GAAS)
| Слой | Материал | x | добавка | Concentration | Толщина (A) | Замечания |
| 12 | n+-GaAs | – | си | 5.0E + 18 см-3 | 500 | – |
| 11 | н-AlAs | – | си | – | – | – |
| 10 | n-AlxДжорджия1-хВ виде | 0.22 | си | – | – | – |
| 9 | си | – | си | 5.0E + 12 см-2 | – | – |
| 8 | AlxДжорджия1-хВ виде | 0.22 | – | – | 30 | – |
| 7 | ВxДжорджия1-хВ виде | – | – | – | – | – |
| 6 | GaAs | – | – | – | – | – |
| 5 | Увы | – | – | – | – | – |
| 4 | GaAs | – | – | – | – | – |
| 3 | Увы | – | – | – | – | – |
| 2 | AlxДжорджия1-хAs / GaAs | 0.22 | – | – | 185/15 | 10 X SL |
| 1 | GaAs | – | – | – | 5000 | – |
| Подложка SI GaAs | ||||||
No.2 Power pHEMT Epitxial Structure (PAM160711-GAAS)
| Слой | Материал | x | добавка | Concentration | Толщина (A) | Замечания |
| 13 | n+-GaAs | – | си | – | 500 | – |
| 12 | н-AlAs | – | – | – | – | – |
| 11 | GaAs | – | – | – | – | |
| 10 | n-AlxДжорджия1-хВ виде | 0.24 | си | – | – | – |
| 9 | си | – | си | 3.0E + 12 см-2 | – | – |
| 8 | AlxДжорджия1-хВ виде | – | – | – | 25 | – |
| 7 | ВxДжорджия1-хВ виде | – | – | – | – | – |
| 6 | AlxДжорджия1-хВ виде | – | – | – | 30 | – |
| 5 | си | – | си | 1.0E + 12 см-2 | – | – |
| 4 | AlxДжорджия1-хВ виде | – | – | – | – | – |
| 3 | GaAs | – | – | – | – | – |
| 2 | AlxДжорджия1-хВ виде | 0.24 | – | – | – | – |
| 1 | GaAs | – | – | – | – | – |
| Подложка SI GaAs | ||||||
No.3 GaAs Epi Wafers for pHEMTs (PAM161121-PHEMT)
| Layer material with doping | Толщина (A) | Doping level | Composition | Note |
| n+-GaAs | 400 | – | – | – |
| Увы | – | – | – | – |
| GaAs | – | – | – | – |
| n-AIGaAs | – | 3E+17cm-3 | – | – |
| GaAs | 9 | – | – | – |
| си | – | – | – | – |
| GaAs | – | – | – | – |
| i-AIGaAs | – | – | – | Spacer |
| i-GaAs | – | – | – | – |
| i-InGaAs | – | – | – | – |
| i-GaAs | – | – | – | – |
| i-AIGaAs | – | – | 0.24 | – |
| GaAs | – | – | – | |
| си | – | 1.5E+12cm-2 | – | – |
| GaAs | 9 | – | – | – |
| i-AIGaAs | – | – | – | – |
| AIGaAs 100A/GaAs 20A superlattice 15 periods | – | – | – | – |
| i-GaAs | – | less than 5E+14cm-3 | – | – |
| S.I. GaAs substrate |
We also can provide InP-based pHEMT epitaxial wafer:
PAM160526-INP
| Слой | Материал | Concentration | Thickness |
| 8 | N+ InxДжорджия1-хВ виде | – | 20nm |
| 7 | N+ InP etch stopper | – | – |
| 6 | i-InxAl1-хAs Schottky barrier | – | – |
| 5 | Si-delta-doping | n=6×1012 см-2 | – |
| 4 | i-InxAl1-хAs spacer | – | – |
| 3 | i-InxДжорджия1-хAs channel | – | – |
| 2 | ВxAl1-х As buffer | – | 300nm |
| 1 | metamorphic buffer (linearly graded from substrate to
ВxДжорджия1-х As) |
– | – |
| InP substrate |
В последние годы с популяризацией и применением систем мобильной связи и беспроводного Интернета стимулировался высокий спрос на полупроводниковые устройства. Полупроводниковые эпитаксиальные материалы являются важной основой для устройств, используемых в беспроводной связи. Чтобы соответствовать требованиям рынка к качеству и стоимости продукции, очень важно разработать высокопроизводительный и стабильный процесс. GaAs pHEMT занимает лидирующие позиции среди беспроводных приложений и перешел на массовое производство. Следовательно, разработка эффективного эпитаксиального процесса играет важную роль в сокращении затрат и времени отклика рынка. Молекулярно-лучевая эпитаксия (МБЭ) является основным техническим методом выращивания эпитаксиальных материалов GaAs pHEMT. По сравнению с другими методами выращивания, такими как химическое осаждение металлоорганических соединений из паровой фазы (MOCVD), MBE имеет более высокую точность управления и стабильность.
2. Об эпитаксиальном материале GaAs pHEMT
2-DEG в pHEMT более ограничен, чем обычный HEMT: существует двойное ограничение с обеих сторон потенциальной ямы, поэтому он имеет более высокую поверхностную плотность электронов (примерно в 2 раза выше). В то же время подвижность электронов также выше, чем в GaAs. Следовательно, производительность pHEMT выше. Эпитаксиальная структура GaAs pHEMT с двойным гетеропереходом не только улучшает температурную стабильность порогового напряжения устройства, но также улучшает выходные вольт-амперные характеристики устройства, так что устройство имеет большее выходное сопротивление, более высокую крутизну и большую текущая пропускная способность и более высокая рабочая частота, более низкий уровень шума и так далее.
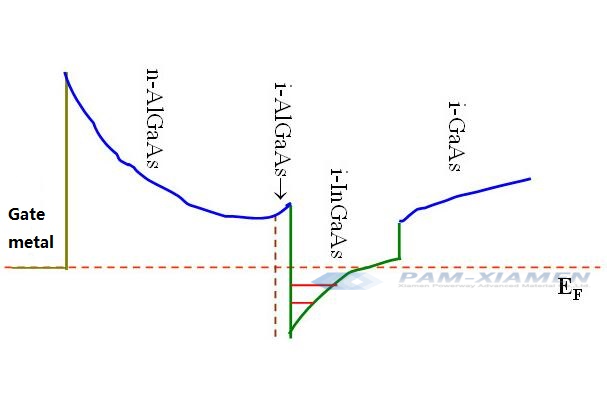
Диаграмма энергетических зон гетероперехода pHEMT
Подвижность каналов эпитаксиальных материалов GaAs pHEMT является одним из важнейших показателей. Повышение мобильности каналов может эффективно улучшить характеристики по постоянному току и ВЧ продуктов pHEMT на основе арсенида галлия (таких как GaAs pHEMT-транзистор, GaAs pHEMT-усилитель и MMIC), что оказывает большое влияние на параметры приложения, такие как крутизна, сопротивление в открытом состоянии, отсечка частота, коэффициент шума, РЧ-усиление и эффективность преобразования мощности.
3. О GaAs pHEMT
pHEMT - это улучшенная структура транзистора с высокой подвижностью электронов (HEMT), также известного как псевдосогласованные транзисторы с высокой подвижностью электронов (pHEMT), который представляет собой высокочастотный силовой транзистор GaAs, изготовленный с использованием специального эпитаксиального слоя, выращенного на GaAs, может достигать низкого напряжения и высокая эффективность при использовании в сотовых телефонах и радиочастотных модемах.
GaAs pHEMT применяется в диапазонах частот микроволнового и миллиметрового диапазонов благодаря превосходным свойствам высокой подвижности электронов, высокой эффективности модуляции тока и низким потерям. Когда рабочая частота устройства входит в полосу частот миллиметрового диапазона, влияние паразитных эффектов на характеристики устройства становится очень очевидным. Модель - это основа схемотехники, и метод точного определения параметров модели высокочастотных паразитных эффектов транзисторов всегда был предметом исследований в отрасли.
В условиях непрерывного развития компонентов и инфраструктуры беспроводной связи 5G технология GaAs pHEMT будет играть ключевую роль в обеспечении соответствия множеству характеристик новых беспроводных сетей. При разработке ключевых компонентов 5G мы продолжаем совершенствовать технологический процесс GaAs pHEMT, чтобы предоставить полный спектр сопутствующих продуктов в линейных цифровых радиостанциях, радиолокационных устройствах V-диапазона, E-диапазона и W-диапазона.

Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресу victorchan@powerwaywafer.com и powerwaymaterial@gmail.com.
