Благодаря преимуществам высокой теплопроводности, высокой напряженности поля пробоя, высокой скорости дрейфа электронов при насыщении и высокой энергии связи, материал SiC может соответствовать новым требованиям современной электронной технологии в отношении высокой температуры, высокой частоты, высокой мощности, высокого напряжения и радиационной стойкости. , поэтому он считается одним из самых перспективных материалов в области полупроводниковых материалов.PAM-СЯМЫНЬможет поставлять пластину затравочного кристалла 4H-SiC, которая применяется для выращивания кристаллов SiC размером 4 или 6 дюймов. Пожалуйста, обратитесь к следующим таблицам для конкретных параметров.
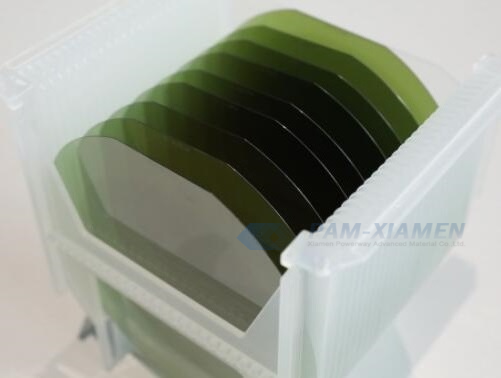
1. Спецификации SiC Seed Wafer
Приложение SiC Seed Wafer: выращивание монокристаллов SiC в 4- или 6-дюймовых
1.1 4H-SiC кристаллическая пластина толщиной 800 мкм
|
Параметры затравочной пластины 4H-SiC |
||||
| Нет. | предметы | производство | Research | Ед. изм |
| 1 | Параметры кристалла | |||
| 1.1 | Polytype | 4H | 4H | |
| 2 | Механические параметры | |||
| 2.1 | Диаметр | 104/150/153±0,5 мм | 104/150/153±0,5 мм | мм |
| 2.2 | Толщина | 800 ± 50 мкм | 800 ± 50 мкм | гм |
| 2.3 | плоский | Ни один | Ни один | гм |
| 2.4 | TTV | ≤10 мкм | ≤20 мкм | гм |
| 2.5 | LTV | ≤5um(5мм*5мм) | ≤10um(5мм*5мм) | гм |
| 2.6 | Лук | -35ум-35ум | -45ум~45ум | гм |
| 2.7 | деформироваться | ≤40um | ≤50 мкм | гм |
| 2.8 | Передняя (Si-face) Шероховатость | Ra≤0,2 нм (5 мкм * 5 мкм) | Ra≤0,2 нм (5 мкм * 5 мкм) | нм |
| 3 | Состав | |||
| 3.1 | микротрубка Плотность | ≤1 шт/см2 | ≤5 шт/см2 | шт/см2 |
| 3.2 | Шестиугольная пустота | Ни один | Ни один | |
| 3.3 | ПРД | ≤2000 | Не Доступно | шт/см2 |
| 3.4 | ТСД | ≤500 | Не Доступно | шт/см2 |
| 4 | Переднее качество | |||
| 4.1 | Фронт | си | си | |
| 4.2 | Чистота поверхности | Si-face CMP | Si-face CMP | |
| 4.3 | Царапины | ≤5 шт., ≤2*диаметр (Суммарная длина) |
Не Доступно | шт/мм |
| 4.4 | Апельсиновые корки/пятна/бороздки/трещины/загрязнения | Ни один | Ни один | мм |
| 4.5 | Краевые сколы/вмятины/трещины/шестигранные пластины | Ни один | Ни один | |
| 4.6 | Политипные области | Ни один | ≤30%(общая площадь) | |
| 4.7 | Передняя лазерная маркировка | Ни один | Ни один | |
| 5 | Назад Качество | |||
| 5.1 | Задняя отделка | C-образный CMP | C-образный CMP | |
| 5.2 | Царапины | ≤2 шт., ≤ диаметр (Суммарная длина) |
Не Доступно | шт/мм |
| 5.3 | Дефекты задней части (краевые сколы/вмятины) | Ни один | Ни один | |
| 5.4 | Задняя шероховатость | Ra≤0,2 нм (5 мкм * 5 мкм) | Ra≤0,2 нм (5 мкм * 5 мкм) | нм |
| 5.5 | Задняя лазерная маркировка | 1 мм (от верхнего края) | 1 мм (от верхнего края) | |
| 6 | край | |||
| 6.1 | край | фаска | фаска | |
| 7 | Упаковка | |||
| 7.1 | Упаковка | Многовафельная кассета | Многовафельная кассета | |
1.2 Затравочная пластина 4H-SiC толщиной 430~570 мкм
|
Параметры затравочного кристалла SI 4H-SiC 6 дюймов |
||
| Нет. | Пункт | параметр |
| 1 | Параметры кристалла | |
| 1.1 | Polytype | 4H |
| 2 | Механические параметры | |
| 2.1 | Диаметр | 150+0,1 мм/-0,3 мм |
| 2.2 | Толщина | 430 мкм ~ 570 мкм |
| 2.3 | Поверхность Ориентация | 1+0,4°/2±0,5° |
| 2.4 | Первичная плоская ориентация | {10-10}±0,5° |
| 2.5 | Первичная плоская длина | 0-25 мм или вырез |
| 2.6 | Вторичная квартира | ни один |
| 2.7 | удельное сопротивление | Не Доступно |
| 3 | Качество пластин | |
| 3.1 | Плотность микротрубок* | <1 см-2 |
| 3.2 | Плотная область микротрубки* | ≤3 места |
| 3.3 | Передние царапины | ни один |
| 3.4 | Чипсы* | Не Доступно |
| 3.5 | Трещины* | Не Доступно |
| 3.6 | Ямы* | ни один |
| 3.7 | Апельсиновая корка* | ни один |
| 3.8 | Загрязнение | ни один |
| 3.9 | Политипные области* | 0%(область удаления кромки 180° напротив вторичной плоскости) |
| 3.10 | Поликристаллический* | ни один |
| 4 | Лазерная маркировка | |
| 4.1 | Лазерная маркировка | Над первичной плоскостью на Si-грани |
| 5 | край | |
| 5.1 | Область удаления края | 3мм |
| Note:”*” data does not contain edge removal areas | ||
1.3 4Inch Seed Crystal of SiC
|
4Inch SiC Seed Crystal |
||
| Grade | производство | Research |
| Диаметр | 100/105±0.5mm | |
| Толщина | 400±100um | 400±150um |
| Orientation | 4±1°(0±1°) | |
| Primary flat orientation | {1010}±0.5° | |
| Первичная плоская длина | 32.5mm±2.0mm | |
| Secondary flat length | 18.0mm±2.0mm | |
| Область удаления края | 2mm | 3мм |
| TTV | ≤10 мкм | ≤15um |
| Surface roughness | C: Ra≤1nm Si: Ra≤1nm |
|
| Политипные области* | Ни один | |
| Поликристаллический* | Ни один | |
| Hexagonal void* | Ни один | |
| Micropipe Density* | ≤1cm-2 | ≤5cm-2 |
| Inclusion | ≤1% | ≤5% |
| Cracks | Ни один | edge≤10mm, cental≤5mm |
| Chips | Ни один | – |
| Macro scratches | Ни один | – |
| Orange peel | Ни один | – |
| Pits | Ни один | – |
| Surface contamination | Ни один | Ни один |
| Note : “*” defects in the edge removal area are excluded. | ||
2. Что такое семенной кристалл?
Затравочный кристалл представляет собой небольшой кристалл с той же ориентацией кристалла, что и желаемый кристалл, и является затравкой для выращивания монокристалла. Используя затравочные кристаллы с различной ориентацией кристаллов в качестве затравки, можно получить монокристаллы с различной ориентацией кристаллов. В зависимости от использования существуют затравочные кристаллы монокристалла Чохральского, затравочные кристаллы зонного плавления, затравочные кристаллы сапфира и затравочные кристаллы SiC.
Здесь пластина SiC используется в качестве своего рода затравочного кристалла для роста кристаллов SiC, а форма затравочной пластины SiC в основном имеет форму тонкой пленки. Сообщается, что применение затравочного кристалла играет важную роль в росте кристалла SiC. Форма кристалла и свойства поверхности затравочной пластины SiC сильно влияют на тип роста, дефектную структуру и электрические свойства кристалла SiC.
Среди них наиболее важным фактором, определяющим политип монокристалла, является ориентация кристаллов затравочной пластины SiC. Слиток 6H-SiC выращивают на поверхности SiC (0001, Si) методом PVT, несмотря на то, что затравочная пластина представляет собой 4H-SiC (0001). Напротив, слиток 4H-SiC выращивается на грани SiC (0001, C) методом PVT, что не имеет никакого отношения к политипу затравочного кристалла.
3. Как сделать семенной кристалл?
Для изготовления затравочного кристалла сначала разрежьте объемный монокристалл SiC на тонкие пленки, затем отшлифуйте, отполируйте и протравите тонкую пленку, чтобы удалить ямки и царапины, образовавшиеся при резке. При шлифовке удаляется слой ямок, разрезающих поверхность пластины, оставляя тонкие, редкие царапины на поверхности пластины. Полировка может удалить царапины, образовавшиеся во время шлифовки, но не полностью удалить слой ухудшения шлифовки или тонкий слой механических повреждений, образовавшийся в результате полировки. Травление позволяет не только выявить структурные дефекты пластины, но и удалить поверхностный слой механических повреждений, образовавшийся при шлифовке и полировке. Протравленная пластина используется в качестве затравочной пластины, а ростовой кристалл может хорошо воспроизводить структуру затравочного кристалла, а поверхность кристалла гладкая.
4. Зачем использовать подложку SiC для выращивания монокристаллов?
Большинство полупроводниковых монокристаллов можно вырастить из расплава или раствора, но свойства самого SiC делают невозможным выращивание монокристаллов этими двумя способами.
В настоящее время метод физического переноса паров (PVT) является наиболее зрелым методом среди всех методов выращивания SiC для выращивания кристаллов SiC. Метод заключается в том, чтобы поместить затравочный субстрат SiC в тигель, содержащий порошковое сырье SiC, затем тигель нагревают с помощью индукционной печи средней частоты или печи сопротивления, чтобы температура достигла более 2000 ℃, а молекулы газа, содержащие Si и C, индуцируются с помощью температурный градиент между сырьем и затравкой SiC, переходящий на затравочную пластину для выращивания кристаллов SiC. Существенное различие между методом PVT и ранним методом Lely заключается в том, что в методе PVT используется затравочный кристалл, который улучшает управляемость процесса роста кристаллизации затравочных кристаллов и подходит для выращивания монокристаллов SiC большого размера.
Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресуvictorchan@powerwaywafer.com и powerwaymaterial@gmail.com.

