Nanofabrication Photoresist
PAM-СЯМЫНЬ Предложения фоторезиста пластины с фоторезистом
- Description
Описание продукта
Нанофабрикация
Предложения PAM-XIAMENфоторезисттарелка сфоторезист
Фоторезист — это светочувствительный материал, используемый в нескольких процессах, таких какфотолитографияи фотогравировка для формирования узорчатого покрытия на поверхности, что имеет решающее значение во всей электронной промышленности.
Позитивный резист — это тип фоторезиста, в котором часть фоторезиста, подвергающаяся воздействию света, растворяется в проявителе фоторезиста. Неэкспонированная часть фоторезиста остается нерастворимой в проявителе фоторезиста.
Негативный фоторезист — это тип фоторезиста, в котором часть фоторезиста, подвергающаяся воздействию света, становится нерастворимой в проявителе фоторезиста. Неэкспонированная часть фоторезиста растворяется проявителем фоторезиста.
По химическому строению фоторезисты можно разделить на три типа: фотополимерные, фоторазлагающиеся, фотосшивающие, фоторезисты.
Применение фоторезиста:
Микроконтактная печать
Изготовление печатных плат (PCB)
Нанесение рисунка и травление подложек
Микроэлектроника
фоторезист микропозит
Футуррекс
другие фоторезисты,
пожалуйста, свяжитесь с нами для получения подробной информации
Подложка кремниевая подложка 2″3″4″5″6″8″
кварцевая подложка SSP/DSP
стеклянная подложка N/P
Подложка SiO2 100/110/111
другой субстрат,
пожалуйста, свяжитесь с нами для получения подробной информации
Различия между положительным и отрицательным сопротивлением
| Характеристика | положительный | отрицательный |
| Адгезия к кремнию | Ярмарка | Отлично |
| Относительная стоимость | Более дорогой | Дешевле |
| База разработчиков | водный | Органическое |
| Растворимость в проявителе | Открытая область растворима | Открытая область нерастворима |
| Минимальная функция | 0,5 мкм | 2 мкм |
| Покрытие шага | Лучше | Ниже |
| Влажная химическая стойкость | Ярмарка | Отлично |
Одна итерацияфотолитографиясочетает в себе несколько последовательных шагов. В современных чистых помещениях для координации процесса используются автоматизированные роботизированные системы отслеживания пластин. Описанная здесь процедура не включает некоторые дополнительные процедуры, такие как разбавители или удаление краевого валика. Основная процедура
Очистка
Если на поверхности пластин присутствуют органические или неорганические загрязнения, их обычно удаляют влажной химической обработкой, например, методом RCA clean на основе растворов, содержащих перекись водорода. Для очистки можно использовать и другие растворы, приготовленные из трихлорэтилена, ацетона или метанола.
Подготовка
Пластина сначала нагревается до температуры, достаточной для удаления любой влаги, которая может присутствовать на поверхности пластины, достаточно 150 ° C в течение десяти минут. Пластины, находившиеся на хранении, должны быть химически очищены от загрязнений. Жидкий или газообразный «усилитель адгезии», такой как бис(триметилсилил)амин («гексаметилдисилазан», HMDS), применяется для улучшения адгезии фоторезиста к пластине. Поверхностный слой диоксида кремния на пластине вступает в реакцию с ГМДС с образованием триметилированного диоксида кремния, сильно водоотталкивающего слоя, мало чем отличающегося от слоя воска на краске автомобиля. Этот водоотталкивающий слой предотвращает проникновение водного проявителя между слоем фоторезиста и поверхностью пластины, тем самым предотвращая так называемый подъем небольших структур фоторезиста в (проявляющемся) узоре. Чтобы обеспечить проявление изображения, его лучше всего накрыть и поместить на горячую пластину и дать ему высохнуть, стабилизируя температуру на уровне 120 ° C.
Применение фоторезиста
Пластина покрыта фоторезистом методом центрифугирования. Вязкий жидкий раствор фоторезиста наносится на пластину, и пластина быстро вращается для получения однородного толстого слоя. Центрифужное покрытие обычно работает со скоростью от 1200 до 4800 об/мин в течение от 30 до 60 секунд и создает слой толщиной от 0,5 до 2,5 микрометров. Процесс центрифугирования приводит к получению однородного тонкого слоя, обычно с однородностью в пределах от 5 до 10 нанометров. Эта однородность может быть объяснена детальным гидромеханическим моделированием, которое показывает, что резист перемещается намного быстрее в верхней части слоя, чем в нижней, где силы вязкости связывают резист с поверхностью пластины. Таким образом, верхний слой резиста быстро отрывается от края пластины, в то время как нижний слой все еще медленно ползет в радиальном направлении вдоль пластины. Таким образом, любые «выпуклости» или «гребни» резиста удаляются, оставляя очень плоский слой. Окончательная толщина также определяется испарением жидких растворителей из резиста. Для очень маленьких плотных элементов (< 125 или около того нм) необходима меньшая толщина резиста (< 0,5 микрометра), чтобы преодолеть эффекты коллапса при высоких соотношениях сторон; типичные соотношения сторон < 4:1.
Пластина, покрытая фоторезистом, затем предварительно обжигается для удаления излишков растворителя фоторезиста, обычно при температуре от 90 до 100 ° C в течение 30–60 секунд на горячей плите.
Экспозиция и разработка
После предварительного обжига фоторезист подвергается воздействию интенсивного света. Воздействие света вызывает химическое изменение, позволяющее удалить часть фоторезиста специальным раствором, называемым «проявителем» по аналогии с фотопроявителем. Позитивный фоторезист, наиболее распространенный тип, при экспонировании растворяется в проявителе; с негативным фоторезистом неэкспонированные области растворяются в проявителе.
Запекание после экспонирования (PEB) выполняется перед проявлением, как правило, чтобы помочь уменьшить явления стоячих волн, вызванные деструктивными и конструктивными интерференционными картинами падающего света. В глубокой ультрафиолетовой литографии используется химия химически усиленного резиста (CAR). Этот процесс гораздо более чувствителен к времени, температуре и задержке PEB, поскольку большая часть реакции «воздействия» (создание кислоты, растворение полимера в основном проявителе) фактически происходит в PEB.
Химия для проявления доставляется на вращающемся устройстве, подобно фоторезисту. Первоначально проявители часто содержали гидроксид натрия (NaOH). Однако натрий считается крайне нежелательным примесью при производстве полевых МОП-транзисторов, поскольку он ухудшает изолирующие свойства оксидов затвора (в частности, ионы натрия могут мигрировать внутрь и наружу затвора, изменяя пороговое напряжение транзистора и затрудняя или облегчая его поворот). транзистор включается со временем). В настоящее время используются проявители, не содержащие ионов металлов, такие как гидроксид тетраметиламмония (TMAH).
Полученная пластина затем «запекается», если использовался нехимически амплифицированный резист, обычно при температуре от 120 до 180 ° C в течение 20–30 минут. Твердое спекание затвердевает оставшийся фоторезист, чтобы создать более прочный защитный слой при будущей ионной имплантации, жидкостном химическом травлении или плазменном травлении.
Травление
При травлении жидкий («мокрый») или плазменный («сухой») химический реагент удаляет самый верхний слой подложки на участках, не защищенных фоторезистом. При производстве полупроводников обычно используются методы сухого травления, поскольку их можно сделать анизотропными, чтобы избежать значительного подрезания рисунка фоторезиста. Это важно, когда ширина определяемых элементов равна или меньше толщины травимого материала (т. е. когда соотношение сторон приближается к единице). Процессы жидкостного травления носят, как правило, изотропный характер, что часто необходимо для микроэлектромеханических систем, где необходимо «освободить» подвесные конструкции от нижележащего слоя.
Разработка процесса анизотропного сухого травления с низким уровнем дефектов позволила перенести на материал подложки все более мелкие элементы, определяемые фотолитографически в резисте.
Удаление фоторезиста
После того, как фоторезист больше не нужен, его необходимо удалить с подложки. Обычно для этого требуется жидкий «отделитель резиста», который химически изменяет резист так, что он больше не прилипает к подложке. В качестве альтернативы фоторезист может быть удален плазмой, содержащей кислород, который его окисляет. Этот процесс называется озолением и напоминает сухое травление. Использование растворителя 1-метил-2-пирролидона (NMP) для фоторезиста является еще одним методом, используемым для удаления изображения. Когда резист растворяется, растворитель можно удалить, нагрев до 80°C, не оставляя следов.
Фоторезист серии Microposit S1800 G2
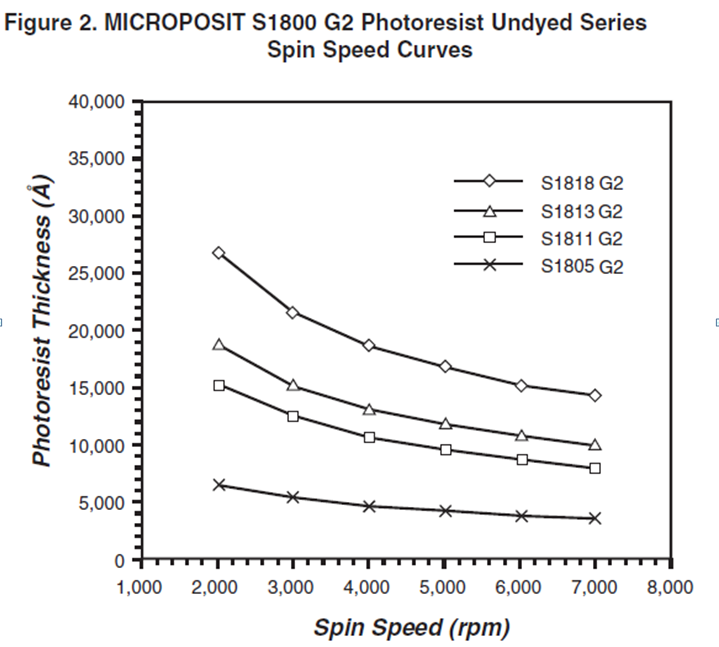
Фоторезист серии Microposit S1800 G2
ОТРИЦАТЕЛЬНЫЙ СОПРОТИВЛЕНИЕ NR9-6000PY

ОТРИЦАТЕЛЬНЫЙ СОПРОТИВЛЕНИЕ NR9-6000P