GaAs-baserad AlGaInPlaserdiodskiva can be supplied by PAM-XIAMEN with a band of 635nm. The III-V AlGaInP semiconductor material that can be lattice matched with the GaAs substrate has a wide direct band gap (1.9~2.3eV), a wide range of luminous wavelengths and high luminous efficiency. AlGaInP is the best material for preparing high-brightness red, orange, and yellow lasers and light-emitting diodes (LEDs). Following is a 635nm visible diode laser epi structure of GaInP / AlGaInP for reference:
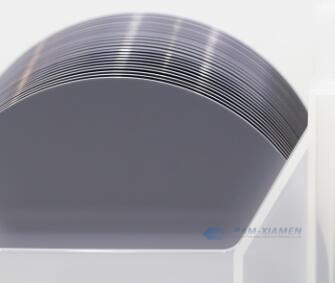
1. Epi-struktur av AlGaInP laserdiod på GaAs-substrat
PAM210709-635LD
| Lager | Material | Molfraktion (x) | Molfraktion (y) | Stam (%) | PL (nm) | Skikttjocklek (um) | Doping (E+18/cm3) | Typ | dopningsmedel |
| 12 | GaAs | 0.2 | >100 | P++ | C | ||||
| 11 | Få(x)P | 0.49 | – | – | p | Mg | |||
| 10 | (AlyFå(x)P | 0.485 | – | p | Mg | ||||
| 9 | AlIn(x)P | 0.485 | – | p | Mg | ||||
| 8 | AlIn(x)P | 0.485 | 0.3 | p | Mg | ||||
| 7 | (AlyFå(x)P | 0.485 | UD | ||||||
| 6 | Få(x)P | xx | 627 | UD | |||||
| 5 | (AlyFå(x)P | 0.485 | UD | ||||||
| 4 | AlIn(x)P | 0.485 | – | n | Si | ||||
| 3 | AlIn(x)P | 0.485 | – | n | Si | ||||
| 2 | Få(x)P | 0.49 | – | n | Si | ||||
| 1 | GaAs | 0.5 | – | n | Si |
2. Varför odla GaInP / AlGaInP LD-struktur på GaAs-substrat utanför vinkeln?
Materialen i GaInP / AlGaInP kvantbrunnslasrar med trycktöjningsinneslutning erhålls genom MOCVD engångs-epitaxiell tillväxt. Användningen av trycktöjning i det aktiva området kan minska tröskelströmmen och driftsströmmen samtidigt som effektiviteten förbättras. Eftersom GaInP- och AlGaInP-material lätt kan bilda metastabila ordnade strukturer under MOCVD-epitaxprocessen, vilket bör undvikas så mycket som möjligt i lasrar, och oordnade strukturer har smalare förstärkningsspektrala linjebredder. För att undvika bildandet av ordnad struktur i MOCVD-tillväxten av GalnP / AlGaInP-material, använder AlGaInP kvantbrunnslasrar i allmänhet GaAs-substrat med avvikande vinkel. Dessutom kan substratet med avvikande vinkel öka dopningskoncentrationen av p-typ i inneslutningsskiktet, och därigenom öka den effektiva barriären av elektroner i det aktiva området, minska läckaget av bärare och hjälpa till att förbättra anordningens högtemperaturprestanda.
3. Varför odla MQWs av AlGaInP, snarare än DH?
Jämfört med DH (dubbel heterojunction) kan MQW-strukturen (multipel kvantbrunn) hos AlGalnP generera högre bärartäthet, och därigenom öka den radioaktiva rekombinationseffektiviteten; effektivt förkorta längden av det ljusemitterande området, och därigenom minska materialets självabsorption av fotoner. GaInP / AlGaInP MQW producerar kvantstorlekseffekter, undviker förorening av AlGaInP-material med hög Al-sammansättning av syre och minskar effektivt emissionsvåglängden under låg Al-sammansättning. Därför odlas AlGaInP-laserdioduppsättningen med multipel kvantbrunnsstruktur istället för AlGaInP-laserdiodövergång, som ofta används i optoelektroniska enheter, såsom LD och LED, etc.
4. Om dopant av AlInP-skikt i AlGaInP LD epitaxiell struktur
För att lösa problemen med bärarläckage används AlInP med största band som beklädnadsskikt. På grund av det låga brytningsindexet kan det starkt begränsa ljusledningsvågor. Och AlInP-skikten måste dopa sig mycket med p-typ eller n-typ, för att få den elektriska ledningsförmågan så hög som möjligt. Det är bevisat att på grund av den lägre diffusiviteten och bättre kontrollerbarhet är Mg mer lämplig att användas som p-typ dopningsmedel för AlInP än Zn. Samtidigt har det visat sig att tillsats av odopad Mg-barriär i Al(Ga) InP-beklädnadsskikt kan förbättra emissionseffektiviteten för AlGaInP-laserdiod.
När det gäller dopning av n-typ av AlInP-beklädnadsskikt, används vanligtvis Si som dopning av n-typ för AlInP epi-skikt.
För mer information, kontakta oss via e-post på victorchan@powerwaywafer.com och powerwaymaterial@gmail.com.

