På grund av dess utmärkta elektriska, termiska och strålningsbeständighet har kiselkarbid blivit ett potentiellt material för applikationer i högfrekventa, högeffekts- och stark strålningsmiljöer. MOS-kondensatorer är ett viktigt sätt att studera halvledarytor och gränssnitt, såväl som den grundläggande strukturen hos MOSFET. Därför är systematisk forskning om SiC MOS-kondensatorer av stor betydelse för att förbättra strålningsmotståndet hos SiC-baserade elektroniska apparater och utrustningarnas livslängd. Som en av ledande tillverkare av epitaxialwafer,PAM-XIAMENkan tillhandahålla SiC epi wafer tillverkningsprocess för MOS kondensatorer. Se följande tabell för specifika parametrar:
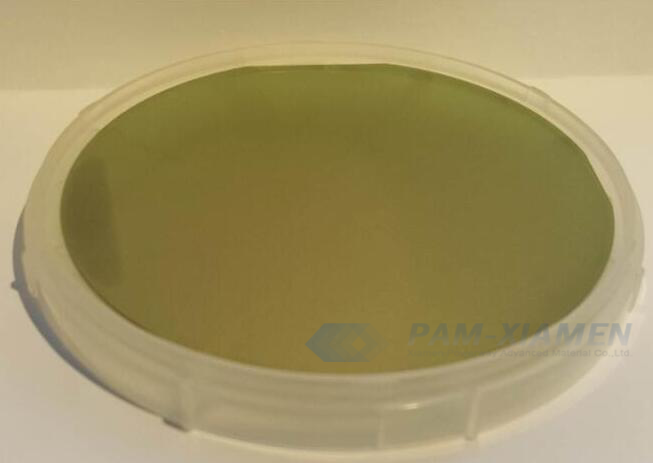
1. Specifikation av 4HN SiC Epitaxial Wafer
PAM210218 – MOSC
| SL nr. | Specifikation | |
| 1 | Wafer material | 4H-kiselkarbid |
| 2 | Wafer-konfiguration | N+ med epi |
| 3 | Antal Epi-lager | 2 lager |
| Lager 1: buffertlager | ||
| Lager 2: översta lagret | ||
| 4 | Skikt 2 Tjocklek | 5/8/10 um±10 % |
| 5 | Lager 2 dopant | Kväve |
| 6 | Tjocklekslikformighet | <=5 % |
| 7 | Ytdefektdensitet | <1/cm2 |
| 8 | Lager 2 Dopingkoncentration | 1,0 x 1016centimeter-3+/-20 % |
| 9 | Koncentration Enhetlighet | <=10 % |
| 10 | Skikt 1 Tjocklek | 0,5 um±10 % |
| 11 | Lager 1 dopant | Kväve |
| 12 | Lager 1 Dopingkoncentration | 1,0 x 1018centimeter-3+/-50 % |
| 13 | Framsida | Si-ansikte |
| 14 | Substratkonduktivitetstyp | Kraftigt dopad n-typ |
| 15 | dopningsmedel | Kväve |
| 16 | kristallorientering | (0001)±0,25° |
| 17 | Off-orientering | 4° mot <11-20> |
| 18 | mikrorördensitet | ≤1 cm-2 |
| 19 | Elektrisk resistans | 0,015~0,028 ohm-cm |
| 20 | Diameter | 100±0,4 mm |
| 21 | Tjocklek | 350±25 um |
| 22 | TTV | ≤10 um |
| 23 | LTV | ≤4 um |
| 24 | Varp | ≤35 um |
| 25 | Primär Flat Orientering | <11-20> |
| 26 | Sekundär Flat Orientering | <1-100> |
| 27 | Si-face Ytfinish | CMP polerad |
| 28 | C-face Ytfinish | Optiskt polerad |
2. Hur kontrollerar man epilagerdopningskoncentrationen i tillverkningsprocessen för SiC Epi Wafer?
Att kontrollera dopningstypen och koncentrationen av epitaxiella skikt är avgörande för prestandan hos SiC-kraftenheter, som direkt bestämmer viktiga elektriska parametrar som specifik på-resistans och blockeringsspänning för efterföljande enheter. Den konkurrerande epitaximetoden som upptäckts av forskare kan effektivt förändra dopningskoncentrationen av N-typ och P-typ i ett stort intervall, och används i stor utsträckning i praktisk produktion. Här förklarar vi kort principen för kväve (N) och aluminium (Al) som dopningselement av N-typ respektive P-typ.
Under tillverkning av epitaxiwafer konkurrerar kväve (N) atomer med kol (C) atomer om gitterpositioner. För att minska dopningskoncentrationen av kväve (N) atomer bör koncentrationen av kol (C) atomer i den epitaxiella gaskällan ökas; däremot, för att minska koncentrationen av kol(C)-atomer i den epitaxiella gaskällan, bör dopningskoncentrationen av kväve(N)-atomer ökas. Medan aluminium (Al) atomer konkurrerar med kisel (Si) atomer om gitter positioner, kan du öka koncentrationen av kisel (Si) atomer i den epitaxiella gaskällan för att minska dopningskoncentrationen av aluminium (Al) atomer; Däremot kan du minska koncentrationen av kiselatomer (Si) i den epitaxiella gaskällan för att öka dopningskoncentrationen av aluminium (Al) atomer.
I SiC-epitaxbehandlingen är den vanligen använda gaskällan för Si-källor SiCl4 eller SiH4; Den vanligaste gaskällan för C-källa är CCl4 eller C3H8. Vi kan kontrollera flödesförhållandet för de två för att kontrollera C/Si-komponentförhållandet, och därigenom effektivt kontrollera dopningskoncentrationen av olika element.
Dessutom är dopningskoncentrationen av SiC-epitaxialskiktet relaterad till gaskällans flödeshastighet, gastryck och tillväxttemperatur i CVD-processen. Ta kvävedopningen (N) som ett exempel för ytterligare förklaring. Kväve (N) dopning kan snabbt uppnås genom att införa kväve (N2) i CVD epitaxial tillväxt. Från Fig. 1 kan vi veta att dopningskoncentrationen på både Si- och C-ytorna är positivt proportionell mot N2-flödeshastigheten inom fyra storleksordningar vid ett fast C/Si-komponentförhållande. Dopningskoncentrationen i tillverkningsprocessen för SiC epi-wafer täcker dopningsintervallet E14-E18, som oftast används i enheter.

Figur 1Förhållandet mellan kväve (N) dopningskoncentration och kväve (N2) flödeshastighet i 4H-SiC epitaxi vid 1550 ℃
Förhållandet mellan gastryck och dopningskoncentration av SiC epi wafer tillverkningsprocessen i en CVD kavitet studerades. Såsom visas i fig. 2 undersöks sambandet mellan N-elementkoncentration och tryck under förhållanden med epitaxiell temperatur på 1600 ℃, C/Si-förhållande på 3,5 och kväveflödeshastighet på 12 ml/min. Oavsett vad på C-planet eller Si-planets epitaxi av 4H-SiC, ökar dopningskoncentrationen vid tillverkning av epi-halvledarwafer med ökande tryck.

Fig. 2Förhållandet mellan N-elementkoncentration och tryck i SiC Epi Wafer Manufacturing Process
3. Vanliga frågor om SiC Epitaxy för MOS-enhet
F:Baserat på specifikationen som du har gett, är strukturen på 4H-SiC-skivan enligt nedan:
2:a lager 4H-SiC epilager (Dopningskoncentration = 1 x 10^16 cm-3)/ 1:a lager 4H-SiC epilager (Dopingkoncentration = 1 x 10^18 cm-3)/ 4H-SiC wafer (resistivitet = 0,015-0,028 ohm cm-3)
Vi planerar att använda denna wafer för att tillverka till MOS-kondensator och utföra kapacitans-spänningsmätning.
Vanligtvis för Silicon wafer (resistivitet = 1-10 ohm), kommer vi att lägga ett lager av metalloxid ovanpå silikonwafern. Efter det kommer vi att deponera toppmetallkontakt och bottenmetallkontakt för att erhålla Al/metalloxid/kisel/metallstruktur (MOS-kondensator) och utföra kapacitans-spänningsmätningar.
Baserat på vår tidigare förståelse av att använda kiselskiva, kommer vi inte att kunna erhålla kapacitans-spänningskurva om resistiviteten hos kiselskiva är 0,005 ohm (vilket är känt som högdopad n-typ kiselskiva).
Vi skulle vilja be om din åsikt om den föreslagna 4H-SiC-skivan är lämplig för vårt forskningsarbete eftersom resistiviteten hos 4H-SiC-skivan anses vara högdopad (0,015-0,028 ohmcm-3) och det första lagret av 4H-SiC epilagret har en hög dopningskoncentration på 10^18 cm-3.
Actually, the thickness of 4H-SiC epilayer is not very crucial for our research work but we need to have the doping concentration in the range of 5 x 10^15 to 5 x 10^16 cm-3. Do you have any standard product produced by your company that will be cheaper when compared with customized wafer?
A: 1) The doping concentration of SiC epitaxial layer is between 5×10 ^ 15 and 5×10 ^ 16 cm-3, which can be achieved in epitaxial technology.
2) For the resistivity between 0.8 and 0.1 ohmcm-3, if the capacitance voltage curve can not be obtained due to the low resistivity, it is suggested that the epitaxial concentration should consider the lower doping concentration (higher resistivity).
För mer information, vänligen kontakta oss maila påvictorchan@powerwaywafer.com och powerwaymaterial@gmail.com.

