Hyung Koun Cho∗
Institutionen för metallurgisk teknik, Dong-A University, Busan 604-714
Jeong Yong Lee
Institutionen för materialvetenskap och teknik,
Korea Advanced Institute of Science and Technology, Daejon 305-701
Vi har undersökt bildandet av V-formade gropar i nitridfilmer som InGaN/GaN och AlGaN/GaN odlade på safirsubstrat med hjälp av transmissionselektronmikroskopi. Mekanismen för gropbildning beror starkt på indium (In) och aluminium (Al) sammansättningarna i InxGa1−xN och AlxGa1−xN skikt, respektive. Med ökningen av indiumsammansättningen härrörde V-formade gropar från spetsen av gängdislokationer till staplingsfelanpassningsgränserna inducerade av staplingsfel och den tredimensionella ö-tillväxten i det inledande skedet på grund av den stora gallermissanpassningen. Med ökningen av aluminiumsammansättningen varierade groparnas ursprung också från ytans vågformning på grund av den elastiska felanpassade töjningen till spetsen av gängdislokationer.
PACS-nummer: 61.72.Ff, 68.55.Ln, 68.55.-a
Nyckelord: Pit, Nitride, TEM, AlGaN, InGaN
I. INLEDNING
Wurtzite GaN-baserade (GaN, InGaN och AlGaN) halvledare är för närvarande under enorma utredningar som lovande material för optoelektroniska, högtemperatur- och högeffektsenheter på grund av vissa egenskaper som stort direktbandgap, hög termisk stabilitet och stark interatomisk obligationer [1, 2]. För InxGa1−xN och AlxGa1−xN-lager odlade på GaN, en ökning av indium (In) och aluminium (Al) kompositioner kan oundvikligen orsaka felpassade stammar i filmer. Utöver en kritisk tjocklek, genereras flera strukturella defekter såsom misspassade dislokationer, staplingsfel, V-formade gropar, etc., av plastisk avslappning [3, 4]. Men även vid mindre tjocklekar kan elastisk avslappning induceras genom bildandet av öar, ytvågor etc., som observerats i InGaP/InAsP, In0.77Ga0.23As/InGaAs, SiGe/Si, och så vidare [5–7 ].Dessutom kan en ökning av In-sammansättningen orsaka den kemiska inhomogeniteten hos InxGa1−xN brunnslager på grund av den dåliga blandbarheten mellan InN och GaN [8, 9].Den låga lösligheten av In i GaN beräknades vara mindre än 6 % vid 800 ◦C med Stringfellows modell [10].Dessa egenskaper kan avsevärt påverka de optiska och strukturella egenskaperna hos enheter [11, 12].
Nyligen rapporterade vi två modeller för bildandet av V-formade gropar i InGaN/GaN multipla kvantbrunnar (MQWs) med hög sammansättning [13]. Oönskadheten och effekten på emissionsegenskaperna hos dessa gropar har tidigare demonstrerats med transmissionselektronmikroskopi (TEM), katodluminescens och fotoluminescens [3, 14, 15]. För att undertrycka gropbildning behövs därför en tydlig förståelse av mekanismerna för gropbildning och mikrostrukturen hos groparna som observeras i olika III-nitridfilmer odlade på safirsubstrat måste utvärderas i detalj. I detta arbete undersökte vi gropbildningen som härrörde från olika källor i InGaN/GaN- och AlGaN/GaN-heterostrukturer med olika In- och Al-kompositioner med hjälp av TEM.
II. EXPERIMENTELL
Alla prover odlades på c-plane safirsubstrat med ett nominellt 25 nm tjockt GaN kärnbildande skikt av en horisontell metallorganisk kemisk ångdepositionsreaktor som arbetar vid lågt tryck. Trimetylgallium, trimetylindium, trimetylaluminium och ammoniak användes som prekursorer för Ga, In, Al och N, respektive. För att analysera effekten av stammen på mekanismen för gropbildning i III-nitrider, odlades tjocka InxGa1−xN-lager (~800 ˚A) vid temperaturer från 830 ◦C (x) = 35 %) till 880 ◦C (x = 10 %) och tjocka AlxGa1−xN-skikt (1000 A) odlades vid 1040 ◦C efter odling av det Si-dopade underliggande GaN-skiktet med ~2 mm tjocklek vid 1080 ◦C. In- och Al-kompositionerna i InxGa1−xN och AlxGa1−xN-skikten var 10, 13, 19 och 35 % respektive 16, 25, 44 och 54 %.
För att karakterisera gropbildningen av III-nitrider preparerades TEM-prover i tvärsnitt längs [11-20] zonaxeln med hjälp av mekanisk polering på stativ följt av lågtemperatur Ar-jonfräsning vid 4,5 kV i en Gatan DuoMill 660 DIF med sektorhastighet kontrollera. Jonenergin reducerades gradvis under de sista stadierna av gallringen för att minimera ytskadorna på proverna. Ljusfältsbilder (BF) och högupplösta TEM (HRTEM) bilder spelades in på en JEOL JEM-2000EX TEM vid 200 kV och JEOL JEM-3010EX vid 300 kV.
III. RESULTAT OCH DISKUSSION
För att undersöka effekten av Al-sammansättning på gropbildning, TEM-mikrofotografier i tvärsnittsljusfält från AlxGa1−xN-skikt odlade med olika Al-kompositioner på GaN-buffertskiktet erhölls som visas i Fig. 1. Den teoretiska kritiska Al-sammansättningen för bildandet av misspassningsdislokationen i 1000 A AlxGa1−xN-lager som odlas på GaN-lager är mindre än 15 % [16]. Inga gropar detekteras i AlxGa1−xN-lager med upp till 25 % Al sammansättning. Endast staplingsfel och sprickor i AlGaN-skikten observeras på grund av den felaktiga töjningen respektive den termiska koefficientskillnaden (ej visad). För Al0.44Ga0.56N/GaN-prov, dock ytan av Al0.44Ga0.56N-skiktet visar många gropar som inte är associerade med strukturella defekter såsom gängförskjutningar, staplingsfel och så vidare [Fig. 1(b) och (d)]. Storleken på dessa gropar är mycket liten, en medeldiameter på 7 nm och en medelhöjd på ~3 nm, jämfört med gropar i InGaN-lager odlade på GaN [13, 14, 16]. Man tror att bildandet av gropar i Al0.44Ga0.56N/GaN kan tillskrivas ytans vågformning av den ökade elastiska felanpassade töjningen som observeras i III-V och II-VI halvledarsystem [5, 6].
Gropdensiteten är mer än 1010 centimeter−2 i ytan. Å andra sidan genereras misspassade dislokationer vid gränssnittet för Al0.54Ga0.46N/GaN-prov för att plastiskt slappna av den lagrade felpassningsstammen som visas i fig. 1(c). V-formade gropar associerade med gängdislokationer vid bottnarna observeras också som InGaN/GaN-heterostrukturer. Dessa V-formade gropar har en öppen sexkantig, omvänd pyramid med sidoväggar [14, 16].
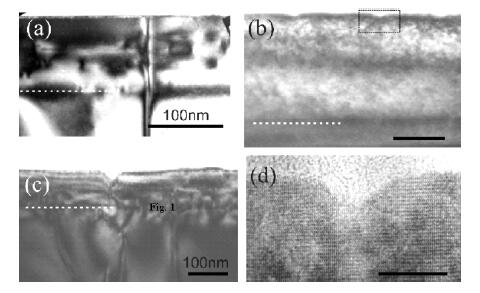
Fig. 1 Tvärsnittsljusfält TEM-bilder med g = 0002 från AlxGa1−xN-lager odlade med Al-sammansättningen av (a) 16 %, (b) 44 % och (c) 54 %. (d) HRTEM-bild erhållen från den streckade rektangeln i (b). De streckade linjerna indikerar AlxGa1−xN/GaN-gränssnitt.
Som en konsekvens klassificerade vi ursprunget till gropformationen i AlxGa1−xN odlas på GaN-buffertskiktet till två modeller som visas i Fig. 4(a) och (d). För AlxGa1−xN-skikt med ~40 % Al-sammansättning, gropar genereras av ytans vågformning på grund av den lagrade elastiska misspassningstöjningen [Fig. 4(d)]. För AlxGa1−xN-skikt med mer än ~50 % Al-sammansättning, dock genereras gropar huvudsakligen vid spetsen av gängdislokationer [Fig. 4(a)].
Figur 2 visar tvärsnittsljusfältets TEM-mikrofotografier från InxGa1−xN-skikt odlade med olika In-kompositioner på GaN-buffertskiktet. Den teoretiska kritiska kompositionen om bildandet av den misspassade dislokationen av ~800˚A InxGa1−xN odlat på GaN-skikt är mindre än 5 %, under vilket InGaN-skikten visar koherent tillväxt [16]. Därför förväntar vi oss In-sammansättningen av all InxGa1−xN-skikt som studerats här har ett värde som är högre än den kritiska In-sammansättningen på bildandet av misspassningsdislokationen. För In0.1Ga0.9N/GaN, inga strukturella defekter såsom misspassande dislokationer, staplingsfel, gropar, etc., observerades inom In0.1Ga0.9N-skiktet. Med en ytterligare ökning av In-sammansättningen av InxGa1−xN-lager (x = 13 %), genereras de V-formade groparna för att slappna av den lagrade felaktiga belastningen, som rapporterats tidigare [14]. Det har rapporterats att en V-formad grop alltid är förbunden med en gängdislokation från GaN-buffertskiktet i botten och endast en liten del av gängdislokationerna orsakar bildandet av de V-formade groparna i InGaN-skikten och InGaN/GaN MQWs [14]. Men tätheten av V-formade gropar i In0.19Ga0.81N-skiktet i Fig. 2(c) har ett större värde än gängdislokationsdensiteten i GaN-buffertskiktet, vilket indikerar att bildningen av V-formade gropar i InGaN med hög In-sammansättning har ett annat ursprung, som tidigare rapporterats för InGaN/GaN MQW-systemen [13]. Vi rapporterade att i InGaN/GaN MQWs med hög sammansättning (~ 30 % i sammansättning) genereras de flesta av de V-formade groparna från staplingsfelmatchningsgränser inducerade av staplingsfel [13]. Även om In0.19Ga0.81N/GaN som används här har en In-sammansättning på mindre än 20 %, den del av V-formade gropar härrör från staplingsfelöverensstämmelsegränser inducerade av staplingsfel på grund av den ökade InGaN-skikttjockleken [Fig. 3(a)] jämfört med InGaN/GaN MQW. För In0.35Ga0.65N/GaN, V-formade gropar med en densitet på mer än 1010 centimeter−2 observeras på ytan. Till skillnad från groparna i In0.19Ga0.81N/GaN-prov, In0.35Ga0.65N regioner med plana (0001) toppytor mellan gropar har ett stort antal staplingsfel och staplingsfelöverensstämmelsegränser som bildas vid det initiala tillväxtstadiet av InGaN [Fig. 3(b)], det vill säga pelarstrukturer inklusive staplingsfel. För att slappna av den stora gallrets oöverensstämmelse mellan In0.35Ga0.65N och GaN, den initiala In0.35Ga0.65N-skiktet odlades med morfologin hos tredimensionella (3D) facetterade öar [17]. En hög täthet av staplingsförkastningar ses tydligt på öarna och gränserna mellan subkorn vid öar är synliga som tillväxten av ett GaN-kärnbildande lager odlat på safirsubstrat [18].
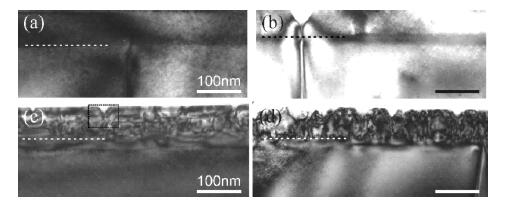
Fig. 2 Tvärsnittsljusfälts-TEM-bilder med g = 0002 från InxGa1−xN-skikt odlade med In-sammansättningen av (a) 10 %, (b) 13 %, (c) 19 % och (d) 35 % på GaN-buffertskiktet. De streckade linjerna indikerar InxGa1−xN/GaN-gränssnitt.
Därför tror vi att groparna i In0.35Ga0.65N/GaN-prov orsakas av en sådan 3D-tillväxt på grund av gallrets felpassning vid den initiala tillväxten av InGaN-skiktet.
Som ett resultat klassificerade vi ursprunget till gropbildning i InxGa1-xN odlas på GaN-buffertskiktet till tre modeller som visas i fig. 4(a), (b) och (c). För InxGa1-xN-lager med låg sammansättning genereras gropar vid spetsen av gängdislokationer [Fig. 4(a)]. För InxGa1-xN-skikt med medium I sammansättningen genereras gropar huvudsakligen från staplingsfelmatchningsgränserna som induceras av staplingsfel [Fig. 4(b)]. En ytterligare ökning av In-sammansättningen av InxGa1-xN-skiktet resulterar i 3D-ötillväxten i det inledande skedet och gropbildning vid den kontinuerliga tillväxten [Fig. 4(c)].
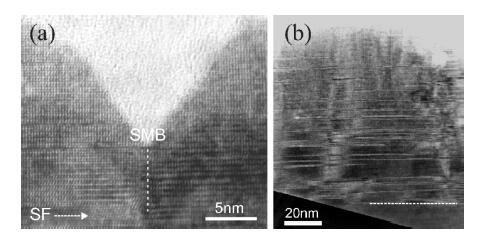
Fig. 3 (a) HRTEM-bild erhållen från den streckade rektangeln i Fig. 2(c). Den observerade V-formade gropen har ett staplingsfel på (0001) plan i sitt nedre läge. (b) HRTEM-bild erhållen från In0.35Ga0.65N på GaN-buffertskiktet.
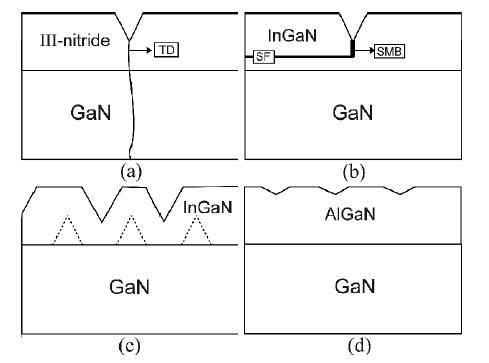
Fig. 4 Schematiska modeller för gropbildning relaterad till (a) en gängdislokation observerad i InGaN/GaN- och AlGaN/GaN-heterostrukturer, (b) en staplingsmissanpassningsgräns inducerad av staplingsfel och (c) 3d-ötillväxten i det inledande skedet observerad i en InGaN/GaN-heterostruktur, och (d) ytvågningen på grund av den elastiska misspassningstöjningen som observerats i en AlGaN/GaN-heterostruktur.
IV. SAMMANFATTNING
Gropformationen i InxGa1-xN och AlxGa1-xN-skikt med olika In- och Al-kompositioner odlade på GaN-buffertskikten studerades med användning av TEM. Vi fann att gropar bildades från olika ursprung såsom gängförskjutningar, staplingsfelpassningsgränser, 3D-ötillväxt och ytvågning beroende på In- och Al-kompositioner.
TACK
Detta arbete stöddes av ett anslag nr. R01-2002- 000-00096-0 från Korea Science & Engineering Foundation och University Research Program från ministeriet för information och kommunikation i republiken Korea.
Referenser
[1] H. Morkoc, Nitride Semiconductors and Devices (Springer, Heidelberg, 1999).
[2] YS Park, J. Korean Phys. Soc. 34, S199 (1999).
[3] HK Cho, JY Lee, CS Kim, GM Yang, N. Sharma och CJ Humphreys, J. Cryst. Growth 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim och GM Yang, J. Korean Phys. Soc. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard och RA Masut, J. Appl. Phys. 81, 3501 (1997).
[6] M. Mitsuhara, M. Ogasawara och H. Sugiura, J. Cryst. Growth 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang och JJ Harris, Semicond. Sci. Technol. 15, 370 (2000).
[8] D. Doppalapudi, SN Basu, KF Ludwig, Jr. och TD Moustakas, J. Appl. Phys. 84, 1389 (1998).
[9] T. Takeuchi, H. Takeuchi, S. Sota, H. Sakai, H. Amano och I. Akasaki, Jpn. J. Appl. Phys. 36, L177 (1997).
[10] GB Stringfellow, J. Cryst. Growth 58, 194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson och R. Stall, J. Cryst . Growth 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Hong, E.-K. Suh, HJ Lee, HK Cho och JY Lee, J. Korean Phys. Soc. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang och CS Kim, Appl. Phys. Lett. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars och JS Speck och SJ Rosner, Appl. Phys. Lett. 72, 692 (1998).
[15] G. Pozina, JP Bergman, B. Monemar, T. Takeuchi, H. Amano och I. Akasaki, J. Appl. Phys. 88, 2677 (2000).
[16] JW Matthews och AE Blakeslee, J. Cryst. Growth 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, JZ Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts och SM Bedair, J. Electron. Mater. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan och S. Mahajan, Appl. Phys. Lett. 77, 3391 (2000).
