GaAsSb / InGaAs / InP heterostruktur tillhandahålls av epi-struktur MBE-odlaren PAM-XIAMEN för tillverkning av optiska sensorer. Galliumarsenidantimonid (GaAsSb) gitterkonstanten är helt matchad med gitterkonstanten för InP-substrat, så det är lätt för epitaxiell tillväxt på InP-substrat med god enhetlighet. Svarsvåglängden för typ II InGaAs / GaAsSb supergitterdetektor kan justeras genom att ändra skikttjockleken och strukturen för varje material i supergittret. GaAsSb / InGaAs supergitter är det föredragna materialsystemet för en ny typ av kortvågiga infraröda detektorer. Här listas specen från PAM-XIAMEN:
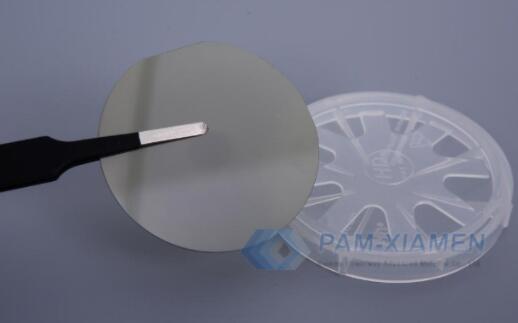
1. Specifikation av GaAsSb / InGaAs Supergitter på InP-substrat
PAM161124 – SLS
| Lager | Komposition | Tjocklek | perioder | bärarkoncentration | dopningsmedel |
| Cap Layer | InGaAs eller InAlAs | – | 1 | – | Bli dopad |
| Spelare | SL-GaAsSb/InGaAs | – | – | – | Bli dopad |
| i-Active | SL-GaAsSb/InGaAs | – | – | – | – |
| n Lager | SL-GaAsSb/InGaAs | – | 50 | – | Si-dopad |
| Buffert | InGaAs | 50 nm | – | – | Si-dopad |
| Botten | InGaAs eller InAlAs | – | – | n=lE18 | Si-dopad |
| Substrat | InP(100) | 350um | – | – | Si-dopad |
2. Tillverkning av GaAsSb/InP Epitaxial Wafer
Den oavsiktliga InGaAs är n-typ, bakgrundskoncentrationen av i-InGaAs för MBE-teknik är mycket lägre än MOCVD. Vår teknik kan nå upp till 7-9E14cm3. Om du behöver lägre bärarkoncentration kommer vi att kompensera i-InGaAs genom att dopa Be.
Den oavsiktliga GaAsSb är p-typ, bakgrundskoncentrationen av i-InGaAs för MBE-teknik är nästan 1-5E15cm3, vilket är mycket lägre än det för MOCVD. Och det är lätt att uppnå lägre bakgrundskoncentration genom att dopa Si.
i-InGaAs-skiktet kan vara lätt p-typ, vilken koncentration är 1-5E15cm3 genom att dopa Be. Normalt, för InP-baserade mikrovågsenheter, odlar vi bara 200 nm InAlAs för buffertskikt, och det räcker för att eliminera dislokation, defekter, fläckar och ytråhet etc. Så vi tror att 500 nm InGaAs är tillräckligt för buffertskikt, och vi kommer att tillhandahålla EPD< 500 InP substrat för dig. Tjockleken på din EPI-wafer är mer än 4,5um, speciellt ternär legering. Det behöver enastående färdigheter för att odla det.
När det gäller ohmsk kontakt till ovanstående spec, är den ohmska kontakten för p-typ InGaAs bättre än p-typ InAlAs. Och Ti/Pt/Au-metall är bäst för metallisering. Dessutom är den ohmska kontakten av n-typ InGaAs bättre än n-typ InAlAs. AuGeNi/Au metall är bäst för metallisering, precis som n-GaAs ohmsk kontakt. För god ohmsk kontakt med p-typ InGaAs måste mesa-etsningen stanna mer eller mindre i mitten av lagret. Så tjockare InGaAs-lagret som enkelt det kunde göras.
3. Effekter av Be Doping på egenskaperna hos InGaAs / GaAsSb epilager
Det finns ett direkt samband mellan bärarkoncentrationen i absorptionsområdet för fotovoltaiska detektorer och detektorns prestanda. Bärarkoncentrationen i absorptionsområdet bestämmer livslängden och diffusionslängden för minoritetsbärare, vilket påverkar kvanteffektiviteten och detektorns detektionshastighet. I supergitterdetektorn av InGaAs/GaAsSb II-typ används supergittret som absorptionsområdet, och bakgrundsbärarna i det inre supergittret är ledande av n-typ, vilket betyder att detektorns minoritetsbärare är hål och diffusionen av hål . Längden är mindre än diffusionslängden för elektroner. Om minoritetsbärarna i absorptionsområdet är elektroner kan diffusionslängden för minoritetsbärarna ökas. Därför använde vi p-typ Be för att kompensera supergittermaterialet och studerade sambandet mellan olika Be-dopningstemperaturer och egenskaperna hos InGaAs / GaAsSb kvantbrunn. Vi fann att dopningskoncentrationen i supergittret är känslig för Be-temperaturen.
För mer information, kontakta oss via e-post på victorchan@powerwaywafer.com och powerwaymaterial@gmail.com.

