Hyung Koun Cho ∗
Khoa Kỹ thuật luyện kim, Đại học Dong-A, Busan 604-714
Jeong Yong Lee
Khoa Khoa học và Kỹ thuật Vật liệu,
Viện Khoa học và Công nghệ Tiên tiến Hàn Quốc, Daejon 305-701
Chúng tôi đã nghiên cứu sự hình thành các lỗ hình chữ V trong các màng nitride như InGaN / GaN và AlGaN / GaN được phát triển trên nền sapphire bằng cách sử dụng kính hiển vi điện tử truyền qua. Cơ chế hình thành hố phụ thuộc mạnh mẽ vào thành phần indium (In) và nhôm (Al) trong InxGa1 − xN và AlxGa1 − xN lớp, tương ứng. Với sự gia tăng thành phần indium, các hố hình chữ V bắt nguồn từ đỉnh của sự lệch luồng đến các ranh giới không khớp xếp chồng gây ra bởi các lỗi xếp chồng và sự phát triển đảo ba chiều ở giai đoạn đầu do sự không phù hợp mạng tinh thể lớn. Với sự gia tăng thành phần nhôm, nguồn gốc của các lỗ cũng thay đổi từ độ nhấp nhô bề mặt do biến dạng đàn hồi sai lệch đến đỉnh của sự sai lệch ren.
Số PACS: 61.72.Ff, 68.55.Ln, 68.55.-a
Từ khóa: Pit, Nitride, TEM, AlGaN, InGaN
I. GIỚI THIỆU
Các chất bán dẫn dựa trên Wurtzite GaN (GaN, InGaN và AlGaN) hiện đang được nghiên cứu rất nhiều như là vật liệu đầy hứa hẹn cho các thiết bị quang điện tử, nhiệt độ cao và công suất cao do một số đặc tính như độ rộng vùng cấm trực tiếp lớn, độ ổn định nhiệt cao và tính liên nguyên tử mạnh trái phiếu [1, 2]. TạixGa1 − xN và AlxGa1 − xN lớp phát triển trên GaN, sự gia tăng thành phần indium (In) và nhôm (Al) chắc chắn có thể gây ra các biến dạng sai lệch trong màng. Ngoài độ dày tới hạn, một số khuyết tật về cấu trúc như lệch vị trí, lỗi xếp chồng, hố hình chữ V, v.v., được tạo ra do giãn chất dẻo [3, 4]. Tuy nhiên, cũng ở độ dày nhỏ hơn, sự giãn đàn hồi có thể được tạo ra bởi sự hình thành các đảo, nhấp nhô bề mặt, v.v., như được quan sát trong InGaP / InAsP, In0,77Ga0,23As / InGaAs, SiGe / Si, v.v. [5–7 ].Ngoài ra, sự gia tăng thành phần In có thể gây ra sự không đồng nhất về mặt hóa học của InxGa1 − xN lớp giếng do khả năng trộn lẫn giữa InN và GaN kém [8, 9].Độ hòa tan thấp của In trong GaN được tính toán là nhỏ hơn 6% ở 800 ◦C bằng cách sử dụng mô hình của Stringfellow [10].Những đặc tính này có thể ảnh hưởng đáng kể đến các đặc tính quang học và cấu trúc của thiết bị [11, 12].
Gần đây, chúng tôi đã báo cáo hai mô hình về sự hình thành các hố hình chữ V trong các giếng lượng tử đa lượng tử InGaN / GaN (MQWs) với thành phần In cao [13]. Ngoài ra, tính không thể phá hủy và ảnh hưởng đến đặc tính phát xạ của các hố này trước đây đã được chứng minh bằng kính hiển vi điện tử truyền qua (TEM), cathodeluminescence và photoluminescence [3, 14, 15]. Do đó, để ngăn chặn sự hình thành hố, cần phải hiểu rõ về cơ chế hình thành hố và cấu trúc vi mô của các hố quan sát được trong các màng III-nitride khác nhau được trồng trên nền sapphire phải được đánh giá chi tiết. Trong công trình này, chúng tôi đã nghiên cứu sự hình thành hố bắt nguồn từ các nguồn khác nhau trong các dị cấu trúc InGaN / GaN và AlGaN / GaN với các thành phần In và Al khác nhau bằng cách sử dụng TEM.
II. THỰC NGHIỆM
Tất cả các mẫu đều được nuôi cấy trên nền sapphire mặt phẳng c với lớp tạo mầm GaN dày 25 nm danh nghĩa bằng lò phản ứng xác định vị trí hơi hóa học tổ chức kim loại nằm ngang hoạt động ở áp suất thấp. Trimetylgallium, trimethylindium, trimethylalumin và amoniac được sử dụng làm tiền chất nguồn cho Ga, In, Al và N. tương ứng. Để phân tích ảnh hưởng của biến dạng đối với cơ chế hình thành hố ở III-nitrua, các lớp InxGa1-xN dày (∼ 800 ˚A) đã được trồng ở nhiệt độ dao động từ 830 ◦C (xTrong = 35%) đến 880 ◦C (xTrong = 10%) và các lớp AlxGa1-xN dày (1000 A) được tăng trưởng ở 1040 ◦C sau khi tăng trưởng lớp GaN bên dưới có pha tạp chất Si có độ dày ∼2 mm ở 1080 ◦C. Các thành phần In và Al trong InxGa1 − xN và AlxGa1 − xN lớp lần lượt là 10, 13, 19 và 35% và 16, 25, 44, và 54%.
Để mô tả sự hình thành hố của III- nitrua, các mẫu TEM được chuẩn bị theo mặt cắt dọc theo trục vùng [11-20] bằng cách sử dụng đánh bóng cơ học bằng chân máy, sau đó là phay ion Ar ở nhiệt độ thấp ở 4,5 kV trong máy Gatan DuoMill 660 DIF với tốc độ khu vực kiểm soát. Năng lượng ion được giảm dần trong giai đoạn cuối của quá trình pha loãng để giảm thiểu sự phá hủy bề mặt của mẫu. Hình ảnh trường sáng (BF) và hình ảnh TEM (HRTEM) có độ phân giải cao được ghi lại trên TEM JEOL JEM- 2000EX ở 200 kV và JEOL JEM-3010EX ở 300 kV.
III. KẾT QUẢ VÀ THẢO LUẬN
Để khảo sát ảnh hưởng của thành phần Al đến sự hình thành hố, ảnh hiển vi trường sáng TEM mặt cắt ngang từ AlxGa1 − xN lớp phát triển với nhiều vị trí Al khác nhau trên lớp đệm GaN thu được như trong Hình 1. Thành phần Al tới hạn về mặt lý thuyết đối với sự hình thành lệch vị trí sai lệch trong 1000 A AlxGa1 − xLớp N phát triển trên các lớp GaN nhỏ hơn 15% [16]. Không có hố nào được phát hiện trong AlxGa1 − xN lớp có đến 25% thành phần Al. Chỉ quan sát được các lỗi và vết nứt xếp chồng trong các lớp AlGaN do biến dạng sai lệch và chênh lệch hệ số nhiệt, tương ứng (không được hiển thị). Đối với Al0.44Ga0.56Mẫu N / GaN, tuy nhiên, bề mặt của Al0.44Ga0.56Lớp N cho thấy nhiều vết rỗ không liên quan đến các khuyết tật cấu trúc như lệch ren, lỗi xếp chồng, v.v. [Hình. 1 (b) và (d)]. Kích thước của các hố này rất nhỏ, đường kính trung bình là 7 nm và chiều cao trung bình là ∼3 nm, so với các hố trong các lớp InGaN được trồng trên GaN [13, 14, 16]. Người ta tin rằng sự hình thành các hố ở Al0.44Ga0.56N / GaN có thể được coi là hiện tượng nhấp nhô bề mặt do biến dạng đàn hồi tăng lên như quan sát thấy trong các hệ thống bán dẫn III-V và II-VI [5, 6].
Mật độ hố lớn hơn 1010 cm−2 trên bề mặt. Mặt khác, sự sai lệch không phù hợp được tạo ra ở giao diện của Al0.54Ga0.46Mẫu N / GaN để làm giãn biến dạng dẻo được lưu trữ như trong Hình 1 (c). Ngoài ra, các hố hình chữ V liên quan đến sự lệch luồng ở đáy được quan sát giống như các dị cấu trúc InGaN / GaN. Những hố hình chữ V này có hình chóp lục giác, mở ngược với các thành bên [14, 16].
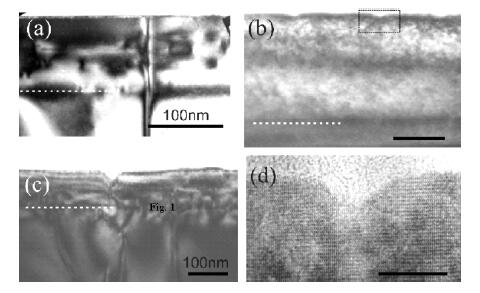
Hình 1 Ảnh TEM trường sáng mặt cắt ngang sử dụng g = 0002 từ AlxGa1 − xN lớp được trồng với thành phần Al là (a) 16%, (b) 44% và (c) 54%. (d) Hình ảnh HRTEM thu được từ hình chữ nhật đứt nét trong (b). Các đường đứt nét biểu thị chữ AlxGa1 − xGiao diện N / GaN.
Do đó, chúng tôi đã phân loại nguồn gốc của sự hình thành hố trong AlxGa1 − xN phát triển trên lớp đệm GaN thành hai mô hình như trong Hình. 4 (a) và (d). Đối với AlxGa1 − xLớp N với thành phần ∼40% Al, các vết rỗ được tạo ra bởi sự nhấp nhô bề mặt do biến dạng sai đàn hồi lưu trữ [Hình. 4 (d)]. Đối với AlxGa1 − xTuy nhiên, lớp N với thành phần Al hơn ∼50%, các vết rỗ chủ yếu được tạo ra ở đỉnh của sự trật khớp ren [Hình. 4 (a)].
Hình 2 cho thấy các ảnh hiển vi TEM trường sáng mặt cắt ngang từ InxGa1 − xN lớp được trồng với các chế phẩm In khác nhau trên lớp đệm GaN. Yếu tố quan trọng về mặt lý thuyết Trong thành phần về sự hình thành sự sai lệch khớp nối của ∼800˚A InxGa1 − xN phát triển trên các lớp GaN nhỏ hơn 5%, dưới đó các lớp InGaN cho thấy sự tăng trưởng nhất quán [16]. Do đó, chúng tôi mong đợi sự kết hợp của tất cả InxGa1 − xN lớp được nghiên cứu ở đây có giá trị cao hơn thành phần quan trọng về sự hình thành của trật khớp lệch lạc. Tại0.1Ga0.9Không có / GaN, không có khuyết tật cấu trúc như lệch vị trí, lỗi xếp chồng, hố, v.v., được quan sát thấy trong lớp In0.1Ga0.9N. Với sự gia tăng hơn nữa trong thành phần InxGa1 − xN lớp (xTrong = 13%), các lỗ hình chữ V được tạo ra để làm giãn các căng thẳng tích trữ, như đã báo cáo trước đây [14]. Người ta đã chứng minh rằng một hố hình chữ V luôn được kết nối với sự trật khớp ren từ lớp đệm GaN ở dưới cùng và chỉ một phần nhỏ của sự trật khớp ren gây ra sự hình thành các lỗ hình chữ V trong các lớp InGaN và InGaN / GaN MQWs [14]. Tuy nhiên, mật độ của các hố hình chữ V trong0.19Ga0.81Lớp N trong Hình 2 (c) có giá trị lớn hơn mật độ lệch luồng trong lớp đệm GaN, điều này cho thấy rằng sự hình thành các lỗ hình chữ V trong InGaN với thành phần In cao có nguồn gốc khác, như đã báo cáo trước đây cho hệ thống InGaN / GaN MQW [13]. Chúng tôi báo cáo rằng trong các MQW InGaN / GaN có Thành phần cao (∼ 30% Trong thành phần), hầu hết các lỗ hình chữ V được tạo ra từ các ranh giới không khớp xếp chồng gây ra bởi các lỗi xếp chồng [13]. Mặc dù trong0.19Ga0.81N / GaN được sử dụng ở đây có thành phần In dưới 20%, phần của các hố hình chữ V bắt nguồn từ các ranh giới không khớp của việc xếp chồng gây ra bởi các lỗi xếp chồng do độ dày lớp InGaN tăng lên [Hình. 3 (a)] so với InGaN / GaN MQW. Tại0.35Ga0.65N / GaN, hố hình chữ V với mật độ lớn hơn 1010 cm−2 được quan sát trên bề mặt. Không giống như các hố trong0.19Ga0.81Mẫu N / GaN, In0.35Ga0.65N vùng có bề mặt trên cùng phẳng (0001) giữa các hố có một số lượng lớn các lỗi xếp chồng và các ranh giới không khớp xếp chồng được hình thành ở giai đoạn phát triển ban đầu của InGaN [Hình. 3 (b)], nghĩa là, cấu trúc cột bao gồm các lỗi xếp chồng. Để làm giãn sự không phù hợp mạng tinh thể lớn giữa In0.35Ga0.65N và GaN, chữ in đầu tiên0.35Ga0.65Lớp N được phát triển với hình thái của các đảo mặt ba chiều (3D) [17]. Mật độ cao của các đứt gãy xếp chồng lên nhau được nhìn thấy rõ ràng ở các đảo và ranh giới giữa các tiểu khu giữa các đảo có thể nhìn thấy giống như sự phát triển của lớp tạo mầm GaN được trồng trên nền sapphire [18].
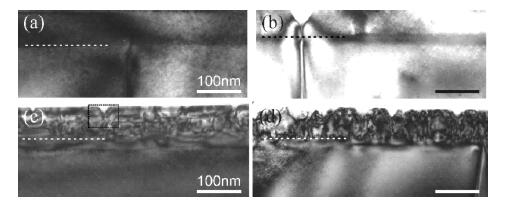
Hình 2 Ảnh TEM trường sáng mặt cắt ngang sử dụng g = 0002 từ InxGa1 − xN lớp được trồng với thành phần In gồm (a) 10%, (b) 13%, (c) 19%, và (d) 35% trên lớp đệm GaN. Các đường đứt nét cho biết InxGa1 − xGiao diện N / GaN.
Do đó, chúng tôi nghĩ rằng các hố trong0.35Ga0.65Mẫu N / GaN được gây ra bởi sự phát triển 3D như vậy do sự sai lệch của mạng tinh thể ở sự phát triển ban đầu của lớp InGaN.
Kết quả là, chúng tôi đã phân loại nguồn gốc hình thành hố trongxGa1-xN phát triển trên lớp đệm GaN thành ba mô hình như trong Hình 4 (a), (b) và (c). Đối với trongxGa1-xLớp N có thành phần thấp, các vết rỗ được tạo ra ở đỉnh của sự lệch luồng [Hình. 4 (a)]. Đối với trongxGa1-xLớp N với môi trường Trong thành phần, các vết rỗ chủ yếu được tạo ra từ các ranh giới không khớp của việc xếp chồng gây ra bởi các lỗi xếp chồng [Hình. 4 (b)]. Sự gia tăng hơn nữa trong thành phần của InxGa1-xLớp N dẫn đến sự phát triển đảo 3D ở giai đoạn đầu và hình thành hố ở giai đoạn tăng trưởng liên tục [Hình. 4 (c)].
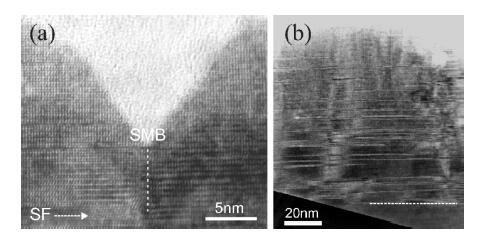
Hình 3 (a) Hình ảnh HRTEM thu được từ góc thẳng nét đứt trong Hình 2 (c). Hố hình chữ V quan sát được có lỗi xếp chồng trên mặt phẳng (0001) ở vị trí thấp hơn của nó. (b) Hình ảnh HRTEM thu được từ In0.35Ga0.65N trên lớp đệm GaN.
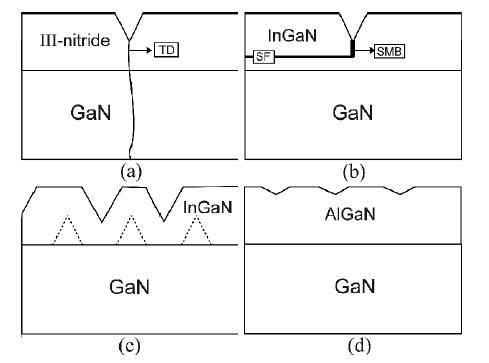
Hình 4 Các mô hình giản đồ cho sự hình thành hố liên quan đến (a) sự lệch luồng được quan sát thấy trong các dị cấu trúc InGaN / GaN và AlGaN / GaN, (b) ranh giới không khớp xếp chồng gây ra bởi các lỗi xếp chồng và (c) sự phát triển đảo 3d ở giai đoạn đầu quan sát thấy trong một dị cấu trúc InGaN / GaN, và (d) sự nhấp nhô bề mặt do biến dạng đàn hồi sai lệch được quan sát thấy trong một dị cấu trúc AlGaN / GaN.
IV. BẢN TÓM TẮT
Sự hình thành hố ở InxGa1-xN và AlxGa1-xN lớp với các thành phần In và Al khác nhau phát triển trên các lớp đệm GaN đã được nghiên cứu bằng cách sử dụng TEM. Chúng tôi nhận thấy rằng các hố được hình thành từ nhiều nguồn gốc khác nhau như sự lệch luồng, ranh giới không khớp xếp chồng lên nhau, sự phát triển đảo 3D và sự nhấp nhô bề mặt tùy thuộc vào thành phần In và Al.
SỰ NHÌN NHẬN
Công việc này được hỗ trợ bởi khoản tài trợ số R01-2002- 000-00096-0 từ Quỹ Khoa học & Kỹ thuật Hàn Quốc và Chương trình Nghiên cứu Đại học từ Bộ Thông tin & Truyền thông tại Hàn Quốc.
NGƯỜI GIỚI THIỆU
[1] H. Morkoc, Chất bán dẫn và thiết bị Nitride (Springer, Heidelberg, 1999).
[2] YS Park, J. Korean Phys. Soc. 34, S199 (1999).
[3] HK Cho, JY Lee, CS Kim, GM Yang, N. Sharma và CJ Humphreys, J. Cryst. Tăng trưởng 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim và GM Yang, J. Korean Phys. Soc. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard và RA Masut, J. Appl. Thể chất. 81, 3501 (1997).
[6] M. Mitsuhara, M. Ogasawara và H. Sugiura, J. Cryst. Tăng trưởng 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang và JJ Harris, Semicond. Khoa học. Technol. 15, 370 (2000).
[8] D. Doppalapudi, SN Basu, KF Ludwig, Jr. và TD Moustakas, J. Appl. Thể chất. 84, 1389 (1998).
[9] T. Takeuchi, H. Takeuchi, S. Sota, H. Sakai, H. Amano và I. Akasaki, Jpn. J. Appl. Thể chất. 36, L177 (1997).
[10] GB Stringfellow, J. Cryst. Tăng trưởng 58, 194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson và R. Stall, J. Cryst . Tăng trưởng 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Hồng, E.-K. Suh, HJ Lee, HK Cho và JY Lee, J. Korean Phys. Soc. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang và CS Kim, Appl. Thể chất. Lett. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars, và JS Speck và SJ Rosner, Appl. Thể chất. Lett. 72, 692 (1998).
[15] G. Pozina, JP Bergman, B. Monemar, T. Takeuchi, H. Amano và I. Akasaki, J. Appl. Thể chất. 88, 2677 (2000).
[16] JW Matthews và AE Blakeslee, J. Cryst. Tăng trưởng 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, JZ Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts và SM Bedair, J. Electron. Mater. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan và S. Mahajan, Appl. Thể chất. Lett. 77, 3391 (2000).
