PAM-XIAMEN cung cấp InGaAs (LT-InGaAs) phát triển ở nhiệt độ thấp trên Chất nền GaAs cho Chất nền ăng-ten dẫn quang InGaAs cho THz, bước sóng kích thích sẽ là 1030 nm. In0.53Ga0.47A phát triển ở nhiệt độ thấp trên GaAs được phát triển ở nhiệt độ thấp bằng công nghệ epit Wax chùm phân tử khí và ảnh hưởng của nhiệt độ tăng trưởng khác nhau và áp suất arsine đến chất lượng của lớp epiticular được nghiên cứu bằng tia X có độ phân giải cao công nghệ nhiễu xạ, giúp tối ưu hóa quá trình tăng trưởng epiticular chùm phân tử. Đồng thời, chất nhận loại p Be được đưa vào InGaAs để bù nồng độ chất mang nhằm tăng khả năng chống tối của vật liệu. Cuối cùng, đã thu được điện trở tấm và siêu mạng InGaAs / InAlAs ở nhiệt độ thấp chất lượng tốt, đạt 1,63×106Ω/□. Xếp chồng màng mỏng epiticular chất lượng cao sử dụng InGaAs trênGaAs waferđược bao phủ bởi các điểm tiếp xúc memtallic có thể được sử dụng trong các ứng dụng khác nhau.
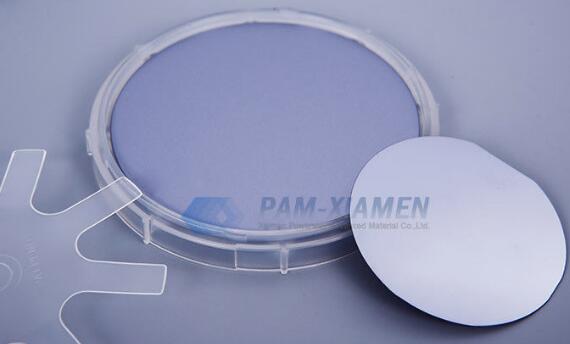
1. Thông số kỹ thuật của LT-InGaAs trên đế GaAs
Tấm wafer 2 inch LT-InGaAs (PAM210129-LT-INGAAS)
Đường kính (mm)Ф 50,8mm ± 1mm
Độ dày 0,5-3um
Diện tích bề mặt có thể sử dụng ≥90%
Đánh bóng: Đánh bóng một mặt
Cấu trúc: LT-InGaAs trên GaAs
Chất nền: Chất nền GaAs
Trong thành phần từ 0,05 đến 0,40
Ngoài ra, chúng tôi có thể cung cấp LT-GaAs (GaAs phát triển ở nhiệt độ thấp trên chất nền GaAs), vui lòng thông số kỹ thuật chi tiết bên dưới:
Thông số kỹ thuật wafer 2 LT-GaAs
Đường kính (mm)Ф 50,8mm ± 1mm
Độ dày 1-2um
Mật độ khuyết tật Marco<5 cm-2
Điện trở suất (300K) >10^8 Ohm-cm
Tuổi thọ của sóng mang <15ps hoặc <1ps
Mật độ trật khớp<1×106cm-2
Diện tích bề mặt có thể sử dụng ≥80%
Đánh bóng: Đánh bóng một mặt
Chất nền: Chất nền GaAs
2. Quá trình phát triển của wafer LT InGaAs Epi dựa trên GaAs
Vật liệu InGaAs ở nhiệt độ thấp được phát triển bằng phương pháp epitaxy chùm phân tử nguồn khí (GMBE), và ảnh hưởng của nhiệt độ tăng trưởng và áp suất As đến các tính chất của InGaAs đã được nghiên cứu. Các điều kiện tăng trưởng đã được tối ưu hóa: nhiệt độ tăng trưởng InGaAs là 300oC và áp suất As là 580 Torr. Thông qua pha tạp Be và sử dụng cấu trúc giếng lượng tử đa In0.52Al0.48As/In0.53Ga0.47As, điện trở của wafer InGaAs được tăng lên 1,632 x 106/sq và nồng độ chất mang giảm xuống 1,058 x 1014 cm-3. XRD cho thấy nhiều vật liệu giếng lượng tử InGaAs có chất lượng tinh thể cao hơn. Vật liệu giếng lượng tử đa pha tạp InGaAs này có mật độ bẫy cao và điện trở suất cao.
Do InAlAs có nồng độ bẫy electron sâu cao nên các electron trong lớp InGaAs có thể bị bẫy bởi bẫy electron sâu của InAlAs thông qua quá trình đào hầm, do đó điện trở tối của vật liệu được cải thiện đáng kể. Đối với lớp epi InGaAs nhiệt độ thấp không pha tạp, nồng độ chất mang không giảm nhiều khi sử dụng cấu trúc giếng lượng tử. Điều này có thể là do nồng độ electron cao của InGaA không pha tạp. Mật độ bẫy electron sâu trong InAlAs bị hạn chế và các electron bị bẫy đã đạt đến trạng thái bão hòa nên nồng độ chất mang không giảm nhiều. Cũng có thể thấy, việc sử dụng cấu trúc giếng đa lượng tử hầu như không ảnh hưởng tới khả năng di chuyển của các tàu sân bay. Bảng sau đây cho thấy các tính chất điện của indium gallium arsenide phát triển ở nhiệt độ thấp:
Đặc tính điện của các vật liệu InGaAs nhiệt độ thấp khác nhau
| Chất liệu | N(cm-3) | Tính di động (cm2/Vs) | Rs(ohm/sq) |
| LT InGaAs | 1,615 x 1017 | 4680 | 109.3 |
| LT InGaAs MQW | 1,25 x 1017 | 4220 | 168.3 |
| LT InGaAs: Hãy là | 1,708 x 1015 | 598 | 7,73 x 104 |
| LT InGaAs: Hãy là MQW | 1,058 x 1014 | 517 | 1,632 x 106 |
Tuy nhiên, vật liệu này sẽ gây ra các khuyết tật điểm nồng độ cao liên quan đến lượng As dư thừa khi nuôi InGaAs ở nhiệt độ thấp. Những khuyết điểm này hoạt động như các trung tâm tái tổ hợp, làm giảm đáng kể tuổi thọ của các hạt mang. Khi đó, năng lượng kích hoạt của mức năng lượng khiếm khuyết được tạo ra bởi sự tăng trưởng ở nhiệt độ thấp này sẽ thấp và InGaAs ở nhiệt độ thấp có độ dẫn điện cao. Một cách để cải thiện điện trở suất là thay thế các vị trí Ga bằng pha tạp Be để bù cho As.Gakhiếm khuyết chống vị trí do As dư thừa gây ra. Ngoài ra, việc thêm một lớp InAlAs mỏng để tạo thành cấu trúc LT InGaAs-InAlAs QWs có thể làm giảm hơn nữa thời gian phản ứng của vật liệu và tăng điện trở suất của vật liệu.
Để biết thêm thông tin, xin vui lòng liên hệ với chúng tôi email tạivictorchan@powerwaywafer.com và powerwaymaterial@gmail.com.

