Enkeltkrystal 3C-SiC substrat kan leveres med specifikationer som:https://www.powerwaywafer.com/3c-sic-wafer.html.
Siliciumcarbid (SiC) har fremragende egenskaber såsom bred båndgab, høj nedbrydningsfeltstyrke, høj mætning af elektrondrifthastighed og høj termisk ledningsevne og har vigtige anvendelser inden for områder som nye energikøretøjer, solcelleanlæg og 5G-kommunikation. Sammenlignet med den meget anvendte 4H-SiC har kubisk SiC (3C SiC) højere bærermobilitet (2-4 gange), lavere grænsefladedefekttæthed af tilstande (en størrelsesorden lavere) og højere elektronaffinitet (3,7 eV). Brugen af 3C-SiC til at forberede felteffekttransistorer kan løse problemet med dårlig enhedspålidelighed forårsaget af flere gate-iltgrænsefladedefekter. Men udviklingen af 3C-SiC baserede transistorer er langsom, hovedsageligt på grund af manglen på enkeltkrystalsubstrater. Tidligere undersøgelser har vist, at 3C-SiC er tilbøjelig til faseovergang under vækst, og eksisterende vækstmetoder kan ikke opnå krystaller med en enkelt krystalform.
1. Stabil vækst af 3C-SiC dyrket på 4H-SiC via TSSG
Ifølge den klassiske krystalvækstteori skal homogen todimensionel kernedannelse for glatte grænsefladekrystaller overvinde kritiske potentielle barrierer, med eksistensen af kritisk Gibbs fri energi eller overmætning, mens vækst kan forekomme ved enhver lille overmætning. For heterogen nukleering, på grund af indførelsen af ny fast-fast grænsefladeenergi, skal todimensionel nukleation overvinde højere kritiske potentielle barrierer. Derfor er homogen kernedannelse og vækst under samme overmætning væsentligt bedre med hensyn til energi end heterogen kernedannelse og vækst, hvilket gør sidstnævnte vanskeligt at forekomme.
For nylig har et forskerhold foreslået den akademiske idé om at regulere faststof-væske-grænsefladeenergien for at prioritere nukleation og vækst på heterogene frøkrystaller sammenlignet med homogene frøkrystaller. Indeholder primært:
1) Gittermismatchet mellem 3C (111)-smelte- og 4H (0001)-smelteoverfladerne er lille, og faststof-faststof-grænsefladeenergien er meget lav;
2) Forskellen i Gibbs fri energi mellem 4H og 3C bulkfaser er relativt lille;
3) Hvis grænsefladeenergien for 3C (111) – smelten er tilstrækkelig lav sammenlignet med den for 4H (0001) – smelter ved at justere smeltesammensætningen, er den todimensionelle nukleering og efterfølgende vækst af Gibbs frie energi mere gunstig for 3C fase.
Holdet designede og byggede uafhængigt testudstyr til overfladespænding og faststof-væske kontaktvinkel for smelter med ultrahøj temperatur. Overfladespændingen af forskellige sammensætninger af smelter og kontaktvinklen mellem smelten og 4H-SiC, 3C-SiC blev målt ved høje temperaturer, og variationsloven for faststof-væske grænsefladeenergi mellem 4H-SiC, 3C-SiC og høj- temperatursmeltning blev opnået, hvilket verificerede gennemførligheden af grænsefladeenergiregulering. Holdet brugte højtemperatur-væskefasemetoden til at opnå et lavere Gibbs-krav til fri energi til 3C-SiC under de samme overmætningsbetingelser, hvilket undertrykker faseovergange under vækst. For første gang internationalt blev der dyrket 3C-SiC enkeltkrystaller med en diameter på 2-4 tommer, en tykkelse på 4-10 mm og en enkelt krystalform, som vist i Fig. 1.
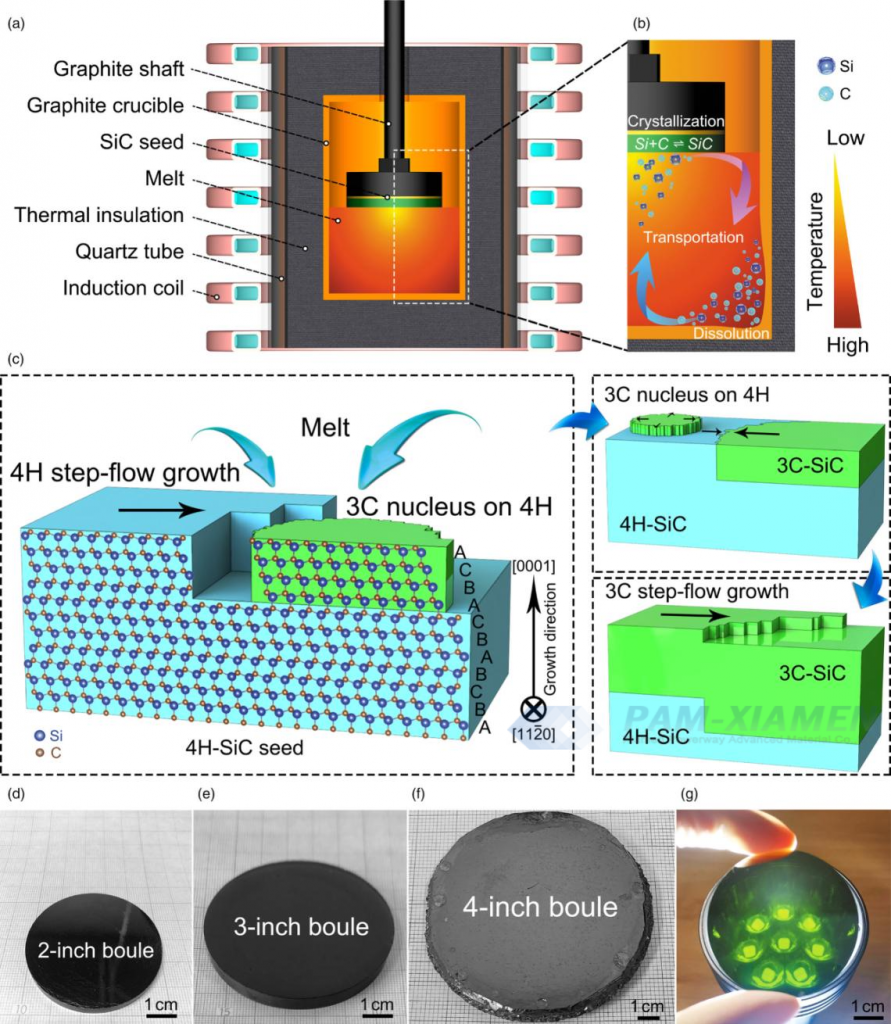
Fig. 1 Heterogen nukleering og stabil krystalvækst på 2-4 tommer, 4-10 mm tyk 3C-SiC blev opnået på 4H-SiC podekrystaller ved hjælp af TSSG-metoden
2. Egenskaber af TSSG Grown 3C-SiC Single Crystal
Raman-spredningsspektroskopi-målingerne langs krystaltykkelsesretningen indikerer, at 3C-SiC i begyndelsen af vækst nukleerer og vokser på 4H-SiC-frøkrystallen med en sameksistenszone på mindre end 20μm. Fig. 2 (ab) bekræfter yderligere ovenstående teori. Den gennemsnitlige halve bredde af røntgen-rokkekurven på (111) vækstoverfladen er 30 buesek., hvilket indikerer, at den dyrkede 3C SiC har høj krystalkvalitet. Rumtemperaturresistiviteten for 3C SiC-enkeltkrystal er kun 0,58 m Ω·cm, hvilket er 1/40 af den kommercielle 4H-SiC-waferresistivitet (15-28 mΩ·cm) og forventes at reducere enhedens energitab.

Fig. 2 Bestemmelse af 3C-SiC krystalstruktur. a) Vælg tilfældigt 20 Raman-spredningsspektre fra (111) vækstoverfladen, og det indsatte viser fordelingen af testpunkter på krystallen. b) Raman-spredningsspektre langs krystaltykkelsesretningen. c) Fotoluminescens (PL) spektrum målt ved 300K. d) Højvinkel ringformet mørkt felt scanning transmission elektronmikroskopi (HAADF-STEM) billede. Illustrationen viser det valgte områdeelektrondiffraktionsmønster (SAED) langs [110] krystalbåndaksen.
Væksten af wafer niveau 3C-SiC enkeltkrystaller udfylder hullet på globalt plan, hvilket gør masseproduktion af 3C-SiC krystaller mulig og giver nye muligheder for udvikling af højtydende kraftelektroniske enheder. I mellemtiden udvider mekanismen for præferencekernedannelse og vækst på heterogene frøkrystaller sammenlignet med homogene frøkrystaller den traditionelle krystalvækstteori.
For mere information, kontakt os venligst e-mail påvictorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

