Einkristallines 3C-SiC-Substrat kann mit folgenden Spezifikationen geliefert werden:https://www.powerwaywafer.com/3c-sic-wafer.html.
Siliziumkarbid (SiC) verfügt über hervorragende Eigenschaften wie eine große Bandlücke, eine hohe Durchbruchfeldstärke, eine hohe Sättigungselektronendriftrate und eine hohe Wärmeleitfähigkeit und hat wichtige Anwendungen in Bereichen wie Fahrzeugen mit neuer Energie, Photovoltaik und 5G-Kommunikation. Verglichen mit dem weit verbreiteten 4H-SiC weist kubisches SiC (3C SiC) eine höhere Ladungsträgermobilität (2- bis 4-fach), eine geringere Grenzflächendefektdichte der Zustände (eine Größenordnung niedriger) und eine höhere Elektronenaffinität (3,7 eV) auf. Die Verwendung von 3C-SiC zur Herstellung von Feldeffekttransistoren kann das Problem der schlechten Gerätezuverlässigkeit lösen, die durch Defekte an mehreren Gate-Sauerstoffschnittstellen verursacht wird. Der Fortschritt bei 3C-SiC-basierten Transistoren ist jedoch langsam, was hauptsächlich auf den Mangel an Einkristallsubstraten zurückzuführen ist. Frühere Studien haben gezeigt, dass 3C-SiC während des Wachstums zum Phasenübergang neigt und mit bestehenden Wachstumsmethoden keine Kristalle in Einkristallform erhalten werden können.
1. Stabiles Wachstum von 3C-SiC, gewachsen auf 4H-SiC über TSSG
Gemäß der klassischen Kristallwachstumstheorie muss die homogene zweidimensionale Keimbildung bei glatten Grenzflächenkristallen kritische Potentialbarrieren überwinden, wobei eine kritische freie Gibbs-Energie oder Übersättigung vorliegt, während Wachstum bei jeder kleinen Übersättigung stattfinden kann. Für die heterogene Nukleation müssen aufgrund der Einführung neuer Festkörper-Grenzflächenenergie bei der zweidimensionalen Nukleation höhere kritische Potentialbarrieren überwunden werden. Daher sind homogene Keimbildung und Wachstum bei gleicher Übersättigung energetisch deutlich besser als heterogene Keimbildung und Wachstum, was letzteres schwierig macht.
Kürzlich hat ein Forschungsteam die akademische Idee vorgeschlagen, die Energie der Fest-Flüssigkeit-Grenzfläche zu regulieren, um die Keimbildung und das Wachstum heterogener Impfkristalle im Vergleich zu homogenen Impfkristallen zu priorisieren. Hauptsächlich darunter:
1) Die Gitterfehlanpassung zwischen der 3C (111)-Schmelzoberfläche und der 4H (0001)-Schmelzoberfläche ist gering und die Festkörper-Grenzflächenenergie ist sehr niedrig;
2) Der Unterschied in der freien Gibbs-Energie zwischen 4H- und 3C-Massenphasen ist relativ gering;
3) Wenn die Grenzflächenenergie von 3C (111) – Schmelze im Vergleich zu der von 4H (0001) – Schmelze durch Anpassung der Schmelzzusammensetzung ausreichend niedrig ist, sind die zweidimensionale Keimbildung und das anschließende Wachstum der freien Gibbs-Energie für 3C günstiger Phase.
Das Team entwarf und baute unabhängig voneinander Prüfgeräte für die Oberflächenspannung und den Fest-Flüssigkeits-Kontaktwinkel von Ultrahochtemperaturschmelzen. Die Oberflächenspannung unterschiedlicher Zusammensetzungen von Schmelzen und der Kontaktwinkel zwischen der Schmelze und 4H-SiC, 3C-SiC wurden bei hohen Temperaturen gemessen, und das Variationsgesetz der Fest-Flüssigkeits-Grenzflächenenergie zwischen 4H-SiC, 3C-SiC und Hoch- Es wurde eine Temperaturschmelze ermittelt, die die Machbarkeit einer Grenzflächenenergieregulierung bestätigte. Das Team nutzte die Hochtemperatur-Flüssigphasenmethode, um unter den gleichen Übersättigungsbedingungen einen geringeren Bedarf an Gibbs-freier Energie für 3C-SiC zu erreichen und Phasenübergänge während des Wachstums zu unterdrücken. Zum ersten Mal auf internationaler Ebene wurden 3C-SiC-Einkristalle mit einem Durchmesser von 2–4 Zoll, einer Dicke von 4–10 mm und einer Einkristallform gezüchtet, wie in Abb. 1 dargestellt.
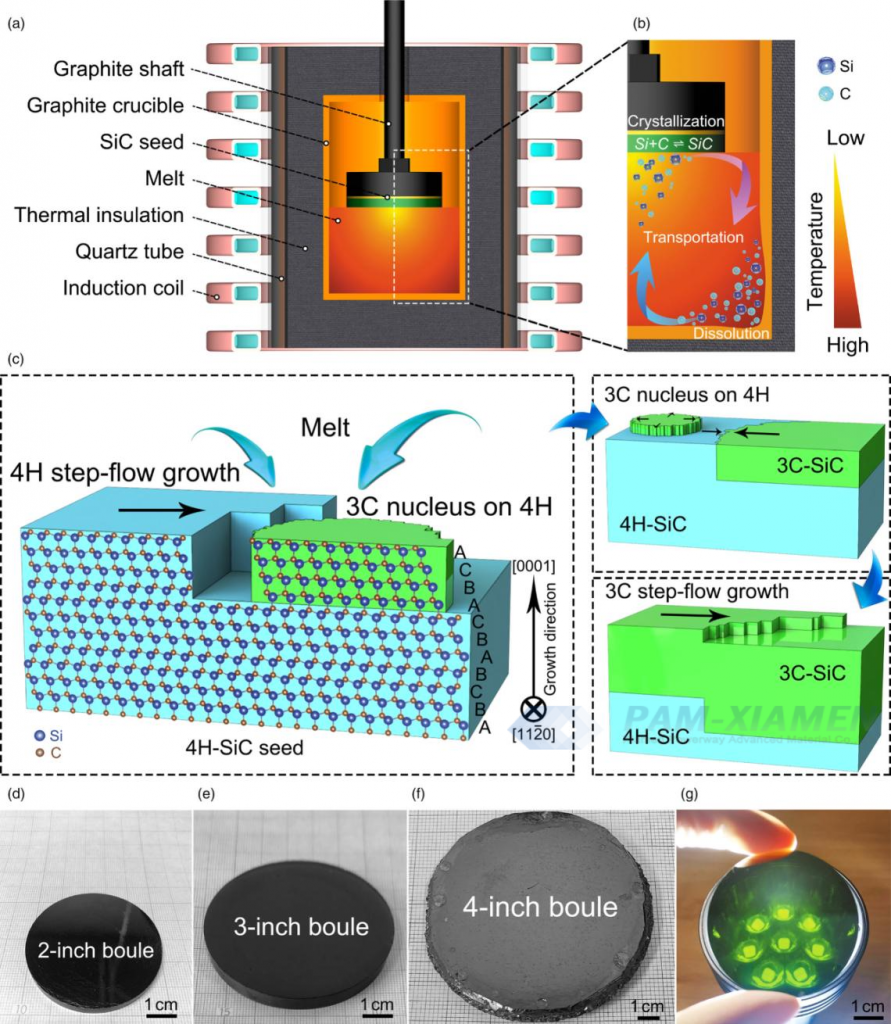
Abb. 1 Mit der TSSG-Methode wurden heterogene Keimbildung und stabiles Kristallwachstum von 2–4 Zoll und 4–10 mm dickem 3C-SiC auf 4H-SiC-Impfkristallen erreicht
2. Eigenschaften des TSSG-gewachsenen 3C-SiC-Einkristalls
Die Messungen der Raman-Streuungsspektroskopie entlang der Kristalldickenrichtung zeigen, dass zu Beginn des Wachstums 3C-SiC Keime bildet und auf dem 4H-SiC-Keimkristall wächst, mit einer Koexistenzzone von weniger als 20 μm. Abb. 2 (ab) bestätigt die obige Theorie weiter. Die durchschnittliche Halbwertsbreite der Röntgen-Rocking-Kurve auf der (111)-Wachstumsoberfläche beträgt 30 Bogensekunden, was darauf hinweist, dass das gewachsene 3C-SiC eine hohe Kristallqualität aufweist. Der spezifische Widerstand des 3C-SiC-Einkristalls bei Raumtemperatur beträgt nur 0,58 mΩ·cm, was 1/40 des kommerziellen spezifischen Widerstands des 4H-SiC-Wafers (15–28 mΩ·cm) entspricht und voraussichtlich den Energieverlust des Geräts reduzieren wird.

Abb. 2 Bestimmung der 3C-SiC-Kristallstruktur. a) Wählen Sie zufällig 20 Raman-Streuungsspektren von der (111)-Wachstumsoberfläche aus. Der Einschub zeigt die Verteilung der Testpunkte auf dem Kristall. b) Raman-Streuungsspektren entlang der Kristalldickenrichtung. c) Photolumineszenzspektrum (PL), gemessen bei 300 K. d) Bild der ringförmigen Dunkelfeld-Rastertransmissionselektronenmikroskopie (HAADF-STEM) mit großem Winkel. Die Abbildung zeigt das Selected Area Electron Diffraction (SAED)-Muster entlang der [110]-Kristallbandachse.
Das Wachstum von 3C-SiC-Einkristallen auf Waferebene füllt die Lücke auf globaler Ebene, ermöglicht die Massenproduktion von 3C-SiC-Kristallen und bietet neue Möglichkeiten für die Entwicklung leistungsstarker leistungselektronischer Geräte. Unterdessen erweitert der Mechanismus der bevorzugten Keimbildung und des bevorzugten Wachstums auf heterogenen Impfkristallen im Vergleich zu homogenen Impfkristallen die traditionelle Kristallwachstumstheorie.
Für weitere Informationen kontaktieren Sie uns bitte per E-Mail untervictorchan@powerwaywafer.com und powerwaymaterial@gmail.com.

