PAM-XIAMEN kan levere SiC epitaksiale wafere til MOSFET-enheder, yderligere information læs venligst:https://www.powerwaywafer.com/sic-mosfet-structure.html. Den epitaksiale proces af SiC danner uundgåeligt forskellige defekter, som påvirker ydeevnen og pålideligheden af SiC-kraftenheder. Nedenfor undersøger vi specifikt virkningen af trekantsfejl på ydeevnen af SiC MOSFET-enheder.
1. Hvad er trekantdefekter?
Trekantdefekt er en 3C-SiC polytype inklusion, der strækker sig langs basalplanets retning til overfladen af SiC epitaksiallaget. Det kan genereres af faldende partikler på overfladen af SiC-epitaksiallaget under den epitaksiale vækstproces. Partiklerne er indlejret i det epitaksiale lag og forstyrrer vækstprocessen, hvilket resulterer i 3C-SiC polytype indeslutninger, der udviser skarpe trekantede overfladetræk, med partiklerne placeret i hjørnerne af den trekantede region. Mange undersøgelser tilskriver også oprindelsen af polymorfe indeslutninger til ukorrekte parametre såsom overfladeridser, mikrotubuli og vækstprocesser.
På grund af forskellige vækstmekanismer er der imidlertid betydelige forskelle i morfologien af mange trekantedefekter på overfladen af det epitaksiale lag. Det kan groft inddeles i følgende typer:
1.1 Trekantdefekt med store partikler i toppen
Denne type trekantdefekt har en stor sfærisk partikel i toppen, som kan være forårsaget af faldende genstande under vækstprocessen. Et lille trekantet område med en ru overflade kan observeres i nedadgående retning af toppunktet. Dette skyldes, at der under den epitaksiale proces blev dannet to forskellige 3C-SiC-lag successivt i den trekantede region, hvor det første lag nukleerede ved grænsefladen og voksede gennem 4H-SiC-trinflow. Efterhånden som tykkelsen af det epitaksiale lag øges, danner det andet lag af 3C polytype kerner og vokser i mindre trekantede gruber, men 4H væksttrinnet dækker ikke 3C polytypeområdet fuldt ud, hvilket gør det V-formede rilleområde af 3C-SiC stadig tydeligt synlig, vist som i fig.

Fig. 1 Overflademorfologi af trekantdefekter med store partikler i toppen
1.2 Små partikler i toppen og ru trekantsfejl på overfladen
Partiklerne ved hjørnerne af denne type trekantdefekt er meget mindre, som vist i fig. 2. Og de fleste af de trekantede områder er dækket af trinstrømmen af 4H-SiC, det vil sige, at hele 3C-SiC-laget er fuldstændigt indlejret under 4H-SiC-laget. Trekantdefektoverfladen kan kun se væksttrinene for 4H SiC, men disse trin er meget større end de konventionelle 4H krystalvæksttrin.
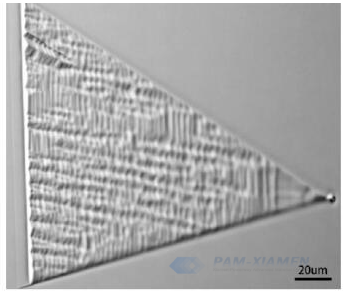
Fig. 2 Diagram af små partikler i toppen og ru trekantedefekter på overfladen
1.3 Glatte trekantedefekter på overfladen
Denne type trekantdefekt har en glat overflademorfologi, som vist i fig. 3. For sådanne trekantdefekter er 3C-SiC-laget dækket af trinstrømning af 4H-SiC, og overfladens 4H-krystalvækst er finere og glattere.
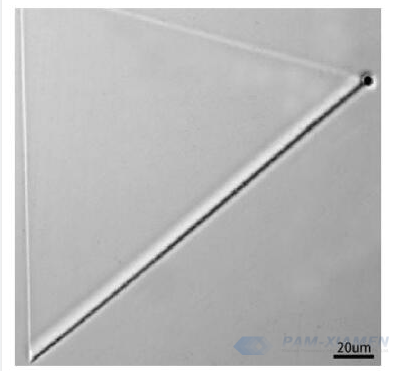
Fig. 3 Overflademorfologi af glatte trekantedefekter på overfladen
2. Trekantedefekters indflydelse på egenskaberne af SiC MOSFET-enheder
Forskere har undersøgt indflydelsen af trekantsdefekter på SiC MOSFET-ydeevne, og resultaterne er vist som fig. 4, som viser et histogram over den statistiske fordeling af fem karakteristika for enheder med trekantdefekter. Den blå stiplede linje repræsenterer segmenteringslinjen for enhedsforringelse, og den røde stiplede linje repræsenterer segmenteringslinjen for enhedsfejl. For enhedsfejl vist som i tabel 1 har trekantdefekter en betydelig indvirkning med en fejlrate på mere end 93 %. Dette tilskrives hovedsageligt påvirkningen af trekantsdefekter på enheders omvendte lækagekarakteristika, hvor op til 93 % af enhederne, der indeholder trekantdefekter, oplever en betydelig stigning i omvendt lækage. Derudover er indflydelsen af trekantsfejl på portens lækagekarakteristika også meget alvorlig med en nedbrydningsrate på 60%. Som vist i tabel 1, for nedbrydningen af tærskelspænding og kropsdiodekarakteristika, er indflydelsen af trekantdefekter relativt lille, med nedbrydningsforhold på henholdsvis 26 % og 33 %. Med hensyn til at forårsage en stigning i ledningsmodstanden er indflydelsen af trekantsdefekter relativt svag med en nedbrydningshastighed på omkring 33 %.
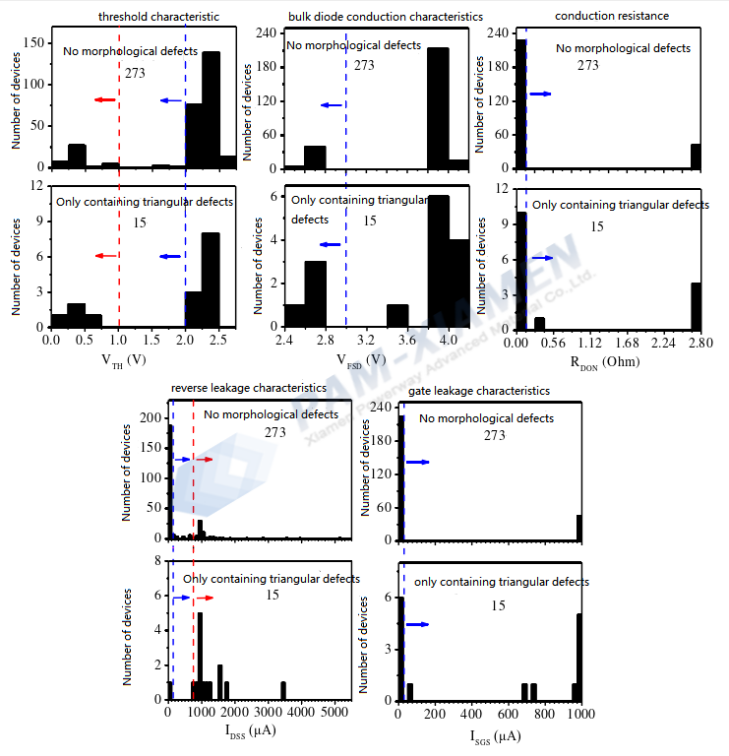
Fig. 4 Histogrammer af forskellige karakteristiske fordelinger af SiC MOSFET'er med trekantedefekter
| Tabel 1 Statistisk tabel over korrelationen mellem trekantdefekter og SiC MOSFET-enhedskarakteristika | |||||
| Enhedens egenskaber | VTHnedbrydningshastighed | VFSDnedbrydningshastighed | RDONnedbrydningshastighed | IDSSnedbrydningshastighed | ISGSnedbrydningshastighed |
| Trekantdefekt | 26% | 33% | 33% | 93% | 60% |
Samlet set viste undersøgelsen, at trekantdefekterne har en betydelig indvirkning på svigt og karakteristisk nedbrydning af SiC MOSFET-enheder. Eksistensen af trekantdefekter er den mest dødelige, med en fejlrate på op til 93%, hovedsageligt manifesteret som en betydelig stigning i omvendt lækage af enheden.
For mere information, kontakt os venligst e-mail påvictorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

